一、224G 高速互聯(lián)技術(shù)概述和背景
帶寬需求連年暴漲,單一通道帶寬 224Gbps 技術(shù)將加速超大規(guī)模云數(shù)據(jù)中心平臺向 800G演進(jìn),成為數(shù)據(jù)中心連接、企業(yè)和運(yùn)營商市場的一項(xiàng)重要技術(shù)。
112G 已批量商用,224G 高速互聯(lián)進(jìn)入預(yù)研階段,各芯片廠商 Marvel、博通、英偉達(dá)等已啟動 224G 高速互聯(lián)技術(shù)研究。研究方案包含光電互聯(lián)以及 PCB/Cable 技術(shù)等。見下圖 1-1所示。

在 28GHz 時,12dB 的板級損耗導(dǎo)致 Megtron6 材料有大約為 5 英寸的覆蓋范圍,而Megtron7 材料的范圍約為 10 英寸。這意味著在大型交換 SOC 和光學(xué)模塊之間驅(qū)動近一英尺的電路板。通過使用 PAM4 調(diào)制將符號速率擴(kuò)展到 200Gbps,同樣的 30 毫米封裝在 112GBd符號速率下將消耗大約 12dB 的損耗。這為電路板留下了大約三分之一的損耗預(yù)算。假設(shè)將相同的均衡水平應(yīng)用于 224G“芯片到模塊”,將導(dǎo)致交換和光模塊之間可用的 Megtron6 材料不到1英寸。更貴的Megtron7材料在兩個設(shè)備之間實(shí)現(xiàn)1.2英寸的距離。顯然,從在112Gbps時可以容忍一英尺的間隔,到 224Gbps 時僅為一英寸。使用光學(xué)器件構(gòu)建系統(tǒng)顯然會因這些類型的路由限制而變得笨拙。這是業(yè)界成功將設(shè)計(jì)擴(kuò)展到 224Gbps 必須克服的挑戰(zhàn)。
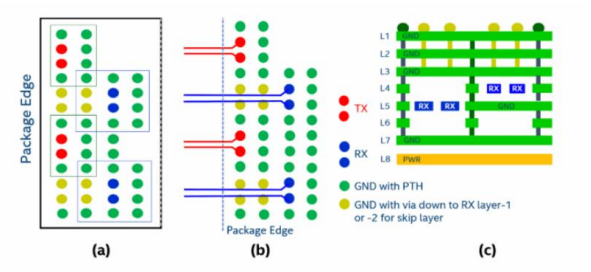
支持 800GbE 模塊的 112Gbps 已逐漸成熟,224Gbps PAM4 已處于開發(fā)階段,預(yù)計(jì)將速度再次提高一倍,最終支持每個模塊高達(dá) 1.6Tbps 或 3.2Tbps。圖 1-2 高速 224G 高速鏈接設(shè)計(jì)。224G 研究進(jìn)展及方案組合見表 1-1。

二、224G 高速互聯(lián)技術(shù)特點(diǎn)
2.1、224G 高速互聯(lián)設(shè)計(jì)
對于 224G 設(shè)計(jì),激光孔的高度會更高,因?yàn)闀褂帽?112G 設(shè)計(jì)更厚的電介質(zhì)來降低走線的 IL/mm,顯然 224G 的阻抗波動和 IL&RL 會差很多。
通過并聯(lián)增加更多的激光過孔以增加信號路徑的截面積來降低寄生電感,同時球墊/焊球與返回平面之間的寄生電容不增加。采用同軸 GSGSG 設(shè)計(jì)優(yōu)化信號返回路徑。通過多次芯板(MLC)疊層來減薄基板 core 厚度,從而縮短 PTH 的高度來進(jìn)一步減小寄生電感。
PCB BGA 區(qū)域與封裝 die bump 區(qū)域的功能相似,球間距是 FCBGA 芯片的關(guān)鍵參數(shù),大型 FCBGA 芯片的傳統(tǒng)球間距為 1.0mm,可以滿足 SIPI 和 PCBA 的可靠性要求。但對于 224Gbps信號,需要使用 0.8mm 或更小的球距來增加信道帶寬。但是,基于目前大型 FCBGA 芯片的技術(shù),0.8mm 或更小的球距不利于 PCBA 的可靠性,PCBA 廠商的焊接經(jīng)驗(yàn)也較少,這意味著球間距越小,PCBA 風(fēng)險(xiǎn)越高。
通過增加信號孔與回流孔的耦合來改善帶寬。帶寬提高到了 84Ghz 左右,回?fù)p也有明顯的降低。
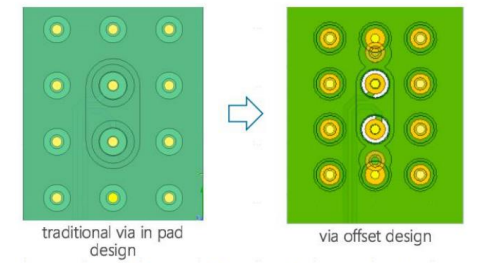
2.2、224G 芯片功耗及組裝
224G 芯片功耗增長,意味著供電電源的電流安培數(shù)增長,對 PCB 厚銅、PCB 導(dǎo)熱技術(shù)提出更高挑戰(zhàn)。
隨著交換芯片 Serdes 從 56Gbps 演變到 224Gbps,傳輸速率的不斷提升對芯片的封裝、組裝也提出了相應(yīng)要求,最直觀的要求就是提高速率、降低損耗。從業(yè)界研究看,焊球形狀(高度、直徑與外形輪廓等)與一致性會對 224G 及以上高速 SI 阻抗有顯著影響,普通鼓型焊點(diǎn)并非最優(yōu),圓柱形焊點(diǎn)反而可以獲得更好的效果。針對不同的焊球形狀和對應(yīng)尺寸進(jìn)行建模仿真,結(jié)果如下圖 2-3 所示,不同的焊球形狀阻抗從正常的 83 Ohm 降到 76 Ohm,極端惡化情況下會跌到 66 Ohm。
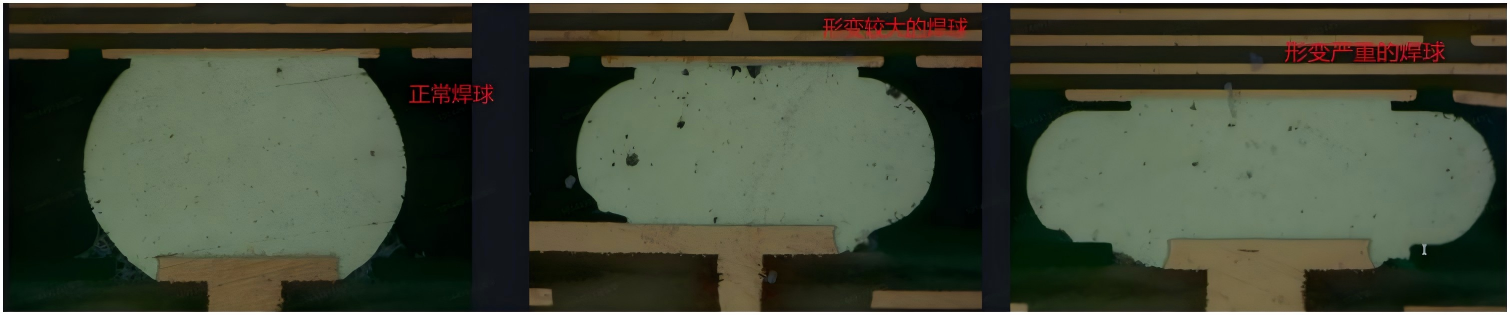
BGA 的焊球形狀最好是圓柱形,而目前 BGA 芯片尺寸越來越大的情況下 Warpage 也越來越大,難以保證焊球高度及形貌,如圖所示壓扁的焊球形貌會使高速性能劣化。目前 224G技術(shù)預(yù)研發(fā)現(xiàn)阻抗劣化已成為最大的瓶頸之一,因此有必要展開相關(guān)技術(shù)研究以攻克“焊形狀影響高速 Serdes 阻抗”這一技術(shù)難題。解決方案包括疊層優(yōu)化降低 PCB 的 CTE,開發(fā) Low CTE 板材減少 PCB 翹曲等。
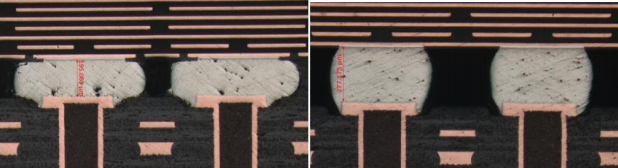
2.3、焊點(diǎn)可靠性
大尺寸BGA芯片焊點(diǎn)可靠性一直是產(chǎn)品痛點(diǎn),且隨著尺寸增大焊點(diǎn)可靠性呈下降趨勢,目前大尺寸芯片存在焊點(diǎn)可靠性風(fēng)險(xiǎn)。
影響焊點(diǎn)長期可靠性的最重要因素是,焊點(diǎn)在溫度變化過程中的失效。在不斷的升降溫過程中,由于各種材料的 CTE 不同(常規(guī)高速板材的 PCB 的 X/Y CTE 約 19-23ppm/℃,SSP4芯片的 CTE 約 12.8-14.7ppm/℃),焊點(diǎn)反復(fù)的應(yīng)力應(yīng)變將導(dǎo)致焊點(diǎn)中裂紋的萌生和擴(kuò)展最終導(dǎo)致焊點(diǎn)的失效。因此需要接近芯片 CTE 的 Low CTE 高速板材。224G 需要的 PCB 板材 CTE 值為,CTE(X,Y)≦13ppm/℃。
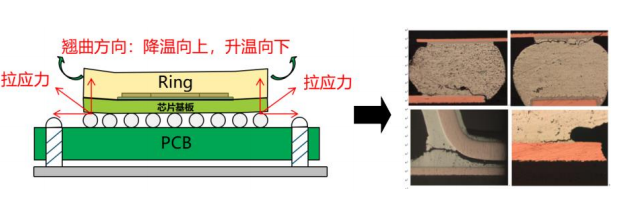
三、224G 互聯(lián)技術(shù)對 PCB 及覆銅板需求
3.1、224G 高速互聯(lián)傳輸目標(biāo)及要求
224G 高速互聯(lián)旨在實(shí)現(xiàn)超高速的數(shù)據(jù)傳輸,以滿足當(dāng)下及未來海量數(shù)據(jù)在各類應(yīng)用場景中的快速交互需求,如在超大規(guī)模云數(shù)據(jù)中心平臺中,助力其向 800G 乃至更高傳輸容量演進(jìn),為數(shù)據(jù)中心連接、企業(yè)和運(yùn)營商市場提供高效穩(wěn)定的數(shù)據(jù)傳輸通道。其對信號完整性、傳輸損耗、帶寬等方面都有著極為嚴(yán)苛的要求,例如要求極低的插入損耗、良好的回波損耗控制以及足夠?qū)挼挠行挘源吮U细咚傩盘柲軌蛟?PCB 及整個鏈路中穩(wěn)定、準(zhǔn)確地傳輸,避免信號失真、衰減等問題影響數(shù)據(jù)傳輸質(zhì)量。

224G 將在 112G 基礎(chǔ)上線路損耗下降 30%,并要求 PCB 具有良好可加工性。

3.2、PCB 布局更密,孔徑更小
要滿足 PCB 扇出插損和串?dāng)_等指標(biāo),224G 產(chǎn)品 PCB 采用極限密集隔離孔(孔壁間距 0.20mm)互聯(lián)工藝設(shè)計(jì),最小孔徑 0.15mm,布局有 0.4QFN、0.5BGA 等小器件。這樣的設(shè)計(jì)布局是為了在有限的 PCB 空間內(nèi)盡可能增加布線密度,縮短信號傳輸路徑,減少信號傳輸延遲以及降低信號間的相互干擾。更小的孔徑和更緊密的布局有助于優(yōu)化 PCB 的電氣性能,使其能夠適配 224G 高速互聯(lián)所要求的高頻高速信號傳輸特性,但同時也對 PCB 的制造工藝和加工精度提出了前所未有的挑戰(zhàn),需要先進(jìn)的設(shè)備和精湛的技術(shù)來確保每一個孔的加工精度以及各器件布局的準(zhǔn)確性。
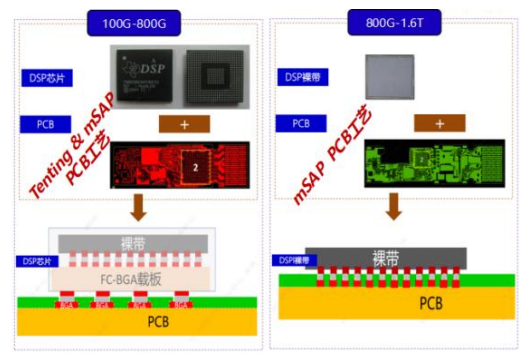
3.3、PCB 尺寸更大,縱橫比更高,漲縮要更小
PCB 尺寸預(yù)計(jì)超過 900mm,PCB 厚度達(dá)到 6.0mm,PCB 縱橫比超過 30:1,直徑最小 0.15mm(如圖 3-2 所示)。隨著高速互聯(lián)技術(shù)向 224G 邁進(jìn),更大尺寸的 PCB 能夠承載更多的電子元件和復(fù)雜的電路設(shè)計(jì),以滿足日益增長的功能集成需求。
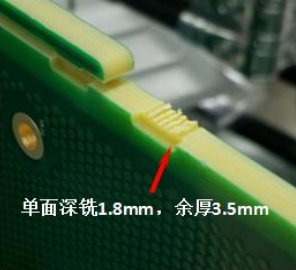
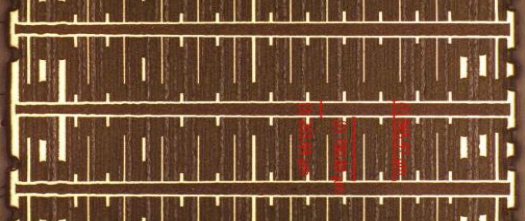
然而,大尺寸與高縱橫比的 PCB 在制造過程中極易出現(xiàn)漲縮問題,這會嚴(yán)重影響各層線路之間的對準(zhǔn)精度以及孔與線路的連接準(zhǔn)確性,進(jìn)而破壞信號傳輸?shù)耐暾浴R虼耍仨殗?yán)格控制 PCB 在加工及后續(xù)使用過程中的漲縮情況,這需要從 PCB 原材料的選擇、制造工藝的優(yōu)化以及生產(chǎn)環(huán)境的精準(zhǔn)控制等多方面入手,確保 PCB 的尺寸穩(wěn)定性達(dá)到 224G 高速互聯(lián)技術(shù)的高標(biāo)準(zhǔn)要求。
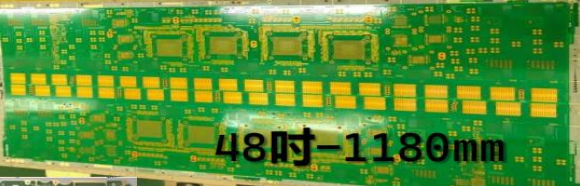
3.4、PCB 板廠 224G 加工能力
從降低插入損耗、損耗公差、背鉆 STUB、對位層偏、阻抗公差控制、最小線寬/線距、最大板厚、最大板尺寸、鉆孔厚徑比、背鉆直徑、新型棕化藥水引入、低損油墨、特殊工藝等各方面滿足 224G Serders 單板設(shè)計(jì)需求,并保證良率(具體見表 3-2)。PCB 板廠需要全面升級其加工能力,在各個工藝環(huán)節(jié)都要達(dá)到更高的精度和穩(wěn)定性。例如,在阻抗公差控制方面,要確保阻抗值在極小的允許誤差范圍內(nèi)波動,以保障高速信號傳輸?shù)姆€(wěn)定性;對于最小線寬/線距的把控,需借助高精度的制造設(shè)備和精細(xì)的工藝操作,實(shí)現(xiàn)極窄線寬和緊密線距的加工,滿足高密度布線要求。新型棕化藥水和低損油墨的引入,則有助于提升 PCB 的表面性能和信號傳輸質(zhì)量,降低信號在 PCB 表面?zhèn)鬏敃r的損耗。總之,PCB 板廠的 224G 加工能力是保障 224G 高速互聯(lián)技術(shù)得以落地應(yīng)用的關(guān)鍵環(huán)節(jié),需要不斷地技術(shù)創(chuàng)新和工藝優(yōu)化來滿足日益增長的高性能 PCB 制造需求。


(未完接下篇)
審核編輯 黃宇
-
pcb
+關(guān)注
關(guān)注
4368文章
23489瀏覽量
409669 -
激光
+關(guān)注
關(guān)注
20文章
3468瀏覽量
67188 -
數(shù)據(jù)中心
+關(guān)注
關(guān)注
16文章
5228瀏覽量
73517 -
覆銅板
+關(guān)注
關(guān)注
9文章
270瀏覽量
26839
發(fā)布評論請先 登錄
激光錫球焊錫機(jī)為MEMS微機(jī)電產(chǎn)品焊接帶來新突破

紫宸激光錫球焊錫機(jī)的應(yīng)用優(yōu)勢
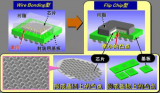
深度解析激光錫焊中鉛與無鉛錫球的差異及大研智造解決方案
震驚!半導(dǎo)體玻璃芯片基板實(shí)現(xiàn)自動激光植球突破

羅徹斯特電子針對BGA封裝的重新植球解決方案

AI領(lǐng)域市場爆發(fā),解讀224G技術(shù)下高速互連方案

SiP封裝產(chǎn)品錫膏植球工藝

224G 高速互聯(lián)對 PCB 及覆銅板需求及激光錫球植球機(jī)的助力(下)

揭秘BGA芯片植球技巧,打造完美電子連接!
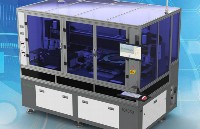
大研智造激光錫球植球機(jī):提升車用集成電路BGA焊球可靠性(上)
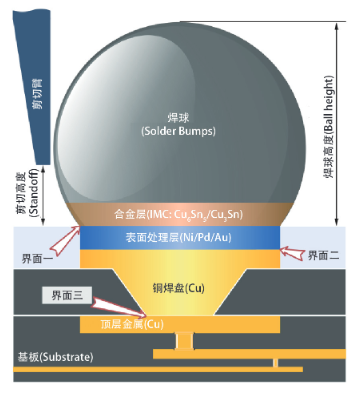
大研智造 探秘激光錫球全自動焊錫機(jī)在耳機(jī)端子制造中的應(yīng)用方案

激光錫球焊接機(jī)植球工藝在半導(dǎo)體行業(yè)的崛起

安費(fèi)諾推出QSFD-DD 224G解決方案
古希臘掌管224G 的神 | Samtec 224G PAM4 高速互連大合集!






 224G 高速互聯(lián)對 PCB 及覆銅板需求及激光錫球植球機(jī)的助力(上)
224G 高速互聯(lián)對 PCB 及覆銅板需求及激光錫球植球機(jī)的助力(上)












評論