微型化浪潮下的封裝革命。在5G通信、人工智能、自動駕駛等技術(shù)的推動下,半導(dǎo)體器件正朝著更高集成度、更小尺寸的方向發(fā)展。傳統(tǒng)的有機基板和陶瓷基板逐漸面臨物理極限,而玻璃基板憑借其優(yōu)異的絕緣性、低熱膨脹系數(shù)、高平整度及高頻性能,成為下一代先進封裝的核心材料。然而,玻璃基板的脆性特質(zhì)和高精度封裝需求,對焊接技術(shù)提出了全新挑戰(zhàn)。在此背景下,自動激光植球技術(shù)憑借其非接觸、高精度、低溫可控等特性,成為玻璃基板封裝的關(guān)鍵突破口。
玻璃基板的優(yōu)勢與挑戰(zhàn)
為何選擇玻璃基板?
1. 高頻性能卓越:玻璃的介電常數(shù)低,信號傳輸損耗小,適用于高頻芯片封裝。
2. 熱穩(wěn)定性強:熱膨脹系數(shù)與硅芯片接近,可減少熱應(yīng)力導(dǎo)致的失效風(fēng)險。
3. 工藝兼容性高:表面平整度優(yōu)于有機基板,適合高密度布線及微型焊盤設(shè)計。
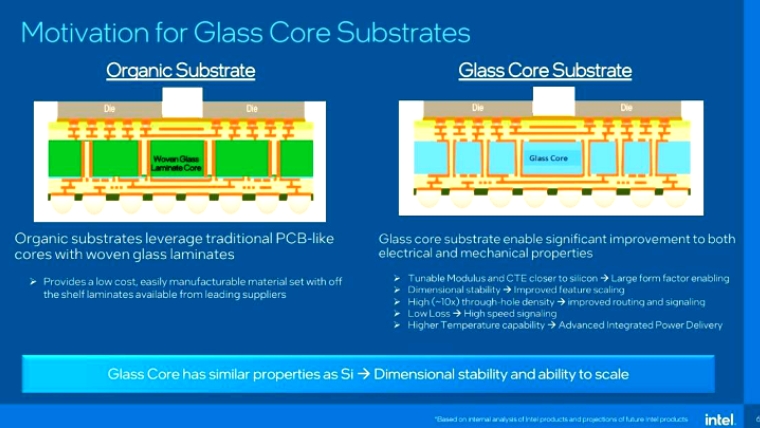
封裝痛點
玻璃基板的脆性使其在傳統(tǒng)焊接中易受機械應(yīng)力損傷;同時,微型焊盤(如50μm以下)對焊球精度和熱輸入控制要求極高。傳統(tǒng)的回流焊、熱壓焊等工藝易導(dǎo)致基板變形或焊球橋接,良率難以保障。
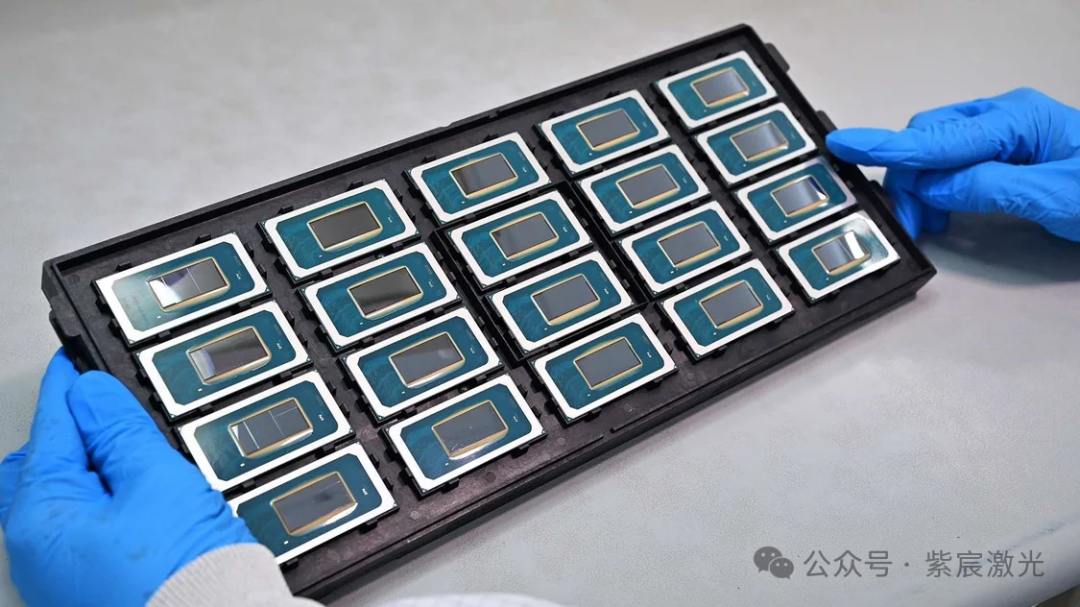
自動激光植球:技術(shù)原理與玻璃基板適配性
激光植球技術(shù)通過高能激光瞬間熔化錫球,并在氮氣保護下將其精準(zhǔn)噴射至焊盤,全程非接觸、無機械應(yīng)力。這一特性完美契合玻璃基板的封裝需求:
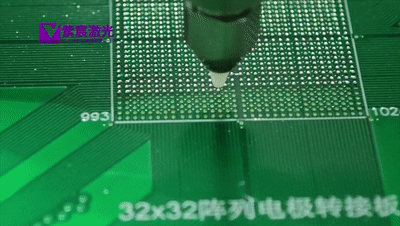
1. 低溫精準(zhǔn)控溫:激光能量可精確調(diào)節(jié),避免玻璃因熱沖擊破裂。
2. 微米級精度:支持60μm~2000μm錫球直徑,配合CCD視覺定位,滿足玻璃基板高密度焊盤需求。
3. 無應(yīng)力焊接:非接觸式工藝避免機械壓力,保護脆性基板結(jié)構(gòu)完整性。
工藝突破:倒裝芯片與2.5D/3D封裝
在玻璃基板的倒裝芯片(Flip Chip)封裝中,激光植球可預(yù)先在芯片焊盤上植球,再通過精準(zhǔn)對位實現(xiàn)芯片與基板的直接互連。此外,其支持非平面焊接的特性,為2.5D/3D堆疊封裝提供了新可能,助力玻璃基板在HBM(高帶寬內(nèi)存)等領(lǐng)域的應(yīng)用。
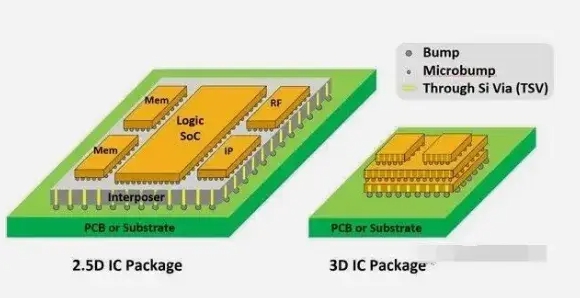
紫宸激光的解決方案:技術(shù)亮點與創(chuàng)新
作為激光焊接領(lǐng)域的領(lǐng)軍企業(yè),紫宸激光針對玻璃基板封裝推出了一系列優(yōu)化方案:
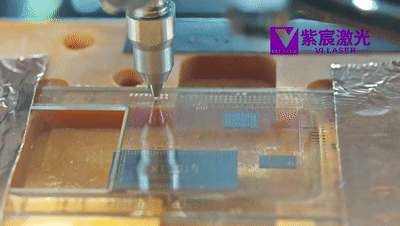
1. 定制化激光參數(shù):針對玻璃基板的熱敏感特性,開發(fā)低溫焊接模式,控制熱影響區(qū)(HAZ)在微米級。
2. 多材料兼容性:支持Au、Ag、Sn、Cu等多種焊盤鍍層,適配玻璃基板常見的金屬化工藝。
3. 智能工藝系統(tǒng):集成溫度反饋與實時監(jiān)測,確保焊點潤濕性優(yōu)良,X-Ray檢測顯示零空洞缺陷。
4. 柔性生產(chǎn)設(shè)計:雙工位交替作業(yè)、陣列上料等功能,提升生產(chǎn)效率至5球/秒,支持小批量多品種需求。
激光植球開啟玻璃基板新時代
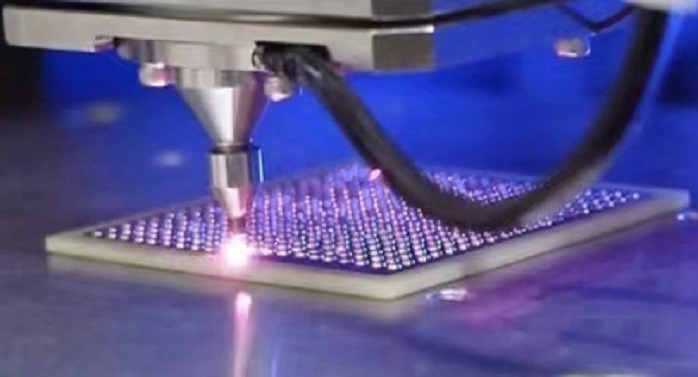
隨著臺積電、英特爾等巨頭加速布局玻璃基板技術(shù),未來3D IC、Chiplet等架構(gòu)將更依賴高精度焊接工藝。激光植球技術(shù)憑借其工藝精簡、成本可控、適應(yīng)性強的優(yōu)勢,有望成為玻璃基板封裝的核心標(biāo)配。紫宸激光等企業(yè)通過持續(xù)迭代光學(xué)系統(tǒng)與智能化控制,將進一步推動半導(dǎo)體封裝向“更小、更快、更可靠”的方向演進。
結(jié)語

在半導(dǎo)體行業(yè)“超越摩爾定律”的探索中,玻璃基板與激光植球技術(shù)的結(jié)合,不僅是材料與工藝的創(chuàng)新,更是整個產(chǎn)業(yè)鏈協(xié)同突破的縮影。未來,隨著5G、AI、汽車電子等需求的爆發(fā),激光錫球焊接機這一技術(shù)組合或?qū)⒊蔀橹袊雽?dǎo)體高端制造的重要競爭力。
-
激光
+關(guān)注
關(guān)注
20文章
3422瀏覽量
65792 -
芯片封裝
+關(guān)注
關(guān)注
11文章
573瀏覽量
31241 -
植球
+關(guān)注
關(guān)注
0文章
3瀏覽量
6724 -
半導(dǎo)體芯片
+關(guān)注
關(guān)注
60文章
928瀏覽量
71223
發(fā)布評論請先 登錄
玻璃基板、柔性基板和陶瓷基板的優(yōu)劣勢

激光植球在半導(dǎo)體高精部位的微焊接應(yīng)用
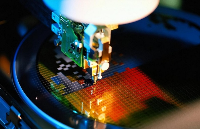
玻璃基板:半導(dǎo)體封裝領(lǐng)域的“黑馬”選手

揭秘BGA芯片植球技巧,打造完美電子連接!
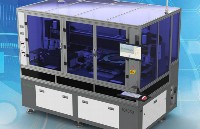
這一聯(lián)合開發(fā)涉及半導(dǎo)體封裝玻璃陶瓷基板
JNTC 向3家半導(dǎo)體封裝公司提供首批玻璃基板樣品
激光錫球焊接機植球工藝在半導(dǎo)體行業(yè)的崛起

特種玻璃巨頭肖特發(fā)力半導(dǎo)體業(yè)務(wù),新材料基板成為下一代芯片突破口
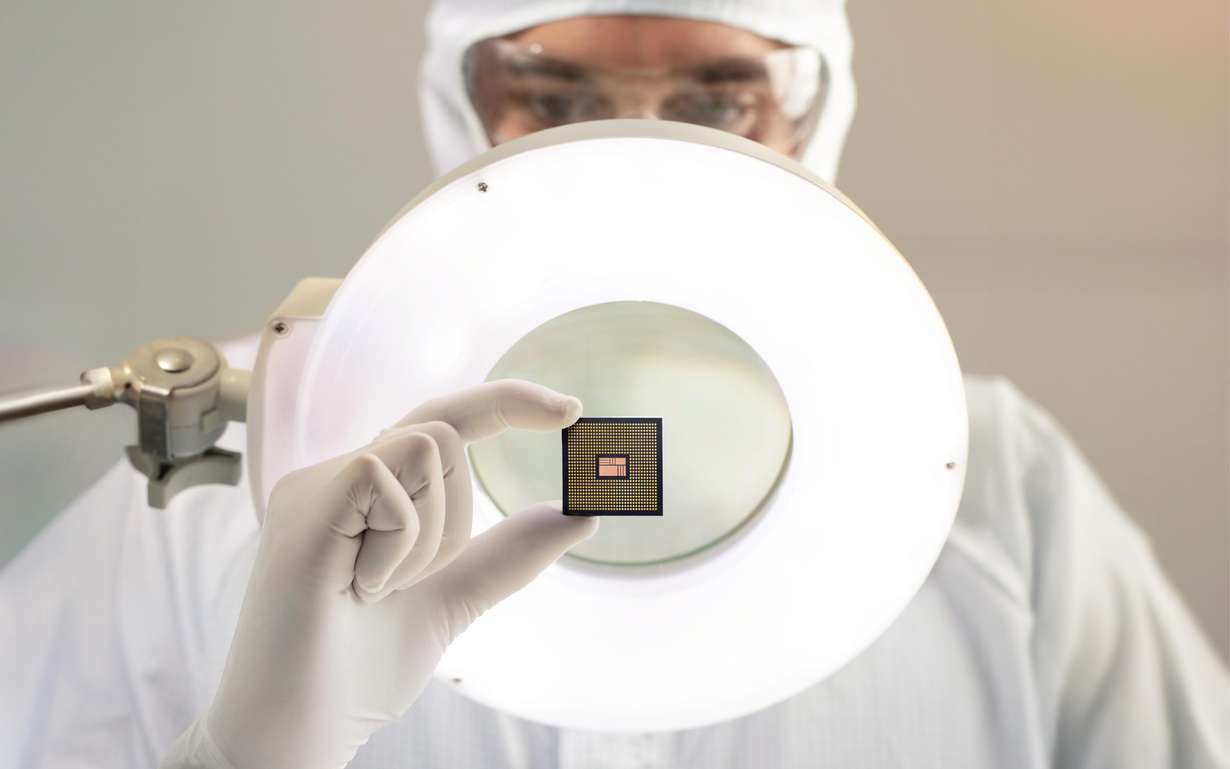
臺積電角力玻璃基板:和英特爾、三星競爭,首批芯片最快有望 2025 年投產(chǎn)
探尋玻璃基板在半導(dǎo)體封裝中的獨特魅力
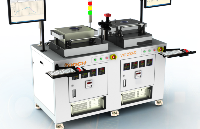
LG進軍半導(dǎo)體玻璃基板市場
英特爾是如何實現(xiàn)玻璃基板的?
BGA連接器植球工藝研究






 震驚!半導(dǎo)體玻璃芯片基板實現(xiàn)自動激光植球突破
震驚!半導(dǎo)體玻璃芯片基板實現(xiàn)自動激光植球突破











評論