1,芯片性能提升催生散熱需求,封裝材料市場穩健增長
AI 需求驅動硬件高散熱需求。根據Canalys預測,兼容AI的個人電腦將從 2025 年開始快速普及,預計至2027年約占所有個人電腦出貨量的60%,AI有望 提振消費者需求。2023年10月,高通正式發布驍龍8 Gen 3處理器,該處理器 將會成為2024年安卓旗艦的標配處理器,包含一個基于Arm Cortex-X4技術的 主處理器核心,Cortex-X4超大核是Arm迄今最強悍的CPU核心,同X3相比, X4 的整數功率從4.1W暴漲至5.7W。在高性能AI處理器的加持以及消費者需求 下,消費電子終端產品持續向高集成、輕薄化方向發展的大趨勢下,芯片和元 器件體積不斷縮小,功率密度卻在快速增加,消費電子產品的散熱方案需要不 斷升級。
圖表1:高通驍龍8歷代芯片功耗對比

多個環節決定了芯片的散熱性能。其中,固晶膠/膜等封裝黏接材料的主要職責 是將載體與芯片或芯片之間進行黏合,但同時因其熱膨脹系數最好接近芯片和 芯片載體,以減小芯片黏接導致的熱應力,而且具有優良的導熱系數,可以有 效地將芯片所產生的熱傳遞到組裝材料以利于散熱;底部填充料(Underfill) 在先進封裝中用于緩解芯片結構之間熱膨脹系數不匹配產生的內應力,以提高 芯片的熱循環可靠性;熱界面材料(TIM)可以直接改善兩個表面之間的散熱性 能;散熱器則需將發熱設備所傳導的熱量再傳導至空氣等物質。
封裝材料市場規模穩健增長,預計2027年達298億元。集成電路封裝產品中所 使用具體材料的種類及其價格按照封裝形式和產品種類的不同存在較大差異, 但封裝材料成本通常會占到整體封裝成本的40%~60%。根據SEMI,2022年全球 半導體封裝材料銷售額為261億美元,預計到2027年將增長至298億美元, CAGR+2.7%。

黏接材料:由DAP向DAF升級 黏接材料的基本功能可以被概述為將集成電路芯片鍵合在芯片載體上,或是芯 片與芯片之間的堆疊及黏接。傳統的芯片黏接材料按其方法的不同可被分為黏 接法、焊接法以及低溫封接玻璃法。
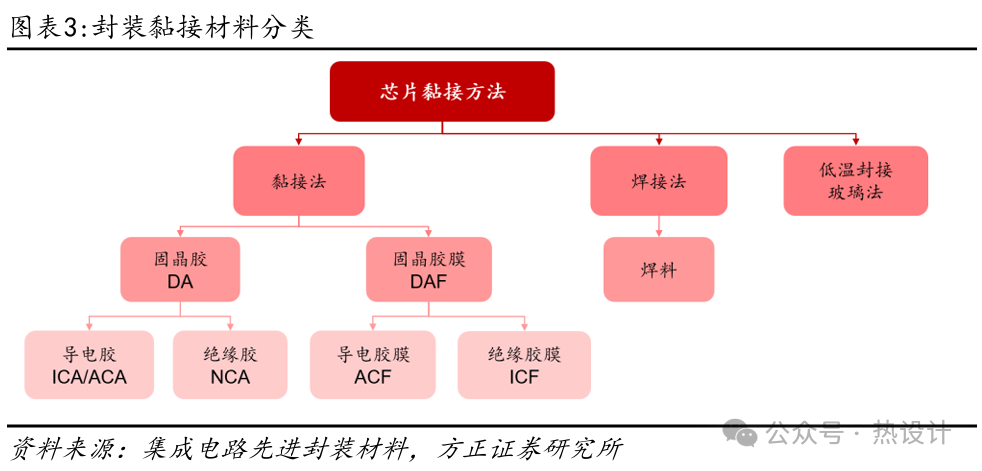
黏接法是指用高分子樹脂把芯片黏到焊盤上,使兩者實現連接。因為環氧樹脂 屬于穩定的高分子聚合物,所以大多數的樹脂黏接劑采用環氧樹脂作為主體材 料分為固晶膠和固晶膠膜。
固晶膠向固晶膠膜升級,以應對芯片尺寸減小及高集成度需求。固晶膠作 為一種封裝黏接材料,對芯片的有效散熱也有重要作用。但受制于固晶膠均 勻性差、容易有樹脂泄漏等缺點,隨著芯片尺寸的減小,芯片在鍵合時的均 勻性對其缺陷率的影響也不斷放大,固晶膠逐漸升級成固晶膠膜。固晶膠膜 相比固晶膠擁有時間、成本以及性能上的全面優勢,其解決了固晶膠的均勻 性問題,同時省去了切割后的涂膠環節,大幅度縮減了工藝流程的時間成 本。
2,封裝散熱材料是芯片熱量轉移的關鍵材料。散熱材料可被分為:熱界面材料,均熱片和散熱器。
1) 熱界面材料(TIMs):
熱界面材料(Thermal Interface Materials, TIM) 可改善兩個表面之間的傳 熱。電子設備的性能不斷提高,但它們消耗更多的電量并產生更多的熱量。如 果熱量無法有效散發,設備的性能就會受到影響。TIM1 型材料被用作第一道防線。TIM1材料通常放置在半導體封裝內,位于發熱 芯片/管芯和散熱金屬蓋之間,與兩者接觸以實現更直接的散熱。TIM2材料作為 第二道防線,通常放置在半導體封裝的外部和散熱器之間。從技術角度來看, TIM1 的可靠性和性能要求比TIM2高得多,需要更高性能的填料和配方。
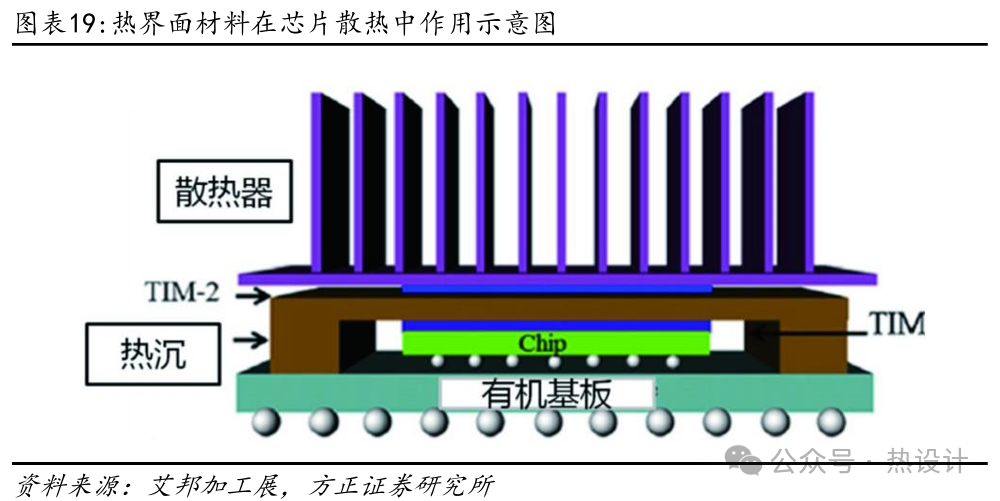
目前導熱界面材料主要有四類:
(1)導熱灌封膠:用于模塊的整體封裝;
(2)導熱硅脂(導熱膏):具有一定流動性或呈黏稠狀的膏狀物,用于填充微小間 隙,比如將膏體涂覆在CPU和散熱器之間,發熱堆和殼體之間,將空氣擠壓出 去,形成散熱通道;
(3)導熱膠墊:是一種柔性可壓縮的彈性材料,在施加一定壓力的情況下,能很 好地順應接觸不規則的表面,填補固體間的空隙,而又不會對元器件造成污 染,用于電子電器產品的控制主板、LED散熱、電機內外部墊腳、鋰電池熱管理 等;
(4)導熱相變材料:在常溫時處于固態,在吸收功率器件熱量后,達到一定溫度 才融化為液態,因此可以很好地浸潤固體界面,從而減少熱阻,它既能吸收熱 量,又有良好的傳熱性,綜合了導熱硅脂和導熱膠墊的優勢,既解決了硅脂涂 抹操作難的問題,也解決了導熱膠墊因為厚度和界面熱阻帶來的導熱效果的問 題。
流動態導熱油脂占據最大市場份額。熱界面材料市場規模方面,流動態的導熱 油脂用作導熱材料,有利于使用過程中的自動化,并且其熱阻很小,是當前市 場份額最大的導熱界面材料,2020年其市場規模達3.6億美元,膠膜和膠帶緊 隨其后,市場規模為3.2億美元,其余熱化合物、金屬基等材料運用相對較小。

TIM1 材料必須能夠承受從-40°C到150°C的極端溫度循環,而溫度循環TIM2 材料的功能上限通常更接近120°C。雖然這30°C的溫度上限差異可能看起來 并不多,但它顯著降低了配方要求,允許在基礎材料和填料選擇方面有更多的 可變性,如某些環氧樹脂或其他熱塑性材料,否則可能會成為TIM1應用的競爭 者,不能承受150°C的溫度而不硬化和分層,導致熱故障。出于這個原因,大 多數TIM1材料是基于有機硅的化學物質,以滿足150°C的上限,還必須利用 表面處理功能化的導熱填料顆粒,以忍受極端溫度隨著時間的推移,而不會變 脆,改變其凝膠狀的特性,并誘導由于高熱膨脹系數不匹配的機械應力。
2) 均熱片:
均熱片(Heat Spreader)是一種半導體器件的熱輻射底板,用于器件的有效散 熱和熱應力的減少。因此,均熱片需要以下幾點特性: (1) 較高的熱導率 (TC) (2) 與器件材料之間最佳的熱膨脹系數 (CTE) (3) 與半導體芯片以及焊料之間的良好粘結性。
均熱片應用廣泛,涵蓋多個終端應用領域。均熱片作為半導體器件封裝中的重 要材料,其形狀與大小也根據元器件的需求進行調整,均熱片的應用領域涵蓋 了消費電子、服務器、汽車電子及通訊等多個應用領域。
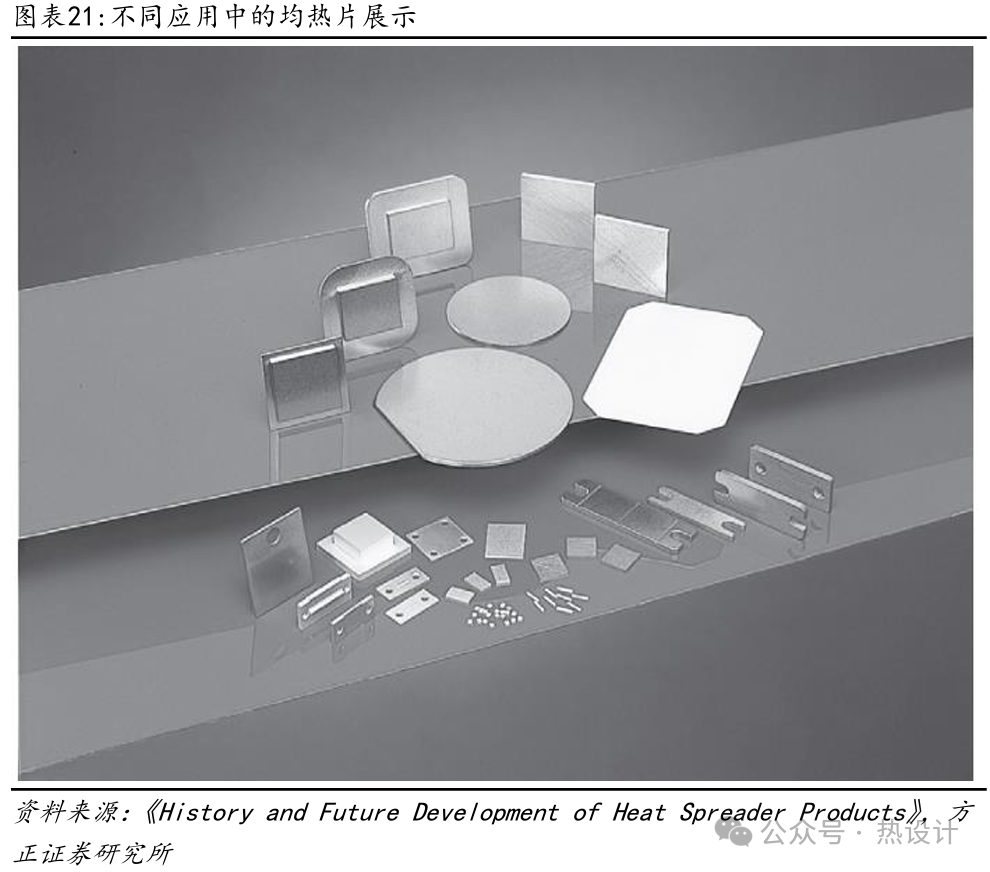
均熱片材料決定了散熱性能。均熱片在芯片散熱領域中屬于“被動性散熱組 件”,將導熱性佳的金屬貼附于發熱表面,以復合的熱交換模式來散熱。均熱片 主要與在其與已封裝的芯片之間的TIM II 配合進行散熱,其本身并不能為器件 降溫,只是將熱量傳遞到另一個物體上,讓熱量安全地從器件上散發出去,因 此制造均熱片的材料決定了均熱片的熱導率以及線性熱膨脹系數。均熱片材料包括銅鎢、銅鉬、銅金剛石、銀金剛石、鋁碳化硅、CVD鉆石等不同 材料。每種材料都具有獨特的特性,可與不同種類的半導體相輔相成,用于不 同的應用領域。
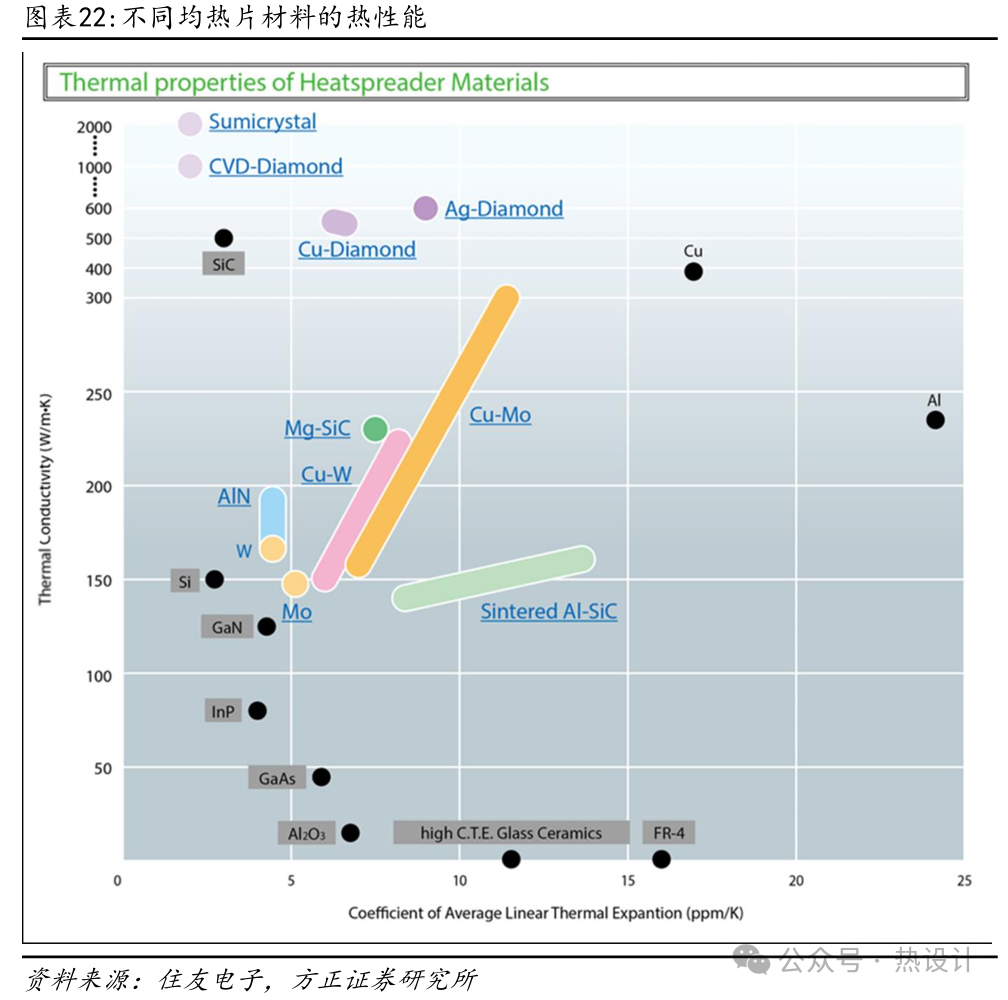
隨著高性能計算對散熱性能愈來愈高,均熱片作為芯片散 熱解決方案最核心的組成部分,對其性能的要求也更加嚴苛,產品的性能溢 價有望進一步提升。
3) 散熱器:散熱器(Heat Sink)與均熱片的作用基本相同。其作為被動散熱器件用于將器 件產生的熱量轉移到流體介質(通常為空氣或液體冷卻劑)中,然后將熱量從 設備中散發出去,從而將設備的溫度控制在最佳水平。散熱器與均熱片不同,通常由排列成梳狀的金屬部件組成,梳狀的部分也被稱 為散熱片,其增加了表面面積,從而提高了散熱性能,往往散熱器會與風扇或 泵結合,以提供強制循環以及主動散熱的作用,以提高冷卻效率。
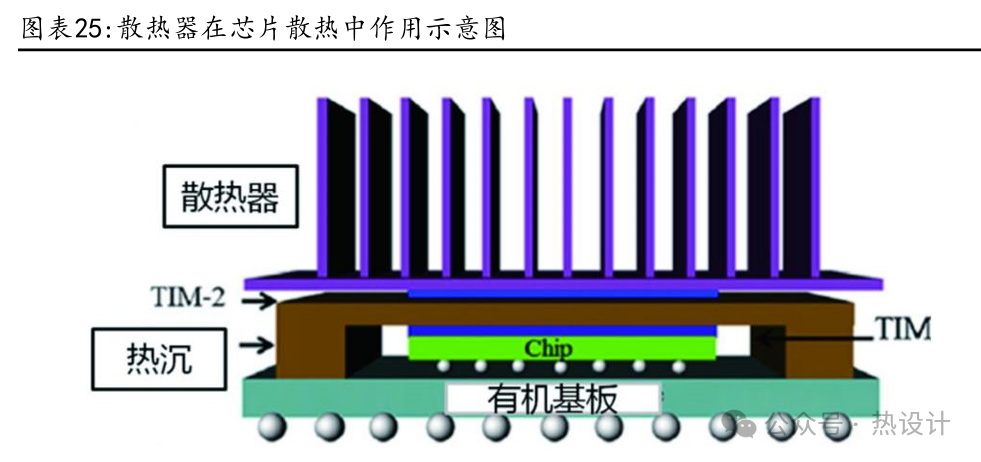
底部填充料是倒裝的關鍵材料之一,在先進封裝中用于包括緩解熱膨脹系 數不匹配產生的內應力,分散芯片正面承載的應力,保護焊球、傳遞芯片間 的熱量等作用。受AI應用蓬勃發展及手機、電腦等消費電子產品小型化驅 動,底部填充膠市場2030年有望增長至15.8億美元,當前市場主要由德 國漢高、日本昭和電工、信越等公司占據主要份額,國內科技不斷加速, 突破海外壟斷,實現國產替代。
新的應用程序層出不窮,也是導致芯片越來越熱的原因之一。新的應用架構、算法和功能需要更多的處理能力和運存,也意味著需要更強大和高效的芯片和操作系統的支持。高效的芯片要求芯片擁有更高的時鐘頻率和更高的運行速度,更多的性能意味著更高的功率。很多應用程序需要在多個線程之間交織運行,這就需要同時依附很多資源,而這些資源都需要芯片持續地為其供電,最終導致芯片溫度極高。


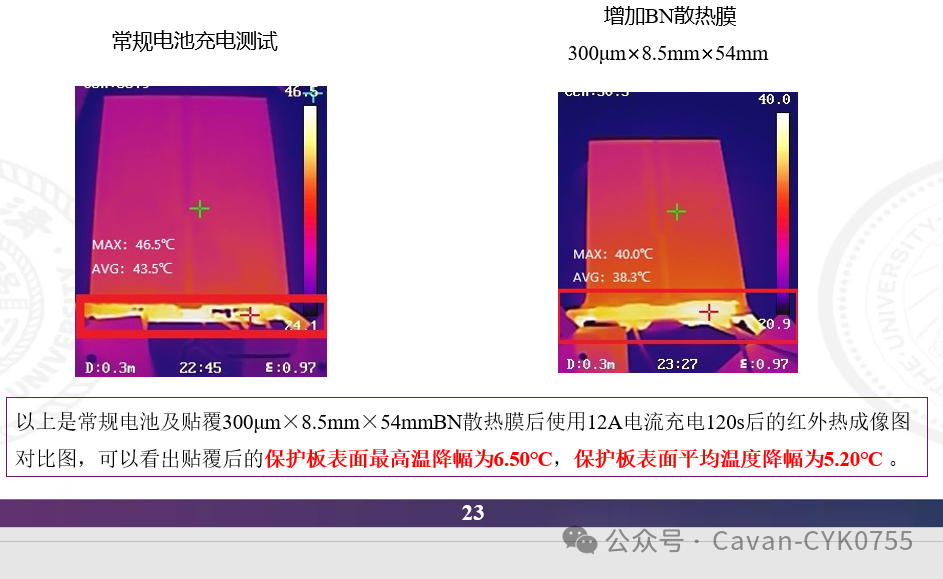
-
芯片
+關注
關注
459文章
52151瀏覽量
436015 -
散熱
+關注
關注
3文章
537瀏覽量
32217 -
封裝材料
+關注
關注
1文章
60瀏覽量
8970 -
芯片功耗
+關注
關注
0文章
8瀏覽量
7178
發布評論請先 登錄
芯片為什么要做低功耗設計?
智慧路燈的推廣面臨哪些挑戰?
全面剖析倒裝芯片封裝技術的內在機制、特性優勢、面臨的挑戰及未來走向
AMD MI300X AI芯片面臨挑戰
7納米工藝面臨的各種挑戰與解決方案
大算力芯片面臨的技術挑戰和解決策略
AI驅動產業革新 | 芯片散熱從風冷到液冷






 芯片功耗提升,散熱面臨挑戰!
芯片功耗提升,散熱面臨挑戰!













評論