大部分掃描電鏡實驗室對于納米尺寸的準確測量,要求沒有那么嚴格,比如線寬或顆粒大小到底是105nm還是95nm,似乎不太重要,大部分用戶關心統計趨勢而不是某一個值的準確值。但在半導體領域,105nm或95nm的誤差,是不可接受的。這就提出了一個問題,我們如何才能測準?本文討論了SEM成像參數、儀器校準以及電子束-樣品相互作用模型對準確度的影響。
自掃描電子顯微鏡(SEM)問世以來,經歷了巨大的演變,已成為許多科學和工業領域的重要研究工具。高分辨SEM特別適合定性和定量方面的應用[1],尤其是納米技術和納米制造。
在第一張SEM圖像被記錄之前,人們最先提出的問題之一很可能是:"這個東西到底有多寬?"在過去的幾年里,這個問題的答案精度有了很大的提高,特別是如今CD-SEM已被用作半導體加工生產線上的主要測量工具,用于監控生產過程。半導體生產的明確需求推動了SEM設備及其功能的快速發展。在過去20年左右的時間里,通過半導體行業大量的研發資金投入,SEM儀器制造商極大地提高了這些儀器的性能,尤其是在使用SEM進行定量測量時。但是,這些數據到底有多好或者多準確?
SEM技術的發展
SEM廣泛應用于科學、醫學、工業研究以及制造業的各個領域。自20世紀50年代誕生和60年代作為商業產品問世以來,SEM經歷了巨大的發展,成為許多應用領域不可或缺的工具。
SEM性能和操作都有了許多改進。**電子源從常規鎢燈絲到六硼化鑭,再發展到冷場和熱場電子槍,提供了更高的亮度和更好的儀器性能。**新的電磁透鏡和靜電透鏡的設計以及數字電子技術的應用,也使儀器的性能得到了提升。如今,自動化程序、自動對焦、自動像散校正和數字成像等其他操作改進,這些改進總體上提高了SEM的整體性能,并使儀器更易于操作。但正因如此,使用該儀器的人可能會以為所有潛在的不準確的隱患都已消除,他們相信在顯微照片上看到的一切總是準確或正確的,但事實可能并非如此。
二次電子圖像的邊緣效應
現代SEM顯示和記錄的圖像看似快速、實時。實際上,電子束是以典型的矩形(或正方形)"光柵"模式快速穿過樣品的。當電子束穿過檢查區域時,會產生幾種不同類型的信號,如透射電子、二次電子、背散射電子、特征X射線等。
如果配備了合適的電子探測器,就可以收集并顯示其中部分或全部信號。事實上,SEM可以同時顯示或記錄多個信號。無論選擇哪種信號,它都是電子束光柵式掃描圖案時與樣品相互作用產生的逐點信號。
收集和顯示的信號被稱為"二次"電子信號,形成典型的SEM圖像。如圖1(a)所示,二次電子信號中的"二次"特意用引號表示,因為它可以是多個成分的總和。

圖1 (a) 二次電子信號的圖示,以及可能對圖像產生影響的四種二次電子。(b) 邊緣信號增強的一種可能性推導圖示,顯示了SEM中邊緣物理位置的不確定性。
在圖像推導方面的第二個考慮因素是,根據被測材料的成分和入射電子束的著陸能量,電子束可以穿透樣品到一定的距離。高能電子在進入樣品和離開樣品時都會產生信號(圖1(b))。根據所觀察樣品的形貌,當電子束接近邊緣時,會在這些形貌特征(如尖端、臺階等)處產生更多的二次電子信號。
所有這些信號,不管是有用的還是無關的,都會針對該點進行求和。如圖2所示,這是大多數二次電子圖像的特征(在隨后的顯微照片中也能觀察到邊緣增強)。邊緣信號增強也會隨探測器位置、樣品和其他儀器操作條件的不同而變化。

圖2 懸浮在網格上的碳納米管樣品的SEM圖,二次電子成像,顯示了邊緣增強效應。
由于二次電子圖像的邊緣信號增強效應會掩蓋樣品真正的邊緣位置,人們對此進行了大量研究。邊緣位置的不確定可能會導致對SEM圖像的許多解釋和測量出現錯誤。在操作條件(著陸能量、信號選擇、傾斜度等)或信號選擇方面通常可以做出許多調整,如果操作人員能夠識別這些調整,通常可以將這些影響降至最低。重要的是,要想獲得準確的測量結果,必須使用基于物理的建模方法來解釋。
儀器校準
簡單地說,校準是指將SEM的X和Y掃描電路調整為名義上以 1:1 的比例掃描,總體結果是圓形物體顯示為圓形,方形物體顯示為方形。如果不正確,圖像就會出現扭曲,出現長方形和橢圓形。此外,還必須確保"放大倍率"或水平視場寬(通常也稱為視場寬度或 FOV—field of view)正確。
水平視野寬度(HFW)是幾年前采用的一種常規方法,用于清楚的定義顯微照片上的圖像比例,以便于出版和展示。當圖像在印刷過程中被縮小或放大,或投射到屏幕上的尺寸與原始校準參考圖像的尺寸不同時,HFW尤其有用。在這種情況下,顯微照片字母數字上顯示的放大倍率通常是不正確和誤導性的,但HFW值保持不變,并且是正確的。
當然,并非所有SEM儀器都會在圖片輸出HFW數值,但基本都會顯示線刻度,因此,HFW很容易計算。但應注意的是,如果顯微鏡平臺在"Y"方向(即垂直方向)傾斜移動和顯示,這時,視野寬度就成了問題,因為任何傾斜都有可能尺寸不準確。因此,任何類似的"Y"向測量都必須在傾斜度為零的情況下進行,這就是垂直場寬度。
精確校準刻度,即HFW非常重要。SEM出廠時總是經過一定程度的校準。但是,即使它們的 HFW 在出廠時已經校準,SEM設備的設置也會隨著時間的推移而漂移。研究人員使用SEM放大率校準的標準樣品(RM)證明,精確的SEM放大率校準和誤差分析是影響SEM成像和測量的重要問題。該研究結果還表明,許多SEM儀器校準不當,誤差會在10%到60%之間。
此外,在許多SEM儀器中,"X"掃描與"Y"掃描的校準比例不是1:1,因此在這種情況下記錄的圓形顆粒會失真。在同一項研究中,還對同一實驗室的多臺儀器進行了測試,結果發現校準存在嚴重差異。這意味著,除了使用其中一臺儀器所產生的固有數據誤差之外,當使用另一臺儀器代替第一臺儀器時,誤差會更大。這種情況可能是多儀器實驗室的常見問題,研究人員會根據時間安排,隨機使用其中某一臺儀器。
當然,并非所有的實驗室的研究數據都很糟糕。在一些實驗室中,訓練有素的操作人員要求儀器校準精確,并且對儀器進行例行測試,因此報告的誤差極小,完全在儀器的機械校準能力范圍之內。同時,使用合適的長度標準,如提供了許多附加結構的標準材料8820,也有助于準確校準SEM的掃描。
圖3 20mm×20mm的標準樣品8820的明視場光學顯微照片
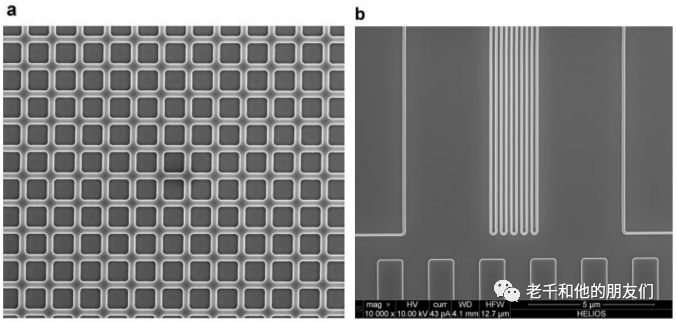
圖4 標準材料 8820 螺距結構的SEM圖
SEM計量/測量
如前所述,SEM是一種儀器,人們常常想當然地認為它是正確的,所產生的任何測量值也是正確的。在過去的幾年里,SEM的測量精度有了極大的提高,CD-SEM也已經成為半導體加工生產線上監控制造過程的主要工具之一。但是,事實還是會被掩蓋,我們必須小心謹慎。
使用任何科學儀器進行定量測量,都需要比想象中更加謹慎和深入了解。定量測量所依據的物理原理必須在測量中得到充分理解和說明。例如,在光學中,必須克服衍射的影響;在掃描探針顯微鏡中,必須考慮掃描探針針尖的形狀;在SEM中,必須考慮測量信號的產生、電子束參數、樣品充電以及電子束與試樣的相互作用。如果不仔細檢查就認為一切正常,很容易得出錯誤的數據。
如今,使用SEM進行的測量主要有三種,尤其是在半導體制造領域。如圖5所示,最簡單的是間距(或位移)測量,第二種是結構寬度(臨界尺寸或線寬測量)。不久之后,第三種測量方式也將成為主流,即輪廓正三維(3D)測量,但三維或輪廓計量學仍處于發展階段。
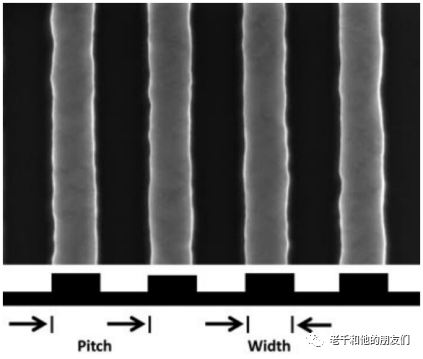
圖5 RM8820放大100,000倍的SEM圖,標準間距為200nm(水平場寬=964 nm)。圖像下方的圖表說明了間距測量與寬度測量之間的區別。
4.1 間距測量
如果我們將兩條線分開一定的距離,那么測量第一條線的前緣到第二條線的前緣的距離就定義了間距或位移。間距測量中的一些系統誤差(由于振動、電子束相互作用效應等)在兩個前緣上都是相同的,這些誤差,包括試樣與電子束相互作用的影響,被認為是可以忽略的。因此,與邊緣相關的誤差有相當大的一部分不在用于計算間距的等式中。成功測量的主要標準是測量的兩條邊緣必須在所有方面都相似。平均多條線可以最大程度地減少校準樣本中邊緣效應造成的影響。使用精確的間距標準可以輕松完成SEM放大校準。RM8820有許多間距結構可用于此過程。
4.2 寬度測量
任何納米結構、納米粒子或半導體線路的寬度測量都很復雜,因為上述的許多系統誤差現在都是相加的。因此,在測量中還包括來自兩個邊緣的邊緣檢測誤差。SEM的放大倍率不應校準為寬度測量值。寬度測量會將這些誤差加在一起,導致測量不確定性增加。
此外,由于電子束-樣品的相互作用效應不同,這些誤差也因樣品而異。使測量更加復雜的是,每臺SEM都會因操作條件和電子收集特性而產生其特有的儀器效應。實際上,通過這種測量方法,我們并不知道圖像中邊緣的準確位置,更重要的是,不知道它是如何隨儀器條件而變化的。因此,基于寬度測量的校準包含許多誤差成分,需要開發和使用電子束-試樣相互作用模型。
電子束-試樣相互作用的建模(蒙特卡洛)
SEM圖像并非樣品真實細節的完美再現,而是樣品、電子束和激發體積的近似卷積。此外,收集到的信號會被探測器和電子設備"塑造"。有些影響可以忽略不計,有些則會導致對這些數據的誤讀。電子束于樣品激發體積的大小通常遠大于測量分辨率,而且直接取決于作為樣品和儀器參數(加速電壓)。因此,必須使用能準確反映信號產生、獲取和處理的物理原理的模型。
起初,研究人員認為電子顯微鏡比用光學顯微鏡觀察樣品更能準確地描述樣品,原因很簡單,圖像的"分辨率"或清晰度要高得多。遺憾的是,情況并非如此。通過建模,可以更清楚地了解構成并導致 SEM 成像和測量不確定性的眾多因素。建模至關重要,只有通過對整個測量過程建模,才能實現真正的尺寸精度。對于某些應用來說,這一過程可能過于復雜或沒有必要,但要保證基于SEM的尺寸測量的準確性,建模是必不可少的。
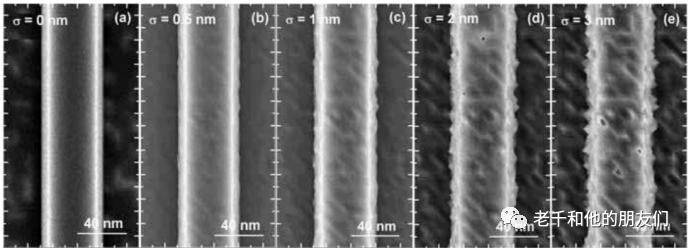
圖6 不同粗糙度振幅線條的模擬CD-SEM圖像
總結
校準良好的現代CD-SEM儀器能夠進行極高分辨率和高度精確的測量。由于對SEM進行了許多改進,可以使用適當的校準樣本以較高的置信度精確校準放大倍率(或刻度)。測量精度一般可以達到或優于0.2nm (1σ),在半導體生產等許多應用中,這樣的高精度已經足夠。但在測量過程中往往有一些潛在誤區。
誤區1:SEM圖像的形成像標準光學顯微鏡一樣,可以同時觀察和記錄整個領域。
真相1:SEM圖像是以點對點的方式形成的,記錄的是樣品掃描時產生的采集信號的調制。
誤區2:SEM圖像是所觀察樣品的真實再現。
真相2:由于電子束-樣品相互作用、原子序數差異、形貌和邊緣增強效應會使二次電子圖像解讀復雜化,并掩蓋樣品的真實邊緣,從而增加測量的不確定性。
誤區3:顯微照片上顯示的放大倍率和線條刻度是長度尺寸的真實測量值。
真相3:不一定,掃描校準對獲得準確數據至關重要,但用戶還必須檢查成像或顯示中使用的任何其他校準,例如顯示圖像的字母數字校準,通常這些校準是相互獨立的。
對于成像和測量,了解造成誤差的因素至關重要。精度是準確性的必要條件,但并不是充分條件。為了保證目前的準確性,以及未來的準確性,圖像和儀器建模至關重要。此外,建模還能揭示這些數據中大量未見的額外信息。要做到這一點,需要采用經過測試和驗證的基于物理學的電子束-樣品相互作用和信號生成模型。整個模型還必須考慮到電子設備、和可能的樣品充電效應等。模型所模擬的圖像可以與SEM的實際圖像進行比較。建模將揭示更多被測樣品的結構和尺寸信息,并最終在不確定度水平上提供精確的測量結果。
審核編輯:劉清
-
探測器
+關注
關注
14文章
2697瀏覽量
74115 -
SEM
+關注
關注
0文章
255瀏覽量
14776 -
掃描電鏡
+關注
關注
0文章
109瀏覽量
9315
原文標題:掃描電鏡能測出線寬的真實長度嗎?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
掃描電鏡總出問題?抗振防磁很關鍵!

掃描電鏡日常操作流程的詳細說明
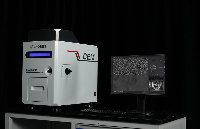
聚焦離子束與掃描電鏡聯用技術
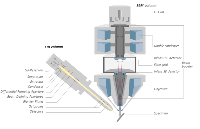
SEM是掃描電鏡嗎?

掃描電鏡能測定什么元素?

材料的哪些性質會影響掃描電鏡下的成像效果
桌面式掃描電鏡是什么?
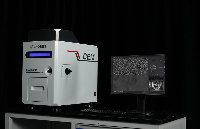
CEM3000系列臺式掃描電鏡在金屬材料分析中的應用

掃描電鏡與氬離子拋光技術在樣品成分分析的作用

如何使用掃描電鏡?

場發射掃描電鏡(FESEM)與常規掃描電鏡(SEM):技術對比及優勢分析
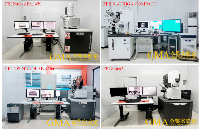





 掃描電鏡能測出線寬的真實長度嗎?如何才能測準?
掃描電鏡能測出線寬的真實長度嗎?如何才能測準?












評論