上一節(jié)我們討論了柵極與半導(dǎo)體材料之間的功函數(shù)差,本節(jié)我們討論絕緣層電荷的影響。
絕緣層相當(dāng)于一個電容,分析施加其上的電壓,就必須先分析清楚絕緣層兩側(cè)及內(nèi)部的電荷分布。
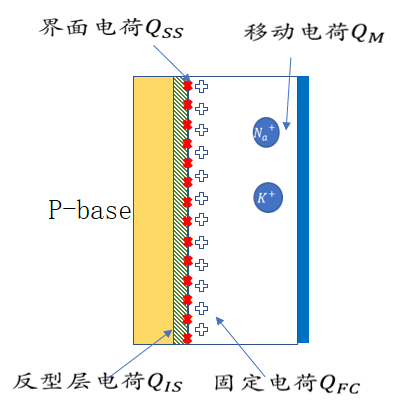
從半導(dǎo)體到柵極,絕緣層內(nèi)外存在四種電荷(這里均為面電荷密度),
1.反型層電荷 (Inversion Charge),來自半導(dǎo)體表面的反型層,寬度一般大約10nm量級,緊鄰絕緣層表面;
(Inversion Charge),來自半導(dǎo)體表面的反型層,寬度一般大約10nm量級,緊鄰絕緣層表面;
2.界面態(tài)電荷 (Interface Charge),來自半導(dǎo)體與絕緣層界面的懸掛鍵、不飽和化學(xué)鍵等,會在半導(dǎo)體禁帶中產(chǎn)生缺陷能級,通常帶正電(工藝中通常通過氫環(huán)境退火來修復(fù));
(Interface Charge),來自半導(dǎo)體與絕緣層界面的懸掛鍵、不飽和化學(xué)鍵等,會在半導(dǎo)體禁帶中產(chǎn)生缺陷能級,通常帶正電(工藝中通常通過氫環(huán)境退火來修復(fù));
3.固定電荷 (Fixed Charge),以二氧化硅來說,通常來自于生長過程中氧的缺失造成的空位,在氧化硅生長之初易出現(xiàn),所以通常在納米尺度的范圍內(nèi),同樣帶正電;
(Fixed Charge),以二氧化硅來說,通常來自于生長過程中氧的缺失造成的空位,在氧化硅生長之初易出現(xiàn),所以通常在納米尺度的范圍內(nèi),同樣帶正電;
4.可移動離子電荷 (Mobile Ionic Charge),與生產(chǎn)工藝環(huán)境的潔凈度有關(guān)系,一般為鈉離子或者鉀離子等,帶正電。
(Mobile Ionic Charge),與生產(chǎn)工藝環(huán)境的潔凈度有關(guān)系,一般為鈉離子或者鉀離子等,帶正電。
除反型層電荷 之外,其他電荷基本來自于工藝環(huán)境和材料性質(zhì)等客觀因素,應(yīng)在制備過程中盡量優(yōu)化,下面粗略分析維持
之外,其他電荷基本來自于工藝環(huán)境和材料性質(zhì)等客觀因素,應(yīng)在制備過程中盡量優(yōu)化,下面粗略分析維持 多大的電壓,該電壓即為在此反型狀態(tài)下的閾值電壓。
多大的電壓,該電壓即為在此反型狀態(tài)下的閾值電壓。
因為推導(dǎo)過程較為繁瑣,這里只梳理分析的邏輯,見右圖,感興趣的可以試著推導(dǎo)一下:
1.根據(jù)高斯定理,維持 需要相應(yīng)的電場;
需要相應(yīng)的電場;
2.根據(jù)泊松方程,電場求解需要知道電勢分布,電勢分布需要知道電荷濃度分布;
3.電荷濃度分布與形成反型層的電勢差 相關(guān)。
相關(guān)。
這里給出實現(xiàn)“強(qiáng)反型”的結(jié)論:


因為沒有詳細(xì)推導(dǎo),這里漏掉了關(guān)于“強(qiáng)反型”的定義,做個補(bǔ)充說明:一般情況下,只要能帶彎曲使得費米能級越過本征能級,即實現(xiàn)了反型,這種情況被稱為“弱反型”,表現(xiàn)為 并不會隨著
并不會隨著 的增長而快速增長;當(dāng)費米能級越過本征能級一倍,即圖中
的增長而快速增長;當(dāng)費米能級越過本征能級一倍,即圖中 時,
時, 將隨
將隨 呈指數(shù)級增長,這種情況被稱為“強(qiáng)反型”。
呈指數(shù)級增長,這種情況被稱為“強(qiáng)反型”。
綜上,得到與氧化硅相關(guān)的電荷分布,電荷除以電容,即得到維持這些電荷所需要的電壓;再加上前面所分析的柵極與半導(dǎo)體之間的功函數(shù)差,以及“強(qiáng)反型”的能帶彎曲 ,即可得到閾值電壓的表達(dá)式。
,即可得到閾值電壓的表達(dá)式。
假設(shè)氧化硅的厚度為 ,那么可定義其單位電容為:
,那么可定義其單位電容為:

那么閾值電壓可表達(dá)為(金屬作為柵極):

閾值電壓可表達(dá)為(N型多晶硅作為柵極):

其中 ,
,
閾值電壓表達(dá)式右邊第一項為柵極與半導(dǎo)體之間的功函數(shù)差,第二項為“強(qiáng)反型”的能帶彎曲 ,第三項為維持強(qiáng)反型
,第三項為維持強(qiáng)反型 ,氧化硅電容需要施加的電壓,第四項為氧化硅電容表面及體內(nèi)固有電荷充電形成的電壓。
,氧化硅電容需要施加的電壓,第四項為氧化硅電容表面及體內(nèi)固有電荷充電形成的電壓。
舉個例子,對于P型硅,摻雜濃度為Na=5e17cm-3,均勻摻雜;柵極為N型多晶硅,摻雜濃度為Npoly=1e20cm-3,柵氧厚度為d=120nm。
硅的本征濃度為1.45e10cm-3,相對介電常數(shù)為11.5;不考慮工藝引入的缺陷或者移動電荷,計算得到 我們看看Na、d以及柵氧電荷(以Qss為例)對閾值電壓的影響。
我們看看Na、d以及柵氧電荷(以Qss為例)對閾值電壓的影響。

-
多晶硅
+關(guān)注
關(guān)注
3文章
249瀏覽量
29842 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28909瀏覽量
237785 -
IGBT
+關(guān)注
關(guān)注
1278文章
4069瀏覽量
254554 -
電容電壓
+關(guān)注
關(guān)注
0文章
76瀏覽量
11534 -
閾值電壓
+關(guān)注
關(guān)注
0文章
97瀏覽量
51916
發(fā)布評論請先 登錄
解答74HC14中正向閾值電壓和負(fù)向閾值電壓是什么/電壓為多少
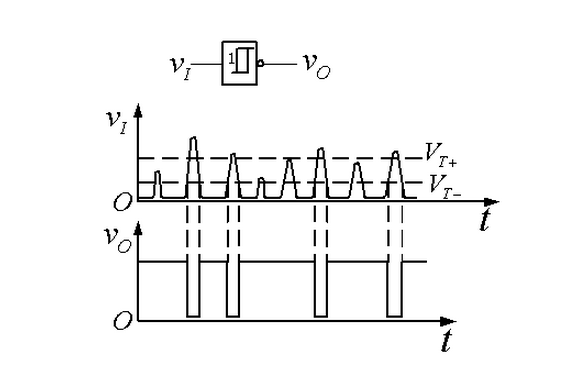
聊一下IGBT驅(qū)動中的參考電位問題

MOS管閾值電壓的問題
閾值電壓的計算

MOS管閾值電壓與溝長和溝寬的關(guān)系

EDA探索之控制閾值電壓
控制閾值電壓
不同Vt cell工藝是怎么實現(xiàn)的?閾值電壓和哪些因素有關(guān)系?
影響MOSFET閾值電壓的因素
什么是MOS管亞閾值電壓?MOSFET中的閾值電壓是如何產(chǎn)生的?
淺談影響MOSFET閾值電壓的因素
MOSFET閾值電壓是什么?影響MOSFET閾值電壓的因素有哪些?






 IGBT中的MOS結(jié)構(gòu)—閾值電壓(下)
IGBT中的MOS結(jié)構(gòu)—閾值電壓(下)













評論