以碳化硅(SiC)或氮化鎵(GaN)為代表的寬禁帶半導體可在功率轉換應用中實現更快的開關速度、更低的損耗和更高的功率密度。隨著功率半導體效率的提高,碳化硅模組周圍材料和組件關注度越來越高,因為需要這些產品配套來進一步增加系統性能,并確保WBG芯片能夠充分發揮其潛力。特別是模組耐溫性能的增加,例如當前需要將SiC模塊的散熱要求到175°C及以上,芯片連接、基板和散熱器的機械和熱性能要求正在不斷提高。
傳統的方法是使用錫焊將芯片連接到支撐基板上,例如直接黏合銅(DBC)和DBC到底板。在本文中,我們將突出一些銀焊合作為錫焊替代品的優點。
焊料與燒結
基于錫 (Sn) 和鉛 (Pb) 的焊料是最常見的芯片粘接材料。ROHS 合規性要求用銀 (Ag) 和銅 (Cu) 替代鉛。焊接過程中,焊料顆粒通常在 200°C – 250°C 范圍內熔化,并潤濕要接觸的表面。
金屬間相是在凝固的冷卻階段形成的。燒結是一種用低于熔點的粉末制造結構的方法。銀燒結1于 1990 年首次推出,現在許多公司提供基于各種銀顆粒配方的芯片粘接解決方案。燒結基于原子擴散,如圖 1(a) 所示,在給定時間內結合使用熱量和壓力來促進向界面的擴散。與焊料不同,沒有相變。
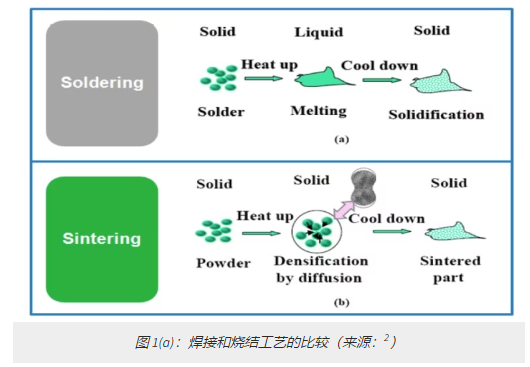
如圖 1(b) 所示,與普通焊料配方相比,銀燒結焊膏的導電性和導熱性以及高溫穩定性得到了很大改善。低熱膨脹系數 (CTE) 和良好的拉伸強度使其在熱循環和功率循環測試中具有優勢。
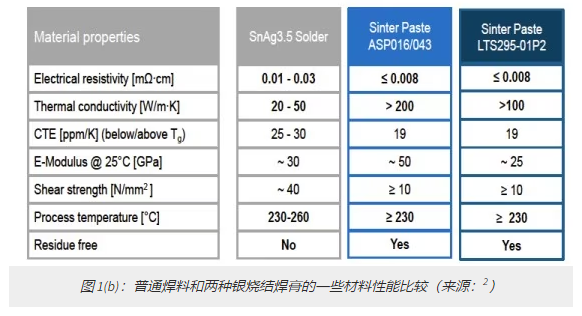
圖 2 概述了燒結類型。壓力輔助燒結對于 SiC 功率模塊最為常見。隨著燒結顆粒的尺寸從微米級減小到納米級(即< 1μm),燒結溫度和時間可以降低。納米級壓力可以在 5 至 15 MPa 范圍內,溫度從 200°C 至 300°C,時間從 1 至 10 分鐘。
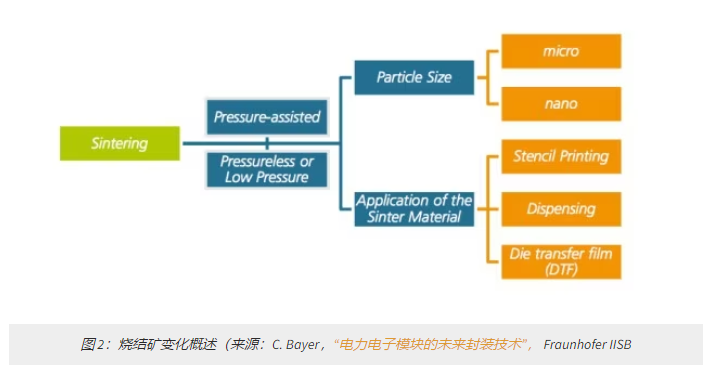
燒結漿料的應用通常通過干法放置的模板印刷來完成。
點膠技術相對較新,濕法放置使得該過程更容易出現錯位。芯片轉移薄膜 (DTF) 是芯片拾放后的流程,首先通過初始加熱和加壓步驟將薄膜轉移到拾取的芯片上,然后將芯片 + 燒結薄膜放置在已拾取的芯片上。最后施加熱量和壓力。
許多團隊使用銀燒結焊料顯著改善了芯片貼裝工藝的溫度循環 (TCT) 和功率循環壽命。圖 3 顯示了這樣的一個示例。在 DBC 基板上進行的主動溫度循環測試中,壽命增加了 17。
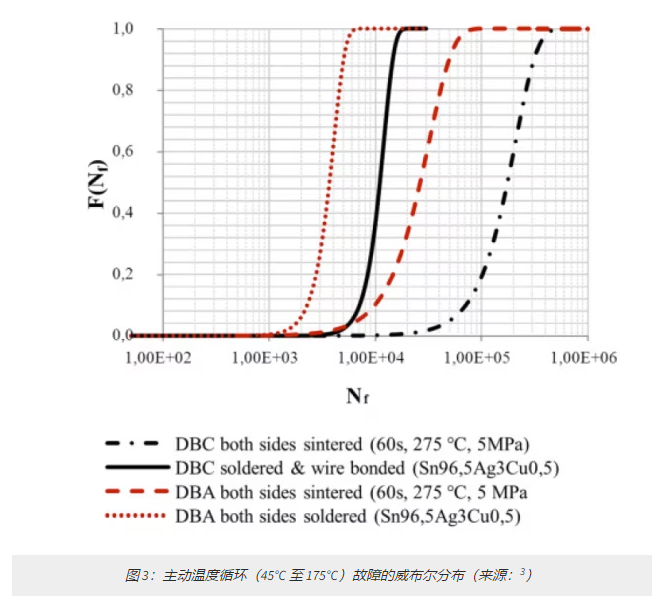
大面積銀燒結
在最近舉行的PCIM Europe 2023 會議上,Heraeus 產品經理 Florian Seifert 和壓力燒結漿料項目負責人 Ulla Hauf 博士介紹了他們關于將銀燒結漿料用于大面積燒結 (LAS) 應用的研究4。
如圖 4 所示,功率模塊組件中的燒結可用于:
芯片附著到基板上,例如 DCB/DBC 或活性金屬釬焊 (AMB) 氮化硅。這些通常具有鎳金 (Ni/Au) 表面處理。銀遷移是一個問題,特別是對于高壓燒結而言,需要仔細優化糊料和燒結條件以降低這種風險。
例如,在芯片頂部進行燒結可以使銅夾或金屬柱取代傳統的鋁線接合。為了實現這一點,可以在芯片上放置金頂部金屬表面處理。銅箔等后取放芯片頂部系統 (DTS)可實現重型銅線鍵合,與傳統鋁線相比,可提高熱性能和可靠性能。
將基板固定到模塊底板上。由于與裸芯片相比尺寸增加,這帶來了新的挑戰,尺寸范圍可以從15×20 mm 2到>40×40 mm 2。此應用程序可歸類為 LAS。
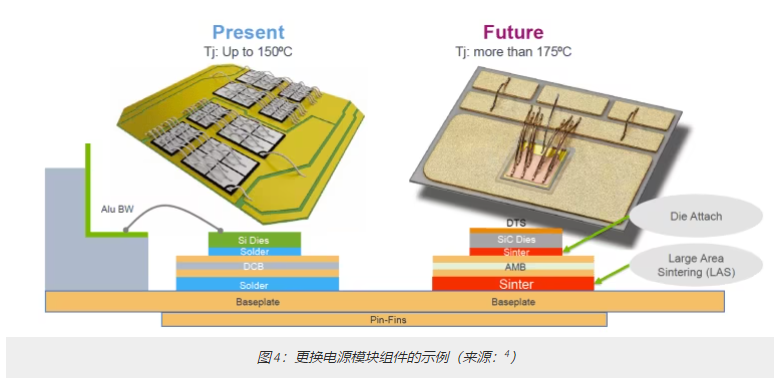
LAS 面臨的一些具體挑戰包括:
獲得壓力均勻的薄膜:更薄的燒結膜可以提高整體模塊的導熱率。雖然燒結在實現更薄的鍵合層厚度 (BLT) 方面比焊接具有特定優勢,但該厚度需要隨著模塊尺寸的增加而增加,例如,從芯片貼裝中使用的正常 <40-50 μm 增加到 >100-50 μm。150 微米。
高度差會使這變得更具挑戰性,因為可能需要更高的壓力,從而增加芯片/散熱器機械完整性的風險。由于基板組件內的封裝材料或焊點所施加的限制,干燥過程的操作窗口可能要小得多。溫度、升溫速率、總時間和氣氛可能都需要優化。
燒結漿料本身的化學性質可能需要進行調整,以便在上面設置的操作窗口限制下更好地工作。
成本:Ag壓力輔助燒結工藝成本較高,而熱界面材料(TIM)具有成本優勢。燒結和 TIM 的組合有時可以在成本和性能之間提供良好的折衷。
來自 Heraeus 的 LAS 流程如圖 5 所示。

LAS 結果
圖 6 所示的剪切強度測試結果證明了 Ag LAS 流的成功優化。與標準芯片貼裝銀燒結漿料相比,LAS 漿料在測試的尺寸范圍內提高了 40% 以上的剪切強度。

如圖 7 所示,在 1000 mm 2基材上循環 1,500 次后未觀察到 LAS 漿料分層。
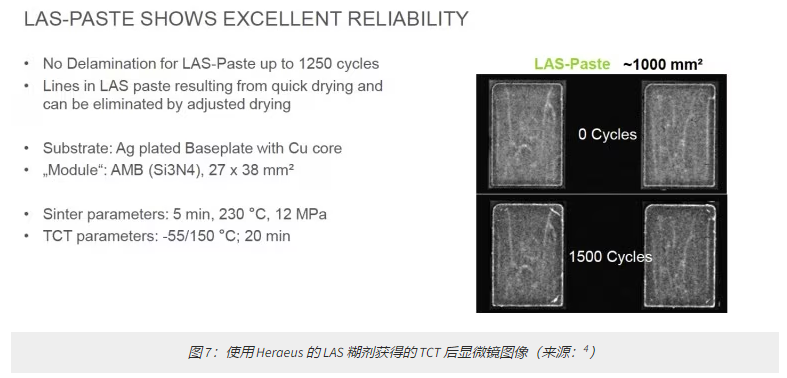
未來展望
電動汽車市場預計將強勁增長,而基于碳化硅的功率模塊將在其中發揮關鍵作用,例如牽引逆變器應用。與焊料相比,銀燒結在性能和可靠性方面具有多種優勢。銅燒結預計將在未來的應用中發揮更大的作用,與銀相比,其耐熱性、抗遷移性和潛在成本優勢得到改善。到 2030 年,LAS 目標市場預計將達到1.7億美金。
審核編輯:湯梓紅
-
SiC
+關注
關注
31文章
3156瀏覽量
64439 -
氮化鎵
+關注
關注
61文章
1760瀏覽量
117486 -
功率模塊
+關注
關注
10文章
528瀏覽量
45766 -
GaN
+關注
關注
19文章
2176瀏覽量
76147 -
碳化硅
+關注
關注
25文章
3016瀏覽量
50055
原文標題:【技術】大面積燒結的進步提高了功率模塊的性能
文章出處:【微信號:dldzjsyyy,微信公眾號:電力電子技術與應用】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
為什么我打印PCB電路圖大面積敷銅都不夠黑?
PCB線路板大面積覆銅的作用是什么?
PCB線路板大面積覆銅的作用是什么
大面積白光OLED器件
大面積均勻電子束產生實驗研究
什么是覆銅 電路板選擇大面積覆銅還是網格覆銅?
蘋果Apple ID出現大面積故障
適合大面積布控的高穩定性工業級無線數傳電臺






 大面積燒結的進步提高了功率模塊的性能
大面積燒結的進步提高了功率模塊的性能











評論