為什么有的芯片是引腳封裝,而手機(jī)的芯片則是用的底部BGA球珊陣列封裝?
所謂的芯片,其實(shí)只有中間很小的一部分,仔細(xì)看它的結(jié)構(gòu),芯片是正面朝上,內(nèi)部的電路會(huì)連接到四周的凸塊。
然后再一根一根打線(xiàn),打出比頭發(fā)絲還要細(xì)的金線(xiàn),連接到引腳。然后再用外殼沾連保護(hù),這種封裝又稱(chēng)為打線(xiàn)封裝。
隨著芯片的功能越多,四周引腳數(shù)量也要隨之增加,相應(yīng)的外殼體積就不得不做得更大。如果要做成手機(jī)處理器級(jí)別的芯片,估計(jì)光一塊芯片體積就得和手機(jī)差不多大,很顯然這種封裝肯定不合適。
我們?cè)賮?lái)看看,另一種封裝是如何解決體積問(wèn)題的。拆開(kāi)芯片外殼,芯片是正面朝下。
然后整面鋪滿(mǎn)凸塊,這些凸塊緊貼著一塊導(dǎo)線(xiàn)載板,導(dǎo)線(xiàn)載板的線(xiàn)路是直接穿孔到另一面。然后直入金屬球,芯片就是通過(guò)這些金屬球和外部連接,對(duì)比之前面積變得更小,引腳數(shù)量可以變得非常多。
如果是用在手機(jī)里的芯片,到這一步還不夠。手機(jī)芯片除了核心計(jì)算,還有存儲(chǔ)、基帶、其他等等多種模塊,也就是要將多個(gè)模塊的芯片實(shí)現(xiàn)相互通信,并且整合在一個(gè)封裝里。它的原理是將所有芯片模塊朝下,放很多非常細(xì)微的凸塊。

然后接上一塊硅中介板,利用化學(xué)的方法在硅中介板時(shí)刻出線(xiàn)路。并且這些線(xiàn)路是穿孔打通,線(xiàn)路只有10微米,約為頭發(fā)絲的1/10。然后在底部再放金屬凸塊連接導(dǎo)線(xiàn)載板。導(dǎo)線(xiàn)載板的線(xiàn)路同樣也是穿孔打通,再接上非常多的金屬球,這一種封裝就是2.5D封裝。目前許多芯片都是采用這種封裝。
從實(shí)物可以看到背部的金屬球非常密集,金屬球之間的間距也非常窄。在焊接電路板的時(shí)候稍微有點(diǎn)傾斜,金屬球非常容易接觸焊盤(pán),所以手機(jī)芯片的焊接環(huán)節(jié)會(huì)采用SMT貼片機(jī)。
利用機(jī)器來(lái)識(shí)別焊盤(pán)的位置精準(zhǔn)貼裝芯片,想要看壓在中間的焊盤(pán)是否準(zhǔn)確對(duì)準(zhǔn),直接看肯定是看不到的。所以SMT工廠(chǎng)會(huì)采用S-ray設(shè)備,它的原理類(lèi)似于照S光,可以清楚看到內(nèi)部的接觸狀況,透過(guò)這個(gè)鏡頭也能清楚看到非常細(xì)小的線(xiàn)路。
現(xiàn)在主流芯片采用的2.5D封裝想要突破,無(wú)論怎么擺所有芯片模塊都是平鋪在一個(gè)面。但還有更加突破的技術(shù)則是連芯片本身也進(jìn)行穿孔,也就是中間層的芯片本身既保持原功能,還要打孔起到上下相通的作用。所以要在晶體管時(shí)刻階段就要考慮走線(xiàn)穿孔的問(wèn)題,這個(gè)難度非常非常大。
目前能夠做到穿孔的芯片,只有一種就是DRAM內(nèi)存芯片。已經(jīng)實(shí)現(xiàn)3D封裝的芯片是用在攝像頭的頭像處理芯片 。

它的頂部是用于受光的傳感器,中間是DRAM實(shí)現(xiàn)中間穿孔,底部則是用于邏輯運(yùn)算的計(jì)算模塊,正好組成一組3D封裝。所以未來(lái)芯片的發(fā)展方向是將所有芯片實(shí)現(xiàn)穿孔堆疊在一起,這個(gè)難度非常非常難,目前還沒(méi)能夠?qū)崿F(xiàn)。
以上就是芯片的封裝原理。
審核編輯:劉清
-
處理器
+關(guān)注
關(guān)注
68文章
19799瀏覽量
233500 -
DRAM
+關(guān)注
關(guān)注
40文章
2341瀏覽量
185159 -
BGA封裝
+關(guān)注
關(guān)注
4文章
121瀏覽量
18411 -
芯片封裝
+關(guān)注
關(guān)注
11文章
571瀏覽量
31237 -
SMT貼片機(jī)
+關(guān)注
關(guān)注
5文章
43瀏覽量
11174
原文標(biāo)題:芯片的封裝原理
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
BGA——一種封裝技術(shù)
長(zhǎng)期收購(gòu)手機(jī)芯片
高價(jià)收購(gòu)手機(jī)芯片 長(zhǎng)期回收手機(jī)芯片
芯片封裝
如何利用BGA芯片激光錫球進(jìn)行植錫
什么是手機(jī)芯片 2021年手機(jī)芯片性能排行榜網(wǎng)
手機(jī)芯片主要是由什么材料制成
手機(jī)芯片的作用
手機(jī)芯片什么組成
漢思新材料:平板電腦主板芯片BGA錫球底部填充加固用膠方案
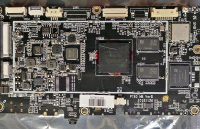
航空攝像機(jī)芯片BGA底部填充膠應(yīng)用

手機(jī)芯片底部填充膠應(yīng)用-漢思底部填充膠
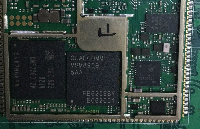





 為什么有的芯片是引腳封裝,而手機(jī)芯片則是用的底部BGA球珊封裝?
為什么有的芯片是引腳封裝,而手機(jī)芯片則是用的底部BGA球珊封裝?










評(píng)論