智能家居智能門鎖芯片底部填充膠和外殼結構粘接方案由漢思新材料提供
01.點膠示意圖


02.應用場景
智能門鎖/兒童早教機器人/語音精靈
03.用膠需求
芯片底部填充和外殼結構粘接方案
要求芯片填充(錫球的填充間隙小于20um);
要求不銹鋼面板與PCB模塊固定(強度滿足1.5M大于30次跌落)
04.漢思新材料優勢
漢思依托于強大的環氧膠研發實力,根據客戶的需求,漢思經過數次的驗證和調整,推薦使用我們成熟的產品方案,滿足客戶的產品性耐性的需求。
05.漢思解決方案
我們推薦客戶使用HS710底部填充膠+HS610低溫黑膠兩款膠水的組合應用方案,成功解決了客戶填充和包封的需求。滿足小間距填充的同時對元件進行四周包封,粘接強度高。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
459文章
52471瀏覽量
440441 -
智能家居
+關注
關注
1934文章
9800瀏覽量
190496
發布評論請先 登錄
相關推薦
熱點推薦
先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹
今天我們再詳細看看Underfill工藝中所用到的四種填充膠:CUF,NUF,WLUF和MUF。 倒裝芯片的底部填充工藝一般分為三種:毛細

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程
一、烘烤烘烤,主要是為了確保主板的干燥。實施底部填充膠之前,如果主板不干燥,容易在填充后有小氣泡產生,在最后的固化環節,氣泡就會發生爆炸,從而影響焊盤與PCB之間的粘結性,也有可能導致






 智能家居門鎖芯片底部填充膠和外殼結構粘接方案
智能家居門鎖芯片底部填充膠和外殼結構粘接方案











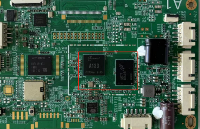











評論