引言
氮化鋁(AlN)和氮化鋁鈉(ScxAl1-xN)是一種壓電材料,在壓電微機(jī)電系統(tǒng)(壓電mems)中具有重要的應(yīng)用價值。這些材料的主要應(yīng)用是在電信的聲學(xué)濾波器上,但許多其他基于它們的MEMS設(shè)備正在出現(xiàn)。本文的目的是開發(fā)一個ScxAl1-xN的模式形成過程。本文首先對AlN和ScxAl1-xN的性質(zhì)進(jìn)行了討論。然后介紹了濕法和干法蝕刻工藝的基本原理。接下來,討論了基于等離子體的化學(xué)工藝在蝕刻和沉積材料中的應(yīng)用。簡要介紹了反應(yīng)性磁控濺射法對AlN和ScxAl1xN薄膜的沉積作用,并對其刻蝕問題進(jìn)行了詳細(xì)的討論。
實驗
實驗工作的重點是發(fā)展用反應(yīng)性磁控濺射沉積的ScxAl1xN薄膜的濕法蝕刻工藝。ScxAl1-xN可以在酸性和堿性溶液中進(jìn)行蝕刻。本研究選擇了四甲基氫氧化銨(TMAH)、磷酸和硫酸溶液。
蝕刻過程可以是各向同性的,也可以是各向異性的(圖3a,b)。各向同性蝕刻在每個方向上均勻地處理蝕刻材料,而各向異性蝕刻最好只在一個方向上進(jìn)行。大多數(shù)濕式蝕刻工藝是各向同性的,而大多數(shù)RIE工藝是各向異性的。各向異性過程顯然是高保真模式的首選。各向同性蝕刻過程將從掩模材料下面的側(cè)面蝕刻材料,這被稱為6下切。側(cè)壁角是基底平面與側(cè)壁之間的夾角。對于理想的各向異性蝕刻,它是90°。(江蘇英思特半導(dǎo)體科技有限公司)
圖3。(a)理想的各向同性蝕刻在各個方向上均勻地進(jìn)行。(b)理想的各向異性蝕刻只進(jìn)行一個方向。(c)各向異性蝕刻與側(cè)壁角α。目標(biāo)材料的蝕刻與掩模之間的選擇性為ER1:ER2。(d)蝕刻成底層材料,蝕刻速率為ER3。(e)由結(jié)晶平面定義的濕式蝕刻,由于界面缺陷造成的掩模凹陷用紅色突出顯示。
結(jié)果和討論
氫氧化鉀或TMAH濕蝕是各向異性濕蝕的一個重要例子,廣泛應(yīng)用于硅的各種結(jié)構(gòu)和設(shè)計。20不同的硅晶平面有不同的反應(yīng)活性,導(dǎo)致不同的蝕刻速率(圖3e)。硅平面的蝕刻速度非常快,而硅平面的蝕刻速度是最慢的,而{100}平面的蝕刻速度是中等的。21不同平面蝕刻的活化能也有所不同,其中蝕刻{111}平面的活化能最高。因此,硅的蝕刻形成了由{111}平面定義的結(jié)構(gòu),而其他平面則被蝕刻掉。這導(dǎo)致側(cè)壁角為57.74°。AlN和ScxAl1-xNAl與堿性和酸性蝕刻劑的蝕刻也具有各向異性。各向異性濕蝕刻往往導(dǎo)致一些面削弱。例如,它可能是由最穩(wěn)定的平面的蝕刻,或由掩模和蝕刻材料之間的界面缺陷引起的。(江蘇英思特半導(dǎo)體科技有限公司)
濕蝕刻和干蝕刻有幾乎相反的優(yōu)缺點。濕式蝕刻通常相當(dāng)便宜,同時也可以進(jìn)行大量晶片的加工。濕蝕刻方案通常對所需材料具有高度選擇性。最大的缺點是濕法蝕刻通常是各向同性的,所以側(cè)壁角難以控制,而下切會導(dǎo)致圖案偏離掩模。此外,毛細(xì)管力在濕蝕刻中可能是一個問題,它們會導(dǎo)致非常精細(xì)的特征坍塌或相互粘附。最后,如果存在天然氧化物或其他殘留物,則濕式蝕刻的高選擇性可能會導(dǎo)致蝕刻起始過程中的不可靠性。另一方面,干式蝕刻技術(shù)需要昂貴的設(shè)備。在RIE和IBE中,通常一次只能處理一個晶圓,而選擇性可能是一個問題,因為它們會相當(dāng)迅速地蝕刻各種材料。然而,對于RIE和IBE,很少發(fā)生切割,側(cè)壁角度可以通過調(diào)整蝕刻配方來控制。(江蘇英思特半導(dǎo)體科技有限公司)
在ICP系統(tǒng)中(圖5),等離子體是由放置在腔室外的線圈產(chǎn)生的。對線圈施加射頻功率會產(chǎn)生磁場,進(jìn)而在等離子體中產(chǎn)生循環(huán)電流。在立方最密堆積系統(tǒng)中使用了一個單獨的底部電極。施加在該電極上的功率控制著獨立于ICP功率的直流偏置。與立方最密堆積相比,這使得可以更好地控制直流偏置和離子電流。
圖5。ICP-RIE的結(jié)構(gòu)。TCP是指變壓器耦合等離子體,它使用平面線圈代替螺旋線圈。
結(jié)論
在橫向蝕刻需要最小的應(yīng)用中,在使用濕式蝕刻形成AlN或ScxAl1-xN之前,仍有許多問題需要研究。首先,應(yīng)該研究鈧濃度對蝕刻速率的影響。其次,對于器件64 65的應(yīng)用,AlN或ScxAl1-xN通常沉積在金屬底電極上。這可能會影響薄膜的蝕刻和視錐體的形成。第三,應(yīng)優(yōu)化退火溫度,以最小化橫向蝕刻速率,同時也應(yīng)優(yōu)化應(yīng)力變化和壓電性能。此外,還應(yīng)研究不同x和不同襯底在退火過程中應(yīng)力變化的來源。(江蘇英思特半導(dǎo)體科技有限公司)
審核編輯:湯梓紅
-
蝕刻工藝
+關(guān)注
關(guān)注
3文章
52瀏覽量
11935 -
壓電材料
+關(guān)注
關(guān)注
0文章
34瀏覽量
15836 -
刻蝕
+關(guān)注
關(guān)注
2文章
205瀏覽量
13400
發(fā)布評論請先 登錄
半導(dǎo)體濕法腐蝕設(shè)備
濕法蝕刻工藝
《炬豐科技-半導(dǎo)體工藝》GaN、ZnO和SiC的濕法化學(xué)蝕刻
納米磁性薄膜材料的濕法工藝
硅基AlN薄膜制備技術(shù)與測試分析

氣動薄膜調(diào)節(jié)閥防腐蝕問題的詳細(xì)說明
濕法煙氣脫硫裝置腐蝕的類型有哪些
多晶ZnO:Al薄膜的蝕刻特性研究
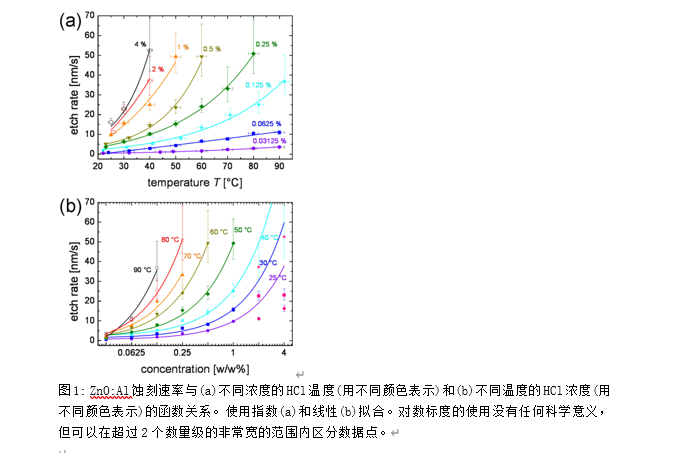
寬帶隙半導(dǎo)體GaN、ZnO和SiC的濕法化學(xué)腐蝕
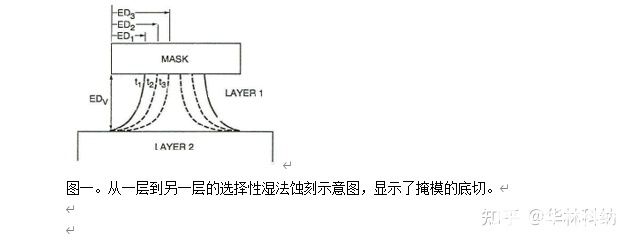
基于Al0.8Sc0.2N薄膜的體聲波諧振器用于射頻濾波器的設(shè)計
半導(dǎo)體工藝?yán)锏?b class='flag-5'>濕法化學(xué)腐蝕
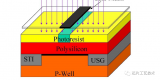
Si(111)襯底上脈沖激光沉積AlN外延薄膜的界面反應(yīng)控制及其機(jī)理
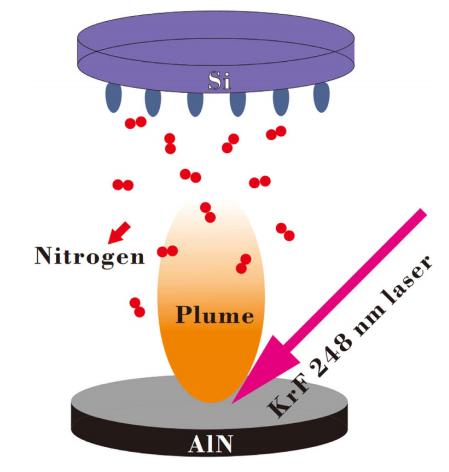
優(yōu)化濕法腐蝕后碳化硅襯底TTV管控

優(yōu)化濕法腐蝕后晶圓 TTV 管控






 AlN和Sc0.2Al0.8N薄膜的濕法化學(xué)腐蝕
AlN和Sc0.2Al0.8N薄膜的濕法化學(xué)腐蝕












評論