IGBT模塊是由IGBT(絕緣柵雙極型晶體管芯片)與FWD(續(xù)流二極管芯片)通過特定的電路橋接封裝而成的模塊化半導體產(chǎn)品。
IGBT是能源變換與傳輸?shù)暮诵钠骷追Q電力電子裝置的“CPU”,應用于直流電壓為600V及以上的變流系統(tǒng)如軌道交通、智能電網(wǎng)、航空航天、電動汽車與新能源裝備等領域。封裝后的IGBT模塊直接應用于變頻器、UPS不間斷電源等設備上。
比如在混合動力汽車上IGBT的作用是交流電和直流電的轉換,同時IGBT還承擔電壓的高低轉換的功能。外界充電的時候是交流電,需要通過IGBT轉變成直流電然后給電池,同時要把220V電壓轉換成適當?shù)碾妷阂陨喜拍芙o電池組充電。電池放電的時候,把通過IGBT把直流電轉變成交流電機使用的交流電,同時起到對交流電機的變頻控制,當然變壓是必不可少的。 IGBT 模塊GBT約占電機驅動系統(tǒng)成本的一半,而電機驅動系統(tǒng)占整車成本的15-20%,也就是說IGBT占整車成本的7-10%,是除電池之外成本第二高的元件,也決定了整車的能源效率。直流充電樁30%的原材料成本是IGBT,電力機車一般需要 500 個 IGBT 模塊。
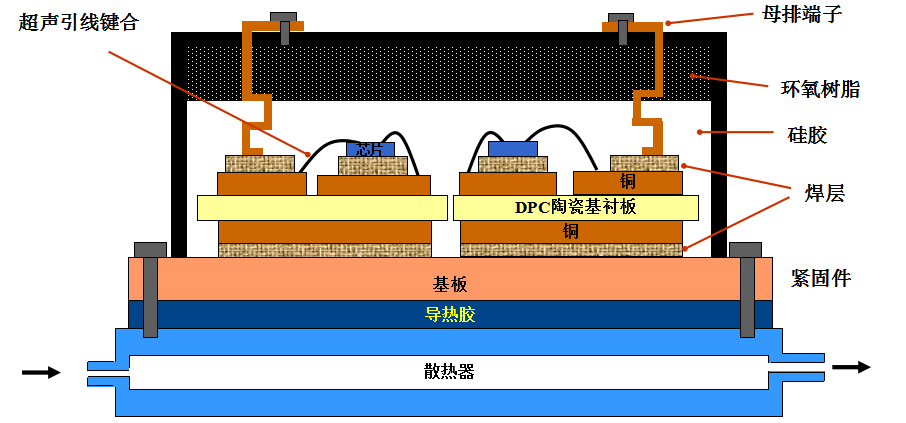
IGBT的封裝工藝流程大體可分為:貼片—燒結—清洗—X-RAY檢測—鍵合—注膠—成型—測試
1. 貼片:通過絲網(wǎng)印刷工藝將錫膏印制在陶瓷襯板上,然后將芯片與襯板線路圖形中相應的銅極貼合。
2.將完成貼片的陶瓷板半成品置于真空爐內,進行回流焊接。
3.通過清洗劑對焊接完成后的半成品進行清洗,以保證IGBT芯片表面潔凈度滿足鍵合打線要求。
4.通過X光檢測篩選出空洞大小符合標準的半成品,防止不良品流入下一道工序。
5.通過鍵合打線,使芯片與基板相連,器件實現(xiàn)功能性。
6. 對殼體內部抽真空注入A、B膠并抽真空高溫固化,達到絕緣保護作用 。
7.對產(chǎn)品進行加裝頂蓋并對端子進行折彎成形。
現(xiàn)有的封裝結構和監(jiān)測方式極大地提高了功率模塊工作的穩(wěn)定性。但面對SiC功率模塊的高頻率和高電壓的工況,現(xiàn)有封裝結構在封裝寄生參數(shù)和散熱能力方面均無法滿足需求。為解決現(xiàn)有封裝結構直接用于SiC模塊封裝存在的問題,新的封裝結構被提出,如直接導線鍵合( Direct-Lead-Bonding,DLB)、柔性封裝( Flexible Printed Circuit,FPC)和疊層封裝。
1、直接導線鍵合結構(DLB):直接導線鍵合結構最大的特點就是利用焊料,將銅導線與芯片表面直接連接在一起,相對引線鍵合技術,該技術使用的銅導線可有效降低寄生電感,同時由于銅導線與芯片表面互連面積大,還可以提高互連可靠性。其測試表明,使用DLB封裝不僅使得鍵合電阻和電感的減小量超一半以上,而且使得IGBT功率模塊芯片溫度分布更加均勻。其生產(chǎn)成本較低,是目前應用最廣泛的IGBT器件。
2、柔性封裝( Flexible Printed Circuit,F(xiàn)PC):利用FPC代替引線鍵合。該封裝方式將雜散電感降低到1.4nH,實現(xiàn)了對雜散參數(shù)的有效控制。
3、疊層封裝:通過壓接型封裝工藝,采用直接接觸的方式而不是引線鍵合或者焊接方式實現(xiàn)金屬和芯片間的互連,該結構包含三層導電導熱的平板,平板間放置功率芯片,平板的尺寸由互連的芯片尺寸以及芯片表面需要互連的版圖結構確定。相比焊接型IGBT器件,壓接型IGBT器件易于規(guī)模化芯片并聯(lián)封裝、串聯(lián)使用,且具有低熱阻、雙面散熱、失效短路等優(yōu)點。
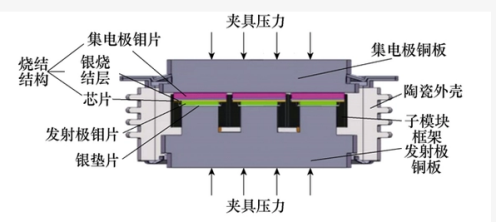
功率半導體模塊封裝是其加工過程中一個非常關鍵的環(huán)節(jié),它關系到功率半導體器件是否能形成更高的功率密度,能否適用于更高的溫度、擁有更高的可用性、可靠性,更好地適應惡劣環(huán)境。功率半導體器件的封裝技術特點為:設計緊湊可靠、輸出功率大。其中的關鍵是使硅片與散熱器之間的熱阻達到最小,同樣使模塊輸人輸出接線端子之間的接觸阻抗最低。
封裝完成后的大功率IGBT,需要對各方面性能進行試驗。比如
1.平整度測試:平整度在IGBT安裝以后,所有熱量散發(fā)都是底板傳輸?shù)缴崞鳌F矫娑仍胶茫崞鹘佑|性能越好,導熱性能越好。
2.推拉測試: IGBT模塊有三個連接部分:芯片上的引線鍵合點、芯片與陶瓷絕緣基板的焊接面、陶瓷絕緣基板與銅底板的焊接面,對所有鍵合點的力度進行測試。
3.硬度測試:對主電極的硬度不能太硬、也不能太軟。
4.超聲波掃描:主要對焊接過程,焊接以后的產(chǎn)品質量的空洞率做一個掃描,這點對于導熱性也是很好的控制。所以陶瓷襯板的導熱性能和熱膨脹系數(shù)直接影響IGBT的質量和性能。
斯利通陶瓷采用DPC直接鍍銅工藝:通過高溫、高真空條件下利用蒸發(fā)、磁控濺射等工藝進行陶瓷基板金屬化,先是在基板表面濺射一層薄膜過渡金屬,然后通過電鍍增厚銅層,最后通過一系列線路板工藝流程完成圖形制作。公司擁有多項自主研發(fā)生產(chǎn)專利,能夠實現(xiàn)板面互聯(lián)(孔導通),孔內填實率等業(yè)內難點,線寬線距做到精細化(最小可完成50um),銅厚范圍可按客戶要求控制在1-1000um內。基材與銅層結合力優(yōu)良,熱膨脹系數(shù)與硅片匹配度高,銅面平整粗糙度小,表面處理工藝多樣化(沉銀、沉金、沉鎳金、OSP等),適應于各種IGBT模組封裝方法。
IGBT具有輸入阻抗大、驅動功率小、控制電路簡單、開關損耗小、速度快及工作頻率高等特點,成為目前最有應用前景的電力半導體器件之一。在軌道交通、航空航天、新能源、智能電網(wǎng)、智能家電這些朝陽產(chǎn)業(yè)中,IGBT作為自動控制和功率變換的關鍵核心部件,是必不可少的功率“核芯”。采用IGBT進行功率變換,能夠提高用電效率,提升用電質量,實現(xiàn)節(jié)能效果,在綠色經(jīng)濟中發(fā)揮著無可替代的作用。
審核編輯:湯梓紅
-
cpu
+關注
關注
68文章
11033瀏覽量
215974 -
IGBT
+關注
關注
1277文章
4024瀏覽量
253363 -
晶體管
+關注
關注
77文章
9978瀏覽量
140640 -
陶瓷線路板
+關注
關注
0文章
19瀏覽量
1351
發(fā)布評論請先 登錄
高微鉆孔線路板,如何憑借小孔徑實現(xiàn)大突破?
陶瓷線路板:超越傳統(tǒng),引領高科技領域的新篇章
陶瓷線路板:高科技領域的散熱新星
線路板立碑是什么?捷多邦一文帶你全面了解
工業(yè)控制線路板設計要點
HDI線路板和多層線路板的五大區(qū)別
生產(chǎn)HDI線路板需要解決的主要問題
PCBA板與傳統(tǒng)線路板區(qū)別
線路板三防漆涂覆工藝及要求






 高功率陶瓷線路板成就高性能IGBT
高功率陶瓷線路板成就高性能IGBT













評論