大功率電子產品已成為半導行業增長最快的細分市場之一,由于這些應用中使用的電力電子模塊在高電壓和高電流密度下運行,因此它們必須能夠應對高溫和惡劣條件,高可靠性電力電子模樣的關鍵部件之一是可靠的金屬化陶瓷基板。
為了在操作期間提供可靠的功能,陶瓷基板材料必須提供出色的電氣、熱、絕緣和機械性能。此外,它們必須使用常用的組裝和互連技術,比如焊接、燒結和引線鍵合。
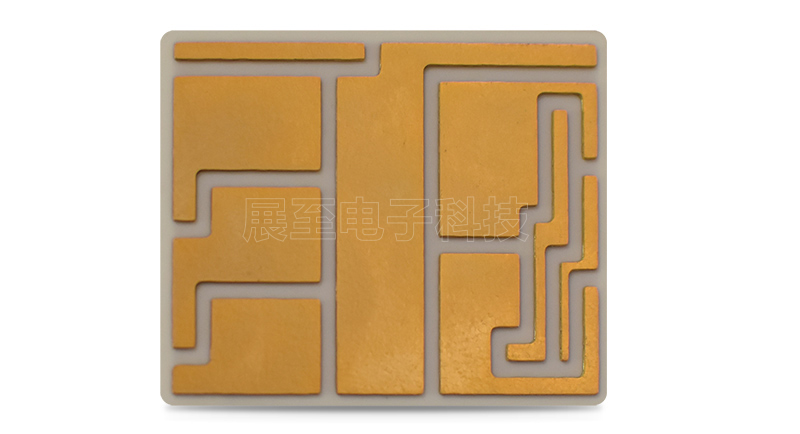
由于成本效益氧化鋁陶瓷基板金屬化,即直接銅鍵合基板,通常用于功率模塊制造。然而,AI2O3陶瓷基板不能充分發揮寬帶隙半導體的潛力。因此,氮化硅陶瓷基板金屬化作為功率模塊組裝材料越來越受歡迎,Si3N4顯示出優異的機械性能和高導熱性。
高度可靠的Si3N4陶瓷基板通常采用活性金屬釬焊(AMB)技術制造,該技術使用含銀和活性金屬(即鈦)的釬焊膏。釬焊膏中的貴金屬含量和緩慢的真空釬焊工藝是AMB陶瓷基板價格的主要驅動因素。然而,一種按成本設計、高度可靠的無銀厚膜銅鍵合技術,用于將氮化物陶瓷基板與銅箔接合,該焊膏無需使用昂貴的真空釬焊技術,但與行業基準AMB基板相比,TCFB的性能如何?
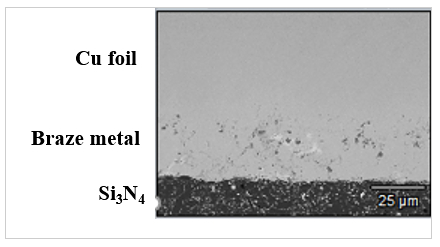
為了比較Condura Ultra與AMB的性能,我們進行了各種可靠性和應用相關測試,例如熱沖擊 (-65℃/+150℃)、剝離強度和高溫儲存(175℃,1000小時)實施。
1、相形成
氮化硅陶瓷基板上的相形成和鍵合機制通過掃描電子顯微鏡(SEM)進行了表征,如圖1所示。實際的鍵合機制基于活性金屬(鈦)和Si之間的反應。氮化硅陶瓷形成穩定的TiN層。由于Condura Ultra系統中不含銀,因此消除了典型的Ag相和Curich相,這在標準AMB技術中已知為使用含銀量高的釬焊填充金屬膏。然而,通過TiN反應層與氮化硅陶瓷基板的鍵合機制是相似的。
2、熱沖擊性能
由于陶瓷的機械穩健性,基于Si3N4的AMB陶瓷基板滿足最高的熱沖擊測試 (TST) 性能要求。評估Condura Ultra在Si3N4上的電阻與熱機械應力如圖2所示,使用內部測試布局(30.6x29 mm2,0.5 mm Cu在0.32 mm陶瓷上)進行熱沖擊測試。測試前Condura Ultra基板的狀態通過掃描聲學顯微鏡 (SAM) 和如圖2左側所示。紅色表示蝕刻的隔離槽,它是所用測試布局的一部分。如果銅和釬焊金屬/陶瓷之間因熱沖擊而分層,則SAM圖片中的紅色隔離槽會變寬。在3000和5000次熱沖擊循環后,SAM重新評估了基板的完整性。結果顯示在圖2的中間和右側,說明在Condura Ultra的初始狀態和循環后的Condura Ultra之間隔離槽沒有明顯變寬,證明陶瓷和釬焊金屬之間沒有發生分層。這表明Condura Ultra技術可以充分利用Si的機械穩健性Si3N4陶瓷,同AMB技術。
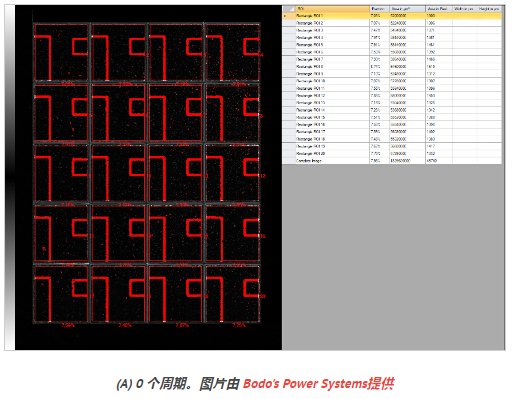
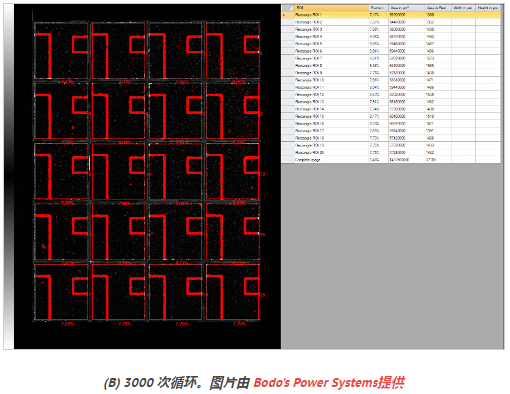
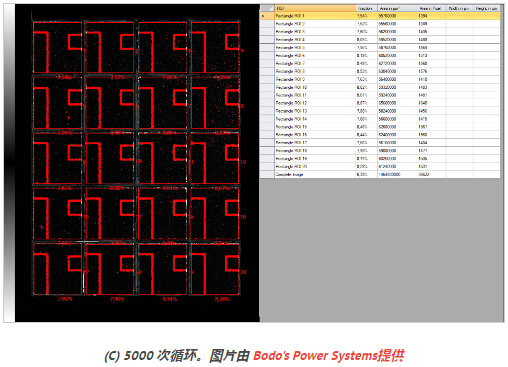
3、銅剝離強度
銅剝離強度表征銅箔對陶瓷的粘合強度。使用簡單的剝離測試,其中使用Condura Ultra技術將銅剝離條(10毫米寬x 0.3毫米厚)釬焊到一塊0.32毫米厚的Si3N4陶瓷上。剝離Cu并測量力。圖3顯示了剝離后剝離測試樣品的示例,該樣品的剝離強度平均為105 N/cm。剝離強度很大程度上取決于所測試的基材類型和技術。
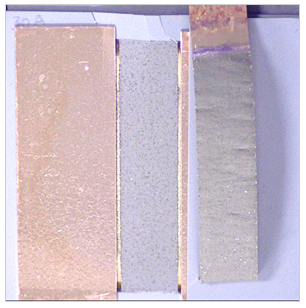
仔細檢查剝離樣品的失效模式可以提供有關粘合質量的有價值的信息。圖3顯示了剝離測試后剝離的銅帶和剩余的基板對應物(右側)。可以看到剝離條和對應物上的深色,表明從陶瓷基板中拉出Si3N4顆粒。這種失效模式也經常出現在Si3N4 AMB陶瓷基板上。然而,Condura Ultra基板的反應區內沒有出現故障。EDS相圖(圖4)證明了這一點,顯示剝離條上的大部分剩余材料源自Si3N4陶瓷而非釬焊金屬,這表明Condura Ultra工藝實現了強大的粘合機制。
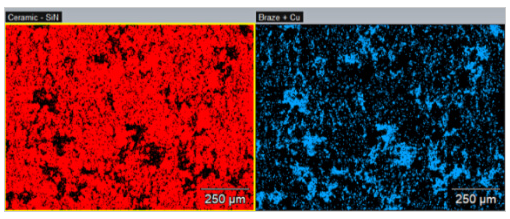
4、熱阻
金屬陶瓷基板的熱阻R th是功率模塊設計的重要因素。較低的熱阻可實現更高的功率密度,從而減小芯片尺寸。R th的主要貢獻者是銅和陶瓷的厚度和類型。Condura Ultra界面形成與AMB不同;因此,需要排除來自釬焊金屬或反應區本身的任何潛在的 R th貢獻。
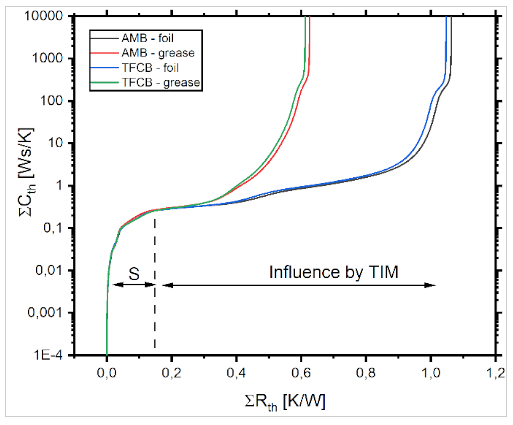
瞬態雙界面法用于評估金屬陶瓷基板的熱阻。二極管被燒結在AMB和Condura Ultra基板上,累積結構函數通過在加熱組件后的冷卻曲線測量中計算得出,二極管的電流為40 A。R th然后通過檢測在不同邊界條件下測量的兩個結構函數的發散點來評估系統的性能,即組件通過兩種不同的熱界面材料 (TIM) - 石墨箔和導熱油脂 - 連接到冷卻系統。得到的結構函數如圖 5 所示。兩種基板類型的發散點相似,表明AMB陶瓷基板和 Condura Ultra 基板在初始狀態下的熱性能沒有差異。之后,Condura Ultra基材在175°C的高溫儲存(HTS)測試中老化1000小時,以對釬焊金屬施加應力并證明釬焊填充金屬系統是穩定的。高溫超導后初始狀態和老化基板之間沒有觀察到差異,
5、熱阻
進行熱模擬以評估導熱率和陶瓷基板中釬焊金屬層的厚度對其總熱阻的影響。應用有限元法 (FEM)來包括熱擴散和其他幾何效應。對典型芯片基板設置的簡化幾何形狀進行了仿真,包括基板本身、陶瓷/Cu界面兩側的銅焊金屬層以及附有燒結銀芯片的硅芯片(圖6)。在模擬中,芯片在其體積內以200 W的恒定功率加熱30秒,同時基板底部保持在25°C的恒定溫度。
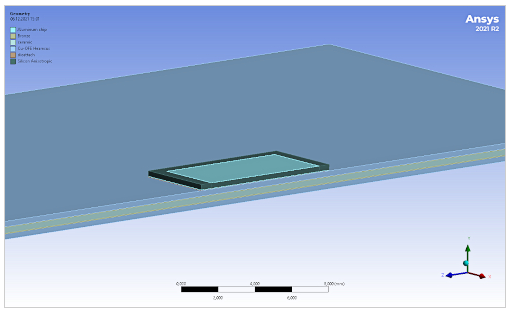
為了評估導熱性和釬焊金屬層厚度對Condura Ultra熱性能的影響,改變了這兩個參數,并將芯片的R th作為基本結果進行跟蹤。R th基于模擬的最大芯片溫度變化dT J和施加的功率計算。通常,靠近芯片的區域受熱最多,而較遠的區域不會出現明顯的溫度變化(圖7)。

作為下一步,進行了數值實驗設計(DoE)。目標是確定哪些不同的參數(熱導率和釬焊金屬層的厚度)對基板的R th影響最大。對于這個DoE,OPTISLANG程序創建了30個模擬,分布在由參數邊界定義的整個設計空間中。在計算了這些結果并確定了它們的R th之后,創建了一個降階模型,該模型允許對輸入參數(熱導率和厚度)對結果(熱阻)的影響進行排序。用于模擬的參數的間隔見下表:
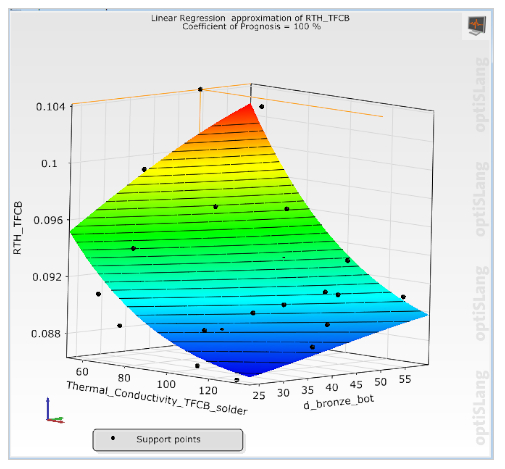

釬焊金屬層的熱導率由其成分定義,其近似于青銅成分CuSn x。釬焊金屬層厚度的典型變化約為20至60 μm,并通過樣品的橫截面和隨后的二次電子顯微鏡分析進行估計。
釬焊金屬層的熱導率、釬焊金屬層的厚度和相應的熱阻之間的相關性可以在圖8的表面圖中觀察到。主要影響因素是釬焊金屬層的熱導率。在朝向較低熱導率的區域中觀察到R th的最強變化,而對較高值的影響減小。使用表中的輸入,從圖8中提取的 R th值在0.088到 0.104 K/W之間變化。將該理論可能范圍與(0.13 ± 0.03) K/W的測量結果進行比較表明,實驗值和模擬值是一致的。可以說,完成了對Condura Ultra基板的整體熱理解。
Condura Ultra技術的性能通過熱沖擊、剝離強度、局部放電、熱測量和熱模擬得到證明。調查表明,Condura Ultra技術能夠使用無銀 Condura Ultra焊膏和非真空釬焊工藝制造具有成本效益但高度可靠的金屬陶瓷基板。
【文章來源:展至科技】
審核編輯 黃昊宇
-
功率
+關注
關注
14文章
2100瀏覽量
71706 -
基板
+關注
關注
2文章
303瀏覽量
23523
發布評論請先 登錄
氮化硅AMB陶瓷覆銅基板界面空洞率的關鍵技術與工藝探索
工業級TOPCon電池的低銀量絲網印刷金屬化技術,實現降銀80%

國產AMB陶瓷基板突破封鎖:高端電子材料的逆襲之路

晶振封裝技術革命:陶瓷VS金屬封裝如何影響設備可靠性
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
陶瓷基板五大工藝技術深度剖析:DPC、AMB、DBC、HTCC與LTCC的卓越表現

效率突破24.32%!江蘇大學J Mater Sci發文:雙面鍍銅金屬化n-TOPCon太陽能電池的穩定性研究

探究絲網印刷的導電銅漿在PERC太陽能電池上的性能和可靠性

玻璃基板之通孔金屬化電鍍技術






 了解金屬化陶瓷基板無銀AMB銅技術粘合的高度可靠性
了解金屬化陶瓷基板無銀AMB銅技術粘合的高度可靠性



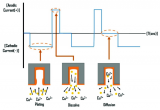










評論