引言
用半導體制造中的清洗過程中使用的酸和堿溶液研究了硅片表面的顆粒去除。
在本文報道的研究中,我們華林科納基于顆粒吸附在晶片表面的機理,研究了去除吸附在水表面的顆粒的機理。在顆粒去除實驗中,用濕法清洗工藝中使用的酸性和堿性溶液清洗了人工污染的單晶提拉法和FZ法晶片。已經(jīng)證明,就顆粒去除效率而言,堿性溶液優(yōu)于酸性溶液。據(jù)認為,由于堿性溶液中大多數(shù)顆粒的ζ電位為負,顆粒被晶片表面電排斥。
除了從膠體化學的角度進行研究之外,我們認為檢查由堿性溶液引起的晶片表面腐蝕也是很重要的。為此,研究了腐蝕速率和微粒去除效率之間的關系。使用直拉和FZ晶片。此外,用聚苯乙烯乳膠球代表有機物,研究了在NH,OH-H2O,-H2O溶液中的氧化過程,以找出氧化程度與顆粒物去除率之間的關系。結果,它已經(jīng)被顯示應該將NH4 H-HOOK-H2O溶液中的NH,OH含量降低到常規(guī)水平的1 /20,以優(yōu)化顆粒去除效率。本文的剩余部分將描述實驗性pro-的細節(jié)cess和結果。
英寸CZ ( 1,0,0)晶片用于粒子吸附實驗。自然氧化物首先在0。5 Y HF溶液。然后將晶片浸入各種接種有顆粒的溶液中10分鐘,然后沖洗并干燥。在晶片表面形成自然氧化物后,在0.5的氫氟酸溶液中再次去除,然后清洗并干燥。
五英寸鋯石(1。0.0)和四英寸FZ ( 1,0,0)晶片用于清洗實驗以研究顆粒去除。使用以下污染源對晶片進行人工污染:對于典型的液相顆粒,在城市水中自然成漿的顆粒,對于典型的氣相顆粒,在潔凈室外部的環(huán)境大氣中自然成漿的顆粒,直徑為0.3 pm和1.0 qm的二氧化硅球作為典型的無機顆粒,直徑為0.506 pm的聚苯乙烯乳膠球作為典型的有機顆粒。通過浸入含有上述顆粒之一的高酸性溶液中,晶片被污染。其他晶片由于暴露在潔凈室外部的環(huán)境空氣中而被污染。通過這些程序。將表面上具有總共5000-10000個缺陷的晶片準備用于清洗實驗,這些缺陷被分類為霧度(< 0.5 μm)或顆粒(> 0.5 μm)。
這些晶片在以下化學藥品中清洗:
a)NH,OH-H,-HCO溶液:29 7 NH4OH。在80℃時,HCO = x:1:5;
b)TMAH(氫氧化四甲銨)-H;80℃時,O2- H2O溶液:2.38升或209?tmah:30 9 hjo:HCO = x:y:z;
c)HzSO4-H,Ot溶液:97 $ r h2so 4:30 HCO,=和NH OH-HCO,或TMAH-HCO;
120℃左右為4:1;
d)鹽酸、氧氣、H2O溶液:369鹽酸:30 9 H2O:H2O
= 1 : 1 : 6,溫度為80—90攝氏度;
e)HF-H2 * H2溶液[12],[13]: 50 HF : 30 7?
h;25°C時Oz: H,O = 1:33:66;
I) HCO-HCO解:30到H2 HCO = 1:0攝氏度
在硫酸-氫氟酸溶液中,將晶片浸入5分鐘。在所有其他溶液中,晶片被浸沒10分鐘。化學清洗后,用超純水沖洗晶片十分鐘。為了避免晶片干燥過程中的顆粒污染,在化學清洗過程中形成的天然氧化物在0.5到HF的溶液中被去除。重新后移動天然氧化物,再次用超純水沖洗晶片10分鐘。清潔效果通過顆粒去除效率來評估。通過計算清洗前后的顆粒數(shù)比率來評估顆粒去除效率。
使用Aeronca WlS-100晶片檢測系統(tǒng)評估所有晶片上的顆粒數(shù)。WIS- 100將檢測尺寸分為顆粒(> 0.5 qm)和霧度I < 0.5 pm)。實驗前,WIS- 100用相對標準晶片校準。在實驗之前,每瓶水的初始粒子數(shù)少于50。
上述實驗程序是在濕站人工進行的。至于清洗槽的材料,HF清洗和超純水沖洗使用PFA清洗槽,而其他化學清洗使用石英清洗槽。PFA載體用于將晶片浸入浴槽中,并將它們從一個浴槽運送到另一個浴槽。這些測試中使用的化學品都是ULSI級和低粒子濃度。
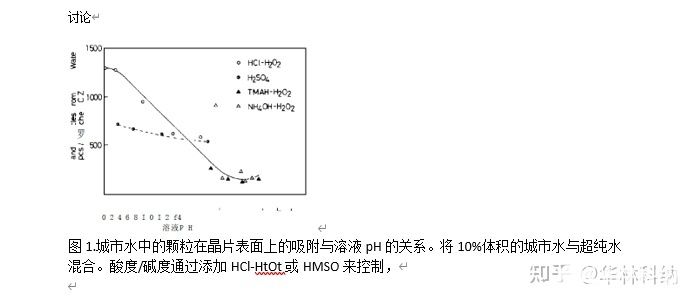
圖1顯示了溶液pH值和吸附在水表面的顆粒數(shù)量之間的關系。將10至10體積的自來水加入到每種測試溶液中提翁。在酸性溶液中,用HCl和H2O 2或h2so 4調節(jié)溶液pH,用NH4OH和H2O 2或TMAH和H2O調節(jié)溶液pH;在堿性溶液中。在低pH值溶液中觀察到最大的顆粒吸附,吸附的顆粒數(shù)量隨著溶液pH值的增加而減少。圖2還顯示了眾所周知的pH值對Fe,O3顆粒ζ電勢的影響。可以看出圖1兩條曲線幾乎完全吻合。據(jù)報道,晶片表面上吸附的SiOz球或聚苯乙烯乳膠球的數(shù)量隨著溶液pH值的增加而減少,如所示圖1.通常,在堿性溶液中,大多數(shù)顆粒的ζ電位被認為是負的。特別是,根據(jù)膠體化學[14]中的下列方程,金屬氧化物顆粒的ζ電勢在酸性溶液中為正,在堿性溶液中為負
低pH值:M-OH+H "+OH
-- M-OH;+ OH高pH值:M — OH + H" + OH
m-OH * H "+OH
-- M-O+HCO+H
此外,據(jù)報道,親水性(覆蓋有氧化膜)和疏水性(裸硅表面)晶片在水中都表現(xiàn)出負表面電荷。將這些觀察結果與圖1所示的結果聯(lián)系起來,據(jù)信在堿性溶液中,晶片表面和顆粒的ζ電勢都顯示出負電荷。結果,晶片表面和顆粒被認為在堿性溶液中是電排斥的。這表明堿性溶液是有益的用于從晶片表面去除顆粒。B.晶片清洗高壓堿性溶液RCA清洗方法[2]是一種主要的濕法硅晶片清洗方法,它采用nh4h-H2 2”H2O溶液作為堿性溶液。氨水-二H2O溶液通常采用1 : 1 : 5的混合比(氨水:HCO:氫)。圖3顯示了NH4 H-Hz z-H溶液中各種NH4OH含量與溶液pH值之間的關系。如圖3所示,1∶1∶5溶液的pH值為
9. 然而,圖1和2所示的結果表明NH4OH-H2O ‖- H中的NH4OH含量;o如果溶液專門用于去除顆粒,則可以減少。
審核編輯:湯梓紅
-
半導體
+關注
關注
335文章
28625瀏覽量
232859 -
晶片
+關注
關注
1文章
407瀏覽量
31938 -
硅片
+關注
關注
13文章
377瀏覽量
35058
發(fā)布評論請先 登錄
wafer清洗和濕法腐蝕區(qū)別一覽
超聲波清洗機的作用是什么?使用超聲波清洗機可以去除毛刺嗎?
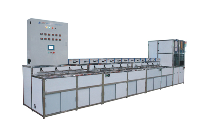
半導體清洗SC1工藝
spm清洗會把氮化硅去除嗎
硅片超聲波清洗機使用指南:清洗技術詳解
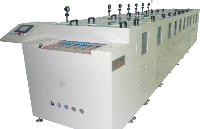





 濕法清洗中去除硅片表面的顆粒
濕法清洗中去除硅片表面的顆粒












評論