碳化硅MOSFETs進入量產階段
碳化硅(SiC)功率器件提供更高的開關效率,非常適合高溫和中高壓應用(1,2)。因此,它們有望在未來十年刺激1000 V以上應用的增長,因為它們能夠顯著降低輻射(3)。SUNY理工學院的電力電子制造聯盟準備利用這種增長,因為它使用150 mm SiC晶片(4,5)為1200 V功率金屬氧化物半導體場效應晶體管(MOSFETs)增加了中等產量。這個斜坡提供了一個機會來描述阻礙SiC MOSFETs批量生產的開發問題,包括成本、吞吐量、產量和可靠性的風險。如果這些參數中的任何一個受到材料差異(Si和SiC之間)的影響,那么就需要識別這些問題并構建一個路線圖,以便在批量制造中進行改進。
SiC的化學惰性給功率MOSFETs制造過程中的清潔和表面處理帶來了獨特的機遇和挑戰。之前的研究已經提出了替代化學方法來解決這些挑戰,但是在這里我們給出了epi測試后清洗的結果,也稱為初始晶片清洗(IWC ),以及基于為Si開發的濃縮化學方法的爐前清洗并且我們討論了隨著SiC技術從中試到批量生產的過渡,稀釋化學品的清潔能力和成本權衡。
雖然在相似的溫度下,單晶SiC中的材料擴散比Si中的慢得多(9),但是SiC熱處理通常發生在更高的溫度下,因此必須將金屬污染降至最低,以保持工藝控制和可靠性。此外,最小化生長在SiC上的氧化物中的金屬雜質是至關重要的,因為鐵、鎳和其他金屬被認為會降低柵極氧化物的固有壽命(10,11)。因此,這些金屬在與適當的Si技術節點相當的水平上被監控用于SiC處理;在這種情況下,用于180納米節點的ITRS FEP規格應該是合適的(12)。TXRF是用于控制這些污染物的有效診斷工具,因此在爐前清潔和高溫爐處理步驟中,它被用于測量與器件批次一起運行的Si和SiC監控晶片。此外,在外延生長的N層上制造1200V SiC MOSFET;這些層通常用汞(Hg)探針電容-電壓(MCV)來表征,在SiC晶片表面上留下痕量。因此,除了典型的金屬問題之外,在晶片進入制造工藝流程之前,必須去除汞。
汞探針CV (MCV),TXRF,和清潔實驗
為了可控地將污染物引入到SiC表面并測試清潔能力,在Semilab MCV-530測試儀中對100 mm和150 mm超低微管密度epi-ready SiC晶片進行汞探測,使用TXRF測量痕量金屬污染物,在各種不同的清潔化學中清潔晶片,并再次分析清潔后的晶片的痕量雜質。使用多種測量模式進行MCV測量,例如半徑掃描、晶片測繪和在同一位置多次測量,這使得第一次TXRF測量能夠比較未污染區域和污染區域,清洗后的TXRF能夠與清洗前的狀態進行比較。
MCV測量開始時,將汞抽出約0.5毫米至2毫米
毫米玻璃毛細管,然后降低毛細管,直到其與晶片表面接觸,約5 kPa的壓力迫使Hg與SiC表面接觸,并進行測量。釋放壓力,將汞抽回到毛細管中,并重復該過程。探針下降時間約為1秒,測量時間約為2秒。第一組MCV處理在兩個100 mm SiC晶片上進行,并且使用44點圖運行,其中多次測量許多位置,以便建立關于可變性的基線特征。第二組MCV處理實驗在150毫米的晶片上進行。圖1的左圖顯示了10個MCV點的徑向掃描,每個點的直徑約為1.7毫米。這種測量模式的目的是將未受污染的區域與受污染的區域進行比較,因為較大的斑點代表10毫米直徑的TXRF測量位置。這些晶片在晶片中心附近接受額外的重復性測量,一個晶片重復5次,另一個晶片在正面重復2次,在背面重復3次(晶片面朝下放置在卡盤上)。在兩個150毫米晶片上也進行了完整的55點MCV圖。

MCV、預清洗TXRF和后清洗TXRF的結果
所有的清洗都顯示出能有效去除一定程度的感興趣的金屬雜質。使用鉬陽極TXRF在100 mm SiC晶片上測量的映射汞水平顯示,在epi測試后立即從2.5x1013 atoms/cm2的典型平均值和2.4x1014 atoms/cm2的典型最大值降低到低于300秒檢測極限~7x1010 atoms/cm2的水平。150 mm SiC晶片上的RCA清洗顯示出在去除Hg以及Ni、Fe和其他金屬方面是有效的,清洗后的測量值低于濃縮RCA序列的檢測極限,并且更低,但是對于稀釋RCA序列仍然是可測量的。
圖2舉例說明了稀釋RCA清洗前后的TXRF測量對比。在清洗之前,表面Fe污染物位于晶片邊緣附近,并且在稀釋RCA清洗之后,在這些位置仍然是可測量的,盡管減少了。清潔趨勢在產量和可靠性相關的各種金屬(包括汞、鐵和鎳)上可以觀察到,并且在多個晶片上重復觀察到。
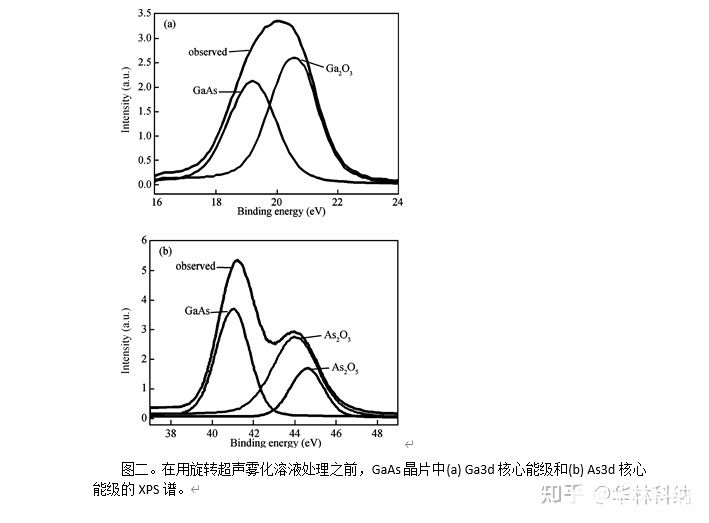
需要使用1.7毫米毛細管進行多次MCV測量,將足夠的汞引入SiC表面,以便在TXRF輕松測量。這種增加不是線性增加的,因此有可能是表面效應,如吸附作用,使更多的汞在后續測量中被引入表面。如果這種機制成立,那么盡管第一次測量達到或低于TXRF檢測極限,但汞仍然存在,必須清除。圖4示出了多次MCV測量對SiC晶片的影響;最左邊的圖接收到如圖1所示的10點徑向測量圖案,加上靠近晶片中心的5個額外的MCV測量,中心圖的晶片接收到10點圖案加上2個額外的測量,最右邊的圖顯示了來自77點圖的測量。77點圖中的汞測量沒有在具有相同圖案的第二個晶片上重復進行,因此該測量可能來自一個TXRF點內多個局部汞污染點的總和。所有清潔方法都降低了汞含量。稀釋的RCA清洗可能是最不有效的,因為它在清洗后僅產生了接近1.9x1010 atoms/cm2檢測極限的測量值。根據對清潔度的要求,該限制對于制造來說是可以接受的。
由于已知RCA化學通過氧化硅表面和去除HF中的這些氧化物來去除污染物,因此該機制在SiC上可能是不可行的,因為這些化學不會在本工作中使用的溫度下蝕刻或氧化SiC。先前的工作(7)表明,粗糙度在捕獲金屬污染物中起作用,HF處理導致親水性表面大部分以Si-OH和C-O基團終止(6)。此處的結果表明,使用較短時間和較低溫度的稀RCA在去除鐵、鎳和可能的汞方面效果較差。雖然粗糙度可能是一個因素,但溫度和時間的作用可能。
審核編輯:符乾江
-
半導體
+關注
關注
335文章
28902瀏覽量
237707 -
碳化硅
+關注
關注
25文章
3066瀏覽量
50462
發布評論請先 登錄
國產SiC碳化硅功率半導體企業引領全球市場格局重構
碳化硅MOSFET的優勢有哪些
碳化硅外延晶片硅面貼膜后的清洗方法

SiC碳化硅MOSFET功率器件雙脈沖測試方法介紹

40mR/650V SiC 碳化硅MOSFET,替代30mR 超結MOSFET或者20-30mR的GaN!
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
8英寸單片高溫碳化硅外延生長室結構

碳化硅MOSFET柵極氧化層缺陷的檢測技術
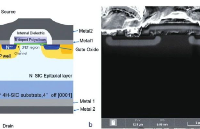
碳化硅功率器件的工作原理和應用






 碳化硅功率 MOSFET 制造中外延后和爐前清潔
碳化硅功率 MOSFET 制造中外延后和爐前清潔

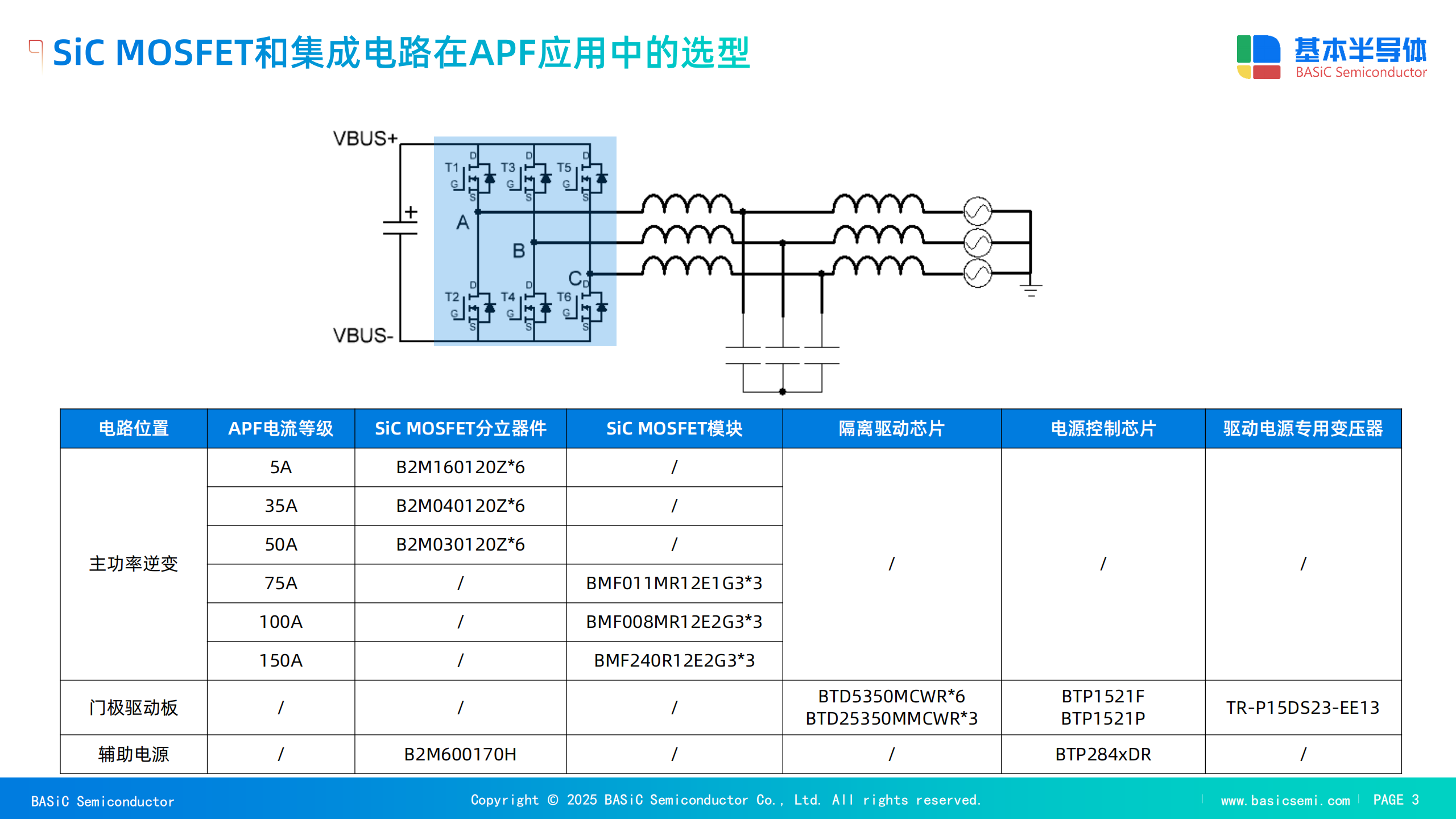
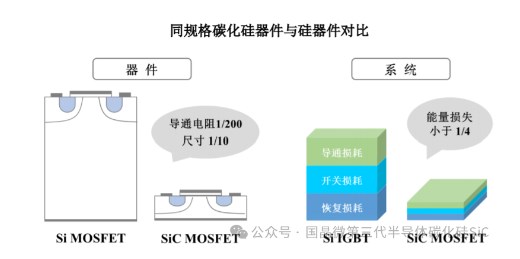
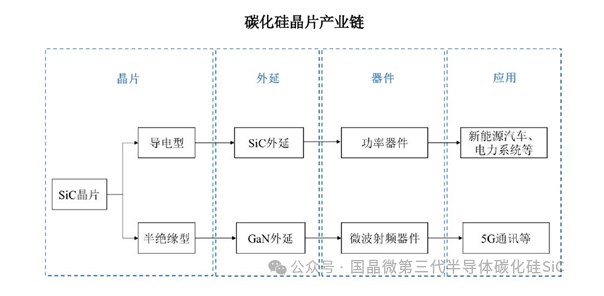
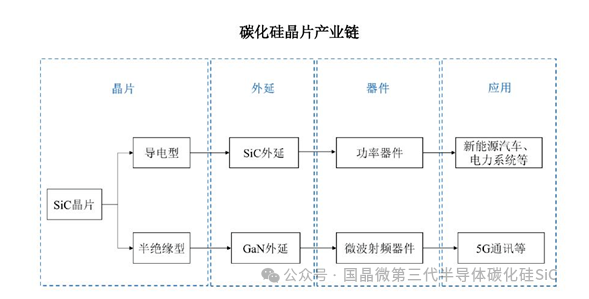










評論