摘要
研究了在半導(dǎo)體制造過程中使用的酸和堿溶液從硅片表面去除粒子。結(jié)果表明,堿性溶液的顆粒去除效率優(yōu)于酸性溶液。在堿性溶液中,顆粒去除的機(jī)理已被證實(shí)如下:溶液腐蝕晶圓表面以剝離顆粒,然后顆粒被電排斥到晶圓表面。實(shí)驗(yàn)結(jié)果表明,需要0.25 nm /min以上的刻蝕速率才能使吸附在晶圓表面的顆粒脫落。
介紹
由于半導(dǎo)體器件正在追求更高水平的-集成度和更高分辨率的模式,ET清潔技術(shù)對(duì)于重新-移動(dòng)硅片表面的污染物仍然至關(guān)重要。在1970年提出的RCA清洗工藝作為一種濕式清洗技術(shù)在世界各地仍在使用,以去除晶圓表面的污染物。雖然RCA凈化-過程中,NH4OH-H2O2-H2O溶液對(duì)-顆粒的去除效果非常好,但其顆粒去除機(jī)理尚不完全清楚。
實(shí)驗(yàn)
采用五英寸CZ(1,0,0)晶片進(jìn)行粒子吸附實(shí)驗(yàn)。天然氧化物首先在0.5%的HF溶液中從晶圓表面去除。然后將晶片浸泡在含有顆粒的各種溶液中10分鐘,然后沖洗和干燥。天然氧化物在晶圓表面形成后,再在0.5%的HF溶液中移動(dòng),然后清洗和干燥。
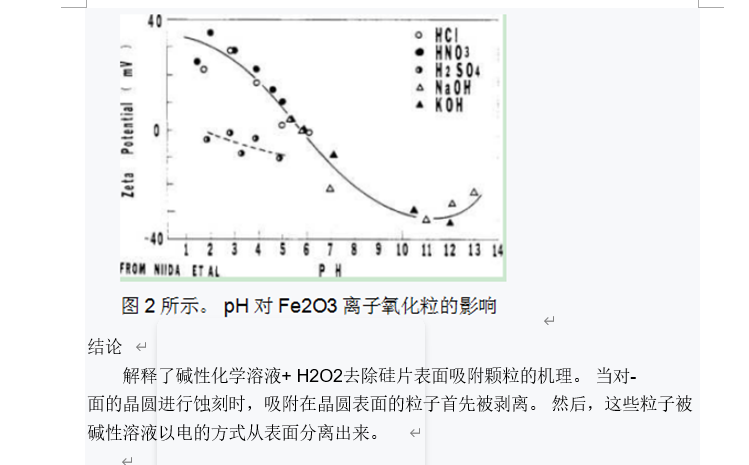
審核編輯:湯梓紅
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28886瀏覽量
237561 -
晶圓
+關(guān)注
關(guān)注
53文章
5159瀏覽量
129757 -
制造
+關(guān)注
關(guān)注
2文章
535瀏覽量
24411
發(fā)布評(píng)論請(qǐng)先 登錄
半導(dǎo)體哪些工序需要清洗
超聲波清洗機(jī)如何在清洗過程中減少廢液和對(duì)環(huán)境的影響?

wafer清洗和濕法腐蝕區(qū)別一覽
芯片清洗機(jī)用在哪個(gè)環(huán)節(jié)
半導(dǎo)體清洗SC1工藝
晶圓濕法清洗工作臺(tái)工藝流程
半導(dǎo)體濕法清洗有機(jī)溶劑有哪些
半導(dǎo)體制造中的濕法清洗工藝解析

深入剖析半導(dǎo)體濕法刻蝕過程中殘留物形成的機(jī)理
8寸晶圓的清洗工藝有哪些
芯片濕法蝕刻工藝
芯片濕法刻蝕殘留物去除方法
芯片制造過程中的兩種刻蝕方法

去除晶圓表面顆粒的原因及方法
揭秘PCB板清洗過程:每一步都關(guān)乎產(chǎn)品質(zhì)量!






 濕法清洗過程中硅片表面顆粒的去除
濕法清洗過程中硅片表面顆粒的去除











評(píng)論