在9 月 7 日的“5G 接入與承載技術發展”專題上,演講嘉賓 MRSI Systems 戰略營銷高級總監周利民博士在會議上帶來《5G 時代新型器件量產的創新解決方案》的精彩演講。周總講述新型器件的市場預測及新型器件在生產過程中面臨的挑戰,為嘉賓帶來 MRSI 提供的全自動、高速、高精度、靈活多功能的貼片方案。
5G 時代的到來催生更多光電新型器件的應用,根據行業機構的光器件市場預測可以看到,光器件市場 2020 年有受疫情影響有所下滑,但中國市場并沒有下滑,最新預測顯示整體趨勢沒有變化,未來十年將高速增長。在新型器件上,周總介紹了 400G 光模塊與 800G 光模塊的預測,400G 從 2019 年開始量產,預計至 2025 年將保持快速增長。800G 需求從 2023 年后保持快速增長。
5G 時代,基站呈倍數增長。由于氮化鎵的優越性能,根據 Yole 的分析,5G 時代在電信基站中應用的氮化鎵的年復合增長率是達到 15%,。根據 IMS2020 的問卷調查,多數人認為氮化鎵會取代 LDMOS 在 5G 中的應用。
硅光器件的發展趨勢方面,根據 Yole 的分析,硅光器件的市場年復合增長率在未來幾年超過 40%,主要增長為光模塊的部分。
周總對市場發展趨勢總結道:“光電器件朝著小型化、高集成、高帶寬、高速率的方向發展,十年前,芯片的貼片需求為 10-15 微米的精度;目前市場應用需求在 3-5 微米,對應 100G/200G 的量產需求;市場也需要 1-3 微米貼片精度,滿足 400G 量產需求。面對 800G 或以上速率的光模塊,硅光子集成是未來發展方向,市場需要亞微米的貼片精度。”
隨著創新器件的快速迭代,對貼片設備的精度及速度方面有了新的要求。器件商也向市場表達了成本壓力,希望貼片設備在滿足高精度前提下,能夠有更多的產出。周總介紹,目前亞微米精度貼片水平可以做到 15 秒貼一個芯片,2025 年目標是提升到 10 秒。
5G 時代新型器件由于成本的壓力,新型的低成本封裝形式興起。例如 TO 封裝,復雜的 TO 集成了不同的光電器件,需要多芯片多工藝的復雜封裝。射頻放大的器件的需求量更大,并采用新型的材料和工藝。光子集成希望可以做到光模塊低成本,從芯片到 wafer 的封裝低成本是必須的。2018 年,錢博士在 Laser Focus World 發表文章表示,云時代產品的更新迭代更加快,光器件以每年 25%的需求量在遞增,同樣光器件的功能成本以每年大于 10%的速度遞減。這個趨勢仍在持續并將持續很長一段時間。作為貼片方案提供商,MRSI 面對新型器件的生產需求始終致力于開發最佳的創新解決方案。
面對新型器件封裝的挑戰,MRSI 不斷推陳出新,2020 年 9 月 8 號正式發布了新產品 MRSI-S-HVM 光子集成的解決方案。MRSI 針對目前光器件的挑戰,提供穩定性和可靠性高的貼片設備,提升精度,同時保證業內最高的生產速度。針對不同的應用提供多工藝的靈活性。這樣將給客戶帶來最高的投資回報率。
在光通信行業,MRSI 提供可大批量和高混合制造的解決方案,2017 年發布 MRS-HVM 系列精度為 3 微米,2019 年在訊石平臺發布了該系列產品精度提升至 1.5 微米。該設備貼片精度非常穩定并不損失靈活性,貼片后的穩定精度可以達到 3 微米,可以實現多芯片多工藝的生產。基于這個設備,周博士在 7 月發表的文章:《為現代光子制造提供最精確的靈活量產芯片貼片解決方案》對該設備的性能進行總結,詳細解釋了它為什么可以實現這么《±3 微米的精度。MRSI 的設備性能不止于此,根據 MRSI 的測機精度顯示,在 100PCS 的玻璃片貼片測試中,1.5 微米設備的精度在用玻璃片驗機中可以達到 0.5 微米左右精度。在 500 個 COC 的生產數據顯示,精度可達到±2.2μm@3σ,而且角度控制為±0.4°@3σ,目前只有 MRSI 的設備可以實現如此精確的芯片角度控制。對于高密度的設計,在一個基板上共晶多個芯片的應用,例如多芯片的 COC、COS,MRSI 設備可以從上面進行加熱,有熱頭的工藝,采用脈沖加熱方式,達到快速升溫,快速降溫的要求。
在針對復雜 TO 的生產設備里面,MRSI-H-TO 設備可以到達業界領先的 1.5 微米的精度。貼片后可達到 5 微米精度,這臺設備具備共晶與蘸膠的工藝,可實現各種角度的多芯片貼片。一臺設備集成多種功能可減少設備的定位,提高貼片的精度。
5G 射頻器件方面的需求成倍增長,為滿足大批量生產需求,MRSI-H-LDMOS 提供 1.5 微米與 MRSI-705 提供 5 微米兩種設備選擇,是市場上用于射頻微波器件封裝方面精度最高的設備,可以滿足高速量產需求。針對過去的 LDMOS 或者新型氮化鎵的封裝工藝,新型氮化鎵的共晶或納米銀膠工藝都可以支持,非常適用于量產。其獨特優勢是共晶期間氧含量控制得非常好,可保證高的貼片質量。
在大功率激光器封裝方面,MRSI-H-HPLD 是專為這類應用設計的,在一臺設備上可以滿足各類封裝形式的貼片需求,例如 CoS, C-mount, Bar-on-Submount(BoS)的共晶貼片工藝均可在一臺設備完成。其獨有的優勢是利用專門設計的自平衡工具來保證大功率激光器貼片的共面性。
最后,周總重點發布了 MRSI-S-HVM 針對硅光器件量產封裝的解決方案,該方案是基于市場應用最廣泛的 MRSI-HVM 設備平臺開發的,繼承了 MRSI-HVM 所有并行工藝的設計,可以在這一臺設備上選擇 2 個精度模式,實現不同精度的芯片封裝,可平衡貼片的精度與速度。以達到最大的設備利用率和設備的產出。其支持底部和頂部脈沖加熱模式,也支持激光加熱模式,該設備支持從 6 英寸 III-V 族晶圓上提取芯片貼裝到 12 英寸的硅基晶圓上,真正實現晶圓級的封裝。
責任編輯:tzh
-
芯片
+關注
關注
459文章
52267瀏覽量
437210 -
晶圓
+關注
關注
52文章
5130瀏覽量
129250 -
封裝
+關注
關注
128文章
8568瀏覽量
144919 -
5G
+關注
關注
1360文章
48746瀏覽量
570795
發布評論請先 登錄
熱門5G路由器參數對比,華為智選Brovi 5G CPE 5 VS SUNCOMM SDX75
5G 時代,TNC 連接器標準如何升級?

5G 時代下,TNC 插頭型號的創新變革之路

新型功率器件真空回流焊焊接空洞的探析及解決方案
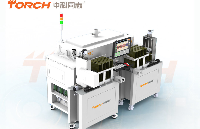
5G 時代 TNC 插頭的創新變革與發展

6G通信技術對比5G有哪些不同?
IP地址與5G時代的萬物互聯

5G RedCap通信網關是什么
物聯網時代下的5G融合定位,可以實現哪些功能?
嵌入式設備中的4G/5G模塊管理






 5G時代的到來將催生更多光電新型器件的應用
5G時代的到來將催生更多光電新型器件的應用


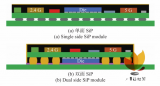










評論