當(dāng)前,一系列的新項(xiàng)目已經(jīng)開始使用3D打印為復(fù)雜的應(yīng)用生產(chǎn)出功能強(qiáng)大的硅基聚合物芯片,但它們與標(biāo)準(zhǔn)芯片設(shè)計(jì)相比如何?
企業(yè)正在利用新的制造工藝——3D打印
集成電路(IC)通常是通過(guò)傳統(tǒng)的制造方法制造的,這種方法優(yōu)先考慮生產(chǎn)剛性器件,因?yàn)檫@些剛性組件是以保護(hù)芯片的方式組裝的。據(jù)專家介紹,剛性器件其實(shí)是一種障礙,它迫使半導(dǎo)體制造商要以較大的尺寸封裝芯片,以防止意外損壞,而芯片的內(nèi)部布局必須適應(yīng)此硬件,因此半導(dǎo)體制造商的設(shè)計(jì)創(chuàng)意會(huì)受到影響。
近年來(lái),半導(dǎo)體制造商一直在尋求現(xiàn)代可用的解決方案,在這一過(guò)程中,柔性集成電路引起了廣泛關(guān)注,但其內(nèi)存密度卻阻礙了這項(xiàng)技術(shù)的發(fā)展。在2017年之后,柔性集成電路的內(nèi)存密度問(wèn)題開始迎來(lái)重大突破。
先前早些時(shí)候,美國(guó)空軍研究實(shí)驗(yàn)室和美國(guó)半導(dǎo)體公司合作產(chǎn)生了一種芯片,這種芯片的存儲(chǔ)容量是當(dāng)前市場(chǎng)上任何柔性集成電路的7000多倍,他們創(chuàng)造了SoC來(lái)支持小型消費(fèi)電子和商用電子的興起。
隨后,Berrigan和美國(guó)半導(dǎo)體公司將傳統(tǒng)知識(shí)與3D打印相結(jié)合,從而創(chuàng)建了具有密集電路的半導(dǎo)體薄板,這些集成電路(IC)類似于正方形的膠片,打印過(guò)程使研究人員能夠集成一個(gè)緊湊的內(nèi)存控制器,從而釋放芯片的出色性能。
再后來(lái),漢堡大學(xué)和德國(guó)電子同步加速器進(jìn)行了一次合作,通過(guò)銀納米線網(wǎng)格促進(jìn)了3D打印,當(dāng)結(jié)合到基底時(shí)形成了導(dǎo)電表面,每根電線都是“幾十納米厚,10到20微米長(zhǎng)”。聚合物壓縮有助于導(dǎo)電性,這些導(dǎo)電軌跡通過(guò)X射線分析進(jìn)行檢查,其目標(biāo)是創(chuàng)造具有類似于傳統(tǒng)集成電路結(jié)構(gòu)的導(dǎo)電層。
從一般意義上講,諸如此類的可延展技術(shù)具有巨大的潛力,3D打印使我們能夠創(chuàng)建充當(dāng)微控制器的靈活系統(tǒng)。那些具有集成內(nèi)存的設(shè)備甚至可以存儲(chǔ)傳感器數(shù)據(jù),使其適合可穿戴設(shè)備、IoT設(shè)備和監(jiān)視應(yīng)用程序。
美國(guó)空軍和美國(guó)半導(dǎo)體公司開發(fā)的一種柔性硅聚合物芯片。圖片由美國(guó)空軍提供。
3D打印集成電路面臨的困境
不過(guò),3D打印的生存能力將在很大程度上取決于制造商的能力、規(guī)模或生產(chǎn)高收益的技術(shù),半導(dǎo)體制造商就此將會(huì)卷入納米競(jìng)賽,英特爾、AMD和ARM的目標(biāo)是通過(guò)增加晶體管密度來(lái)減小芯片尺寸。
這些更小的設(shè)計(jì)更有能力、更節(jié)能,這些特性對(duì)于小型電子產(chǎn)品來(lái)說(shuō)是至關(guān)重要的,較小的尺寸有助于簡(jiǎn)化內(nèi)部設(shè)計(jì),那么半導(dǎo)體制造商可以通過(guò)3D打印來(lái)實(shí)現(xiàn)這些相同的改進(jìn)嗎?
首先,有證據(jù)表明,當(dāng)前半導(dǎo)體制造商擁有不錯(cuò)的生產(chǎn)帶寬,但按目前的制造標(biāo)準(zhǔn),產(chǎn)量仍然很低;半導(dǎo)體制造商也可以將集成電路和系統(tǒng)組件直接打印到印刷電路板(PCB)上,但是這種做法仍然是相當(dāng)專業(yè)且費(fèi)時(shí)費(fèi)力。因此3D打印本身雖是獨(dú)特且強(qiáng)大的制作方式,但目前還沒(méi)有廣泛的吸引力,只能寄希望于未來(lái)。
同時(shí),半導(dǎo)體工業(yè)目前在10nm或更低的波長(zhǎng)下生產(chǎn)大量工藝,3D打印現(xiàn)在只能達(dá)到接近微米級(jí)的分辨率,印刷工藝也依賴于材料的共沉積,這是制造過(guò)程中的另一種困境。
最后,長(zhǎng)期的芯片制造方法采用超大規(guī)模集成(VLSI),將數(shù)百萬(wàn)個(gè)晶體管封裝到單個(gè)芯片中,這對(duì)于小型化至關(guān)重要。因?yàn)榧词棺詈玫?D打印機(jī)也具有相對(duì)較低的分辨率,因此無(wú)法實(shí)現(xiàn)這種晶體管密度,未來(lái)還需要進(jìn)行改進(jìn)。
未來(lái)仍舊充滿希望
不過(guò)3D打印集成電路的未來(lái)仍然充滿希望,3D打印涉及的聚合物和工藝具有獨(dú)特的優(yōu)勢(shì):如聚合物與半導(dǎo)體晶圓的結(jié)合良好;可以通過(guò)PVD、CVD或熱蒸發(fā)法進(jìn)行電觸點(diǎn)的附加沉積;聚合物可以應(yīng)對(duì)冷熱溫度波動(dòng);這些材料也較不易碎,3D打印SoC可能比其前任產(chǎn)品具有長(zhǎng)期的耐用性和性能優(yōu)勢(shì),尤其是在芯片尺寸趕上之后。
一旦這項(xiàng)技術(shù)成熟,3D打印可能會(huì)早日起飛。越來(lái)越多的公司可能會(huì)采用3D打印集成電路(IC)作為可靠、便宜的替代方案,這將有助于該技術(shù)獲得可見(jiàn)性和動(dòng)力。為了使3D打印進(jìn)入對(duì)話,有必要對(duì)打印過(guò)程進(jìn)行進(jìn)一步的改進(jìn),一旦出現(xiàn)新的印刷技術(shù),制造商將獲得豐厚的回報(bào)。
同時(shí)需要注意的是,小批量生產(chǎn)對(duì)于3D集成電路是有利的,與傳統(tǒng)的同類產(chǎn)品不同,它們不需要在晶圓上生產(chǎn),這消除了成本密度問(wèn)題,制造時(shí)間是一致的,因此,低容量的電子制造商可能會(huì)選擇采用3D打印。但是如果要進(jìn)行大批量制造,公司必須在新機(jī)器上進(jìn)行投資,這些資本成本會(huì)迅速增加,半導(dǎo)體制造商還必須考慮生產(chǎn)后的質(zhì)量控制成本,在制造過(guò)程還沒(méi)有完全解決之前,制造商可能會(huì)選擇拋棄3D打印集成電路的可能性。
-
集成電路
+關(guān)注
關(guān)注
5424文章
12057瀏覽量
368411 -
3D打印
+關(guān)注
關(guān)注
27文章
3590瀏覽量
112488
發(fā)布評(píng)論請(qǐng)先 登錄
基于樹莓派的工業(yè)級(jí) 3D 打印機(jī)!

答疑|3D打印能打印立體字母嗎?
3D打印技術(shù):如何讓古老文物重獲新生?
3D打印中XPR技術(shù)對(duì)于打印效果的影響?
有源晶振在3D打印機(jī)應(yīng)用方案
uvled光固化3d打印技術(shù)

3D集成電路的結(jié)構(gòu)和優(yōu)勢(shì)

UV光固化技術(shù)在3D打印中的應(yīng)用
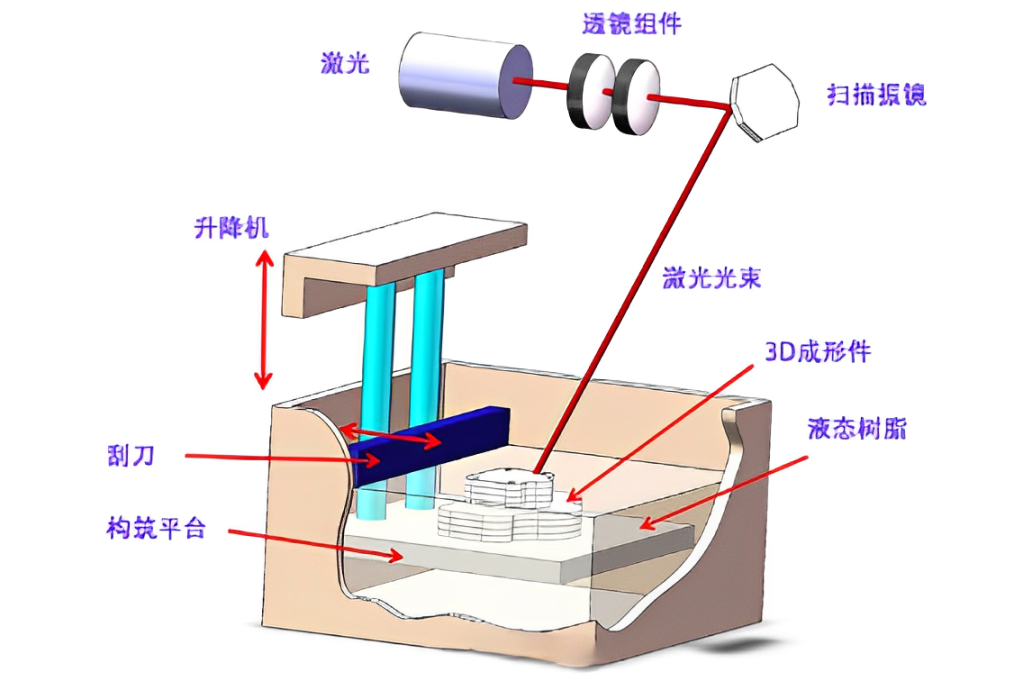
揭秘3D集成晶圓鍵合:半導(dǎo)體行業(yè)的未來(lái)之鑰

3D打印技術(shù)應(yīng)用的未來(lái)
物聯(lián)網(wǎng)行業(yè)中的模具定制方案_3D打印技術(shù)分享

物聯(lián)網(wǎng)行業(yè)中的模具定制方案_3D打印材料選型分享

透明樹脂材料3D打印服務(wù)全透應(yīng)用案例
3D打印汽車零部件建模設(shè)計(jì)3D打印服務(wù)






 3D打印集成電路的未來(lái)如何
3D打印集成電路的未來(lái)如何












評(píng)論