電子發燒友網綜合報道,據韓媒報道,三星近日與長江存儲簽署了3D NAND混合鍵合專利許可協議,從第10代V-NAND開始,將使用長江存儲的專利技術,特別是在“混合鍵合”技術方面。
?
W2W技術是指將兩片已經加工完畢的晶圓直接鍵合在一起。這項技術通過直接將兩片晶圓貼合,省去了傳統的凸點連接,從而縮短了電氣路徑,提高了性能和散熱能力,同時優化了生產效率,是目前混合鍵合中最常用的技術。
?
據ZDNet報道,三星之前在NAND生產中使用COP(外圍單元)方法,即將外圍電路置于一個晶圓上,并將單元堆疊在上面。當層數超過400層時,底層外圍電路的壓力會顯著增加,影響芯片的可靠性。
?
根據三星的計劃,2025年下半年將量產下一代V10 NAND,預計堆疊層數將達到420至430層。因此引入W2W技術勢在必行。
?
長江存儲的混合鍵合技術命名為“晶棧(Xtacking)”,于四年前推出并用于3D NAND制造,同時進行了全面的專利布局。
?
據介紹,在晶棧Xtacking架構推出前,市場上的3D NAND主要分為傳統并列式架構和CuA(CMOS under Array)架構。長江存儲通過創新布局和縝密驗證,經過長達9年在3D IC領域的技術積累和4年的研發驗證后,終于將晶圓鍵合這一關鍵技術在3D NAND閃存上得以實現。
?
?
?
在指甲蓋大小的面積上實現數十億根金屬通道的連接,合二為一成為一個整體,擁有與同一片晶圓上加工無異的優質可靠性表現,這項技術為未來3D NAND帶來更多的技術優勢和無限的發展可能。隨著層數的不斷增高,基于晶棧Xtacking所研發制造的3D NAND閃存將更具成本和創新優勢。
?
晶棧Xtacking可實現在兩片獨立的晶圓上加工外圍電路和存儲單元,這樣有利于選擇更先進的邏輯工藝,從而讓NAND獲取更高的I/O接口速度及更多的操作功能。當兩片晶圓各自完工后,創新的晶棧Xtacking技術只需一個處理步驟即可通過數十億根垂直互聯通道(VIA)將兩片晶圓鍵合,合二為一。
?
在傳統3DNAND架構中,外圍電路約占芯片面積20~30%,晶棧?Xtacking技術創新的將外圍電路置于存儲單元之上,從而實現比傳統3D NAND更高的存儲密度,芯片面積可減少約25%。
?
晶棧Xtacking 技術充分利用存儲單元和外圍電路的獨立加工優勢,實現了并行的、模塊化的產品設計及制造,產品開發時間可縮短三個月,生產周期可縮短20%。此外,這種模塊化的方式也為引入NAND外圍電路的創新功能以實現NAND閃存的定制化提供了可能。
?
在長江存儲第三代系列產品中,晶棧 Xtacking已全面升級至2.0,進一步釋放3D NAND閃存潛能。晶棧 Xtacking2.0充分利用架構優勢為客戶帶來更多價值。其中包括:進一步提升閃存吞吐速率、提升系統級存儲的綜合性能、開啟定制化閃存全新商業模式等。
?
根據TechInsights技術分析,致態TiPro9000固態硬盤(ZTSS3CB08B34MC)采用了長江存儲的新型Xtacking4.x芯片。它由2yy 個有源層(除漏極選擇柵極SGD外,總柵極數為 294層)組成,下層擁有 150 個柵極,而上層則有 144 個柵極。其TLC NAND 的位密度增至20Gbit/mm^2以上,這在業界尚屬首次。
?
?
?
?
目前掌握3D NAND混合鍵合關鍵專利的公司包括美國的Xperi、中國的長江存儲和中國臺灣的臺積電。Xperi是一家專利授權公司,臺積電是一家半導體代工企業,而長江存儲的“Xtaking”技術已經穩定量產,并演進到“4.x”版本。
?
外媒報道稱,三星要開發下一代NAND幾乎不可能規避長江存儲的專利。同樣的,SK海力士也在開發400層以上NAND產品,一旦用到混合鍵合技術或將不可避免地需要與長江存儲簽訂專利授權協議。
?
?
?
閃存沖擊400層+,混合鍵合技術傳來消息
- 閃存(115237)
相關推薦
鋁帶鍵合點根部損傷研究
潘明東 朱悅 楊陽 徐一飛 陳益新 (長電科技宿遷股份公司) 摘要: 鋁帶鍵合作為粗鋁線鍵合的延伸和發展,鍵合焊點根部損傷影響了該工藝的發展和推廣,該文簡述了鋁帶鍵合工藝過程,分析了導致鋁帶鍵合點
2024-11-01 11:08:07 1673
1673
 1673
1673
半導體晶片鍵合的對準方法
多年來,半導體晶片鍵合一直是人們感興趣的課題。使用中間有機或無機粘合材料的晶片鍵合與傳統的晶片鍵合技術相比具有許多優點,例如相對較低的鍵合溫度、沒有電壓或電流、與標準互補金屬氧化物半導體晶片的兼容性
2022-04-26 14:07:04 3971
3971
 3971
3971
晶圓鍵合中使用的主要技術
晶片鍵合是指通過一系列物理過程將兩個或多個基板或晶片相互連接和化學過程。晶片鍵合用于各種技術,如MEMS器件制造,其中傳感器組件封裝在應用程序中。其他應用領域包括三維集成、先進的封裝技術和CI制造業在晶圓鍵合中有兩種主要的鍵合,臨時鍵合和永久鍵合,兩者都是在促進三維集成的技術中發揮著關鍵作用。
2022-07-21 17:27:43 3291
3291
 3291
3291介紹芯片鍵合(die bonding)工藝
作為半導體制造的后工序,封裝工藝包含背面研磨(Back Grinding)、劃片(Dicing)、芯片鍵合(Die Bonding)、引線鍵合(Wire Bonding)及成型(Molding)等步驟。
2023-03-27 09:33:37 13706
13706
 13706
13706IGBT芯片互連常用鍵合線材料特性
鋁線鍵合是目前工業上應用最廣泛的一種芯片互連技術,鋁線鍵合技術工藝十分成熟,且價格低廉。鋁線根據直徑的不同分為細錫線和粗鋁線兩種,直徑小于100um的鋁線被稱為細鋁線,直徑大于100um小于500um的鋁線被稱為粗鋁線。粗鋁線鍵合實物如圖1所示。
2023-03-27 11:15:57 4867
4867
 4867
4867銅線鍵合設備焊接一致性探索
相對于傳統金線鍵合,銅線鍵合設備焊接過程工藝窗口更小,對焊接的一致性要求更高。通過對銅線鍵合工藝窗口的影響因素進行分析,探索了設備焊接過程的影響和提升辦法,為銅線鍵合技術的推廣應用提供技術指導。
2023-10-31 14:10:16 917
917
 917
917
鋁硅絲超聲鍵合引線失效分析與解決
在微電子封裝中,引線鍵合是實現封裝體內部芯片與芯片及芯片與外部管腳間電氣連接、確保信號輸入輸出的重要方式,鍵合的質量直接關系到微電子器件的質量和壽命。針對電路實際生產中遇到的測試短路、內部鍵合絲脫落
2023-11-02 09:34:05 1093
1093
 1093
1093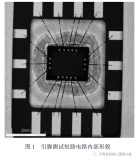
全球首臺光學拆鍵合設備發布,和激光拆鍵合有什么不同?
晶圓與載板分離。 當前,激光拆鍵合是主要的拆鍵合技術發展方向。激光拆鍵合技術是將臨時鍵合膠通過旋涂的方式涂在器件晶圓上,并配有激光響應層,當減薄、TSV加工和金屬化等后面工藝完成之后,再通過激光掃描的方式,分離
2024-03-26 00:23:00 3133
3133
 3133
3133
3D NAND閃存來到290層,400層+不遠了
V-NAND 1Tb TLC達290層,已開始量產。根據規劃,2025年主流閃存廠商的產品都將進入300層+,甚至400層以上。至于遠期,到2030年閃存有望突破1000層。 ? 2024 年三星第9 代
2024-05-25 00:55:00 4135
4135
 4135
4135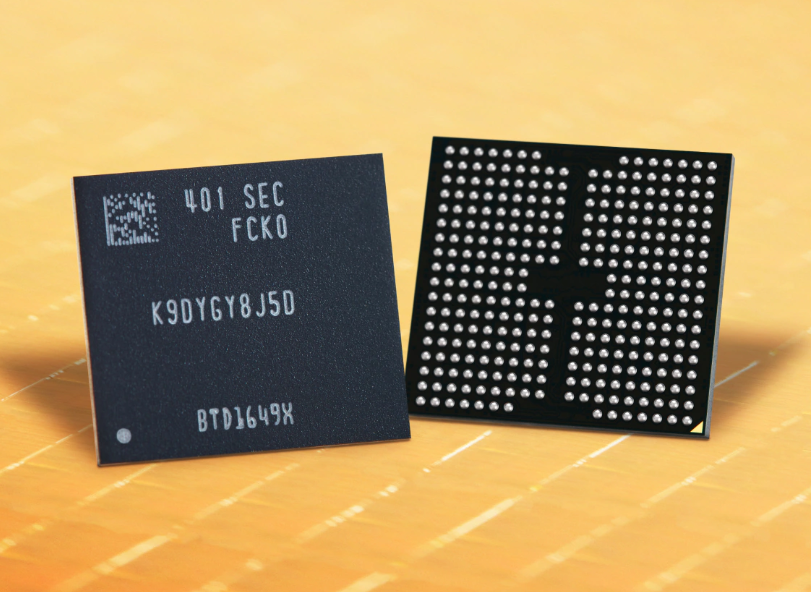
SiC功率器件的封裝技術研究
。使用軟焊可以消除應力,卻要以熱疲勞和低強度為代價,而硬焊具有高強度卻無法消除應力。瞬態液相鍵合技術要求使用一個擴散勢壘,以防止Si3N4襯底上的銅金屬化層與用來鍵合SiC芯片的Au層之間的互擴散
2018-09-11 16:12:04
臨時鍵合有人做過這個嗎?
目前在做砷化鎵和磷化銦,在研究bongder和debonder工藝, 主要是超薄片很難處理,so暫定臨時鍵合解鍵合和薄片清洗流程,因為正面有保護可以做背面工藝,這里有前輩做過這個嗎?
2018-12-17 13:55:06
優化封裝之鍵合線封裝中的兩個主要不連續區
的物理層包括一個連接到子卡的鍵合線封裝或倒裝芯片封裝的發射器件。子卡通過一個連接器插在背板上。背板上的路由通過插入的子卡連接到一個或一組連接器。采用鍵合線或倒裝芯片封裝的接收芯片也位于這些子卡上
2018-09-12 15:29:27
有償求助本科畢業設計指導|引線鍵合|封裝工藝
任務要求:
了解微電子封裝中的引線鍵合工藝,學習金絲引線鍵合原理,開發引線鍵合工藝仿真方法,通過數據統計分析和仿真結果,分析得出引線鍵合工序關鍵工藝參數和參數窗口,并給出工藝參數和鍵合質量之間的關系
2024-03-10 14:14:51
硅-直接鍵合技術的應用
硅-硅直接鍵合技術主要應用于SOI、MEMS和大功率器件,按照結構又可以分為兩大類:一類是鍵合襯底材料,包括用于高頻、抗輻射和VSIL的SOI襯底和用于大功率高壓器件的類外延的疏水鍵合N+-N-或
2018-11-23 11:05:56
芯片封裝鍵合技術各種微互連方式簡介教程
芯片封裝鍵合技術各種微互連方式簡介微互連技術簡介定義:將芯片凸點電極與載帶的引線連接,經過切斷、沖壓等工藝封裝而成。載帶:即帶狀載體,是指帶狀絕緣薄膜上載有由覆 銅箔經蝕刻而形成的引線框架,而且芯片
2012-01-13 14:58:34
新型銅線鍵合技術
銅線以其良好的電器機械性能和低成本特點已在半導體分立器件的內引線鍵合工藝中得到廣泛應用,但銅線的金屬活性和延展性也在鍵合過程中容易帶來新的失效問題,文中對這種
2009-03-07 10:30:57 16
16
 16
16陽極鍵合工藝進展及其在微傳感器中的應用
分析了陽極鍵合技術的原理和當前陽極鍵合技術的研究進展,綜述了微傳感器對陽極鍵合的新需求,展望了陽極鍵合技術在傳感器領域的應用前景。關鍵詞:陽極鍵合; 傳感器; 硅片
2009-07-18 09:37:49 26
26
 26
26混合電路內引線鍵合可靠性研究
摘要:本文簡述了混合電路以及半導體器件內引線鍵合技術原理,分析了影響內引線鍵合系統質量的因素,重點分析了最常見的幾種失效模式:鍵合強度下降、鍵合點脫落等,并提
2010-05-31 09:38:04 30
30
 30
30NAND閃存的自適應閃存映射層設計
NAND閃存的自適應閃存映射層設計
閃存存儲器主要分為NAND和XOR兩種類型,其中NAND型是專為數據存儲設計。本文的閃存映射方法主要是針對NAND類型的
2010-05-20 09:26:23 1014
1014
 1014
1014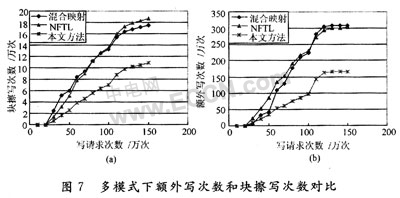
大功率IGBT模塊封裝中的超聲引線鍵合技術
從超聲引線鍵合的機理入手,對大功率IGBT 模塊引線的材料和鍵合界面特性進行了分析,探討了鍵合參數對鍵合強度的影響。最后介紹了幾種用于檢測鍵合點強度的方法,利用檢測結果
2011-10-26 16:31:33 66
66
 66
66集成電路封裝中的引線鍵合技術
在回顧現行的引線鍵合技術之后,本文主要探討了集成電路封裝中引線鍵合技術的發展趨勢。球形焊接工藝比楔形焊接工藝具有更多的優勢,因而獲得了廣泛使用。傳統的前向拱絲越來越
2011-10-26 17:13:56 86
86
 86
86Ziptronix授權索尼DBI混合鍵合專利技術
美國北卡羅來納州研究三角園消息—2015年3月28日—三維集成電路低溫直接鍵合專利技術開發商和供應商Ziptronix公司今天宣布與索尼公司簽署了一份用于高級圖像傳感器應用的專利許可協議。
2015-04-01 11:55:38 1771
1771
 1771
1771鍵合線等效電阻的IGBT模塊老化失效研究
已有研究表明,鍵合線老化脫落失效是影響絕緣柵雙極型晶體管( IGBT)可靠性的主要因素之一。以此為研究背景,首先根據IGBT模塊內部鍵合線的結構布局與物理特性,分析鍵合線等效電阻與關斷暫態波形的關系
2018-01-02 11:18:14 5
5
 5
5長江存儲計劃量產64層3D NAND閃存芯片 閃存市場將迎來一波沖擊
國產存儲芯片再下一城,日前有產業鏈方面的消息稱,中國長江存儲將如期在今年年底量產64層3D NAND閃存芯片,這對價格本就在不斷下探的閃存市場無疑又將帶來一波新的沖擊。
2019-04-01 16:53:12 1806
1806
 1806
1806SK海力士全球首個量產128層堆疊4D閃存:沖擊176層
SK海力士宣布,已經全球第一家研發成功,并批量生產128層堆疊的4D NAND閃存芯片,此時距離去年量產96層4D閃存只過去了八個月。
2019-06-27 15:23:28 3287
3287
 3287
3287長江存儲宣布將跳過96層堆疊閃存技術直接投入128層閃存研發和量產
今年初,長江存儲市場與銷售資深副總裁龔翔曾公開表示,長江存儲將跳過如今業界常見的96層堆疊閃存技術,直接投入128層閃存的研發和量產工作。
2020-04-08 16:38:21 1058
1058
 1058
1058陽極鍵合技術廣泛應用于MEMS器件的制備過程中
1969年,美國的Wallis和Pomerantz兩位研究人員首次提出了陽極鍵合技術,其鍵合方法如圖1所示。陽極鍵合目前在硅片與玻璃鍵合中得到了較為廣泛的應用,技術發展相對較為成熟。其基本原理如圖2
2020-06-17 11:33:14 13167
13167
 13167
13167研發的銅混合鍵合工藝正推動下一代2.5D和3D封裝技術
代工廠、設備供應商、研發機構等都在研發一種稱之為銅混合鍵合(Hybrid bonding)工藝,這項技術正在推動下一代2.5D和3D封裝技術。
2020-10-10 15:24:32 7366
7366
 7366
7366
銀線二焊鍵合點剝離失效分析
銀線二焊鍵合點剝離LED死燈的案子時常發生,大家通常爭論是鍍銀層結合力差的問題,還是鍵合線工藝問題,而本案例,金鑒從百格實驗和FIB截面觀察的角度來判定為鍵合工藝導致。
2021-05-16 11:53:12 2623
2623
 2623
2623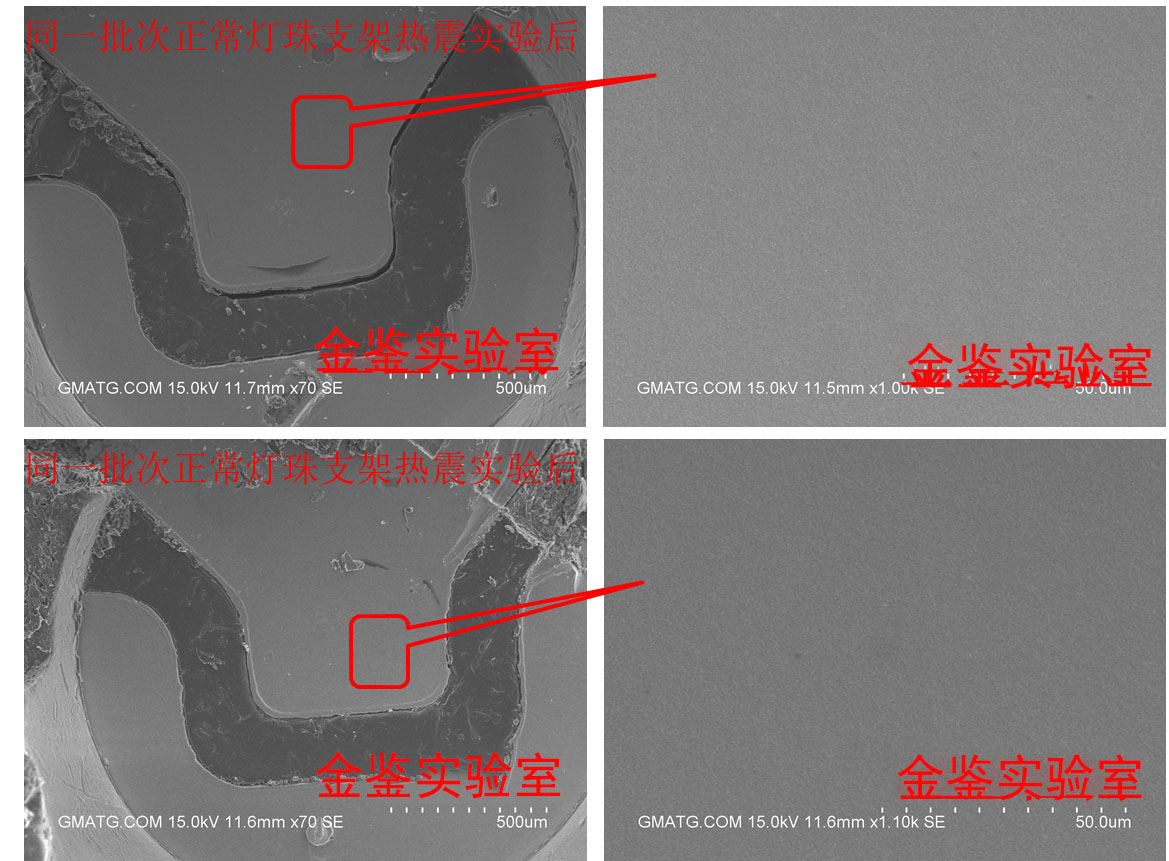
晶片鍵合技術和薄膜傳輸技術
結合離子注入工藝、激光照射和去除犧牲層,晶片鍵合技術是將高質量薄膜轉移到不同襯底上的最有效方法之一。本文系統地總結和介紹了蘇州華林科納的晶片鍵合技術在電子、光學器件、片上集成中紅外傳感器和可穿戴傳感器等領域的應用。依次介紹了基于智能剝離技術
2021-12-21 16:33:29 2871
2871
 2871
2871
三大引線材料、工藝助力陶瓷封裝鍵合工藝
引線鍵合技術是一種固相鍵合方法,其基本原理是:在鍵合過程中,采用超聲、加壓和加熱等方式破壞被焊接表面的氧化層和污染物,產生塑性變形,使得引線與被焊接面親密接觸,達到原子間的引力范圍并導致界面間原子擴散而形成有效焊接。
2022-03-21 10:45:31 6911
6911
 6911
6911MEMS工藝中的鍵合技術
鍵合技術是 MEMS 工藝中常用的技術之一,是指將硅片與硅片、硅片與玻璃或硅片與金屬等材料通過物理或化學反應機制緊密結合在一起的一種工藝技術。
2022-10-11 09:59:57 5184
5184
 5184
5184電鍍創新實現超精細銦鍵合
)至關重要,混合集成是將來自不同技術的芯片組合成高性能模塊的過程,例如激光雷達和其他成像應用中的混合像素探測器。曾經用于倒裝芯片接合的錫焊料正在被包括銦在內的無鉛替代品所取代。然而,使用傳統方法制備對于形成鍵合必不可少的銦
2022-11-11 17:11:01 1282
1282
 1282
1282半導體封裝:鍵合銅絲的性能優勢與主要應用問題
為解決銅絲硬度大帶來的鍵合難度,半導體封裝企業通常選擇應用超聲工藝或鍵合壓力工藝提升鍵合效果,這也導致焊接期間需要耗費更多的時間完成鍵合工作。
2022-12-15 15:44:46 3597
3597
 3597
3597陶瓷基板上自動鍵合各參數對鍵合形貌的影響研究
通過控制單一變量的試驗方法,研究了金絲變形度、超聲功率、超聲時間和鍵合壓力等參數對自動鍵合一致性和可靠性的影響,分析了每個參數對自動鍵合的影響規律,給出了自動鍵合參數的參考范圍。
2023-02-01 17:37:31 2136
2136
 2136
2136半導體集成電路銅線鍵合性能有哪些?
,不斷創造新的技術極限。傳統的金線、鋁線鍵合與封裝技術的要求不相匹配。銅線鍵合在成本和材料特性方面有很多優于金、鋁的地方,但是銅線鍵合技術還面臨一些挑戰和問題。如果這些問題能夠得到很好的解決,銅線鍵合技術
2023-02-07 11:58:35 2159
2159
 2159
2159極小焊盤的金絲鍵合方案
金絲鍵合質量的好壞受劈刀、鍵合參數、鍵合層鍍金質量和金絲質量等因素的制約。傳統熱壓鍵合、超聲鍵合、熱超聲鍵合或楔形鍵合和球形鍵合分別在不同情況下可以得到最佳鍵合效果。工藝人員針對不同焊盤尺寸所制定
2023-02-07 15:00:25 5396
5396
 5396
5396銅混合鍵合的發展與應用
兩片晶圓面對面鍵合時是銅金屬對銅金屬、介電值對介電質,兩邊鍵合介面的形狀、位置完全相同,晶粒大小形狀也必須一樣。所以使用混合鍵合先進封裝技術的次系統產品各成分元件必須從產品設計、線路設計時就開始共同協作。
2023-05-08 09:50:30 1455
1455
 1455
1455?晶圓直接鍵合及室溫鍵合技術研究進展
晶圓直接鍵合技術可以使經過拋光的半導體晶圓,在不使用粘結劑的情況下結合在一起,該技術在微電子制造、微機電系統封裝、多功能芯片集成以及其他新興領域具有廣泛的應用。對于一些溫度敏感器件或者熱膨脹系數差異
2023-06-14 09:46:27 1951
1951
 1951
1951
先進封裝中銅-銅低溫鍵合技術研究進展
Cu-Cu 低溫鍵合技術是先進封裝的核心技術,相較于目前主流應用的 Sn 基軟釬焊工藝,其互連節距更窄、導 電導熱能力更強、可靠性更優. 文中對應用于先進封裝領域的 Cu-Cu 低溫鍵合技術進行了
2023-06-20 10:58:48 2941
2941
 2941
2941
半導體器件鍵合失效模式及機理分析
本文通過對典型案例的介紹,分析了鍵合工藝不當,以及器件封裝因素對器件鍵合失效造成的影響。通過對鍵合工藝參數以及封裝環境因素影響的分析,以及對各種失效模式總結,闡述了鍵合工藝不當及封裝不良,造成鍵合本質失效的機理;并提出了控制有缺陷器件裝機使用的措施。
2023-07-26 11:23:15 2102
2102
 2102
2102引線鍵合是什么?引線鍵合的具體方法
的傳輸路徑)的方法被稱為引線鍵合(Wire Bonding)。其實,使用金屬引線連接電路的方法已是非常傳統的方法了,現在已經越來越少用了。近來,加裝芯片鍵合(Flip Chip Bonding)和硅穿孔
2023-08-09 09:49:47 4845
4845
 4845
4845
表面清潔工藝對硅片與晶圓鍵合的影響
隨著產業和消費升級,電子設備不斷向小型化、智能化方向發展,對電子設備提出了更高的要求。可靠的封裝技術可以有效提高器件的使用壽命。陽極鍵合技術是晶圓封裝的有效手段,已廣泛應用于電子器件行業。其優點是鍵合時間短、鍵合成本低。溫度更高,鍵合效率更高,鍵合連接更可靠。
2023-09-13 10:37:36 684
684
 684
684
3D Cu-Cu混合鍵合技術的優點和未來發展
先進半導體封裝的凸塊技術已取得顯著發展,以應對縮小接觸間距和傳統倒裝芯片焊接相關限制帶來的挑戰。該領域的一項突出進步是 3D Cu-Cu 混合鍵合技術,它提供了一種變革性的解決方案。
2023-09-21 15:42:29 1534
1534
 1534
1534什么是引線鍵合?引線鍵合的演變
引線鍵合是在硅芯片上的 IC 與其封裝之間創建互連的常用方法,其中將細線從器件上的鍵合焊盤連接到封裝上的相應焊盤(即引線)。此連接建立了從芯片內部電路到連接到印刷電路板 (PCB) 的外部引腳的電氣路徑。
2023-10-24 11:32:13 2493
2493
 2493
2493
晶圓鍵合的種類和應用
晶圓鍵合技術是將兩片不同結構/不同材質的晶圓,通過一定的物理方式結合的技術。晶圓鍵合技術已經大量應用于半導體器件封裝、材料及器件堆疊等多種半導體應用領域。
2023-10-24 12:43:24 1685
1685
 1685
1685
什么是混合鍵合?為什么要使用混合鍵合?
要了解混合鍵合,需要了解先進封裝行業的簡要歷史。當電子封裝行業發展到三維封裝時,微凸塊通過使用芯片上的小銅凸塊作為晶圓級封裝的一種形式,在芯片之間提供垂直互連。凸塊的尺寸范圍很廣,從 40 μm 間距到最終縮小到 20 μm 或 10 μm 間距。
2023-11-22 16:57:42 5272
5272
 5272
5272
IGBT模塊銀燒結工藝引線鍵合工藝研究
方法,分別驗證并優化了銀燒結和銅引線鍵合的工藝參數,分析了襯板鍍層對燒結層和銅線鍵合界面強度的影響,最后對試制的模塊進行浪涌能力和功率循環壽命測試。結果顯示?,?與普通模塊相比?,?搭載銀燒結和銅線鍵合技術的模塊浪涌能力和功率
2023-12-20 08:41:09 2114
2114
 2114
2114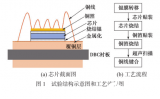
晶圓鍵合設備及工藝
隨著半導體產業的飛速發展,晶圓鍵合設備及工藝在微電子制造領域扮演著越來越重要的角色。晶圓鍵合技術是一種將兩個或多個晶圓通過特定的工藝方法緊密地結合在一起的技術,以實現更高性能、更小型化的電子元器件。本文將詳細介紹晶圓鍵合設備的結構、工作原理以及晶圓鍵合工藝的流程、特點和應用。
2023-12-27 10:56:38 1756
1756
 1756
1756
鋁質焊盤的鍵合工藝
共讀好書 姚友誼 吳琪 陽微 胡蓉 姚遠建 (成都西科微波通訊有限公司) 摘要: 從鋁質焊盤鍵合后易發生欠鍵合和過鍵合的故障現象著手,就鋁焊盤上幾種常見鍵合方式進行了探討,得出鍵合的優先級為硅鋁絲
2024-02-02 16:51:48 1089
1089
 1089
1089
金絲引線鍵合的影響因素探究
共讀好書 劉鳳華 中電科思儀科技股份有限公司 摘要: 鍵合對設備性能和人員技能的要求極高,屬于關鍵控制工序,鍵合質量的好壞直接影響電路的可靠性。工藝人員需對鍵合的影響因素進行整體把控,有針對性地控制
2024-02-02 17:07:18 944
944
 944
944
鍵合銅絲的研究及應用現狀
共讀好書 周巖 劉勁松 王松偉 彭庶瑤 彭曉飛 (沈陽理工大學 中國科學院金屬研究所師昌緒先進材料創新中心江西藍微電子科技有限公司) 摘要: 目前,鍵合銅絲因其價格低廉、具有優良的材料性能等特點
2024-02-22 10:41:43 1417
1417
 1417
1417
人工智能推動混合鍵合技術
領域的領導企業Adeia戰略副總裁Seung Kang博士表示,對計算能力的需求正在加速增長,需求將超過當前支撐當今高性能基礎設施、平臺和設備的芯片組技術的能力。 全球數字經濟的各個垂直領域幾乎都對人工智能的興趣日益濃厚,預計將推動整個半導體行業對混合鍵合技術的需求激增。 Ga
2024-02-01 14:42:50 391
391
 391
391消息稱三星正在整合混合鍵合技術
據業界消息人士透露,為了進一步提升其芯片代工能力,三星正全力推進混合鍵合技術的整合工作。據悉,應用材料公司和Besi Semiconductor已在三星的天安園區開始安裝先進的混合鍵合設備,這些設備預計將用于三星的下一代封裝解決方案,如X-Cube和SAINT。
2024-02-18 11:13:23 832
832
 832
832混合鍵合技術大揭秘:優點、應用與發展一網打盡
混合鍵合技術是近年來在微電子封裝和先進制造領域引起廣泛關注的一種新型連接技術。它通過結合不同鍵合方法的優點,實現了更高的封裝密度、更強的機械性能和更好的熱穩定性,為現代電子產品的微型化、高性能化提供了有力支持。
2024-02-18 10:06:19 3209
3209
 3209
3209
晶圓到晶圓混合鍵合:將互連間距突破400納米
來源:IMEC Cu/SiCN鍵合技術的創新是由邏輯存儲器堆疊需求驅動的 晶圓到晶圓混合鍵合的前景 3D集成是實現多芯片異構集成解決方案的關鍵技術,是業界對系統級更高功耗、性能、面積和成本收益需求
2024-02-21 11:35:29 703
703
 703
703
先進封裝中銅-銅低溫鍵合技術研究進展
用于先進封裝領域的 Cu-Cu 低溫鍵合技術進行了綜述,首先從工藝流程、連接機理、性能表征等方面較系統地總結了熱壓工藝、混合鍵合工藝實現 Cu-Cu 低溫鍵合的研究進展與存在問題,進一步地闡述了新型納米材料燒結工藝在實現低溫連接、降低工藝要求方面的優
2024-03-25 08:39:56 976
976
 976
976
引線鍵合技術:微電子封裝的隱形力量,你了解多少?
引線鍵合是微電子封裝領域中的一項關鍵技術,它負責實現芯片與封裝基板或其他芯片之間的電氣連接。隨著集成電路技術的不斷進步,引線鍵合技術也在不斷發展,以適應更高性能、更小尺寸和更低成本的需求。本文將詳細介紹引線鍵合技術的發展歷程、現狀以及未來趨勢。
2024-04-28 10:14:33 1404
1404
 1404
1404
半導體芯片鍵合裝備綜述
發展空間較大。對半導體芯片鍵合裝備進行了綜述,具體包括主要組成機構和工作原理、關鍵技術、發展現狀。半導體芯片鍵合裝備的主要組成機構包括晶圓工作臺、芯片鍵合頭、框架輸送系統、機器視覺系統、點膠系統。半導體芯片鍵合裝備的關鍵技
2024-06-27 18:31:14 1670
1670
 1670
1670
混合鍵合能走多遠?
推動了這項技術的發展,這項技術對尖端處理器和存儲器至關重要。這項技術被稱為混合鍵合,它將兩個或多個芯片堆疊在同一封裝中,使芯片制造商能夠增加處理器和存儲器中的晶體管數量,盡管曾經定義摩爾定律的傳統晶體管
2024-06-18 16:57:51 1690
1690
 1690
1690三星與海力士引領DRAM革新:新一代HBM采用混合鍵合技術
內存(HBM)中采用先進的混合鍵合(Hybrid Bonding)技術,這一創新舉措無疑將推動DRAM技術邁向新的高度。
2024-06-25 10:01:36 849
849
 849
849金絲鍵合強度測試儀試驗方法:鍵合拉脫、引線拉力、鍵合剪切力
金絲鍵合強度測試儀是測量引線鍵合強度,評估鍵合強度分布或測定鍵合強度是否符合有關的訂購文件的要求。鍵合強度試驗機可應用于采用低溫焊、熱壓焊、超聲焊或有關技術鍵合的、具有內引線的器件封裝內部的引線
2024-07-06 11:18:59 808
808
 808
808
鍵合點剪切力試驗步驟和檢查內容
最近比較多客戶咨詢鍵合剪切力試驗儀器以及如何測試剪切力?抽空整理了一份鍵合點剪切力試驗步驟和已剪切的鍵合點如何檢查。鍵合點剪切試驗:在開始進行試驗前,鍵合剪切設備應通過所有的自診斷測試。鍵合剪切設備
2024-07-12 15:11:04 764
764
 764
764
SK海力士將在HBM生產中采用混合鍵合技術
在半導體技術日新月異的今天,SK海力士再次站在了行業創新的前沿。據最新消息,該公司計劃于2026年在其高性能內存(High Bandwidth Memory, HBM)的生產過程中引入混合鍵合技術,這一舉措不僅標志著SK海力士在封裝技術上的重大突破,也預示著全球半導體行業將迎來新一輪的技術革新。
2024-07-17 09:58:19 871
871
 871
871SK海力士加速NAND研發,400+層閃存量產在即
韓國半導體巨頭SK海力士正加速推進NAND閃存技術的革新,據韓媒最新報道,該公司計劃于2025年末全面完成400+層堆疊NAND閃存的量產準備工作,并預計于次年第二季度正式開啟大規模生產。這一舉措標志著SK海力士在NAND閃存領域再次邁出堅實步伐,引領行業技術前沿。
2024-08-02 16:56:11 1200
1200
 1200
1200金絲鍵合工藝溫度研究:揭秘鍵合質量的奧秘!
在微電子封裝領域,金絲鍵合(Wire Bonding)工藝作為一種關鍵的電氣互連技術,扮演著至關重要的角色。該工藝通過細金屬線(主要是金絲)將芯片上的焊點與封裝基板或另一芯片上的對應焊點連接起來
2024-08-16 10:50:14 2170
2170
 2170
2170
混合鍵合技術:開啟3D芯片封裝新篇章
在半導體制造領域,技術的每一次革新都標志著行業邁向新的里程碑。近年來,隨著芯片性能需求的不斷提升,傳統的二維封裝技術已難以滿足日益增長的數據處理速度和功耗控制要求。在此背景下,混合鍵合(Hybrid
2024-08-26 10:41:54 1177
1177
 1177
1177
金剛石/GaN 異質外延與鍵合技術研究進展
,主要包括GaN 功率器件的器件層散熱和襯底層散熱。器件層散熱主要有金剛石鈍化散熱技術,其在GaN 器件層中異質外延金剛石散熱層;襯底層散熱主要有鍵合技術、異質外延技術,其中鍵合技術通常需要在金剛石
2024-11-01 11:08:07 585
585
 585
585電子封裝 | Die Bonding 芯片鍵合的主要方法和工藝
DieBound芯片鍵合,是在封裝基板上安裝芯片的工藝方法。本文詳細介紹一下幾種主要的芯片鍵合的方法和工藝。什么是芯片鍵合在半導體工藝中,“鍵合”是指將晶圓芯片連接到基板上。連接可分為兩種類型,即
2024-09-20 08:04:29 1129
1129
 1129
1129
混合鍵合,成為“芯”寵
要求,傳統互聯技術如引線鍵合、倒裝芯片鍵合和硅通孔(TSV)鍵合等,正逐步顯露其局限。在這種背景下,混合鍵合技術以其革命性的互聯潛力,正成為行業的新寵。
2024-10-18 17:54:54 661
661
 661
661
晶圓鍵合技術的類型有哪些
晶圓鍵合技術是一種先進的半導體制造工藝,它通過將兩塊或多塊晶圓在一定的工藝條件下緊密結合,形成一個整體結構。這種技術廣泛應用于微電子、光電子、MEMS(微機電系統)等領域,是實現高效封裝和集成的重要步驟。晶圓鍵合技術不僅能夠提高器件的性能和可靠性,還能滿足市場對半導體器件集成度日益提高的需求。
2024-10-21 16:51:40 808
808
 808
808混合鍵合的基本原理和優勢
混合鍵合(Hybrid Bonding)是半導體封裝領域的新興技術,能夠實現高密度三維集成,無需傳統的焊料凸點。本文探討混合鍵合的基本原理、相比傳統方法的優勢,以及該領域的最新發展。
2024-10-30 09:54:51 1275
1275
 1275
1275
先進封裝技術激戰正酣:混合鍵合成新星,重塑芯片領域格局
隨著摩爾定律的放緩與面臨微縮物理極限,半導體巨擘越來越依賴先進封裝技術推動性能的提升。隨著封裝技術從2D向2.5D、3D推進,芯片堆迭的連接技術也成為各家公司差異化與競爭力的展現。而“混合鍵合
2024-11-08 11:00:54 789
789
 789
789三維堆疊封裝新突破:混合鍵合技術揭秘!
隨著半導體技術的飛速發展,芯片的性能需求不斷提升,傳統的二維封裝技術已難以滿足日益增長的數據處理速度和功耗控制要求。在此背景下,混合鍵合(Hybrid Bonding)技術應運而生,并迅速成為三維
2024-11-13 13:01:32 1343
1343
 1343
1343
晶圓鍵合膠的鍵合與解鍵合方式
晶圓鍵合是十分重要的一步工藝,本文對其詳細介紹。???????????????????????????? ? 什么是晶圓鍵合膠? 晶圓鍵合膠(wafer bonding adhesive)是一種用于
2024-11-14 17:04:44 985
985
 985
985
混合鍵合:開創半導體互聯技術新紀元
功能?在眾多關鍵技術中,晶圓鍵合技術雖然不像光刻技術那樣廣為人知,但它卻默默地在我們的手機圖像傳感器、重力加速傳感器、麥克風、4G和5G射頻前端,以及部分NAND閃存中發揮著重要作用。那么,這一技術中的新興領域——混合
2024-11-18 10:08:05 556
556
 556
556微流控多層鍵合技術
一、超聲鍵合輔助的多層鍵合技術 基于微導能陣列的超聲鍵合多層鍵合技術: 在超聲鍵合微流控芯片多層鍵合研究中,有基于微導能陣列的聚碳酸酯微流控芯片超聲鍵合技術。研究對比了大量鍵合方法,認為超聲鍵合方式
2024-11-19 13:58:00 275
275
 275
275
芯片倒裝與線鍵合相比有哪些優勢
線鍵合與倒裝芯片作為封裝技術中兩大重要的連接技術,各自承載著不同的使命與優勢。那么,芯片倒裝(Flip Chip)相對于傳統線鍵合(Wire Bonding)究竟有哪些優勢呢?倒裝芯片在封裝技術演進
2024-11-21 10:05:15 909
909
 909
909
從發展歷史、研究進展和前景預測三個方面對混合鍵合(HB)技術進行分析
摘要: 隨著半導體技術的發展,傳統倒裝焊( FC) 鍵合已難以滿足高密度、高可靠性的三維( 3D) 互連技術的需求。混合鍵合( HB) 技術是一種先進的3D 堆疊封裝技術,可以實現焊盤直徑≤1 μm
2024-11-22 11:14:46 1767
1767
 1767
1767
有什么方法可以去除晶圓鍵合邊緣缺陷?
去除晶圓鍵合邊緣缺陷的方法主要包括以下幾種:
一、化學氣相淀積與平坦化工藝
方法概述:
提供待鍵合的晶圓。
利用化學氣相淀積的方法,在晶圓的鍵合面淀積一層沉積量大于一定閾值(如1.6TTV
2024-12-04 11:30:18 374
374
 374
374
帶你一文了解什么是引線鍵合(WireBonding)技術?
微電子封裝中的引線鍵合技術引線鍵合技術在微電子封裝領域扮演著至關重要的角色,它通過金屬線將半導體芯片與外部電路相連,實現電氣互連和信息傳遞。在理想條件下,金屬引線與基板之間的連接可以達到原子級別的鍵
2024-12-24 11:32:04 857
857
 857
857
微流控芯片鍵合技術
微流控芯片鍵合技術的重要性 微流控芯片的鍵合技術是實現其功能的關鍵步驟之一,特別是在密封技術方面。鍵合技術的選擇直接影響到微流控芯片的整體性能和可靠性。 不同材料的鍵合方式 玻璃材料:通常通過熱鍵合
2024-12-30 13:56:31 192
192
 192
192引線鍵合的基礎知識
引線鍵合 引線鍵合,又稱壓焊,是半導體封裝工藝中的關鍵環節,對封裝的可靠性和最終產品的測試良率具有決定性影響。 以下是對引線鍵合的分述: 引線鍵合概述 引線鍵合設備 引線鍵合方法 1 引線鍵合概述
2025-01-02 10:18:01 407
407
 407
407
什么是引線鍵合(WireBonding)
線鍵合(WireBonding)線鍵合是一種使用細金屬線,利用熱、壓力、超聲波能量為使金屬引線與基板焊盤緊密焊合,實現芯片與基板間的電氣互連和芯片間的信息互通。在理想控制條件下,引線和基板間會發
2025-01-06 12:24:10 356
356
 356
356
混合鍵合中的銅連接:或成摩爾定律救星
混合鍵合3D芯片技術將拯救摩爾定律。 為了繼續縮小電路尺寸,芯片制造商正在爭奪每一納米的空間。但在未來5年里,一項涉及幾百乃至幾千納米的更大尺度的技術可能同樣重要。 這項技術被稱為“混合鍵合”,可以
2025-02-09 09:21:43 195
195
 195
195
 電子發燒友App
電子發燒友App
























評論