摘要
隨著工業(yè)智能制造和電子信息技術(shù)的快速發(fā)展,集成電路的重要性日益凸顯。光刻技術(shù)作為集成電路產(chǎn)業(yè)的核心技術(shù),已成為國(guó)內(nèi)外科研人員研究的重點(diǎn)方向。本文對(duì)光刻技術(shù)進(jìn)行了簡(jiǎn)單介紹,并對(duì)未來的發(fā)展方向進(jìn)行了展望。首先,分析了光刻系統(tǒng)的關(guān)鍵指標(biāo)——分辨率及其與光刻性能的關(guān)系。其次,討論了目前業(yè)界常用的幾種基于紫外和深紫外光源的曝光方法。隨后,介紹了一些具有代表性的光刻設(shè)備的結(jié)構(gòu)和性能。然后,對(duì)EUV光刻和高NA光刻的最新進(jìn)展進(jìn)行了總結(jié)。最后,分析了當(dāng)前光刻技術(shù)的局限性,并對(duì)光刻技術(shù)的未來進(jìn)行了展望。本文旨在為大家提供光刻設(shè)備,特別是目前最先進(jìn)的產(chǎn)品的使用指南。此外,本文還重點(diǎn)介紹了光刻技術(shù)在未來發(fā)展中可能面臨的一些挑戰(zhàn),并對(duì)未來十年光刻技術(shù)的發(fā)展趨勢(shì)進(jìn)行了展望,為指導(dǎo)光刻機(jī)未來的發(fā)展方向以及如何進(jìn)一步推動(dòng)摩爾定律提供了參考。
1. 引言
1965年,摩爾假設(shè)單位面積內(nèi)可容納的晶體管數(shù)量大約每?jī)赡攴环琜1],這成為半導(dǎo)體產(chǎn)業(yè)發(fā)展的重要規(guī)律,即摩爾定律。隨著時(shí)間的推移,整個(gè)半導(dǎo)體產(chǎn)業(yè)仍然在摩爾定律的指導(dǎo)下發(fā)展。光刻技術(shù)是半導(dǎo)體產(chǎn)業(yè)的核心技術(shù),決定了摩爾定律是否繼續(xù)有效。在光刻機(jī)的發(fā)展中,在曝光方式上,光刻機(jī)從接觸式曝光機(jī)開始,經(jīng)過接近式曝光機(jī)、投影式光刻機(jī)、步進(jìn)式光刻機(jī)、步進(jìn)掃描式光刻機(jī)、浸沒式光刻機(jī),到現(xiàn)在的極紫外(EUV)光刻機(jī)。在曝光光源上,研究人員不斷探索如何在光刻機(jī)上應(yīng)用更短波長(zhǎng)的光,以制造更小的片上電路。首先,20世紀(jì)80年代,汞燈發(fā)出的波長(zhǎng)為436納米(nm)的藍(lán)光被用作光刻機(jī)的光源,可以實(shí)現(xiàn)1微米的臨界尺寸。隨后,光源波長(zhǎng)達(dá)到 365 nm,被稱為汞 i 線,將特征尺寸推向 220 nm。20 世紀(jì) 80 年代中期,激光開始使用,光刻技術(shù)進(jìn)入深紫外(DUV)時(shí)期。深紫外光刻(DUVL)開始在半導(dǎo)體工業(yè)中發(fā)揮越來越重要的作用。
波長(zhǎng)為 193 nm 的 ArF 準(zhǔn)分子激光器和波長(zhǎng)為 248 nm 的 KrF 準(zhǔn)分子激光器在工業(yè)上廣泛用作曝光光源 [2]。F2 準(zhǔn)分子激光器可以提供波長(zhǎng)為 157 nm 的光,但到 2003 年,由于光刻膠和掩模材料的限制,157 nm 被認(rèn)為是繼 193 nm 之后光學(xué)光刻不切實(shí)際的下一步 [3]。后來,通過引入折射率 >1 的浸沒液,193 nm 浸沒式光刻取代了 157 nm 光刻浸沒式光刻技術(shù)帶來了數(shù)值孔徑(NA)大于1的投影光學(xué)系統(tǒng)。先進(jìn)半導(dǎo)體材料光刻技術(shù)公司(ASML)生產(chǎn)的NXT:2050i是目前最先進(jìn)的采用浸沒式光刻技術(shù)的DUV光刻機(jī),NA為1.35,分辨率可達(dá)38納米。
雖然DUVL機(jī)器可以通過多重曝光技術(shù)將線寬縮小到7-5納米,但如果要獲得更小的線寬,DUVL已經(jīng)達(dá)到了極限。采用EUV作為光源的極紫外光刻(EUVL)成為研究的重點(diǎn),其波長(zhǎng)為13.5納米。ASML的EUVL機(jī)器NXE:3600D可以達(dá)到13納米的分辨率,具有5-3納米邏輯節(jié)點(diǎn)的制造能力。作為下一代光刻技術(shù),ASML和卡爾蔡司正在開發(fā)NA=0.55的高NA EUV曝光系統(tǒng)[5]。
本文概述了光刻機(jī)并介紹了面臨的挑戰(zhàn)。本文的其余部分安排如下。第二部分將簡(jiǎn)要介紹光刻機(jī)的基本原理,如瑞利準(zhǔn)則以及參數(shù)與光刻機(jī)性能之間的一些關(guān)系。第三部分將介紹不同類型的光刻機(jī)。第四部分將展示先進(jìn)的EUV光刻機(jī)和高NA EUV光刻機(jī),重點(diǎn)關(guān)注光源和光學(xué)元件。第五部分將分析光刻機(jī)研究的局限性或技術(shù)問題并給出未來的展望。
2. 原理?
2.1 分辨率
自1958年集成電路發(fā)明以來,集成電路的集成密度不斷提高,特征尺寸也不斷減小。到現(xiàn)在,集成電路圖形的線寬已減小了約5個(gè)數(shù)量級(jí),28nm~45nm線寬的加工技術(shù)已經(jīng)非常普遍。與此同時(shí),集成密度提高了7個(gè)數(shù)量級(jí)以上,一個(gè)集成電路芯片上可以包含數(shù)千萬甚至數(shù)億個(gè)器件。這些成就很大程度上得益于光刻技術(shù)的進(jìn)步。線寬小于1μm的光刻技術(shù)在技術(shù)上已經(jīng)非常復(fù)雜,在此基礎(chǔ)上進(jìn)一步減小光刻圖形尺寸將帶來許多技術(shù)甚至理論上的挑戰(zhàn)。目前,首要要解決的問題是如何進(jìn)一步提高光刻的分辨率。

分辨率描述的是成像系統(tǒng)解析成像物體細(xì)節(jié)的能力 [6]。光刻系統(tǒng)能夠區(qū)分和處理的線條的最小尺寸或機(jī)器能夠充分打印的區(qū)域稱為微圖像處理的最小分辨率。分辨率是光刻系統(tǒng)最重要的指標(biāo)之一,分辨率越高,光刻機(jī)能實(shí)現(xiàn)的最小線寬就越小。瑞利公式如下

其中 lm 是臨界尺寸,即最小可能特征尺寸。λ 是所用光的波長(zhǎng)。k1 是一個(gè)系數(shù),它取決于與芯片制造工藝相關(guān)的許多其他因素。k1 通常等于 0.75,而光刻的物理極限為 k1 = 0.25
[7]。NA 是光學(xué)元件的數(shù)值孔徑,一般在 0.16 到 0.9 之間。NA 決定了它們可以收集多少光如下公式

n為折射率?θ為光錐在晶圓上匯聚成點(diǎn)像的半角,D為透鏡直徑,f為焦距[8],如圖1[9]所示。根據(jù)公式(1),可以通過降低波長(zhǎng)λ(光刻加工的極限為λ/2,即半波長(zhǎng)分辨率)、增加NA、優(yōu)化系統(tǒng)設(shè)計(jì)(分辨率增強(qiáng)技術(shù))和降低k1來提高分辨率。
2.2 紫外線曝光
紫外線 (UV) 和深紫外線 (DUV) 光源目前在工業(yè)中被廣泛用作曝光光源。使用 UV 和 DUV 光源的最常見曝光方法是接觸印刷、接近印刷和投影印刷,如圖 2 所示 [10]。

2.2.1 接觸印刷
如圖 2a [10] 所示,在該技術(shù)中,涂有光刻膠的硅晶片與掩模板物理接觸。晶片由真空系統(tǒng)固定。當(dāng)晶片與掩模板接觸時(shí),系統(tǒng)會(huì)從掩模板頂部暴露在紫外線下,曝光過程發(fā)生在光刻膠層中。接觸印刷可以實(shí)現(xiàn)高分辨率,并且優(yōu)于鄰近印刷,因?yàn)楣饪棠z和掩模板直接接觸 [11]。它是集成電路研究和生產(chǎn)中使用的第一種曝光方法,但由于灰塵會(huì)滯留在光刻膠之間,因此現(xiàn)在已經(jīng)過時(shí)。此外,掩模板會(huì)損壞掩模板并導(dǎo)致圖案缺陷,從而降低產(chǎn)量。此外,由于掩模板與光刻膠直接接觸,因此它不能重復(fù)使用 [11]。
2.2.2 鄰近印刷
鄰近印刷類似于接觸印刷。圖 3 給出了鄰近印刷系統(tǒng)的示意圖 [11]。它由光源及光學(xué)聚焦系統(tǒng)、掩模版、硅片、對(duì)準(zhǔn)臺(tái)四大部分組成。光學(xué)聚焦系統(tǒng)將汞燈發(fā)出的紫外光轉(zhuǎn)換成平行光,平行光穿過掩模版在光刻膠上成像。由于掩模版與硅片之間存在很小的間隙s(通常s=5μm),所以這種方法被稱為接近式打印。理論上光刻的分辨率為1/λ,但在接近式打印系統(tǒng)中,掩模版與硅片之間的間隙s很小,因此會(huì)因?yàn)檠苌涞脑驅(qū)Ψ直媛视兴拗疲F(xiàn)實(shí)中只能在3μm以上的工藝中使用接近式打印。
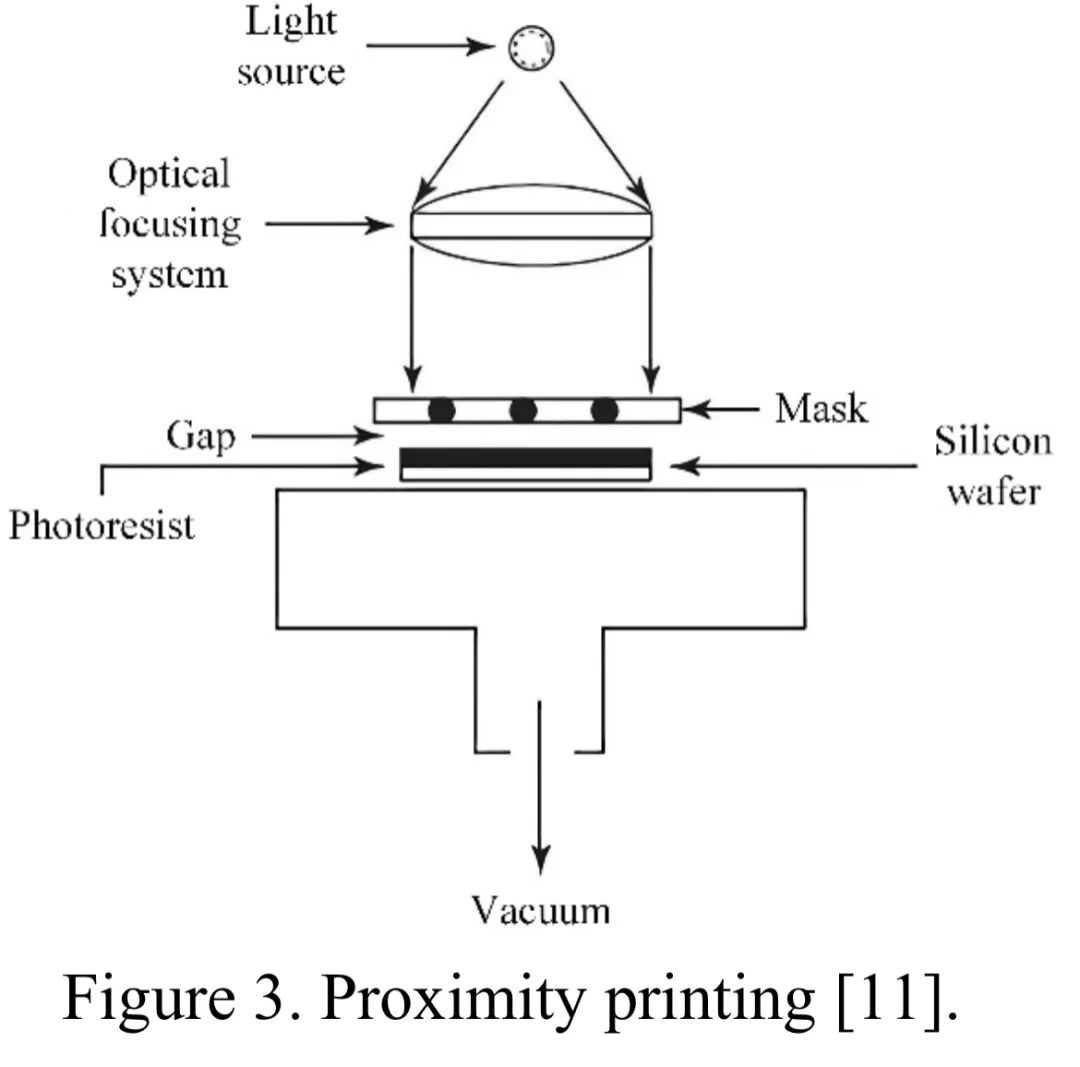
2.2.3 投影打印
圖4為投影打印系統(tǒng)示意圖[11]。光學(xué)聚焦系統(tǒng)將光源發(fā)出的光轉(zhuǎn)換為平行光,然后穿過掩模版,由第二光學(xué)聚焦系統(tǒng)投射到晶圓上。晶圓支架和掩模版之間有一個(gè)對(duì)準(zhǔn)系統(tǒng)。實(shí)際上,為了在投影打印中實(shí)現(xiàn)高分辨率,只有一小部分掩模被成像。這個(gè)小區(qū)域的圖像場(chǎng)在晶圓表面上掃描。以幾納米的分辨率將掩模圖像步進(jìn)到晶圓表面上的投影打印機(jī)稱為步進(jìn)重復(fù)系統(tǒng)[11]。投影打印系統(tǒng)的分辨率主要受衍射限制,一般來說,投影打印可以達(dá)到亞微米級(jí)。
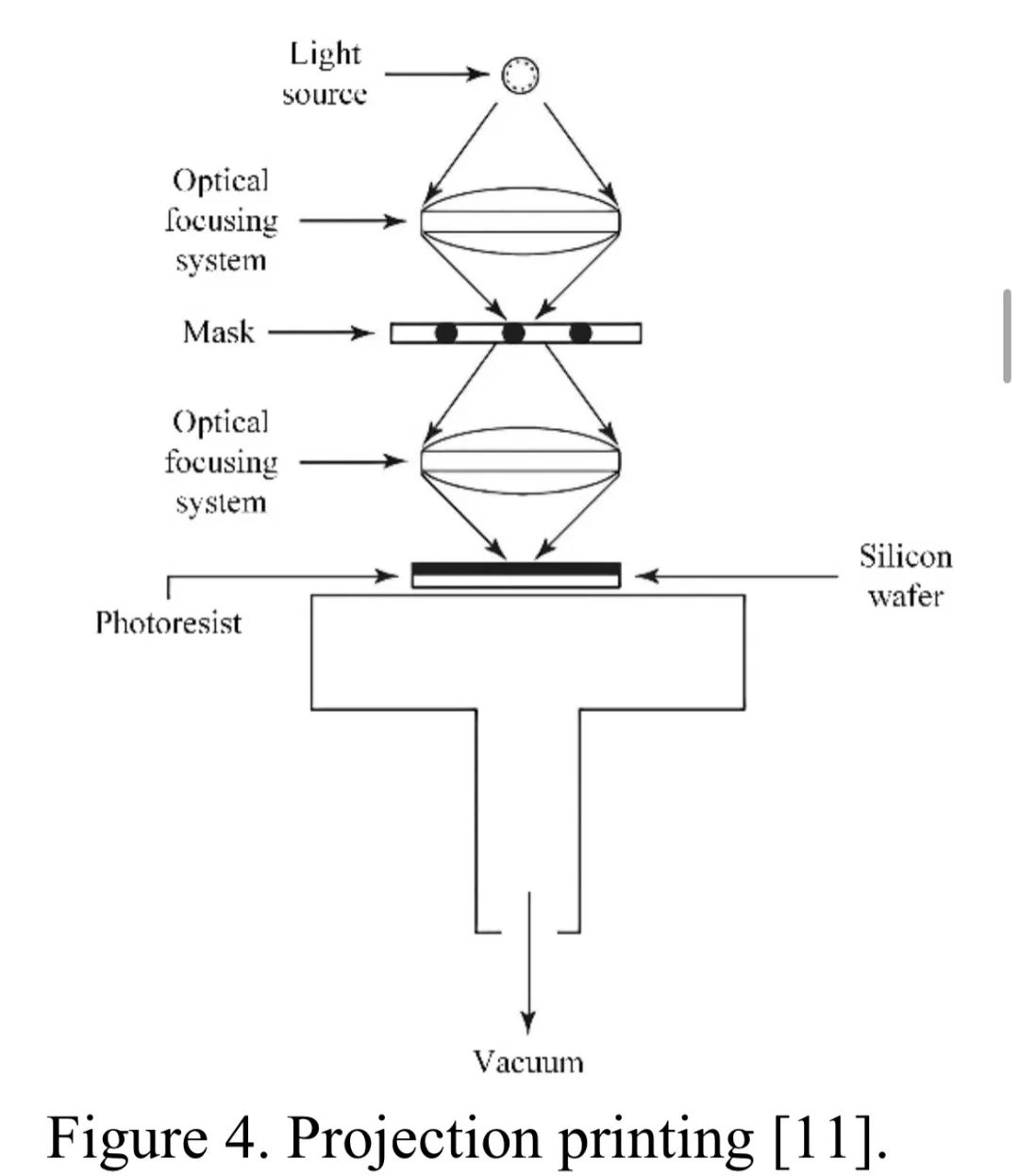
投影印刷有兩個(gè)最顯著的優(yōu)點(diǎn),一是硅片不與掩膜接觸,避免了因接觸而磨損造成的工藝缺陷,二是掩膜不易破損,可以仔細(xì)修正以消除缺陷,提高掩膜的利用率,由于這些優(yōu)點(diǎn),投影印刷已成為小于3μm光刻工藝最重要的方法之一。
3. 光刻設(shè)備
自平面光刻工藝發(fā)明以來,光刻設(shè)備已經(jīng)歷了五代,每代設(shè)備都能夠達(dá)到一定的臨界尺寸(CD)和分辨率。五個(gè)光刻時(shí)代的代表分別是接觸式光刻機(jī)、接近式光刻機(jī)、掃描投影式光刻機(jī)、步進(jìn)重復(fù)式光刻機(jī)和步進(jìn)掃描系統(tǒng)。
3.1 接觸式光刻機(jī)
從SSI時(shí)代到20世紀(jì)70年代,接觸式光刻機(jī)是光刻的主要方法。它用于線寬5μm及以上的制造工藝。雖然也可以實(shí)現(xiàn)0.4μm的線寬,但目前接觸式光刻機(jī)已不再?gòu)V泛使用。圖5是接觸式光刻機(jī)系統(tǒng)示意圖[12]。接觸式光刻機(jī)的掩模版包含所有將被復(fù)制到硅片表面的陣列圖案。硅片上涂有光刻膠,并被裝載到可以手動(dòng)控制的平臺(tái)上。通過分光顯微鏡同時(shí)觀察掩模版和硅片,然后操作員手動(dòng)定位平臺(tái),使掩模版上的圖案與硅片上的圖案對(duì)齊。一旦掩模版和硅片對(duì)準(zhǔn),掩模版就會(huì)直接接觸硅片表面的光刻膠涂層,這就是該設(shè)備被稱為接觸對(duì)準(zhǔn)器的原因。然后將掩模版和硅片暴露在紫外線 (UV) 下。紫外線穿過掩模版的透明部分,然后將掩模版上的圖案轉(zhuǎn)移到光刻膠上。

3.2 接近式對(duì)準(zhǔn)器
接近式對(duì)準(zhǔn)器由接觸式對(duì)準(zhǔn)器發(fā)展而來,在 20 世紀(jì) 70 年代的 SSI 和 MSI 早期都得到了廣泛應(yīng)用。然而,這些對(duì)準(zhǔn)器仍在一些小批量生產(chǎn)的實(shí)驗(yàn)室或生產(chǎn)分立器件的舊晶圓生產(chǎn)線中使用,因?yàn)橥顿Y用新設(shè)備替換舊設(shè)備并不劃算。在實(shí)際制造中,這種類型的設(shè)備適用于線寬為 2 至 4 μm 的工藝。

3.3 掃描投影曝光機(jī)
20 世紀(jì) 70 年代初,掃描投影曝光機(jī)(又稱掃描儀)的開發(fā)試圖解決前面提到的接觸式曝光機(jī)和接近式曝光機(jī)的問題。20 世紀(jì) 70 年代末和 80 年代初,掃描投影曝光機(jī)是占主導(dǎo)地位的光刻曝光工具 [13]。這些曝光機(jī)仍然在線寬大于 1 μm 的舊晶圓生產(chǎn)線中使用。掃描投影曝光機(jī)的理念是使用反射系統(tǒng)將掩模版上的整個(gè)圖案以 1:1 的圖像投影到硅片表面上。由于掩模版是 1X 尺寸,因此圖像沒有縮放,掩模版上的圖案與硅片上的圖案大小相同。如圖 6 [14] 所示,紫外光通過狹縫聚焦在硅片上,以獲得更均勻的光線。將掩模版和涂有光刻膠的晶圓放在掃描架上并同步移動(dòng),然后通過窄紫外光束對(duì)晶圓上的光刻膠進(jìn)行曝光。最終,掩模版上的圖像通過掃描運(yùn)動(dòng)被精確地復(fù)制到晶圓表面。
3.4 步進(jìn)重復(fù)曝光機(jī)(步進(jìn)機(jī))
步進(jìn)重復(fù)曝光機(jī)又稱步進(jìn)機(jī),是20世紀(jì)90年代硅片制造的主流光刻設(shè)備。步進(jìn)重復(fù)曝光機(jī)之所以得名,是因?yàn)檫@種設(shè)備每次只能投射一個(gè)曝光場(chǎng)(可能是硅片上的一個(gè)或多個(gè)芯片),然后步進(jìn)到晶圓上的下一個(gè)位置進(jìn)行下一次曝光。20世紀(jì)80年代末,步進(jìn)機(jī)在集成電路制造業(yè)占據(jù)了主導(dǎo)地位[15]。它主要用于形成關(guān)鍵尺寸小至0.35μm(傳統(tǒng)i線光刻膠)和0.25μm(深紫外光刻膠)的圖案[16]。步進(jìn)式光刻機(jī)不使用掩模版,而是使用光罩,因?yàn)楣庹职c一個(gè)或多個(gè)芯片相對(duì)應(yīng)的單個(gè)曝光場(chǎng)中的圖案,而掩模版包含所有芯片陣列。步進(jìn)式光刻機(jī)的光學(xué)投影曝光系統(tǒng)使用折射光學(xué)元件將光罩圖像投射到硅晶片上。圖 7 顯示了步進(jìn)式重復(fù)對(duì)準(zhǔn)器 [12]。

產(chǎn)量是步進(jìn)式光刻機(jī)的主要問題。掃描投影對(duì)準(zhǔn)器每小時(shí)可以生產(chǎn)近 100 片晶圓,而步進(jìn)式光刻機(jī)每小時(shí)通常只能生產(chǎn) 20 到 50 片晶圓。公式 (3) 可用于表示系統(tǒng)的輸出

這里,n 表示每片晶圓上的芯片數(shù)量,E 表示曝光時(shí)間,M 表示每次曝光時(shí)平臺(tái)移動(dòng)的時(shí)間,S 表示平臺(tái)的穩(wěn)定時(shí)間,A 表示逐場(chǎng)對(duì)準(zhǔn)時(shí)間(如果使用),F(xiàn) 表示自動(dòng)對(duì)焦時(shí)間(如果使用),O 表示包括裝載/卸載、預(yù)對(duì)準(zhǔn)、將晶圓移入和移出系統(tǒng)以及執(zhí)行全局對(duì)準(zhǔn)在內(nèi)的時(shí)間。為了減少或消除 O,總時(shí)間中的某些項(xiàng)目可以與上一片晶圓的曝光同時(shí)完成。由于 n 通常在 50 到 100 之間,因此等式 (3) 中括號(hào)內(nèi)的總時(shí)間對(duì)于步進(jìn)式光刻機(jī)的商業(yè)成功至關(guān)重要。作為一種可以實(shí)際使用的工具,它應(yīng)該保持在 2 或更小。
3.5 步進(jìn)掃描系統(tǒng)
為了解決曝光場(chǎng)大小與鏡頭成本之間的矛盾,隨著光刻曝光設(shè)備的發(fā)展,步進(jìn)掃描系統(tǒng)這一新技術(shù)應(yīng)運(yùn)而生。步進(jìn)掃描系統(tǒng)是一種結(jié)合了掃描投影曝光技術(shù)和步進(jìn)重復(fù)曝光技術(shù)的混合設(shè)備,它使用縮小的鏡頭將大曝光場(chǎng)的圖像掃描到硅片的一部分上,光罩和硅片都被一束窄帶聚焦光掃過。步進(jìn)掃描系統(tǒng)的標(biāo)準(zhǔn)曝光場(chǎng)大小為26 mm×33 mm,使用6英寸光罩,如圖8所示[17]。當(dāng)掃描過程和圖案轉(zhuǎn)移過程完成后,硅片將步進(jìn)到下一個(gè)曝光區(qū)域,并重復(fù)掃描過程。
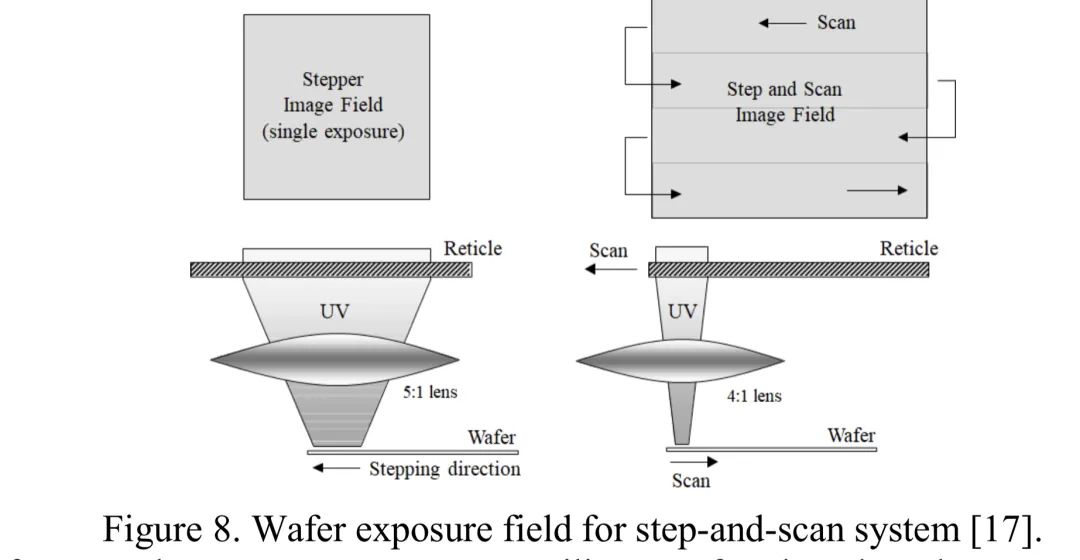
使用步進(jìn)掃描系統(tǒng)曝光硅片具有增加曝光場(chǎng)的優(yōu)勢(shì),從而可以實(shí)現(xiàn)更大的芯片尺寸。鏡頭的視野可以只是一條細(xì)條帶狀,就像全晶圓掃描投影對(duì)準(zhǔn)器一樣。在步進(jìn)到下一個(gè)位置之前,它會(huì)通過一個(gè)小型且經(jīng)過良好校正的 26 mm×33 mm 圖像場(chǎng) [13] 掃描縮小的掩模版(通常為 4 倍),如圖 9 [17] 所示。更寬視野的另一個(gè)顯著優(yōu)勢(shì)是可以在掩模版上放置更多圖案,從而允許在單次曝光中曝光更多芯片。
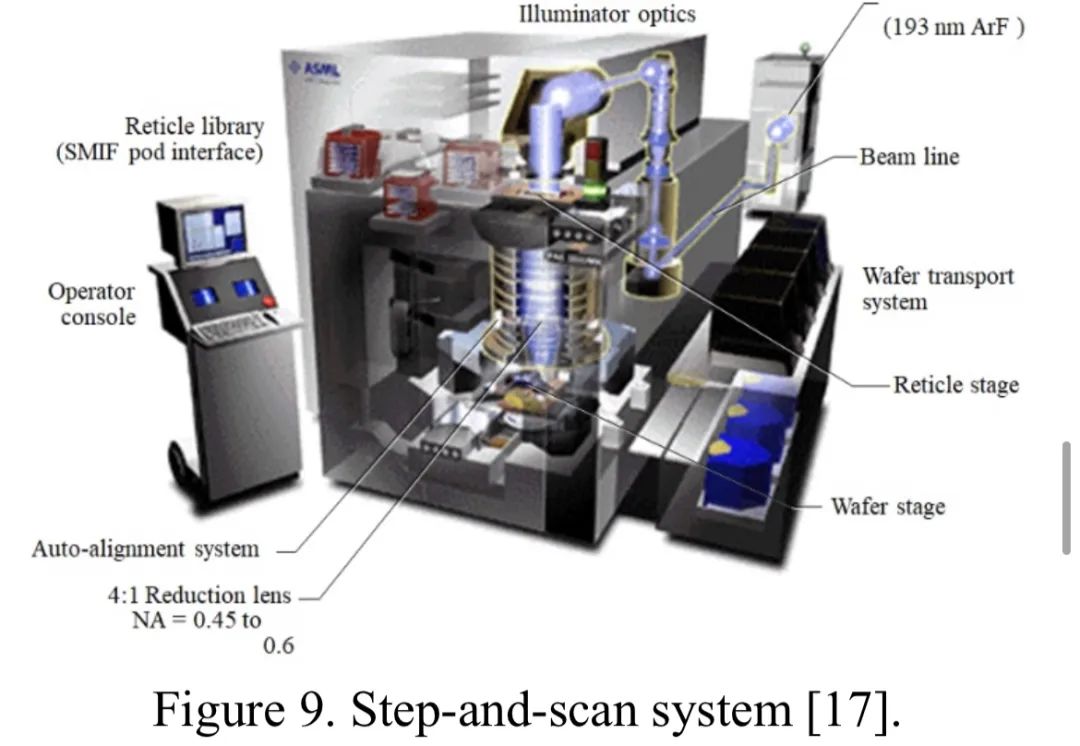
?

此外,步進(jìn)掃描系統(tǒng)還具有在整個(gè)掃描過程中調(diào)整焦點(diǎn)的能力,以補(bǔ)償鏡頭缺陷和晶圓平整度的變化。這提高了掃描過程中對(duì)焦點(diǎn)的控制,從而更好地控制了整個(gè)曝光場(chǎng)的CD均勻性。步進(jìn)掃描系統(tǒng)的主要挑戰(zhàn)是對(duì)機(jī)械公差控制的要求增加,因?yàn)楸仨毻娇刂凭A臺(tái)和掩模版臺(tái)的運(yùn)動(dòng)。步進(jìn)機(jī)只需快速將晶圓移動(dòng)到新位置,但步進(jìn)掃描系統(tǒng)必須同時(shí)精確地將晶圓和掩模版沿相反方向移動(dòng)。在掃描和步進(jìn)過程中,定位公差不能超過幾十納米。表1總結(jié)了各代光刻設(shè)備所采用的曝光方法及其廣泛使用的時(shí)間段。
4.最新產(chǎn)品
4.1 EUV光刻機(jī)
EUV光刻機(jī)是半導(dǎo)體行業(yè)最先進(jìn)的光刻機(jī),廣泛應(yīng)用于制造7甚至5納米以下工藝的芯片。整機(jī)的核心系統(tǒng)是曝光系統(tǒng)。它產(chǎn)生 EUV 光。為了獲得高效率,必須對(duì)系統(tǒng)進(jìn)行抽真空以防止空氣中的物質(zhì)吸收 EUV。激光產(chǎn)生等離子體 (LPP) 源使用 Sn 液滴和 CO2 激光器產(chǎn)生 13.5 nm EUV 光,如圖 10 所示 [18]。當(dāng) Sn 液滴離開發(fā)生器時(shí),它將通過預(yù)脈沖進(jìn)行“調(diào)節(jié)”。優(yōu)化后的 Sn 靶比液體靶密度低,因此更多的 Sn 離子參與發(fā)射 EUV,從而提高轉(zhuǎn)換效率 [19]。已經(jīng)實(shí)現(xiàn)了 250 W 的 EUV 源功率 [20]。EUV 源功率越高,吞吐量就越高。對(duì)于鏡頭,曝光系統(tǒng)中使用的高反射率鏡子在穿透鏡頭時(shí)會(huì)被吸收,這歸因于 EUV 光,這將導(dǎo)致效率下降。為了保證傳輸效率,鏡子上涂有多層涂層,基本上充當(dāng)布拉格反射器 [21]。ASML 最先進(jìn)的 EUV 光刻機(jī)是 NXE:3600D,使用 13.5nm 波長(zhǎng)的 EUV 光,分辨率為 13nm。3600D 可用于制造 5nm 和 3nm 邏輯節(jié)點(diǎn)以及前沿 DRAM 節(jié)點(diǎn)。其投影光學(xué)元件為 0.33NA。至于產(chǎn)能,在 30mJ/cm2 的劑量下,每小時(shí)可生產(chǎn)大于等于 160 片晶圓。
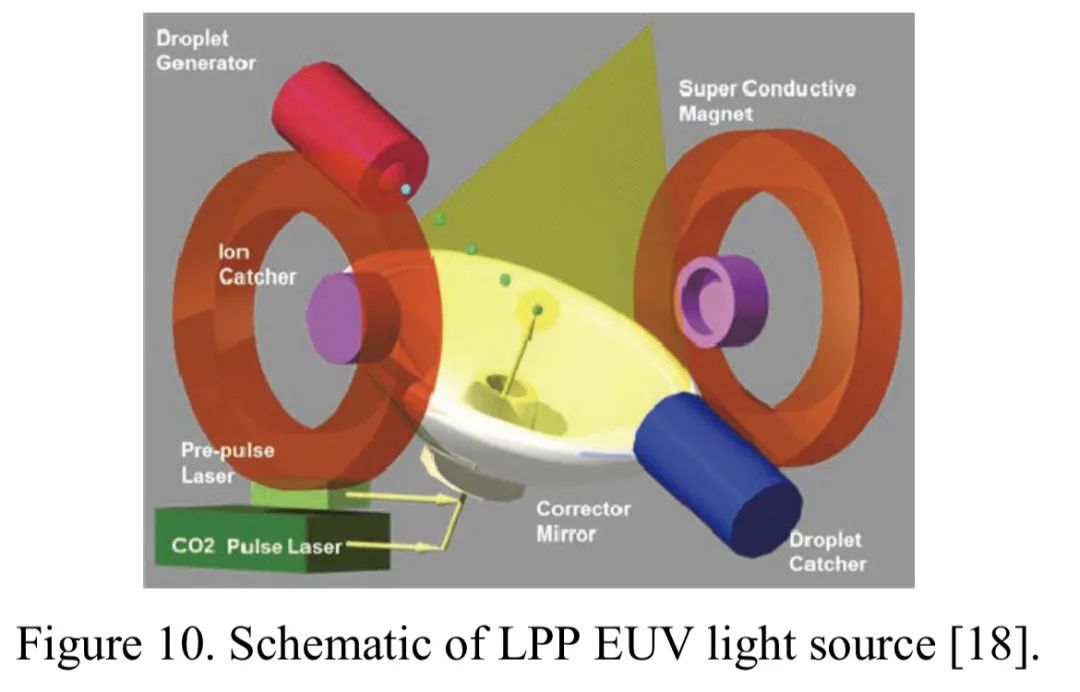
4.2 高數(shù)值孔徑EUV光刻機(jī)
ASML和Carl Zeiss正在開發(fā)NA=0.55的下一代EUV曝光系統(tǒng)[22]。與0.33NA光刻機(jī)相比,NA提高了67%,可提供亞8納米半節(jié)距分辨率[23]。對(duì)于光源,仍可使用LPP光源,但EUV光刻機(jī)上應(yīng)用的光源功率不足以打印較小的圖案。要實(shí)現(xiàn)10納米半節(jié)距圖案,劑量應(yīng)大于80mJ/cm2[24]。如果光源功率太低,產(chǎn)量將顯著降低。對(duì)于高數(shù)值孔徑EUV光刻機(jī),劑量為80mJ/cm2的500W光源每小時(shí)可生產(chǎn)120片晶圓。如果光源功率足夠高,機(jī)械考慮的極限是每小時(shí)185片晶圓。當(dāng)光源功率達(dá)到1.3 kW或更高,劑量為80 mJ/cm2時(shí),就會(huì)出現(xiàn)這種限制[25]。
數(shù)值孔徑的增大意味著偏轉(zhuǎn)角的增大和鏡子的體積的增大。作為高數(shù)值孔徑光學(xué)系統(tǒng)的最后一面鏡子,根據(jù)數(shù)值孔徑=nsinα的關(guān)系,與EUV光刻機(jī)相比,光錐角將從19°增大到33°。對(duì)于倒數(shù)第二面鏡子,為避免最后一面鏡子被遮擋,應(yīng)增大偏轉(zhuǎn)角,鏡子體積也應(yīng)增大。鏡子上的多層鍍膜起著布拉格反射鏡的作用,必須在偏轉(zhuǎn)角下工作,在角度變化盡可能小的情況下,可獲得最大反射率。為了解決光線如何在較小的偏轉(zhuǎn)角下照射最后一面鏡子的問題,ASML引入了如圖11所示的中央遮擋[26]。在掩模版一側(cè),隨著系統(tǒng)數(shù)值孔徑的增大,數(shù)值孔徑也會(huì)增大。入射光和反射光在傳輸過程中會(huì)重疊。決定采用變形4x/8x系統(tǒng)以避免對(duì)比度損失。但曝光場(chǎng)將比過去減少一半[27, 28]。圖12展示了與0.33NA光刻機(jī)相比高NA光刻機(jī)的其他一些改進(jìn)[29]。

?
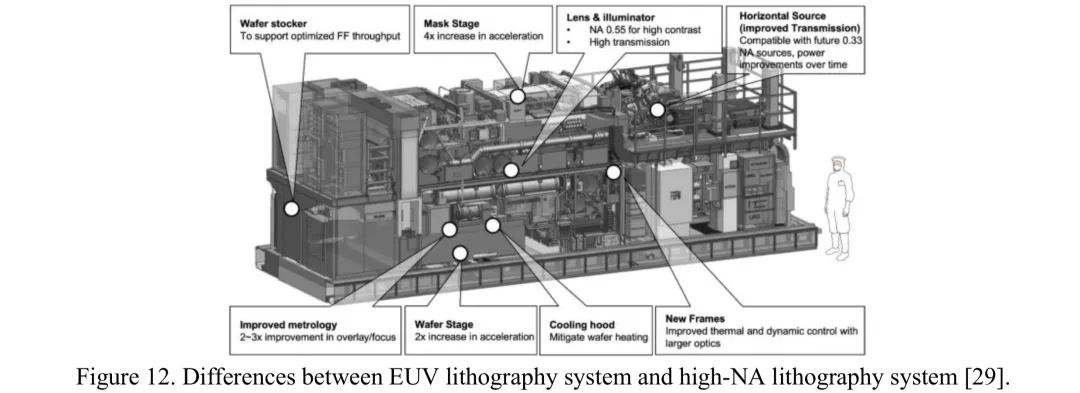
5. 局限性與未來展望
在瑞利準(zhǔn)則的指導(dǎo)下,可以找到波長(zhǎng)更短的光,增加NA并更接近k1極限。考慮到EUV光刻光源的波長(zhǎng)為13.5nm,幾乎達(dá)到了真正的X射線波長(zhǎng)范圍。由于X射線對(duì)EUV光刻機(jī)鏡上的反射材料穿透性太強(qiáng),導(dǎo)致效率低下,因此X射線的損失會(huì)非常高。另一方面,X射線光源意味著更高的功率需求,這將給電力供應(yīng)帶來新的問題。找到另一種波長(zhǎng)更短的光比增加NA更困難。增加NA的另一種方法與焦深(DoF)有關(guān)。根據(jù)DoF的公式,

其中k2是與工藝相關(guān)的因素,隨著NA的增加,DoF會(huì)減小,當(dāng)k2=1時(shí),DoF約為45nm,大約是EUV光刻機(jī)120nm DoF的1/3。為了掩蓋艾里斑的離焦,DoF控制應(yīng)優(yōu)于35nm[20]。較低的DoF會(huì)對(duì)晶圓表面的平整度、光刻膠的厚度和系統(tǒng)控制提出新的挑戰(zhàn)。較大的NA會(huì)導(dǎo)致反射鏡的口徑更大,使反射鏡更大更重也成為一個(gè)不可忽視的問題,給制造和裝配帶來更大的難度。由于中心遮擋,衍射和部分0級(jí)甚至1級(jí)衍射點(diǎn)會(huì)被遮蔽[30],即丟失一些圖案信息導(dǎo)致模糊。
光刻機(jī)是一個(gè)極其復(fù)雜和精密的系統(tǒng)。要突破技術(shù)限制,應(yīng)考慮在瑞利判據(jù)的指導(dǎo)下采用更短波長(zhǎng)的光源,減少短波長(zhǎng)光在傳輸過程中的損失。在光源方面,自由電子激光器(FEL)是一種適用于光刻的光源。FEL具有波長(zhǎng)范圍連續(xù)可調(diào)、輸出功率高、光束質(zhì)量高等優(yōu)點(diǎn),EUV FEL和XFEL在光刻機(jī)上具有巨大的應(yīng)用潛力。然而,用于產(chǎn)生FEL的裝置相當(dāng)龐大且昂貴。將FEL裝置小型化并應(yīng)用于工業(yè)仍然是研究的熱點(diǎn)。如果FEL能夠應(yīng)用于光刻工業(yè),更高的功率和更短的波長(zhǎng)將帶來生產(chǎn)率的提高和更精細(xì)的圖案。除了光源之外,優(yōu)化光學(xué)反射系統(tǒng)也是使結(jié)構(gòu)更緊湊并節(jié)省成本的必要條件。盡量增加NA可能比尋找更短波長(zhǎng)的光源更容易。如果光的波長(zhǎng)和NA有限,調(diào)整k1以發(fā)揮最佳性能是值得考慮的。高數(shù)值孔徑光刻技術(shù)是延續(xù)摩爾定律的有力工具,但隨著光刻機(jī)的發(fā)展,我們面臨的挑戰(zhàn)不僅是機(jī)械限制,還有物理限制。
6. 結(jié)論
總之,本文從光源和傳輸系統(tǒng)的角度討論了光刻機(jī)的特點(diǎn)。具體來說,首先對(duì)光刻機(jī)進(jìn)行了總體介紹。然后,討論了光刻系統(tǒng)的關(guān)鍵指標(biāo)——分辨率,以及在紫外和深紫外光源上開發(fā)的一些常見曝光方法。之后,針對(duì)每一代光刻技術(shù),本文介紹了一種具有代表性的光刻設(shè)備。隨后,我們還總結(jié)了EUV光刻機(jī)的特點(diǎn)和高數(shù)值孔徑光刻機(jī)的先進(jìn)發(fā)展。最后,本文分析了當(dāng)前最先進(jìn)光刻機(jī)的局限性,并概述了未來的前景。光刻技術(shù)是延續(xù)摩爾定律的關(guān)鍵,而高數(shù)值孔徑光刻機(jī)則將摩爾定律拓展到了下一個(gè)十年。放眼未來,有必要思考下一個(gè)光刻時(shí)代的可行方法,以解決擺在我們面前的物理限制問題。總體而言,這些結(jié)果為光刻機(jī),特別是最先進(jìn)的產(chǎn)品提供了指導(dǎo),同時(shí)提出了一些觀點(diǎn),指出了光刻機(jī)發(fā)展的一些潛在挑戰(zhàn)并提出了相應(yīng)的解決方案。

?

審核編輯:黃飛
?
 電子發(fā)燒友App
電子發(fā)燒友App













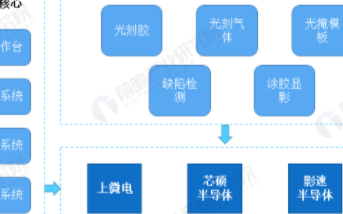
















評(píng)論