完善資料讓更多小伙伴認(rèn)識你,還能領(lǐng)取20積分哦,立即完善>
標(biāo)簽 > 3d封裝
3D封裝的形式有很多種,主要可分為填埋型、有源基板型和疊層型等3類。填埋型三維立體封裝出現(xiàn)上世紀(jì)80年代,它是將元器件填埋在基板多層布線內(nèi)或填埋、制作在基板內(nèi)部,它不但能靈活方便地制作成填埋型,而且還可以作為IC芯片后布線互連技術(shù),使填埋的壓焊點與多層布線互連起來。這就可以大大減少焊接點,提高電子部件封裝的可靠性。
文章:117個 瀏覽:27662次 帖子:31個

先進(jìn)封裝對比傳統(tǒng)封裝的優(yōu)勢及封裝方式
一、技術(shù)發(fā)展方向 半導(dǎo)體產(chǎn)品在由二維向三維發(fā)展,從技術(shù)發(fā)展方向半導(dǎo)體產(chǎn)品出現(xiàn)了系統(tǒng)級封裝(SiP)等新的封裝方式,從技術(shù)實現(xiàn)方法出現(xiàn)了倒裝(FlipCh...
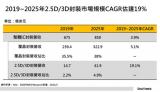
2.5D和3D封裝技術(shù)有何異同?異構(gòu)整合的優(yōu)點
人工智能(AI)、車聯(lián)網(wǎng)、5G 等應(yīng)用相繼興起,且皆須使用到高速運算、高速傳輸、低延遲、低耗能的先進(jìn)功能芯片;然而,隨著運算需求呈倍數(shù)成長,究竟要如何延...
Cadence推出Clarity 3D場求解器,擁有近乎無限的處理能力
楷登電子今日發(fā)布Cadence? Clarity? 3D Solver場求解器,正式進(jìn)軍快速增長的系統(tǒng)級分析和設(shè)計市場。與傳統(tǒng)的三維場求解器相比,Cad...
半導(dǎo)體業(yè)界,幾家公司正在競相開發(fā)基于各種下一代互連技術(shù)的新型2.5D和3D封裝。
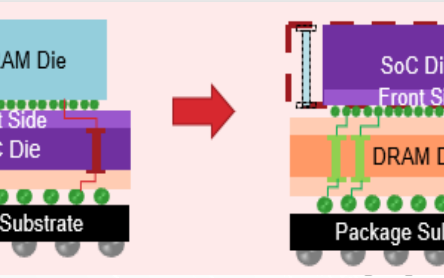
用3D堆疊技術(shù)打造DRAM成為L4級緩存,華邦電子CUBE解決方案助力邊緣AI
華邦電子一直以來提供閃存和DRAM的良品裸晶圓(KGD)產(chǎn)品,KGD可以與SoC進(jìn)行合封,以實現(xiàn)更優(yōu)的成本和更小的尺寸。據(jù)華邦電子次世代內(nèi)存產(chǎn)品營銷企劃...

研發(fā)的銅混合鍵合工藝正推動下一代2.5D和3D封裝技術(shù)
代工廠、設(shè)備供應(yīng)商、研發(fā)機構(gòu)等都在研發(fā)一種稱之為銅混合鍵合(Hybrid bonding)工藝,這項技術(shù)正在推動下一代2.5D和3D封裝技術(shù)。
2.5D/3D封裝技術(shù)升級,拉高AI芯片性能天花板
電子發(fā)燒友網(wǎng)報道(文/李彎彎)一直以來,提升芯片性能主要依靠先進(jìn)制程的突破。但現(xiàn)在,人工智能對算力的需求,將芯片封裝技術(shù)的重要性提升至前所未有的高度。為...
SIP有多種定義和解釋,其中一說是多芯片堆疊的3D封裝內(nèi)系統(tǒng)集成,在芯片的正方向堆疊2片以上互連的裸芯片的封裝。SIP是強調(diào)封裝內(nèi)包含了某種系統(tǒng)的功能封...
針對AMD移動銳龍4000系列的猛烈攻勢,英特爾在2020下半年將以兩套全新平臺予以還擊,新平臺的代號分別為Lakefield和Tiger Lake,前...
3D封裝成半導(dǎo)體巨頭發(fā)展重點 封裝技術(shù)在臺積電技術(shù)版圖中的重要性已越來越突出
近日,全球第二大晶圓代工廠格芯(GlobalFoundries)宣布,采用12nm FinFET工藝,成功流片了基于ARM架構(gòu)的高性能3D封裝芯片。這意...
2.5D封裝技術(shù)是一種先進(jìn)的異構(gòu)芯片封裝技術(shù),它巧妙地利用中介層(Interposer)作為多個芯片之間的橋梁,實現(xiàn)高密度線路連接,并最終集成為一個封裝體。
最近,關(guān)于臺積電的先進(jìn)封裝有很多討論,讓我們透過他們的財報和最新的技術(shù)峰會來對這家晶圓代工巨頭的封裝進(jìn)行深入的介紹。 資料顯示,在張忠謀于2011年重返...
推進(jìn)摩爾定律,臺積電力推SoIC 3D封裝技術(shù)
自2018年4月始,臺積電已在眾多技術(shù)論壇或研討會中揭露創(chuàng)新的SoIC技術(shù),這個被譽為再度狠甩三星在后的秘密武器,究竟是如何厲害?
3D封裝火熱 臺積電和英特爾各領(lǐng)風(fēng)騷
隨著先進(jìn)納米制程已逼近物理極限,摩爾定律發(fā)展已難以為繼,無法再靠縮小線寬同時滿足性能、功耗、面積及訊號傳輸速度等要求;再加上封裝技術(shù)難以跟上先進(jìn)制程的發(fā)...
行業(yè) | Intel「Foveros」3D封裝技術(shù)打造首款異質(zhì)處理器
英特爾在今年的COMPUTEX終于正式宣布,其10納米的處理器「Ice Lake」開始量產(chǎn),但是另一個10納米產(chǎn)品「Lakefiled」卻缺席了。
隨著國際電子信息行業(yè)新的變革, 3D封裝 蓬勃興起。為了在封裝之內(nèi)硬塞進(jìn)更多功能,芯片制造商被推到了極限。此外,我們不能忘記更加棘手的互連問題。采用Z方...
2011-09-16 標(biāo)簽:3D封裝 3262 0
快訊:3D封裝戰(zhàn)延燒 臺積電攪動“一池春水”三星上演復(fù)仇大計
2018 年電視市場三星電子與 QLED 電視大獲全勝,三星除了成功衛(wèi)冕銷售冠軍,QLED 電視銷量也成功超越 OLED 電視,然而國內(nèi)業(yè)者來勢洶洶,三...
微電子封裝技術(shù)未來發(fā)展面臨的問題與挑戰(zhàn)
毫無疑問,3D封裝和SIP系統(tǒng)封裝是當(dāng)前以至于以后很長一段時間內(nèi)微電子封裝技術(shù)的發(fā)展方向。 目前3D封裝技術(shù)的發(fā)展面臨的難題:一是制造過程中實時工藝過程...
英特爾2020年發(fā)布首款獨立繪圖芯片與NVIDIA分庭抗禮
英特爾(Intel)于12日舉行保密多時的「架構(gòu)日」(Architecture Day),會中全面揭露下一代技術(shù)方向,除采用10納米工藝平臺的產(chǎn)品展示為...
 換一批
換一批
編輯推薦廠商產(chǎn)品技術(shù)軟件/工具OS/語言教程專題
| 電機控制 | DSP | 氮化鎵 | 功率放大器 | ChatGPT | 自動駕駛 | TI | 瑞薩電子 |
| BLDC | PLC | 碳化硅 | 二極管 | OpenAI | 元宇宙 | 安森美 | ADI |
| 無刷電機 | FOC | IGBT | 逆變器 | 文心一言 | 5G | 英飛凌 | 羅姆 |
| 直流電機 | PID | MOSFET | 傳感器 | 人工智能 | 物聯(lián)網(wǎng) | NXP | 賽靈思 |
| 步進(jìn)電機 | SPWM | 充電樁 | IPM | 機器視覺 | 無人機 | 三菱電機 | ST |
| 伺服電機 | SVPWM | 光伏發(fā)電 | UPS | AR | 智能電網(wǎng) | 國民技術(shù) | Microchip |
| Arduino | BeagleBone | 樹莓派 | STM32 | MSP430 | EFM32 | ARM mbed | EDA |
| 示波器 | LPC | imx8 | PSoC | Altium Designer | Allegro | Mentor | Pads |
| OrCAD | Cadence | AutoCAD | 華秋DFM | Keil | MATLAB | MPLAB | Quartus |
| C++ | Java | Python | JavaScript | node.js | RISC-V | verilog | Tensorflow |
| Android | iOS | linux | RTOS | FreeRTOS | LiteOS | RT-THread | uCOS |
| DuerOS | Brillo | Windows11 | HarmonyOS |