近年來,電動汽車、高鐵和航空航天領域不斷發展,對功率器件/模塊在高頻、高溫和高壓下工作的需求不斷增加。傳統的 Si 基功率器件/模塊達到其自身的材料性能極限,氮化鎵(GaN)作為第三代寬禁帶半導體
2022-08-22 09:44:01 3651
3651 IGBT 功率模塊工作過程中存在開關損耗和導通損耗,這些損耗以熱的形式耗散,使得在 IGBT 功率模塊封裝結構產生溫度梯度。并且結構層不同材料的熱膨脹系數( Coefficient of Thermal Expansion,CTE) 相差較大
2022-09-07 10:06:18 4436
4436 封裝技術是一種將芯片與承載基板連接固定、引出管腳并將其塑封成整體功率器件或模塊的工藝,主要起到電氣連接、結構支持和保護、提供散熱途徑等作用[4]。封裝作為模塊集成的核心環節,封裝材料、工藝和結構
2022-09-21 11:56:26 2298
2298 SiC MOSFET器件的集成化、高頻化和高效化需求,對功率模塊封裝形式和工藝提出了更高的要求。本文中總結了近年來封裝形式的結構優化和技術創新,包括鍵合式功率模塊的金屬鍵合線長度、寬度和并聯
2023-01-07 10:24:37 1062
1062 在有限的封 裝空間內,如何把芯片的耗散熱及時高效的釋放到外界環境中以降低芯片結溫及器件內部各封裝材料的工作溫度,已成 為當前功率器件封裝設計階段需要考慮的重要問題之一。本文聚焦于功率器件封裝結構
2023-04-18 09:53:23 5976
5976 
針對功率器件的封裝結構,國內外研究機構和 企業在結構設計方面進行了大量的理論研究和開 發實踐,多種結構封裝設計理念被國內外研究機構提出并研究,一些結構設計方案已成功應用在商用功率器件上。
2023-05-04 11:47:03 893
893 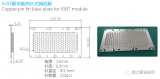
雜散電感參數較大,難以匹配器件的快速開關特性;器件高溫工作時,封裝可靠性降低;以及模塊的多功能集成封裝與高功率密度需求等。針對上述挑戰,本文分析傳統封裝結構中雜散電感參數大的根本原因,并對國內外的現有
2023-09-24 10:42:40 391
391 
,碳化硅器件持續的小型化和快速增長的功率密度也給功率模塊封裝與熱管理帶來了新 的挑戰。傳統封裝結構和散熱裝置熱阻較大,難以滿足碳化硅器件高熱流密度冷卻需求,同時,高功率密度 模塊散熱集成封裝需求
2023-11-08 09:46:44 1117
1117 4G的技術演進道路及趨勢報告從現有技術考慮,4G有三條可能的技術演進軌跡,但最終的趨勢將是不同的無線通信技術在NGN架構下融合、共存,形成多層次的無線網絡環境。2006年,在業界還在為3G牌照的歸屬猜測議論之時,4G已經“潤物細無聲”的走入人們的視野。[hide][/hide]
2009-12-18 16:40:24
柵極(Gate),漏極(Drain)和源極(Source)。功率MOSFET為電壓型控制器件,驅動電路簡單,驅動的功率小,而且開關速度快,具有高的工作頻率。常用的MOSFET的結構有橫向雙擴散型
2016-10-10 10:58:30
功率半導體器件以功率金屬氧化物半導體場效應晶體管(功率MOSFET,常簡寫為功率MOS)、絕緣柵雙極晶體管(IGBT)以及功率集成電路(power IC,常簡寫為PIC)為主。
2020-04-07 09:00:54
模塊化結構提高了產品的密集性、安全性和可靠性,同時也可降低裝置的生產成本,縮短新產品進入市場的周期,提高企業的市場競爭力。由于電路的聯線已在模塊內部完成,因此,縮短了元器件之間的連線,可實現優化布線
2021-09-09 09:15:24
DigiPCBA 解決元器件庫封裝 有沒有直接可以搜索元器件封裝怎么單個導入
2021-03-18 10:17:32
半導體產品的集成度和成本一直在按照摩爾定律演進。在這方面,作為半導體產品的重要一支———可編程邏輯器件也不例外。“最先進的半導體工藝幾乎都會在第一時間被應用在FPGA產品上。”駿龍科技公司
2019-10-29 06:02:53
應力會使光器件和光纖之間的對準發生偏移。在高精度加速度計和陀螺儀中,封裝需要和MEMS芯片隔離以優化性能(見圖1)。圖1 常規晶圓級封裝(WLP)結構示意圖根據生產的MEMS器件類型的不同,電子性能
2010-12-29 15:44:12
為滿足晶體管用戶的需求,有源器件的功率密度持續增長。商用無線通訊、航空電子、廣播、工業以及醫療系統應用推動固態功率封裝隨著更小輸出級器件輸出更高輸出功率的要求而發展。對飛思卡爾半導體公司而言,為這些
2019-07-05 06:56:41
為滿足晶體管用戶的需求,有源器件的功率密度持續增長。商用無線通訊、航空電子、廣播、工業以及醫療系統應用推動固態功率封裝隨著更小輸出級器件輸出更高輸出功率的要求而發展。對飛思卡爾半導體公司而言,為這些
2019-07-09 08:17:05
。 傳統的功率半導體封裝技術是采用鉛或無鉛焊接合金把器件的一個端面貼合在熱沉襯底上,另外的端面與10-20mil鋁線楔或金線鍵合在一起。這種方法在大功率、高溫工作條件下缺乏可靠性,而且
2018-09-11 16:12:04
、IGBT、可控硅、電源模塊、整流橋、功率電阻等領域工藝與技術已經趨于完善。 TO-247-3L封裝結構與尺寸表 TO-247-2L封裝結構與尺寸表 TO247安裝注意事項: TO247
2020-09-24 15:57:31
半導體器件主要有功率模組、功率集成電路(即Power IC,簡寫為PIC,又稱為功率IC)和分立器件三大類;其中,功率模組是將多個分立功率半導體器件進行模塊化封裝;功率IC對應將分立功率半導體器件與驅動
2019-02-26 17:04:37
`什么是光模塊?光模塊又有著哪些類型和參數?這些你知道嗎?今天,小編就給大家分享一下光模塊的類型、參數和發展史。 光模塊的誕生可以從最早的1X9封裝光模塊說起,1X9封裝光模塊從誕生到現在也有近20
2017-11-01 13:36:50
用cadence畫元器件封裝,在已有元器件封裝基礎上如何修改封裝的實體范圍?
2015-09-28 17:07:45
和DRAM),40μm的芯片堆疊8個總 厚度為1.6 mm,堆疊兩個厚度為0.8 mm。如圖1所示。圖1 元器件內芯片的堆疊 堆疊元器件(Amkor PoP)典型結構如圖2所示: ·底部PSvfBGA
2018-09-07 15:28:20
都將按照自身的規律不斷發展下去。封裝中系統(SiP)是近年來半導體封裝的重要趨勢,代表著未來的發展方向。封裝中系統在一個封裝中集成多個形式各異、相對獨立義緊密相連的模塊以實現完整強大的功能,具有較短
2018-11-23 17:03:35
晶體管有H型、Q型封裝的管芯一陶瓷一金屬結構,雙極型功率晶體管因成本低,仍占有一席之地,功率MOSFET向低內阻、低電壓應用發展。管芯與封裝占用面積之比也是功率器件封裝改進的重要方向,在以往的SMT封裝
2018-08-29 10:20:50
電傳輸性的影響作了系統的實驗研究與分析,并論述了聲表面波器件在封裝方面的現狀及其發展趨勢。關鍵詞:封裝,聲表面波器件,電傳輸性,濾波器,諧振器,移動通信中圖分類號:TN305.94 文獻標識碼:A
2018-11-23 11:14:02
線路相對簡單,散熱結構完善,物理特性穩定。所以說,大功率LED器件代替小功率LED器件成為主流半導體照明器件的必然的。但是對于大功率LED器件的封裝方法并不能簡單地套用傳統的小功率LED器件的封裝方法
2013-06-10 23:11:54
白光LEI)制造工藝、器件設計、組裝技術三方面的進展,LED發光性能一直在提高.其成本一直在降低。PN結設計、再輻射磷光體和透鏡結構都有助于提高效率,因此也有助于提高可獲得的光輸出。目前多數的封裝方式
2013-06-04 23:54:10
上海瞻芯該項專利中所提供的半導體結構和制備方法,相較于同種器件而言,其電場強度能夠大幅降低,提高了半導體器件柵氧化層的可靠性。同時柵漏之間的電容也被大幅降低,從而極大的減少了開關功率的損耗
2020-07-07 11:42:42
支持模塊化的趨勢,通過降低其他封裝技術的成本來實現。隱身的電子器件(嵌入式芯片)可有效防止逆向工程和造假。”嵌入式芯片是將多個芯片集成到單個封裝體中的幾種方法之一,但并不是唯一選擇。TEL NEXX公司
2019-02-27 10:15:25
傳熱材料、功率母線、功率器件、銅層、陶瓷、集成無源模塊、金屬層、表面貼裝芯片(驅動、檢測及保護元件)等。這種三維多層集成封裝技術,將功率模塊、集成電路等做成三明治(Sandwich)結構形式。 圖2 嵌入功率器件的多層集成封裝的剖面圖 :
2018-11-23 16:56:26
:傳統封裝雜散電感參數較大,難以匹配器件的快速開關特性;器件高溫工作時,封裝可靠性降低;以及模塊的多功能集成封裝與高功率密度需求等。針對上述挑戰,論文分析傳統封裝結構中雜散電感參數大的根本原因,并對國內外
2023-02-22 16:06:08
各位大神們,求Allegro中的一些器件PCB封裝SP3232EEN DB9公頭/母頭插座 端子3P 功率電感5*5*2 功率電感4*4*2 SN74CB3Q3253 排針2X12p 排針2X12p
2017-09-30 17:31:25
汽車用基礎電子元器件發展現狀如何?國內汽車用基礎電子元器件發展現狀如何?汽車用基礎電子元器件發展趨勢是什么?
2021-05-17 06:27:16
為標準化模塊,并封裝為一體,構成集成電力電子模塊。集成電力電子模塊既不是某種特殊的半導體器件,也不是一種無源元件。它是按照最優化電路拓撲和系統結構的原則而設計出的包含多種器件的集成組件或模塊。除了具備有功率
2018-08-28 11:58:28
給電阻和電容添加封裝時,功率是怎么選定的,比如axial0.4他的功率是多少呢???
2013-07-24 19:14:55
ASIC、FPGA和DSP的應用領域呈現相互覆蓋的趨勢,使設計人員必須在軟件無線電結構設計中重新考慮器件選擇策略問題。本文從可編程性、集成度、開發周期、性能和功率五個方面論述了選擇ASIC、FPGA
2019-07-26 06:09:25
)的工業系統需要多個電源軌,同時面臨小尺寸和低成本的挑戰。集成柔性功率器件可以為這種應用顯著降低成本,減小解決方案尺寸。 集成柔性功率器件在同一封裝內包含多個DC/DC轉換器。這些DC/DC轉換器可以是單個
2022-11-14 06:20:23
大功率LED封裝結構的仿真設計:設計針對大功率L ED 的光學結構進行分析, 建立大功率L ED 的光學仿真模型, 模擬L ED 光強分布曲線,對實測數據和仿真結果進行了比較, 重點說明L ED 封
2008-10-27 17:08:31 41
41 小功率LED光源封裝光學結構的MonteCarlo模擬及實驗分析
摘要:采用MonteCarlo方法對不同光學封裝結構的LED進行模擬,建立了小功率LED的仿真模型,應用空間二次曲
2010-06-04 15:55:35 18
18 文章論述了大功率LED封裝中的散熱問題,說明它對器件的輸出功率和壽命有很大的影響,分析了小功率、大功率LED 模塊的封裝中的散熱對光效和壽命的影響。對封裝及應用而言,
2010-10-22 08:53:33 136
136 現代功率模塊及器件應用技術
引言
最近20年來,功率器件及其封裝技術的迅猛發展,導致了電力電子技術領域的巨大變化。當今的
2009-04-09 08:54:24 1001
1001 
智能功率器件的原理與應用
摘要:目前,功率器件正朝著集成化、智能化和模塊化的方向發展。智能功率器件為機電一體化
2009-07-15 07:56:56 1565
1565 
SiC功率器件的封裝技術要點
具有成本效益的大功率高溫半導體器件是應用于微電子技術的基本元件。SiC是寬帶隙半導體材料,與S
2009-11-19 08:48:43 2355
2355 本文介紹了大功率電力電子器件I P M 智能功率模塊,給出了模塊的內部電路結構及功能特點。以通用變頻電源的設計為例,介紹了以I P M 智能功率模塊為核心的主電路及其控制電路的設
2011-12-22 14:30:11 105
105 1998年前,LED封裝結構比較單一,主要以小功率LAMP系列為主。而2000年以來,隨著SMD系列產品的誕生,不斷有新的LED封裝結構出現。與此同時,LED封裝結構主要根據應用產品的需求而改變
2012-07-11 09:37:00 4481
4481 
高可靠功率器件金屬封裝外殼的技術改進
2017-09-12 14:30:47 14
14 目前國際功率半導體器件的主流主品功率MOS器件只是近年來才有所涉及,且主要為平面柵結構的VDMOS器件,IGBT還處于研發階段。
2017-09-20 17:46:59 44
44 本文詳細介紹了光收發模塊的封裝技術及其發展趨勢。
2017-11-06 10:51:56 58
58 本文介紹了VISHAY汽車級功率器件的設計及應用趨勢。
2017-11-20 16:44:25 24
24 本文介紹了什么是功率半導體器件,對功率半導體器件分類和功率半導體器件優缺點進行了分析,分析了功率半導體模塊的發展趨勢以及功率半導體器件的基本功能和用途。
2018-01-13 09:19:43 17515
17515 可控硅模塊通常被稱之為功率半導體模塊。最早是在1970年由西門康公司率先將模塊原理引入電力電子技術領域,是采用模塊封裝形式,具有三個PN結的四層結構的大功率半導體器件。可控硅模塊從內部封裝芯片上可以分為可控模塊和整流模塊兩大類
2018-01-26 17:30:51 15979
15979 
由于以前器件的存在,多是分離式器件(discrete device)或模塊(module)形式,而不是更習見的集成電路封裝;其生產工廠多為傳統的6吋廠、8吋廠,而使用制程最多止于0.13/0.11微米,因此比較少接受到關注。
2018-11-16 16:23:14 6237
6237 Carsem(嘉盛半導體)是分立功率器件行業的領先OSAT廠商,是全球最大的封裝和測試組合產品供應商之一。
2019-07-02 15:05:04 3984
3984 功率器件的封裝方法,其特征在于,在管芯內充以高熱導率的流體使之完全充滿。戚者也可以在芯片表面涂敷一層高熱導率的薄膜。
2020-05-09 10:28:41 4405
4405 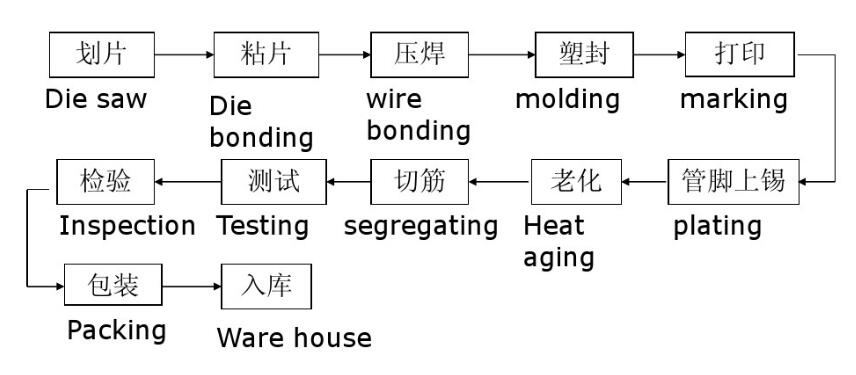
小包并輸送能量,在輸出端使之重新成為另一種連續的能量流,而這些主要便是依靠功率半導體器件及特定的電路結構來實現的。下面列舉了電力電子器件的一些應用場合: 功率半導體按照不同的分類標準可以進行如下分類: ①按照控制特性分
2022-12-02 17:07:19 3803
3803 SKiiP功率半導體器件的封裝技術指將DCB陶瓷基片和散熱器直接熱壓接構成,因此可以去掉銅底板。這使得該技術在可靠性和結溫方面具有內在的優勢。兩種新的功率模塊系列產品利用這項技術,把壓力連接的設想
2021-01-18 16:47:16 14
14 隨著電子產業的發展,電子產品正在向著質量輕、厚度薄、體積小、功耗低、功能復雜、可靠性高這一方向發展。這就要求功率模塊在瞬態和穩態情況下都要有良好的導熱導電性能以及可靠性。功率模塊的體積縮小會引起模塊
2022-03-20 12:13:37 2907
2907 3D封裝對電源器件性能及功率密度的影響
2021-05-25 11:56:03 15
15 產業發展趨勢 5G對光模塊速率需求提升,25/50/100Gb/s光模塊成前中回傳主流需求 為了滿足大帶寬、低延時、廣覆蓋的要求,5G無線接入網架構從4G的基帶處理單元、射頻拉遠單元兩級結構演進為集中單元、分布單元和有源天線單元三級結構,相應的
2021-06-18 15:28:44 1592
1592 器件的可靠性備受業界的期待。而其中關鍵的影響因素是功效器件封裝失效的問題。本文介紹功率器件封裝的內涵和分類,通過對失效機理的分析,提出功率器件封裝工藝優化的路徑。 封裝工藝是為了提升電子設備運行的可靠性,采取的相應保護措施,即
2021-07-05 16:45:15 4054
4054 隨著新一代 IGBT 芯片結溫及功率密度的提高,對功率電子模塊及其封裝技術的要求也越來越高。文
章主要介紹了功率電子模塊先進封裝互連技術的最新發展趨勢,重點比較了芯片表面互連、貼片焊接互連、導電
2022-05-06 15:15:55 6
6 IGBT 功率模塊基本的封裝工藝介紹,給初入半導體芯片制造封裝的工程師作為參考資料。
2022-06-17 14:28:42 51
51 廣義的光通信器件按照物理形態的不同,可分為:芯片、有源光器件、無源光器 件、光模塊與子系統這四大類。其中,有源光收發模塊在光通信器件中占據蕞大 份額,約 65%。有源光器件主要用于光電信號轉換,包括激光器、調制器、探測器和集成器件等。
2022-06-30 11:02:41 2521
2521 
直接導線鍵合結構最大的特點就是利用焊料,將銅導線與芯片表面直接連接在一起,相對引線鍵合技術,該技術使用的銅導線可有效降低寄生電感,同時由于銅導線與芯片表面互連面積大,還可以提高互連可靠性。
2022-07-27 15:08:59 2298
2298 日前,貝思科爾舉辦了《功率器件Power Cycling測試與數據后處理分析》線上直播活動。 本次直播主要針對各種先進封裝工藝的功率器件和模塊的快速發展,分析該領域功率器件模塊的Rth熱測試和PC
2022-10-21 17:15:54 1928
1928 ? ? ? 針對要求最嚴苛的功率開關應用的功率分立元件和模塊的封裝趨勢,從而引入改進的半導體器件。即碳化硅(SiC)和氮化鎵(GaN)等寬帶隙類型,將顯著提高功率開關應用的性能,尤其是汽車牽引逆變器
2022-11-16 10:57:40 539
539 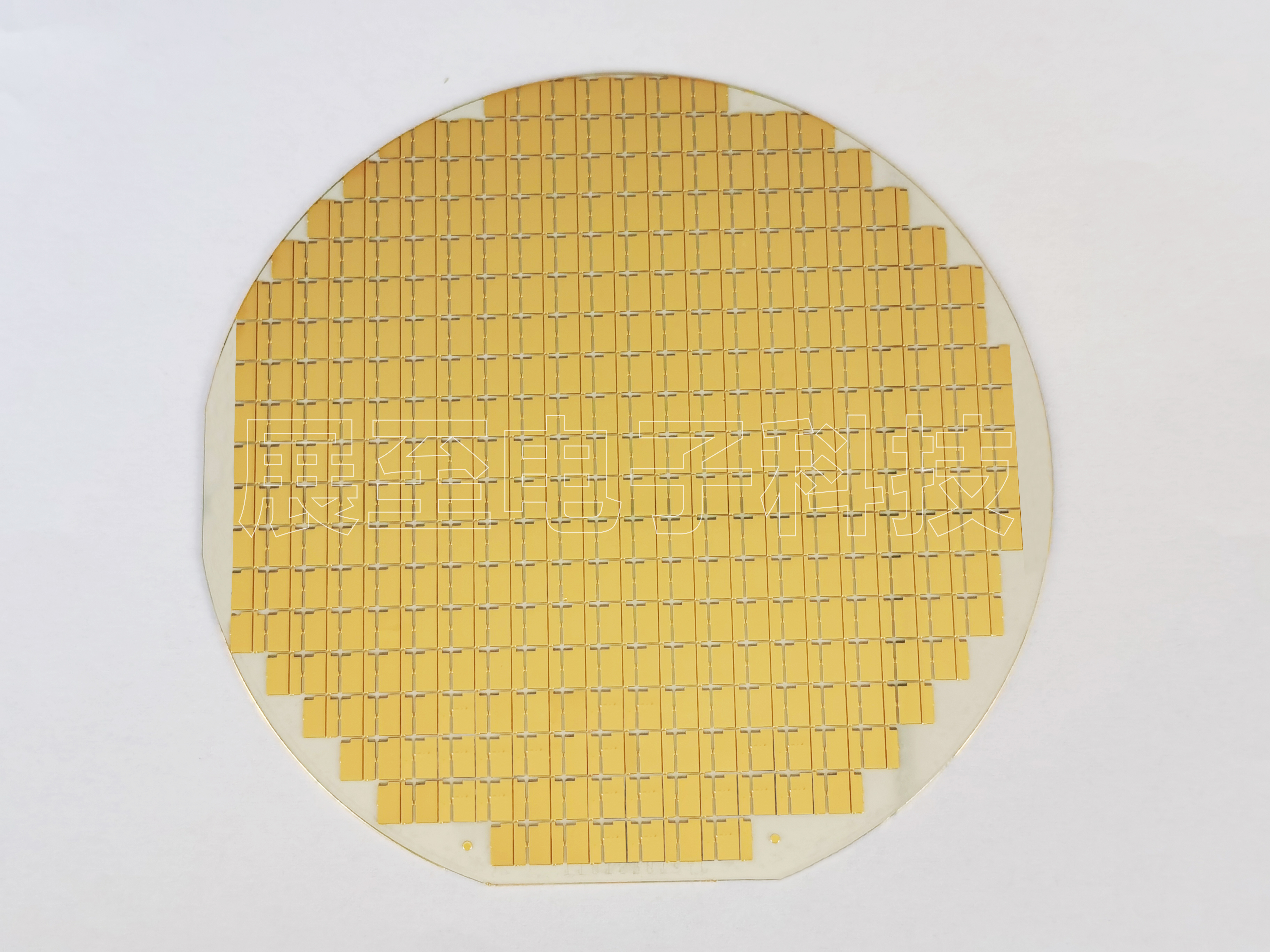
SiC MOSFET器件的集成化、高頻化和高效化需求,對功率模塊封裝形式和工藝提出了更高的要求。本文中總結了近年來封裝形式的結構優化和技術創新,包括鍵合式功率模塊的金屬鍵合線長度、寬度和并聯
2022-12-12 13:57:58 1468
1468 大家好,我們都知道無論是**功率半導體模塊封裝設計**還是**功率變換器的母線**設計,工程師們都在力求 **雜散電感最小化** ,因為這樣可以有效減小器件的 **開關振蕩及過壓風險** ,今天我們結合主流功率半導體廠商的SiC MOSFET模塊,聊一下低雜感模塊封裝內部是如何設計的?
2023-01-21 15:45:00 914
914 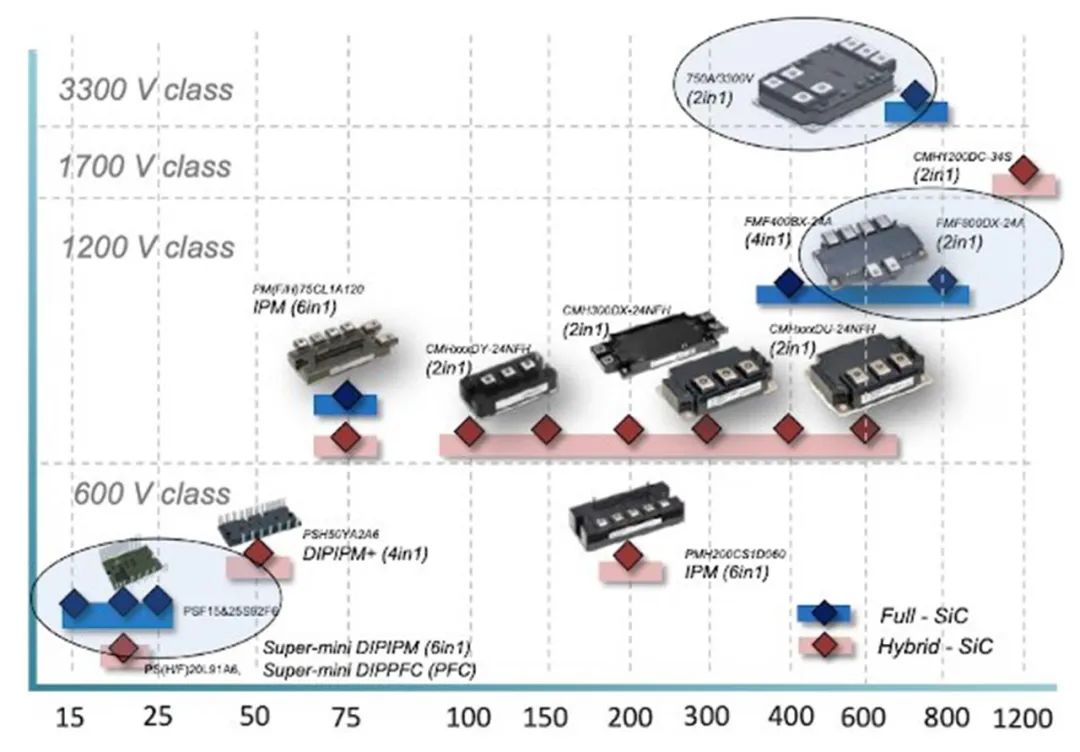
意法半導體推出了各種常用橋式拓撲的ACEPACK SMIT封裝功率半導體器件。與傳統 TO 型封裝相比,意法半導體先進的ACEPACK SMIT 封裝能夠簡化組裝工序,提高模塊的功率密度。
2023-01-16 15:01:25 1079
1079 
來源:意法半導體 2023 年 1 月 16日,中國——意法半導體推出了各種常用橋式拓撲的ACEPACK? SMIT 封裝功率半導體器件。與傳統 TO 型封裝相比,意法半導體先進的ACEPACK
2023-01-18 15:40:29 361
361 作為電子系統中的基本單元,功率半導體是電力電子設備正常運行不可或缺的部件,應用場景廣泛,且需求日益豐富。從行業技術和性能發展來看,功率半導體器件結構朝復雜化演進,功率半導體的襯底材料朝大尺寸和新材料
2023-02-03 09:46:40 976
976 
功率器件到底在半導體中扮演著什么角色呢?在本文中,我們將從功率器件的概況、市場分布與競爭格局、國內外發展差
距以及國產化替代的現狀等幾個方面,簡要探討一下功率器件行業的現狀與趨勢。
2023-02-16 15:11:21 7
7 功率器件及功率模塊的散熱計算,其目的是在確定的散熱條件下選擇合適的散熱器,以保證器件或模塊安全、可靠地工作。目前的電子產品主要采用貼片式封裝器件,但大功率器件及一些功率模塊仍然有不少用穿孔式封裝,這主要是可方便地安裝在散熱器上,便于散熱。
2023-02-16 17:52:29 675
675 我們拿慧制敏造碳化硅半導體出品的KNSCHA碳化硅二極管封裝接下來我們來看一下碳化硅二極管的貼片封裝,常見的有有TO-263和TO-252封裝,隨著近些年電源對于功率密度要求不斷提高,碳化硅功率器件
2023-02-21 13:38:16 1795
1795 
功率半導體是電子裝置中電能轉換與電路控制的核心,主要用于改變電子裝置中電壓和頻率、直流交流轉換等,是電子裝置中電能轉換與電路控制的核心。功率半導體器件種類眾多,按集成度可分為功率IC、功率模塊和功率分立器件三大類
2023-02-22 15:41:02 560
560 功率半導體器件一直是電力電子技術發展的重要組成部分,隨著電力電子應用領域的不斷擴展和電力電子技術水平的提高,功率半導體器件也在不斷發展和創新。目前,功率半導體器件發展的主要趨勢和方向包括以下幾個方面
2023-02-28 11:22:19 3017
3017 功率器件的封裝正朝著小體積和3D封裝發展,在工作損耗不變的情況下,使得器件的發熱功率密度變得更大,在熱導率和熱阻相同的情況下,會使得封裝體和裸芯的溫度更高,高溫會帶來許多問題。
2023-03-20 17:49:46 964
964 功率半導體模塊主要應用于電能轉換和電能 控制,是電能轉換與電能控制的關鍵器件,被譽為 電能處理的“CPU”,是節能減排的基礎器件和核心技術之一
2023-03-24 17:29:23 3748
3748 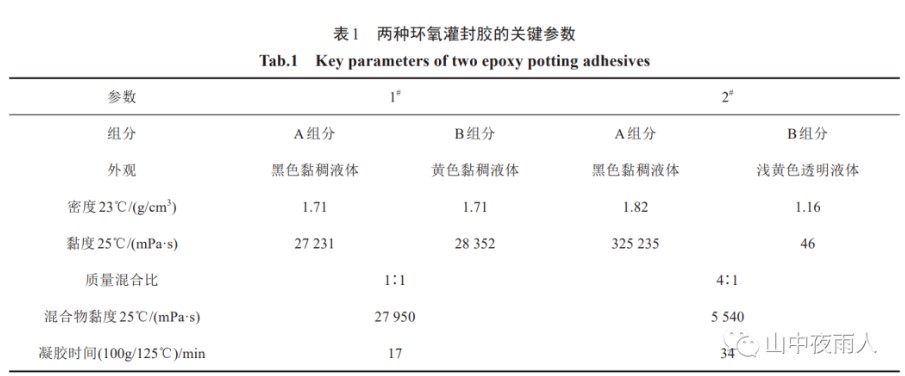
作為高可靠性芯片連接技術,銀燒結技術得到了功率模塊廠商的廣泛重視,一些功率半導體頭部公司相繼推出類似技術,已在功率模塊的封裝中取得了應用。
2023-03-31 12:44:27 1885
1885 通過對現有功率器件封裝方面文獻的總結,從器件封裝結構散熱路徑的角度可以將功率器件分為單面散熱器件、雙面散熱器件和多面散熱器件。
2023-04-26 16:11:33 918
918 
等。 由于功率開關元件在操作時產生很多熱量,因此功率模塊封裝選擇具有優異的散熱性能的材料是重要的,并且因為功率開關元件應在垂直方向上彼此平行布置,所以功率模塊封裝被設計成具有優異的導熱性和熱擴散性的封裝結構。 因此,目前在功率
2023-05-31 09:32:31 289
289 化、多功能化和體積緊湊化的發展趨勢。為實現封裝器件低電感設計,器件封裝結構更加緊湊,而芯片電壓等級和封裝模塊的功率密度持續提高,給封裝絕緣和器件散熱帶來挑戰。在有限的
2023-04-20 09:59:41 711
711 
單元,IGBT模塊得到越來越廣泛的應用。IGBT器件封裝形式主要有焊接式和壓接式兩種,其中焊接式發展成熟,應用廣泛。IGBT模塊的封裝結構比較復雜,是由多種材料組合
2023-05-18 10:11:52 2952
2952 
功率器件是指用于控制、調節和放大電能的電子元件。它們主要用于處理大功率電信號或驅動高功率負載,例如電機、變壓器、照明設備等。
2023-06-28 17:02:09 1649
1649 功率半導體包括功率半導體分立器件(含模塊)以及功率 IC 等。其中,功率半導體分立器件,按照器件結構劃分,可分為二極管、晶閘管和晶體管等。
2023-07-26 09:31:03 5068
5068 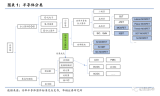
碳化硅(SiC)作為一個新興的寬帶隙半導體材料,已經吸引了大量的研究關注。其優越的電氣性能、高溫穩定性和高頻響應使其在功率電子器件領域中具有巨大的應用潛力。但要完全發揮SiC功率器件的潛力,封裝技術同樣至關重要。本文主要探討碳化硅功率器件封裝的三個關鍵技術。
2023-08-15 09:52:11 701
701 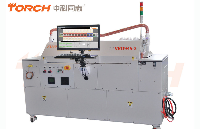
封裝技術是一種將芯片與承載基板連接固定、引出管腳并將其塑封成整體功率器件或模塊的工藝,主要起到電氣連接、結構支持和保護、提供散熱途徑等作用[4]。封裝作為模塊集成的核心環節,封裝材料、工藝和結構直接影響到功率模塊的熱、電和電磁干擾等特性。
2023-08-24 11:31:34 1050
1050 
功率半導體器件在現代電力控制和驅動系統中發揮著重要作用。IGBT模塊和IPM模塊是其中兩個最為常見的器件類型。它們都可以用于控制大功率負載和驅動電機等應用,但是它們的內部結構和功能有所不同,那么
2023-09-04 16:10:49 4679
4679 
尤其是在目前功率器件高電壓、大電流和封裝 體積緊湊化的發展背景下,封裝器件的散熱問題已 變得尤為突出且更具挑戰性。芯片產生的熱量 會影響載流子遷移率而降低器件性能。此外,高溫 也會增加封裝不同材料間因熱膨脹系數不匹配造 成的熱應力,這將會嚴重降低器件的可靠性及工作壽命。
2023-09-25 16:22:28 365
365 
長電科技在功率器件封裝領域積累了數十年的技術經驗,具備全面的功率產品封裝外形,覆蓋IGBT、SiC、GaN等熱門產品的封裝和測試。
2023-10-07 17:41:32 398
398 傳統的功率半導體封裝技術是采用鉛或無鉛焊接合金把器件的一個端面貼合在熱沉襯底上,另外的端面與10-20mil鋁線楔或金線鍵合在一起。這種方法在大功率、高溫工作條件下缺乏可靠性,而且不具備足夠的堅固性。
2023-10-09 15:20:58 299
299 
傳統的功率模塊基本結構分層圖來說說其構成:可見,我們前面聊的很多的半導體芯片,只是功率模塊中的一部分,除此之外還包括其他的成分。而這些成分的選擇和搭配,再結合半導體芯片的特性,將決定功率模塊的整體性
2023-10-24 09:45:03 3037
3037 
電動汽車近幾年的蓬勃發展帶動了功率模塊封裝技術的更新迭代。
2023-10-24 16:46:22 1114
1114 
1、SiC MOSFET對器件封裝的技術需求
2、車規級功率模塊封裝的現狀
3、英飛凌最新SiC HPD G2和SSC封裝
4、未來模塊封裝發展趨勢及看法
2023-10-27 11:00:52 419
419 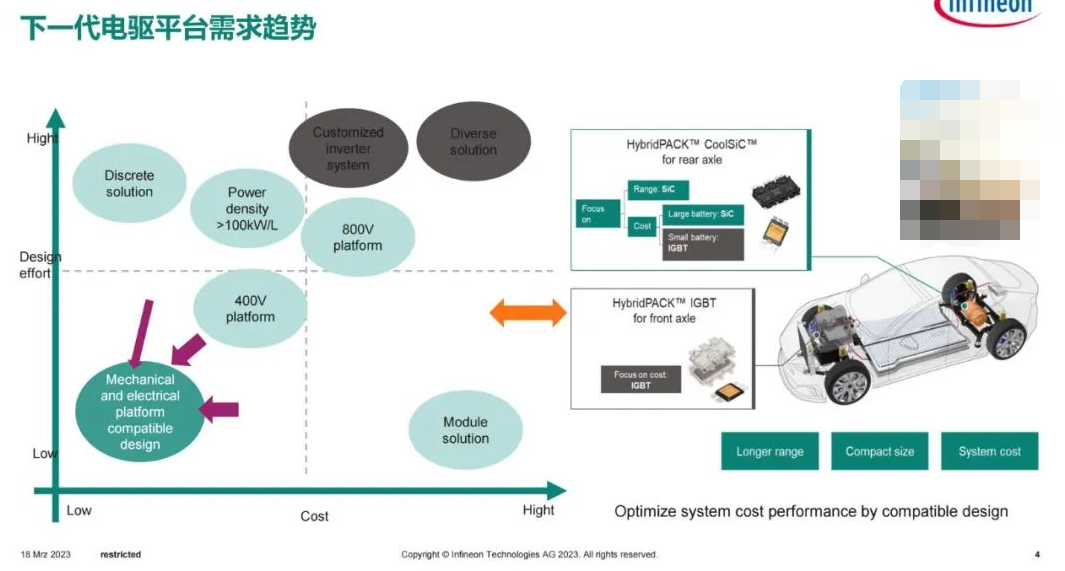
專利摘要顯示,本公開實施例提供了一種封裝結構和封裝方法,涉及半導體封裝技術領域。該封裝結構包括轉接板以及間隔貼裝在轉接板上的第一器件、第二器件和第三器件,第一器件、第二器件和第三器件之間相互間隔設置,以在第三器件朝向第一器件和第二器件的一側形成第一間隙槽,第一器件和第二器件之間形成第二間隙槽
2023-11-06 10:44:22 301
301 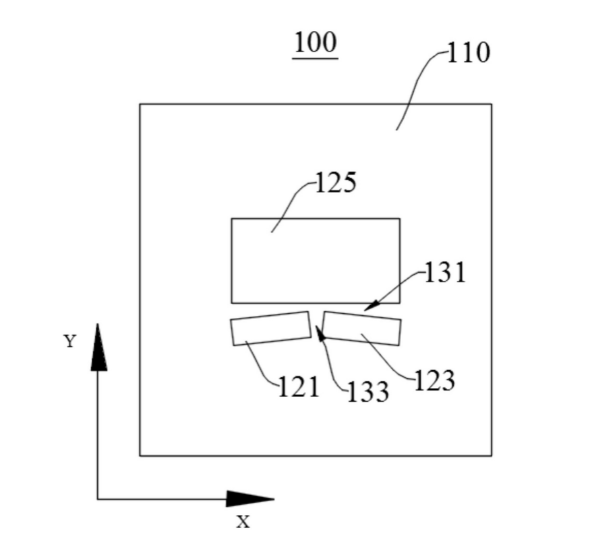
和導電性的要求外,更能提高 IPM 芯片密度的設計,并配合未來銅燒結鍵合的方向,有效幫助 SiC 模塊充分發揮高功率的性能。
2024-01-03 14:04:45 232
232 
分析多方面因素綜合作用下的功率器件失效過程和機理。半導體模塊在實際的工作中不僅涉及熱應力,同時還受振動、濕度等因素影響,現有研究主要集中在溫度對器件可靠性的影響,較少分析多種因素共同作用下的失效機理。
2024-01-03 16:21:05 354
354 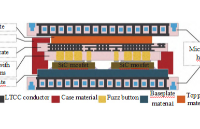
氮化鎵功率器件是一種新型的高頻高功率微波器件,具有廣闊的應用前景。本文將詳細介紹氮化鎵功率器件的結構和原理。 一、氮化鎵功率器件結構 氮化鎵功率器件的主要結構是GaN HEMT(氮化鎵高電子遷移率
2024-01-09 18:06:41 667
667 共讀好書 敖國軍 張國華 蔣長順 張嘉欣 (無錫中微高科電子有限公司) 摘要: 倒裝焊是今后高集成度半導體的主要發展方向之一。倒裝焊器件封裝結構主要由外殼、芯片、引腳(焊球、焊柱、針)、蓋板(氣密性
2024-02-21 16:48:10 132
132 
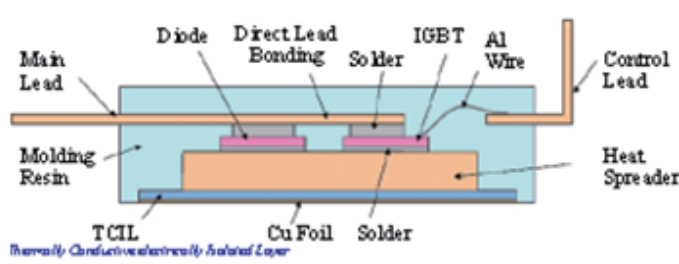 DLB結構 ?
DLB結構 ?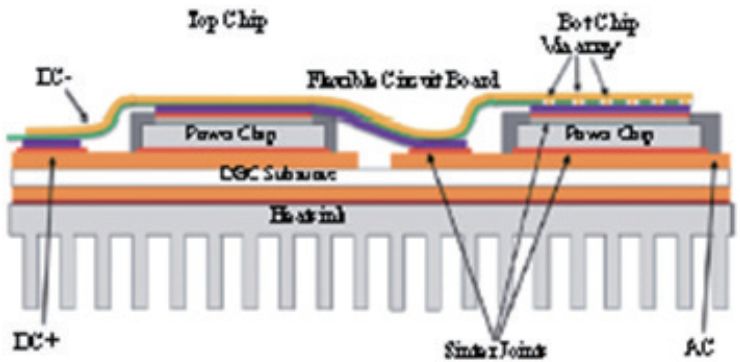 SKiN結構 ? ?
SKiN結構 ? ?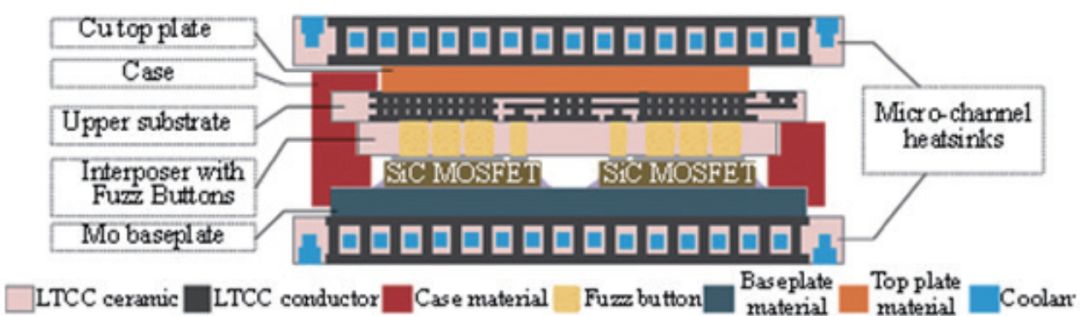 2.5D模塊封裝結構 ?
2.5D模塊封裝結構 ? 采用緊壓工藝的3D模塊封裝結構 ?
采用緊壓工藝的3D模塊封裝結構 ?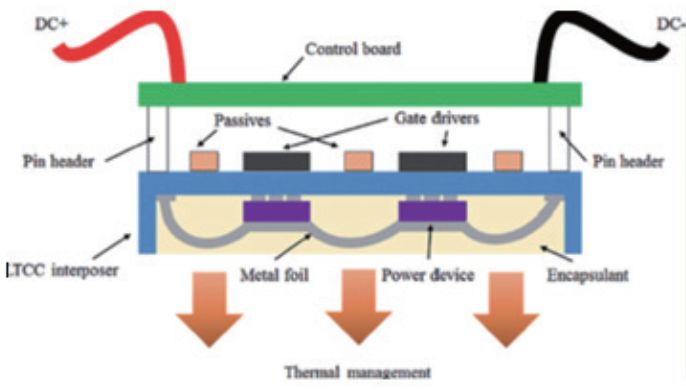 ? ? ? IGBT模塊封裝流程簡介
? ? ? IGBT模塊封裝流程簡介 電子發燒友App
電子發燒友App










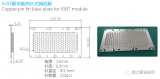






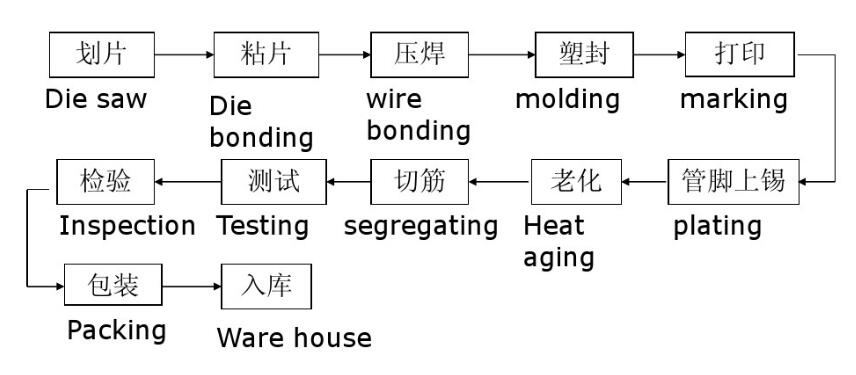

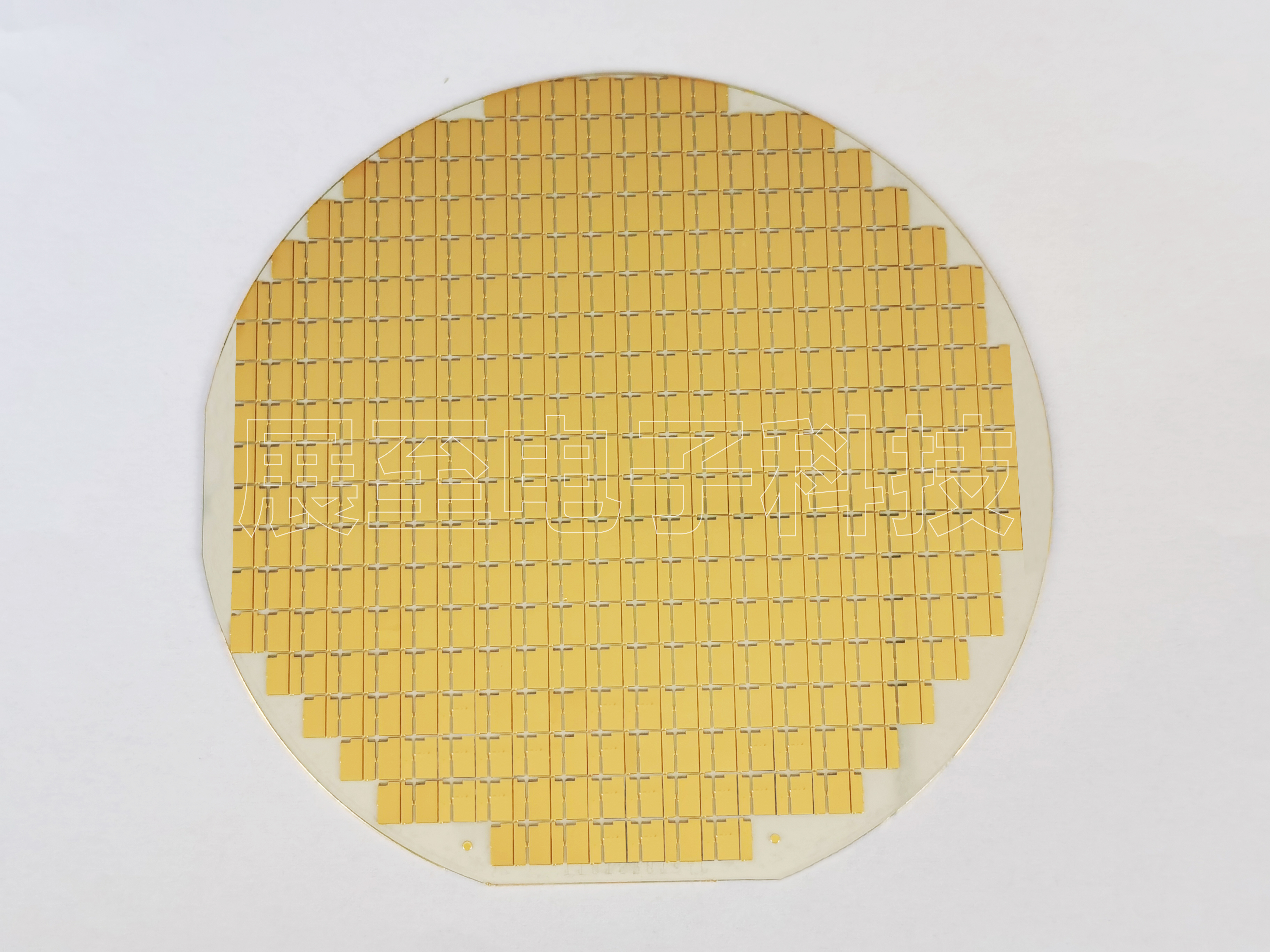
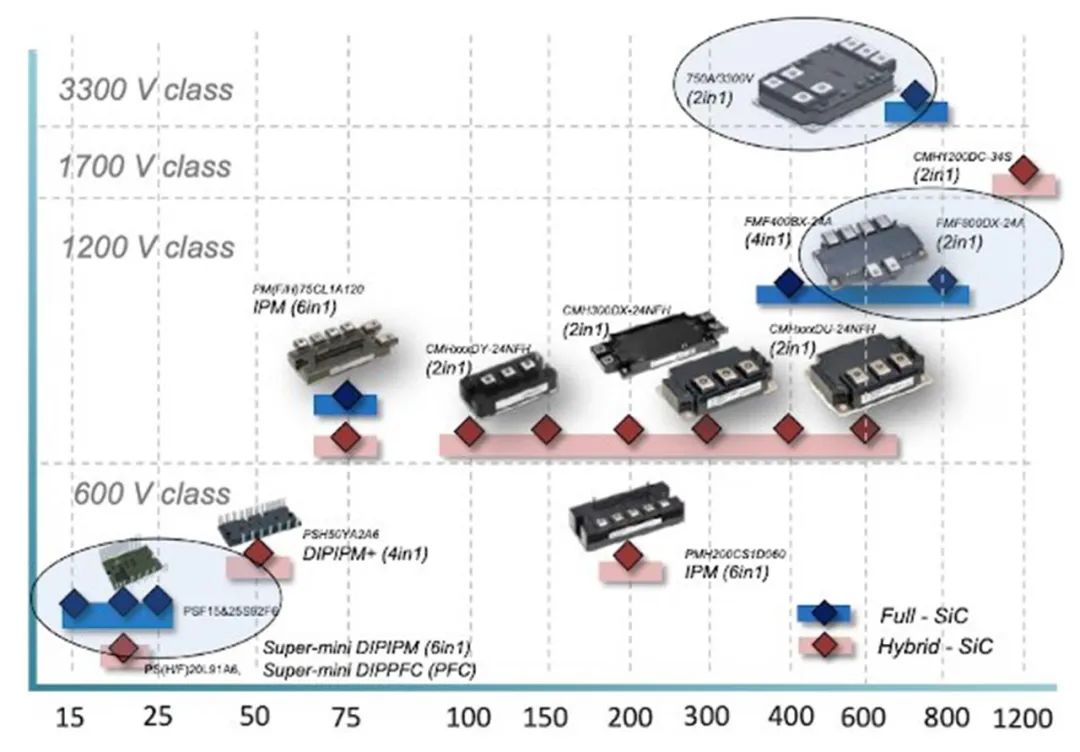



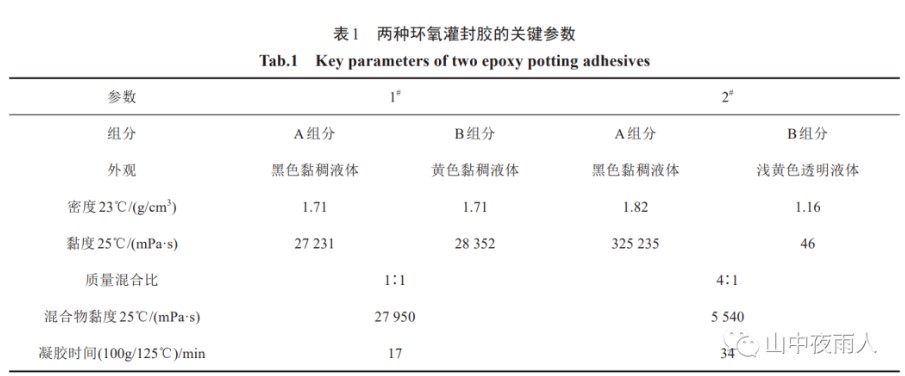



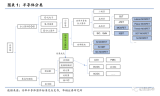
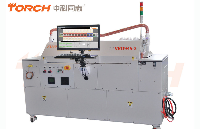




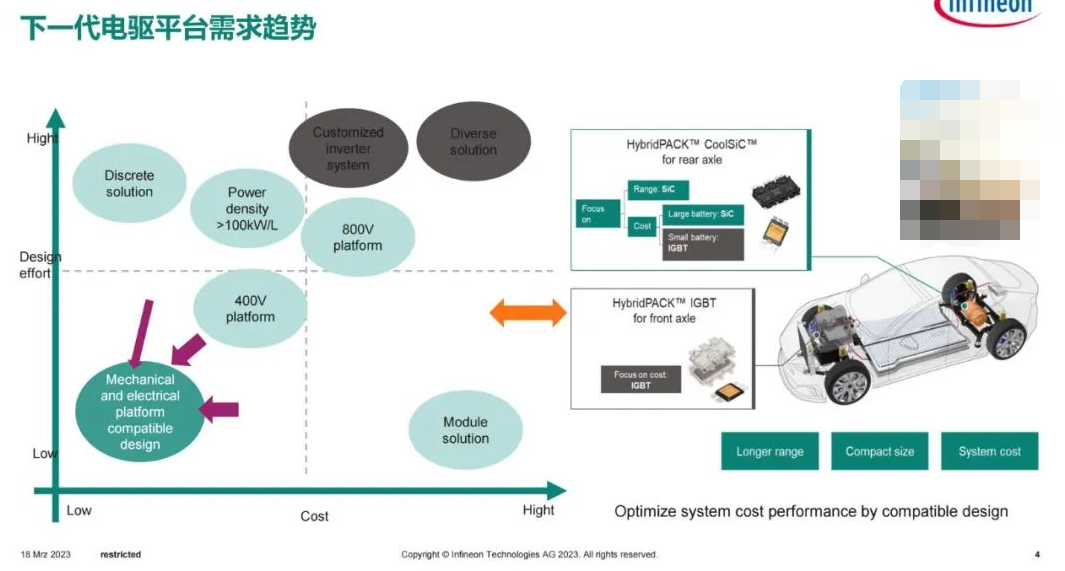
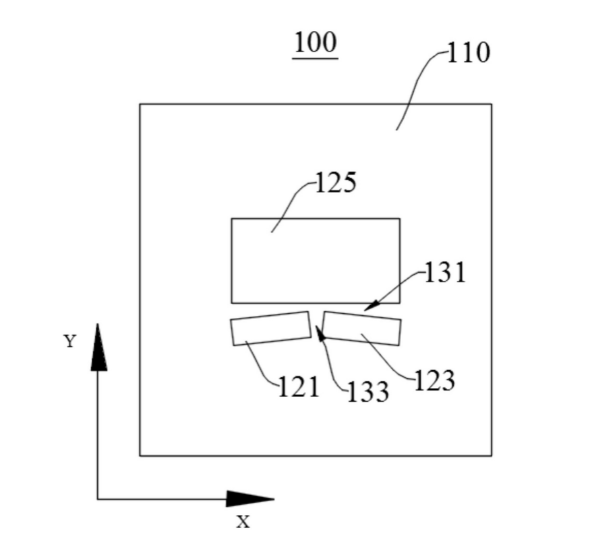

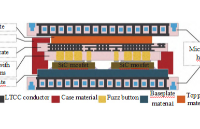











評論