來(lái)源:半導(dǎo)體風(fēng)向標(biāo) 從HBM存儲(chǔ)器到3D NAND芯片,再到CoWoS,硬件市場(chǎng)上有許多芯片是用英文稱為TSV構(gòu)建的,TSV是首字母縮寫(xiě),意為“通過(guò)硅通孔”并翻譯為via硅的事實(shí),它們垂直地穿過(guò)
2023-07-26 10:06:15 335
335 日本的半導(dǎo)體公司rafidus成立于2022年8月,目前正集中開(kāi)發(fā)利用2.5d和3d包裝將多個(gè)不同芯片組合起來(lái)的異構(gòu)體集成技術(shù)。Rapidus當(dāng)天通過(guò)網(wǎng)站表示:“計(jì)劃與西方企業(yè)合作,開(kāi)發(fā)新一代3d lsi(大規(guī)模集成電路),并利用領(lǐng)先技術(shù),批量生產(chǎn)2納米及以下工程的芯片。”
2023-07-21 10:32:31 437
437 編者注:TSV是通過(guò)在芯片與芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通;TSV技術(shù)通過(guò)銅、鎢、多晶硅等導(dǎo)電物質(zhì)的填充,實(shí)現(xiàn)硅通孔的垂直電氣互聯(lián),這項(xiàng)技術(shù)是目前唯一的垂直電互連技術(shù),是實(shí)現(xiàn)3D先進(jìn)封裝的關(guān)鍵技術(shù)之一。
2023-07-03 09:45:34 873
873 
稱為增材制造,是一個(gè)總稱,涵蓋了幾種截然不同的 3D 打印工藝。這些技術(shù)是天壤之別,但關(guān)鍵過(guò)程是相同的。例如,所有 3D 打印都從數(shù)字模型開(kāi)始,因?yàn)樵?b style="color: red">技術(shù)本質(zhì)上是數(shù)字化的。零件或產(chǎn)品最初是使用計(jì)算機(jī)輔助設(shè)計(jì) (CAD) 軟件設(shè)計(jì)或從數(shù)字零件庫(kù)獲
2023-06-29 15:36:27 810
810 工藝的發(fā)展重點(diǎn)。 ? 當(dāng)前最主要的封裝形式仍然為倒裝鍵合和引線鍵合,先進(jìn)封裝(包括2.5D集成、Fan-out WLP/PLP等)已經(jīng)進(jìn)入市場(chǎng)并占據(jù)一定市場(chǎng)份額,3D集成是當(dāng)前技術(shù)研究熱點(diǎn)。2018年底,英特爾發(fā)布了首個(gè)商用3D集成技術(shù):FOVEROS混合封裝。 ? 傳統(tǒng)的集成電
2023-05-31 11:02:40 884
884 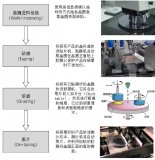
等提供小尺寸、高性能的芯片。通過(guò)綜述 TSV、TGV、 RDL 技術(shù)及相應(yīng)的 2.5D、3D 異質(zhì)集成方案,闡述了當(dāng)前研究現(xiàn)狀,并探討存在的技術(shù)難點(diǎn)及未來(lái)發(fā) 展趨勢(shì)。
2023-04-26 10:06:07 292
292 
然已經(jīng)有很多關(guān)于 3D 設(shè)計(jì)的討論,但對(duì)于 3D 的含義有多種解釋。然而,這不僅僅是語(yǔ)義,因?yàn)槊總€(gè)封裝選項(xiàng)都需要不同的設(shè)計(jì)方法和技術(shù)。
2023-03-27 13:01:38 299
299 :“BeSang創(chuàng)立于三年前,是家專門做3D IC技術(shù)的公司, BeSang即將實(shí)現(xiàn)單芯片3D IC工藝的商業(yè)化應(yīng)用。通過(guò)在邏輯器件頂部使用低溫工藝和縱向存儲(chǔ)設(shè)備,每個(gè)晶圓可以制造更多的裸片,這就是裸片
2008-08-18 16:37:37
本文要點(diǎn):3D集成電路需要一種方法來(lái)連接封裝中垂直堆疊的多個(gè)裸片由此,與制造工藝相匹配的硅通孔(Through-SiliconVias,TSV)設(shè)計(jì)應(yīng)運(yùn)而生硅通孔設(shè)計(jì)有助于實(shí)現(xiàn)更先進(jìn)的封裝能力,可以
2022-11-17 17:58:04 429
429 
為了應(yīng)對(duì)半導(dǎo)體芯片高密度、高性能與小體積、小尺寸之間日益嚴(yán)峻的挑戰(zhàn),3D 芯片封裝技術(shù)應(yīng)運(yùn)而生。從工藝和裝備兩個(gè)角度詮釋了 3D 封裝技術(shù);介紹了國(guó)內(nèi)外 3D 封裝技術(shù)的研究現(xiàn)狀和國(guó)內(nèi)市場(chǎng)對(duì) 3D
2022-11-11 09:43:08 1109
1109 多年來(lái),3D IC技術(shù)已從初始階段發(fā)展成為一種成熟的主流制造技術(shù)。EDA行業(yè)引入了許多工具和技術(shù)來(lái)幫助設(shè)計(jì)采用3D IC路徑的產(chǎn)品。最近,復(fù)雜的SoC實(shí)現(xiàn)開(kāi)始利用3D IC技術(shù)來(lái)平衡性能和成本目標(biāo)。
2022-09-16 10:06:41 830
830 異質(zhì)整合需要通過(guò)先進(jìn)封裝提升系統(tǒng)性能,以2.5D/3D IC封裝為例,可提供用于存儲(chǔ)器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 2860
2860 并討論了構(gòu)建下一代 3D 片上系統(tǒng)所需的技術(shù)。各級(jí)報(bào)告的進(jìn)展將使系統(tǒng)設(shè)計(jì)和開(kāi)發(fā)進(jìn)入下一個(gè)層次,有望在系統(tǒng)的功率-性能-面積-成本 (PPAC) 指標(biāo)方面獲得巨大回報(bào)。 未來(lái)幾年哪些主要趨勢(shì)將標(biāo)志著您的研究領(lǐng)域? Eric Beyne:“傳統(tǒng)的 CMOS 技術(shù)規(guī)模化——產(chǎn)生單片 CMOS 單芯片片上
2022-07-26 10:39:05 1041
1041 
硅通孔(Through Silicon Via,TSV)技術(shù)是一項(xiàng)高密度封裝技術(shù),它正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認(rèn)為是第四代封裝技術(shù)。在2.5D/3D IC中TSV被大規(guī)模應(yīng)用于
2022-05-31 15:24:39 1736
1736 2.5D/3D 芯片包含 Interposer/ 硅穿孔 (Through Silicon Via, TSV) 等復(fù)雜結(jié)構(gòu),通過(guò)多物理場(chǎng)
仿真可以提前對(duì) 2.5D/3D 芯片的設(shè)計(jì)進(jìn)行信號(hào)完整性
2022-05-06 15:20:42 8
8 直通硅通孔(TSV)器件是3D芯片封裝的關(guān)鍵推動(dòng)者,可提高封裝密度和器件性能。要實(shí)現(xiàn)3DIC對(duì)下一代器件的優(yōu)勢(shì),TSV縮放至關(guān)重要。
2022-04-12 15:32:46 732
732 
本文介紹了一種新型的高縱橫比TSV電鍍添加劑系統(tǒng),利用深層反應(yīng)離子蝕刻(DRIE)技術(shù)對(duì)晶片形成圖案,并利用物理氣相沉積(PVD)技術(shù)沉積種子層。通過(guò)陽(yáng)極位置優(yōu)化、多步驟TSV填充過(guò)程、添加劑濃度
2021-12-27 16:00:41 1390
1390 
單片工作原理—3D動(dòng)畫(huà)演示
2021-11-10 18:35:59 38
38 眾所周知3D打印技術(shù)在醫(yī)學(xué)上面的應(yīng)用是越來(lái)越多,也越來(lái)越廣了。近日,上海交通大學(xué)醫(yī)學(xué)3D打印創(chuàng)新研究中心日照分中心在市人民醫(yī)院成立,這是日照首個(gè)醫(yī)學(xué)3D打印創(chuàng)新研究中心,標(biāo)志著日照市醫(yī)學(xué)3D打印技術(shù)發(fā)展邁上了新臺(tái)階。
2021-07-22 15:13:40 2270
2270 1.??3D視覺(jué)技術(shù) 2D視覺(jué)技術(shù)借助強(qiáng)大的計(jì)算機(jī)視覺(jué)和深度學(xué)習(xí)算法取得了超越人類認(rèn)知的成就,而3D視覺(jué)則因?yàn)樗惴ń:铜h(huán)境依賴等問(wèn)題,一直處于正在研究的前沿。 3D視覺(jué)同樣為傳統(tǒng)研究領(lǐng)域,但最近5
2021-04-01 14:01:26 4093
4093 
異構(gòu) 3D 系統(tǒng)級(jí)封裝集成 3D 集成與封裝技術(shù)的進(jìn)步使在單個(gè)封裝(包含采用多項(xiàng)技術(shù)的芯片)內(nèi)構(gòu)建復(fù)雜系統(tǒng)成為了可能。 過(guò)去,出于功耗、性能和成本的考慮,高級(jí)集成使用單片實(shí)施。得益于封裝與堆疊技術(shù)
2021-03-22 09:27:53 1881
1881 AI技術(shù)的研究正在從2D走向更高難度的3D。12月3日,記者獲悉,阿里技術(shù)團(tuán)隊(duì)研發(fā)了全新3D AI算法,可基于2D圖片精準(zhǔn)搜索出相應(yīng)的3D模型,準(zhǔn)確率大幅提升10%,可降低3D打印、VR看房、場(chǎng)景
2020-12-04 15:49:21 2990
2990 盛美半導(dǎo)體設(shè)備(NASDAQ:ACMR),作為半導(dǎo)體制造與先進(jìn)晶圓級(jí)封裝領(lǐng)域中領(lǐng)先的設(shè)備供應(yīng)商,近日發(fā)布了應(yīng)用于填充3D硅通孔(TSV)的硅通孔電鍍?cè)O(shè)備Ultra ECP 3d。借助盛美半導(dǎo)體電鍍?cè)O(shè)備的平臺(tái),該設(shè)備可為高深寬比(H.A.R)銅應(yīng)用提供高性能、無(wú)孔洞的鍍銅功能。
2020-11-26 11:30:45 2916
2916 在Intel、臺(tái)積電各自推出自家的3D芯片封裝技術(shù)之后,三星也宣布新一代3D芯片技術(shù)——X-Cube,基于TSV硅穿孔技術(shù),可以將不同芯片搭積木一樣堆疊起來(lái),目前已經(jīng)可以用于7nm及5nm工藝。
2020-10-10 15:22:58 1440
1440 三星計(jì)劃明年開(kāi)始與臺(tái)積電在封裝先進(jìn)芯片方面展開(kāi)競(jìng)爭(zhēng),因而三星正在加速部署3D芯片封裝技術(shù)。
2020-09-20 12:09:16 2798
2798 “盡管3D打印為MEMS技術(shù)的施展提供了更大的自由,但只有平均不到1%的3D打印相關(guān)研究集中在MEMS技術(shù)上。”研究人員表示,“這與MEMS制造中3D打印技術(shù)的潛在優(yōu)勢(shì)形成了鮮明反差,特別是3D打印還可避免因各向異性蝕刻圖案未對(duì)準(zhǔn)而導(dǎo)致的3D結(jié)構(gòu)欠蝕刻的相關(guān)問(wèn)題。”
2020-07-08 09:53:26 2913
2913 
SIP有多種定義和解釋,其中一說(shuō)是多芯片堆疊的3D封裝內(nèi)系統(tǒng)集成,在芯片的正方向堆疊2片以上互連的裸芯片的封裝。SIP是強(qiáng)調(diào)封裝內(nèi)包含了某種系統(tǒng)的功能封裝,3D封裝僅強(qiáng)調(diào)在芯片方向上的多芯片堆疊
2020-05-28 14:51:44 5102
5102 波蘭華沙大學(xué)的研究人員利用激光直接書(shū)寫(xiě)(DLW)3D打印技術(shù)設(shè)計(jì)出了微米大小的鏡片。這種3D打印的透鏡可以在各種材料上制作,包括易碎的石墨烯類材料。
2020-05-18 23:36:59 3635
3635 從最初為圖像傳感器設(shè)計(jì)的硅2.5D集成技術(shù),到復(fù)雜的高密度的高性能3D系統(tǒng),硅3D集成是在同一芯片上集成所有功能的系統(tǒng)芯片(SoC)之外的另一種支持各種類型的應(yīng)用的解決方案,可用于創(chuàng)建性價(jià)比更高的系統(tǒng)。
2020-04-10 17:38:49 1980
1980 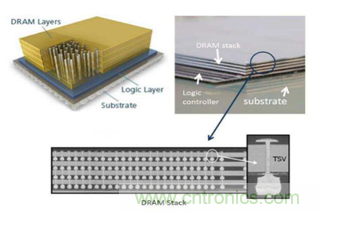
從低密度的后通孔TSV 硅3D集成技術(shù),到高密度的引線混合鍵合或3D VSLI CoolCubeTM解決方案,研究人員發(fā)現(xiàn)許多開(kāi)發(fā)新產(chǎn)品的機(jī)會(huì)。本文概述了當(dāng)前新興的硅3D集成技術(shù),討論了圖像傳感器
2020-01-16 09:53:00 695
695 類比積體電路設(shè)計(jì)也將進(jìn)入三維晶片(3D IC)時(shí)代。在數(shù)位晶片開(kāi)發(fā)商成功量產(chǎn)3D IC方案后,類比晶片公司也積極建置類比3D IC生產(chǎn)線,期透過(guò)矽穿孔(TSV)與立體堆疊技術(shù),在單一封裝內(nèi)整合采用不同制程生產(chǎn)的異質(zhì)類比元件,以提升包括電源晶片、感測(cè)器與無(wú)線射頻(RF)等各種類比方案效能。
2019-10-21 14:28:53 973
973 類比積體電路設(shè)計(jì)也將進(jìn)入三維晶片(3D IC)時(shí)代。在數(shù)位晶片開(kāi)發(fā)商成功量產(chǎn)3D IC方案后,類比晶片公司也積極建置類比3D IC生產(chǎn)線,期透過(guò)矽穿孔(TSV)與立體堆疊技術(shù),在單一封裝內(nèi)整合采用不同制程生產(chǎn)的異質(zhì)類比元件,以提升包括電源晶片、感測(cè)器與無(wú)線射頻(RF)等各種類比方案效能。
2019-10-14 14:18:13 762
762 這項(xiàng)新技術(shù)允許使用超過(guò)60,000個(gè)TSV孔堆疊12個(gè)DRAM芯片,同時(shí)保持與當(dāng)前8層芯片相同的厚度。 全球先進(jìn)半導(dǎo)體技術(shù)的領(lǐng)導(dǎo)者三星電子今天宣布,它已開(kāi)發(fā)出業(yè)界首個(gè)12層3D-TSV(直通硅通孔
2019-10-08 16:32:23 5357
5357 從英特爾所揭露的技術(shù)資料可看出,F(xiàn)overos本身就是一種3D IC技術(shù),透過(guò)硅穿孔(Through-Silicon Via, TSV)技術(shù)與微凸塊(micro-bumps)搭配,把不同的邏輯芯片堆疊起來(lái)。
2019-08-14 11:18:42 2987
2987 
對(duì)于3D封裝技術(shù),英特爾去年宣布了其對(duì)3D芯片堆疊的研究,AMD也談到了在其芯片上疊加3D DRAM和SRAM的方案。
2019-08-13 10:27:53 2478
2478 從英特爾所揭露的技術(shù)資料可看出,F(xiàn)overos本身就是一種3D IC技術(shù),透過(guò)硅穿孔(Through-Silicon Via, TSV)技術(shù)與微凸塊(micro-bumps)搭配,把不同的邏輯芯片堆疊起來(lái)。
2019-07-08 11:47:33 4538
4538 對(duì)于目前的高端市場(chǎng),市場(chǎng)上最流行的2.5D和3D集成技術(shù)為3D堆疊存儲(chǔ)TSV,以及異構(gòu)堆疊TSV中介層。Chip-on-Wafer-on-Substrate(CoWos)技術(shù)已經(jīng)廣泛用于高性能計(jì)算
2019-02-15 10:42:19 5984
5984 
在近日舉行的英特爾“架構(gòu)日”活動(dòng)中,英特爾不僅展示了基于10納米的PC、數(shù)據(jù)中心和網(wǎng)絡(luò)系統(tǒng),支持人工智能和加密加速功能的下一代“Sunny Cove”架構(gòu),還推出了業(yè)界首創(chuàng)的3D邏輯芯片封裝技術(shù)——Foveros。這一全新的3D封裝技術(shù)首次引入了3D堆疊的優(yōu)勢(shì),可實(shí)現(xiàn)在邏輯芯片上堆疊邏輯芯片。
2018-12-14 15:35:32 7653
7653 作為前沿技術(shù)之一,3D打印可謂是賺足了球。在世界各國(guó)研究人員的共同推動(dòng)下,3D打印技術(shù)不斷成熟,眾多3D打印設(shè)備也逐步應(yīng)用于工農(nóng)業(yè)生產(chǎn)等多個(gè)場(chǎng)景。在3D打印融入具體應(yīng)用場(chǎng)景的過(guò)程中,其潛在的商用價(jià)值得以展現(xiàn),這引起了一些美食從業(yè)者的重視。
2018-11-02 15:31:02 2155
2155 奧地利維也納理工大學(xué)材料科學(xué)與技術(shù)研究所的科研團(tuán)隊(duì),對(duì)人體胎盤機(jī)制進(jìn)行了研究,采用的正是器官芯片的方法。在制造芯片時(shí),TU Wien團(tuán)隊(duì)使用了雙光子聚合微納米3D打印技術(shù)。
2018-08-17 10:23:49 2465
2465 的填充,實(shí)現(xiàn)硅通孔的垂直電氣互連。硅通孔技術(shù)可以通過(guò)垂直互連減小互聯(lián)長(zhǎng)度,減小信號(hào)延遲,降低電容/電感,實(shí)現(xiàn)芯片間的低功耗,高速通訊,增加寬帶和實(shí)現(xiàn)器件集成的小型化。基于TSV技術(shù)的3D封裝主要有以下幾個(gè)方面優(yōu)勢(shì):
2018-08-14 15:39:10 88421
88421 醫(yī)藥生物行業(yè)是目前 3D 打印技術(shù)擴(kuò)張最為迅猛的行業(yè)。3D 打印技術(shù)能夠?yàn)獒t(yī)療生物行業(yè)提供更完整的個(gè)性化解決方案;生物 3D 打印技術(shù)將促進(jìn)再生醫(yī)學(xué)領(lǐng)域在人造活體組織與器官的研究。在個(gè)性化
2017-09-24 09:23:55 11
11 3D打印技術(shù)近年來(lái)得到普遍關(guān)注。目前,3D打印技術(shù)在各領(lǐng)域的應(yīng)用已取得明顯進(jìn)展,但是3D打印技術(shù)還沒(méi)有得到全面應(yīng)用。就地學(xué)信息領(lǐng)域而言,僅在個(gè)別部門得到初步應(yīng)用。
2017-06-23 10:32:12 3578
3578 3D打印技術(shù)以令人驚嘆的速度發(fā)展起來(lái),3D汽車、3D器官、3D食物等等都將會(huì)深刻地影響我們?nèi)粘I睢km然3D打印技術(shù)現(xiàn)在并不完善,但是一旦邁過(guò)這個(gè)技術(shù)門檻,絕對(duì)會(huì)給我們的世界帶來(lái)巨大的變革。與此對(duì)應(yīng)的,城市也將會(huì)迎來(lái)新的發(fā)展機(jī)遇和變化。
2017-05-17 10:29:56 1852
1852 3D顯示技術(shù)和3D電視機(jī)
2017-04-21 10:11:22 12
12 3D技術(shù)的應(yīng)用探索3D機(jī)器視覺(jué)庫(kù) 的資料。
2016-03-22 15:01:57 27
27 2014年S3S會(huì)議上,工程師共同分享了SOI材料的優(yōu)勢(shì),亞閾值電壓的設(shè)計(jì)新方案,單片3D集成以及今年的企業(yè)并購(gòu)案。今年芯片行業(yè)一共有23起收購(gòu)案,比前兩年的總量還多。預(yù)計(jì)到年底,并購(gòu)的總額將由174億美元上升到30億美元。
2014-10-09 15:23:28 1311
1311 采用矽穿孔(TSV)的2.5D或3D IC技術(shù),由于具備更佳的帶寬與功耗優(yōu)勢(shì),并能以更高整合度突破制程微縮已趨近極限的挑戰(zhàn),是近年來(lái)半導(dǎo)體產(chǎn)業(yè)的重要發(fā)展方向。在產(chǎn)業(yè)界的積極推動(dòng)下,3D IC已從概念逐漸成為事實(shí),預(yù)計(jì)將于二至三年后進(jìn)入量產(chǎn)階段,必將成為未來(lái)市場(chǎng)的重要游戲改變者。
2013-03-07 09:13:13 1110
1110 聯(lián)電矽穿孔(TSV)制程將于2013年出爐。為爭(zhēng)食2.5D/三維晶片(3D IC)商機(jī)大餅,聯(lián)電加緊研發(fā)邏輯與記憶體晶片立體堆疊技術(shù),將采Via-Middle方式,在晶圓完成后旋即穿孔,再交由封測(cè)廠
2012-09-12 09:41:32 775
775 裸眼3D顯示技術(shù)詳解介紹了3D顯示原理、3D顯示分類、柱狀透鏡技術(shù)、視差屏障技術(shù)、指向光源技術(shù)以及3D顯示技術(shù)發(fā)展趨勢(shì)。
2012-08-17 13:39:55 143
143 通過(guò)裸眼3D技術(shù),你就能看到本來(lái)要借助特殊眼鏡才能觀看到的3D立體影像。很好奇吧,就讓《最新裸眼3D技術(shù)揭秘》技術(shù)專題帶你一起揭秘裸眼3D,一起了解裸眼3D技術(shù)、裸眼3D產(chǎn)品(含裸眼3D手機(jī)、裸眼3D顯示器、裸眼3D電視...)、裸眼3D技術(shù)特點(diǎn)、裸眼3D技術(shù)應(yīng)用等知識(shí)吧!
2012-08-17 12:21:52

封裝技術(shù)的進(jìn)步推動(dòng)了三維(3D)集成系統(tǒng)的發(fā)展。3D集成系統(tǒng)可能對(duì)基于標(biāo)準(zhǔn)封裝集成技術(shù)系統(tǒng)的性能、電源、功能密度和外形尺寸帶來(lái)顯著改善。雖然這些高度集成系統(tǒng)的設(shè)計(jì)和測(cè)試
2012-06-01 09:25:32 1350
1350 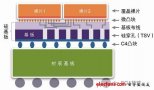
縮短型3D角反射器天線.
2012-04-25 15:03:39 58
58 主動(dòng)快門式3D技術(shù)和偏光式3D技術(shù)應(yīng)為看3D顯示設(shè)備還需要佩戴3D眼鏡,這讓不少用戶感覺(jué)到麻煩。裸眼3D讓用戶不用帶3D眼鏡即可看到3D畫(huà)面。
2012-02-28 09:45:17 6040
6040 
TSV3DIC技術(shù)雖早于2002年由IBM所提出,然而,在前后段IC制造技術(shù)水準(zhǔn)皆尚未成熟情況下,TSV3DIC技術(shù)發(fā)展速度可說(shuō)是相當(dāng)緩慢,DIGITIMESResearch分析師柴煥欣分析,直至2007年?yáng)|芝(Toshiba)將
2012-02-21 08:45:37 1350
1350 3D集成電路被定義為一種系統(tǒng)級(jí)集成結(jié)構(gòu)電路,在這一結(jié)構(gòu)中,多層平面器件被堆疊起來(lái),并經(jīng)由穿透硅通孔(TSV)在Z方向連接起來(lái)。
2011-12-15 14:47:55 5001
5001 
對(duì)3D封裝技術(shù)結(jié)構(gòu)特點(diǎn)、主流多層基板技術(shù)分類及其常見(jiàn)鍵合技術(shù)的發(fā)展作了論述,對(duì)過(guò)去幾年國(guó)際上硅通孔( TSV)技術(shù)發(fā)展動(dòng)態(tài)給與了重點(diǎn)的關(guān)注。尤其就硅通孔關(guān)鍵工藝技術(shù)如硅片減薄
2011-12-07 11:00:52 149
149 重點(diǎn)討論了垂直互連的硅通孔(TSV)互連工藝的關(guān)鍵技術(shù)及其加工設(shè)備面臨的挑戰(zhàn).提出了工藝和設(shè)備開(kāi)發(fā)商的應(yīng)對(duì)措施并探討了3DTSV封裝技術(shù)的應(yīng)用前景。
2011-12-07 10:59:23 87
87 在最近舉辦的GSA存儲(chǔ)大會(huì)上,芯片制造業(yè)的四大聯(lián)盟組織-IMEC, ITRI, Sematech以及SEMI都展示了他們各自在基于TSV的3D芯片技術(shù)方面的最新進(jìn)展
2011-04-14 18:38:31 5943
5943 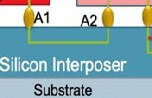
MASTERIMAGE 3D公司向世界展示強(qiáng)大的3D立體技術(shù) -- 4月份參加中國(guó)國(guó)際 3D 立體視像論壇暨展覽會(huì)以及美國(guó)
2010-04-08 08:27:59 496
496 本文研究了嵌入式3D引擎的特征,并給出了一個(gè)基于構(gòu)件技術(shù)的嵌入式3D引擎ElaDX的設(shè)計(jì)框架和初步實(shí)現(xiàn)。該3D引擎接口規(guī)范,使用方便,存儲(chǔ)空間小,具有靈活的可裁減性和可移植性
2009-05-30 09:14:33 17
17

 電子發(fā)燒友App
電子發(fā)燒友App









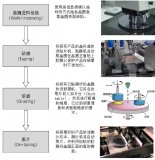








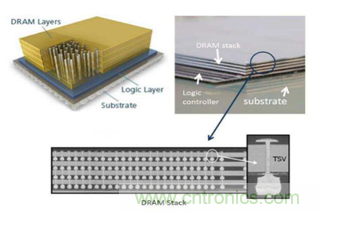



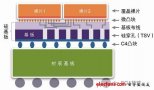


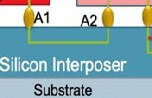










評(píng)論