日月光集團研發中心李長祺處長日前在世界半導體大會的先進封裝創新技術論壇上分享小芯片集成的2.5D/3D IC封裝技術,李處長表示, 全球數據總量在2025年將達到175ZB,大數據處理過程與傳輸及時化日趨重要。系統整合把傳輸的距離縮短,有效提升傳輸速率及能量效率。隨著硅光子學(Silicon Photonics)發展,光的傳輸頻寬級效率也變得越來越高,把光整合至封裝形態是未來重要的發展趨勢。
李處長也強調,系統整合與SoC分拆是驅動先進封裝與小芯片Chiplet集成的關鍵因素,在系統整合中,內存、電源與光學整合是主要的發展機會,SoC分拆中I/O分拆與SRAM分拆最為重要。小芯片Chiplet集成技術中細間距互連、大規模整合、電力傳輸以及散熱等都是未來主要發展方向。
2.5D/3D IC封裝特性與異質整合
異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。此外可通過DTC Interposer與IPD/Si Cap技術完成電源集成,通過高帶寬非封裝互連提供高性能的長距離資料傳輸。日月光目前與合作伙伴正在合作開發Optical Chiplet與Optical Interposer的技術,為進一步小型化提供可靠的解決方案。
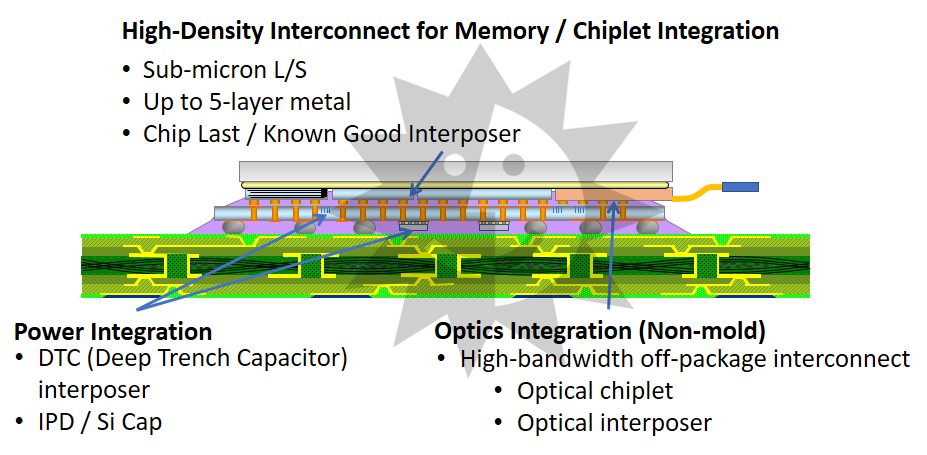
內存集成發展趨勢
內存頻寬的需求越來越高,高頻寬內存的集成發展成為關鍵競爭力。內存集成未來主要發展趨勢有兩種,一種是整合HBM3提高頻寬,另一種是做3D整合及堆疊,如SRAM堆疊及DRAM堆疊。日月光率先在2015年量產HBM1整合的封裝,2017年HBM2也順利量產,在2021年量產HBM2E,目前正朝著3D整合方向發展。
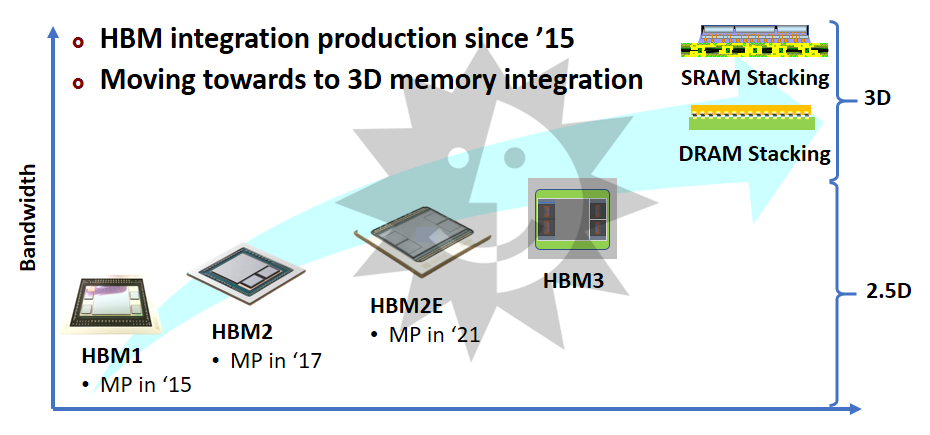
電源集成Si Cap發展趨勢
隨著電源功率越來越高,電容密度的要求也同步提高,因此電容整合的重要性尤為突出。日月光正在與合作伙伴共同開發不同的電容技術,例如應用在Si Cap及DTC Interposer上溝槽電容器(Trench Capacitor)以及電容密度更高的堆疊電容器(Stacked Capacitor),以滿足越來越高的電容密度需求。
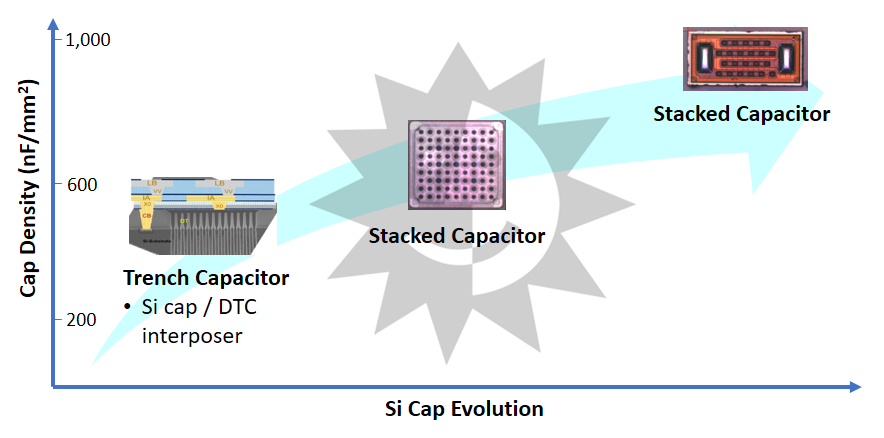
光學集成發展趨勢
頻寬與能量效率問題是未來電的長距離傳輸主要瓶頸,因此光學整合成為重點發展趨勢之一。目前日月光與合作伙伴開發兩種不同的光整合技術,第一個是光學小芯片Chiplet技術,應用2.5D 硅中介層(Silicon Interposer)整合光學小芯片Chiplet以及SoC技術,以滿足最高的能量效率與最高的頻寬,如應用于高速運算光學I/O的要求。另一個發展趨勢是基于3D整合的光學中介層(Optical Interposer)技術,即電子IC在上面,光子IC在下面,這種整合方式可提供更高的頻寬級能量效率的需求,可應用于網絡交換機。
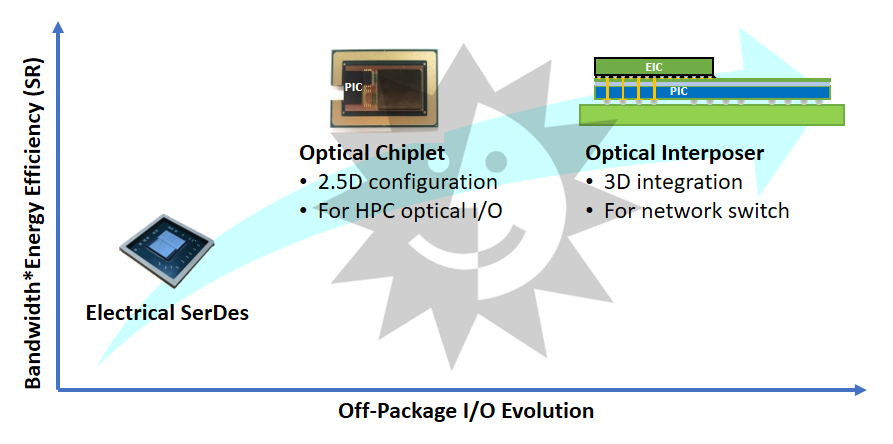
日月光持續開發不同的先進封裝如扇出型封裝Fan Out形態的 FOCoS、2.5D/3D IC封裝、混合鍵合Hybrid Bonding技術等,與產業鏈合作伙伴們共同研發合作,以滿足系統整合及小芯片Chiplet集成發展要求。
審核編輯:劉清
-
電容器
+關注
關注
64文章
6525瀏覽量
101845 -
soc
+關注
關注
38文章
4329瀏覽量
221627 -
DRAM芯片
+關注
關注
1文章
88瀏覽量
18268 -
IC封裝
+關注
關注
4文章
187瀏覽量
27126
原文標題:聚焦小芯片Chiplet集成的2.5D/3D IC 封裝技術
文章出處:【微信號:ASE_GROUP,微信公眾號:ASE日月光】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 分享一下小芯片集成的2.5D/3D IC封裝技術
分享一下小芯片集成的2.5D/3D IC封裝技術




















評論