本文是篇綜述,回顧了學(xué)術(shù)界、工業(yè)界在解決2.5D封裝熱力問(wèn)題上的努力。研究?jī)?nèi)容包含對(duì)翹曲應(yīng)變、BGA疲勞壽命的仿真測(cè)試評(píng)估,討論了材料物性、結(jié)構(gòu)參數(shù)的影響。
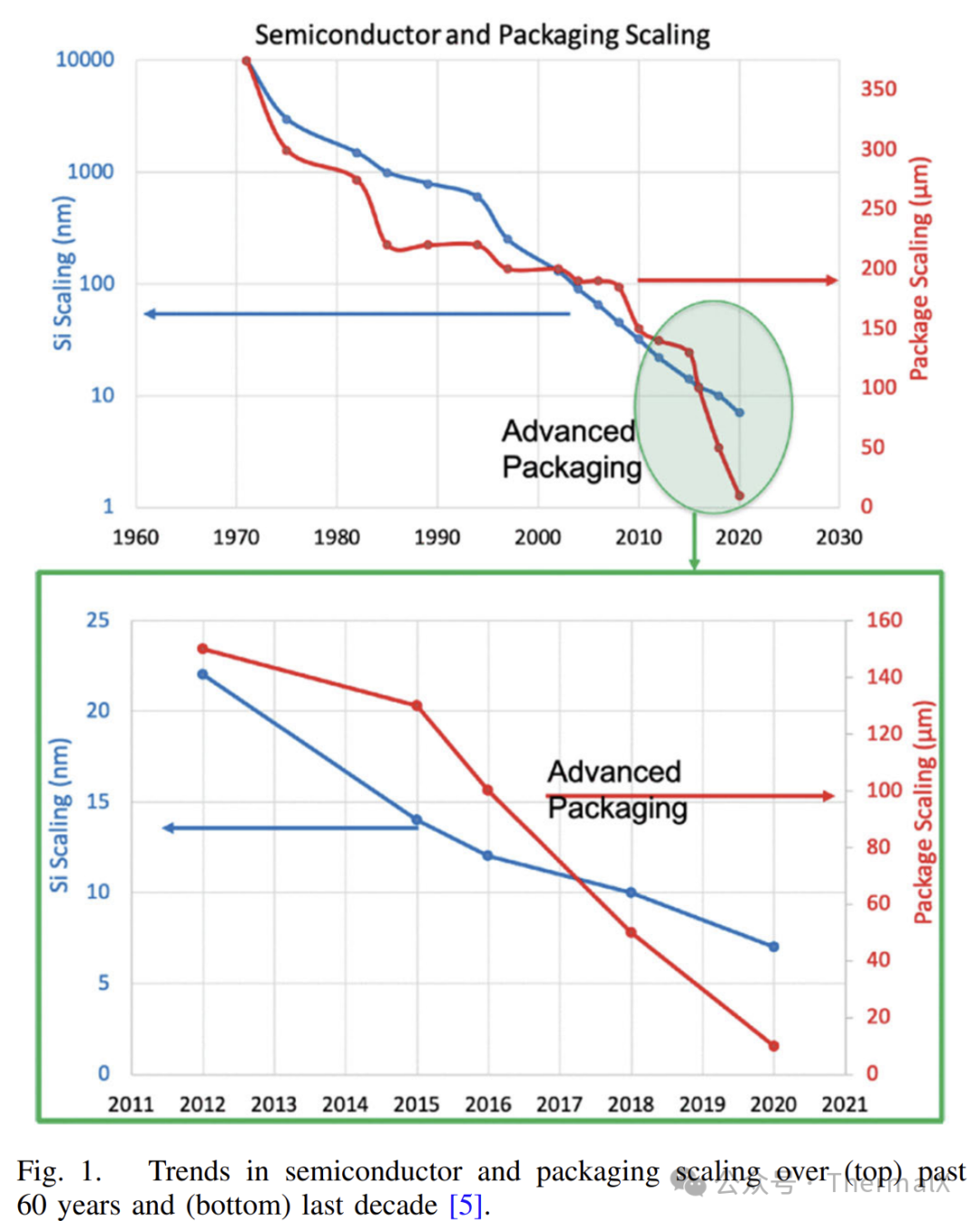
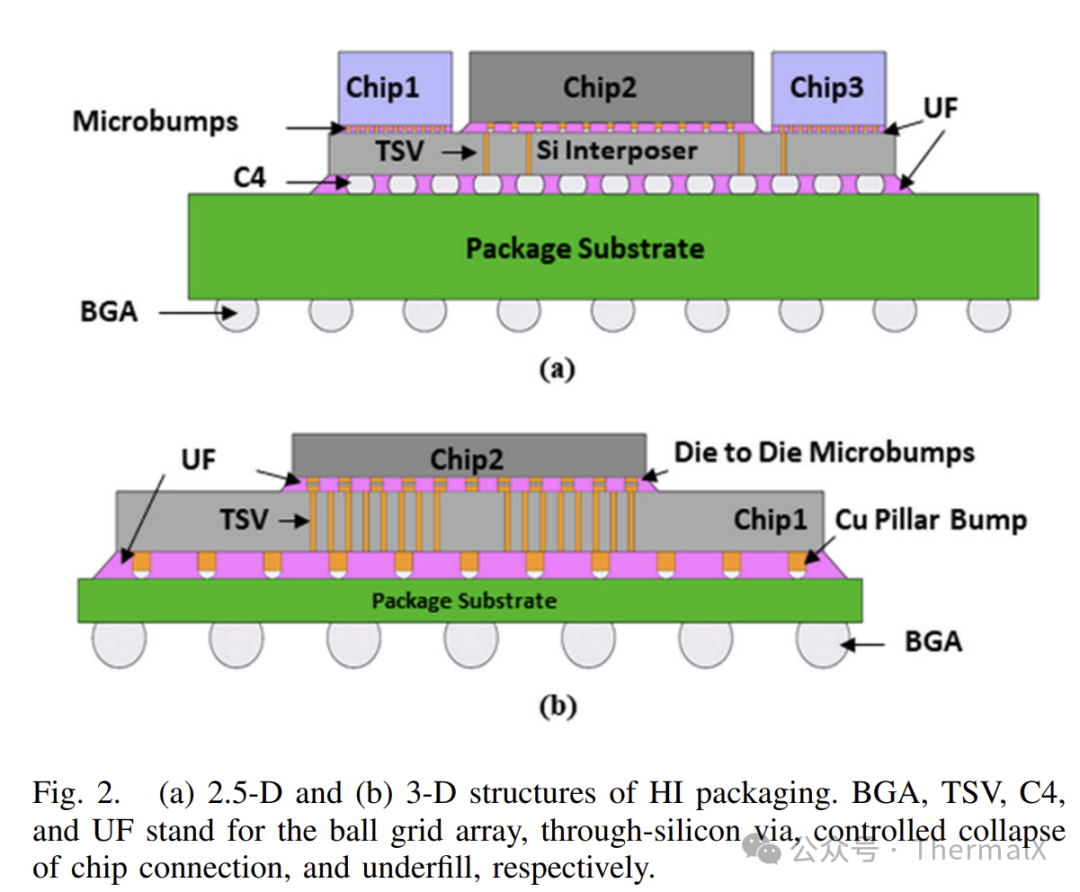
根據(jù)JEDEC,封裝失效機(jī)理可分為三類:1)溫度變化導(dǎo)致的熱力;2)化學(xué)或電化學(xué)導(dǎo)致的金屬腐蝕或遷移;3)高溫下的老化。2.5D封裝中,最主要的失效是第一類,因封裝尺寸越來(lái)越大,各部件材料CTE的不匹配,會(huì)引起熱變形或翹曲。翹曲不僅會(huì)導(dǎo)致焊球的non-wet或橋接,還會(huì)導(dǎo)致焊接界面的分層或斷裂,當(dāng)封裝焊到PCB后,應(yīng)力會(huì)導(dǎo)致BGA的疲勞失效。
翹曲有三類:
凸、凹、復(fù)雜翹曲。
翹曲的影響:
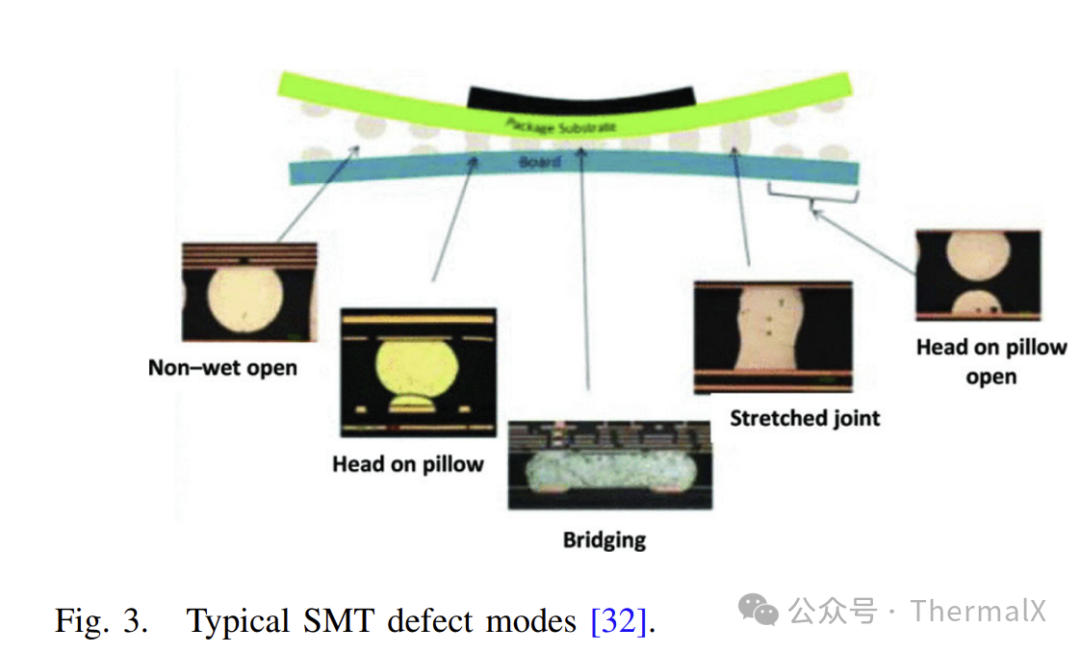
翹曲仿真一般都會(huì)做簡(jiǎn)化和等效,因此通過(guò)實(shí)驗(yàn)結(jié)果來(lái)驗(yàn)證仿真的準(zhǔn)確性至關(guān)重要。
翹曲的測(cè)試方法:shadow morie,3DIC,激光反射,條紋投影。前兩者應(yīng)用最廣:
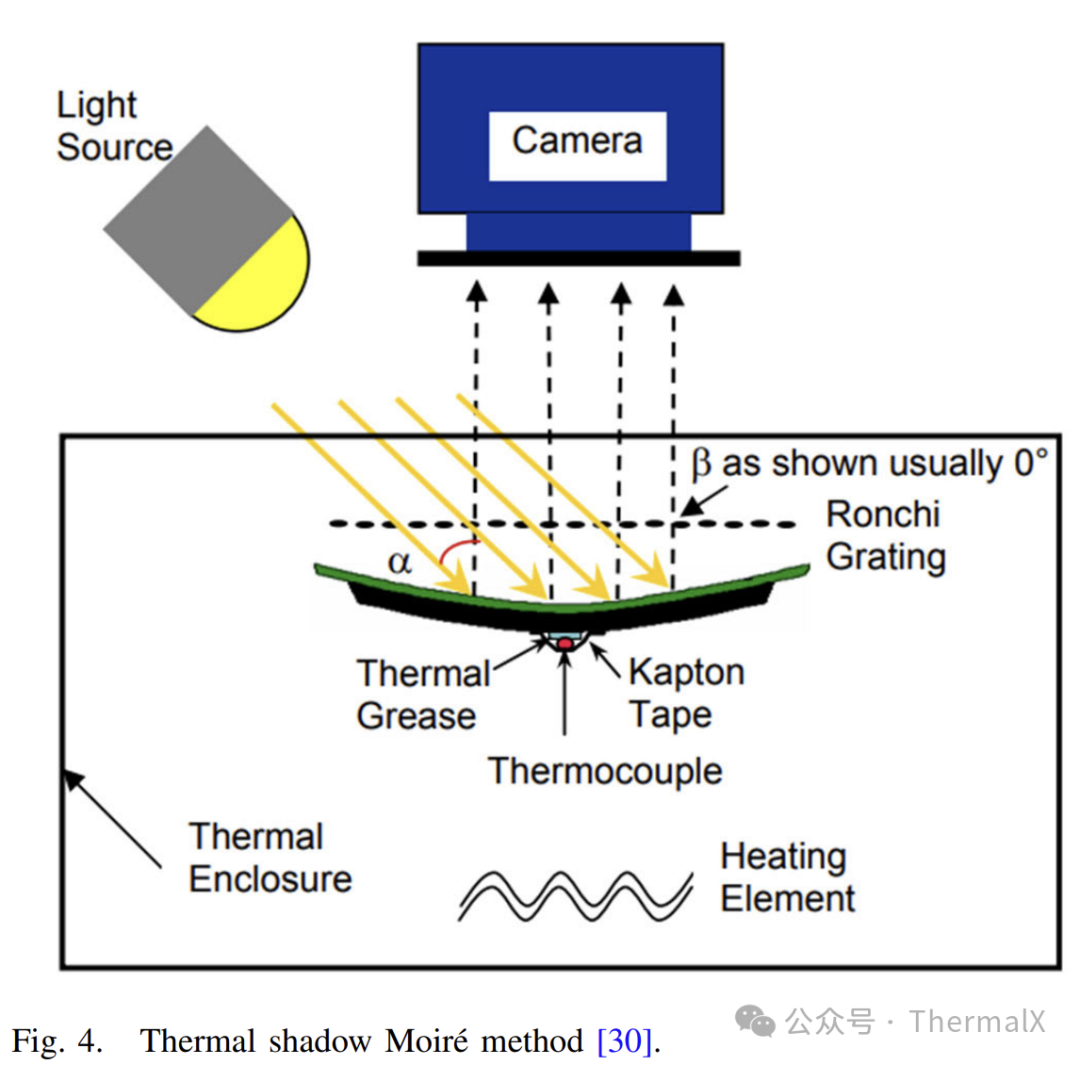

文章回顧了過(guò)往眾多論文里控制翹曲的各種參數(shù)分析,包含材料物性、幾何結(jié)構(gòu):

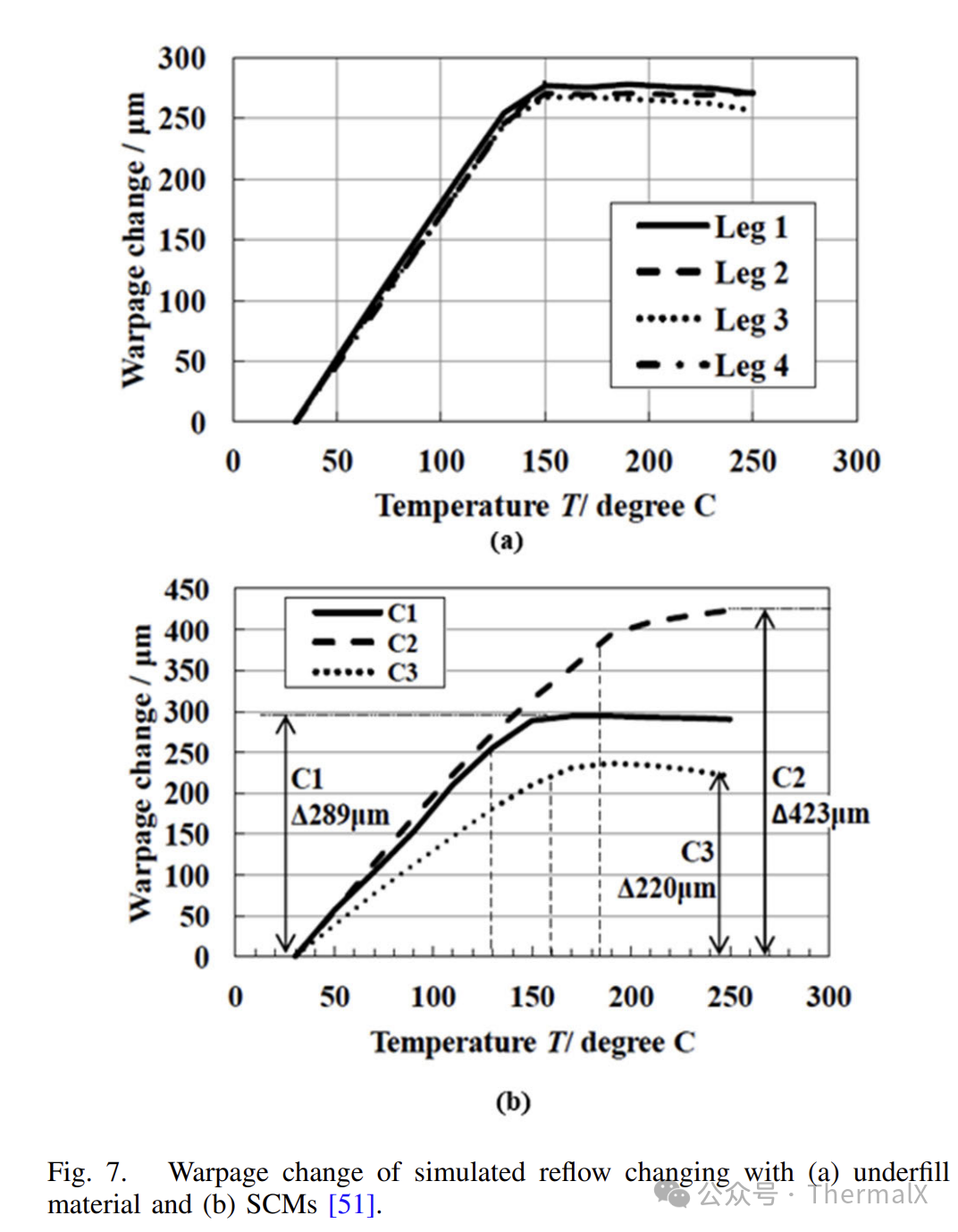
SCM:substrate core material.

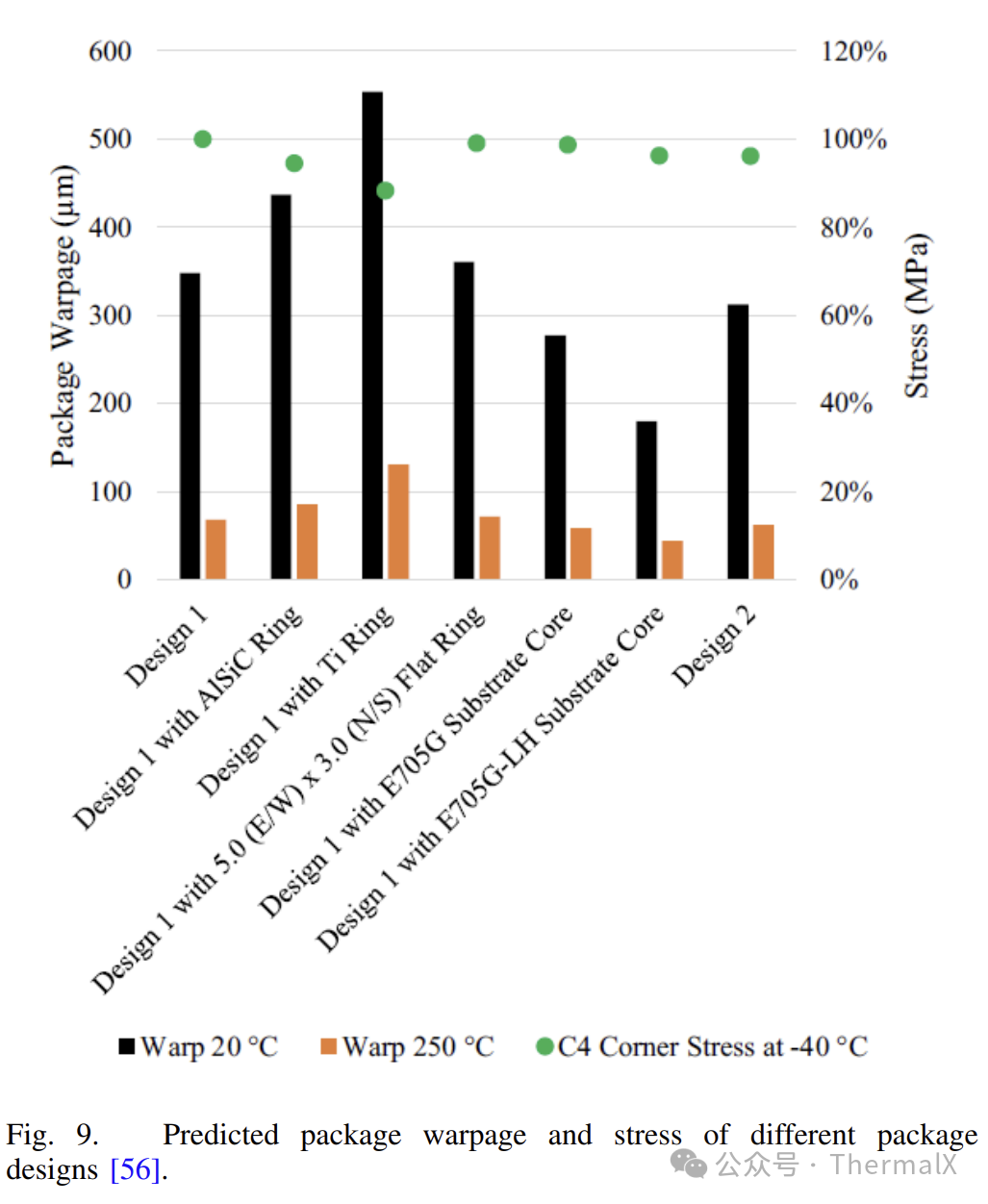

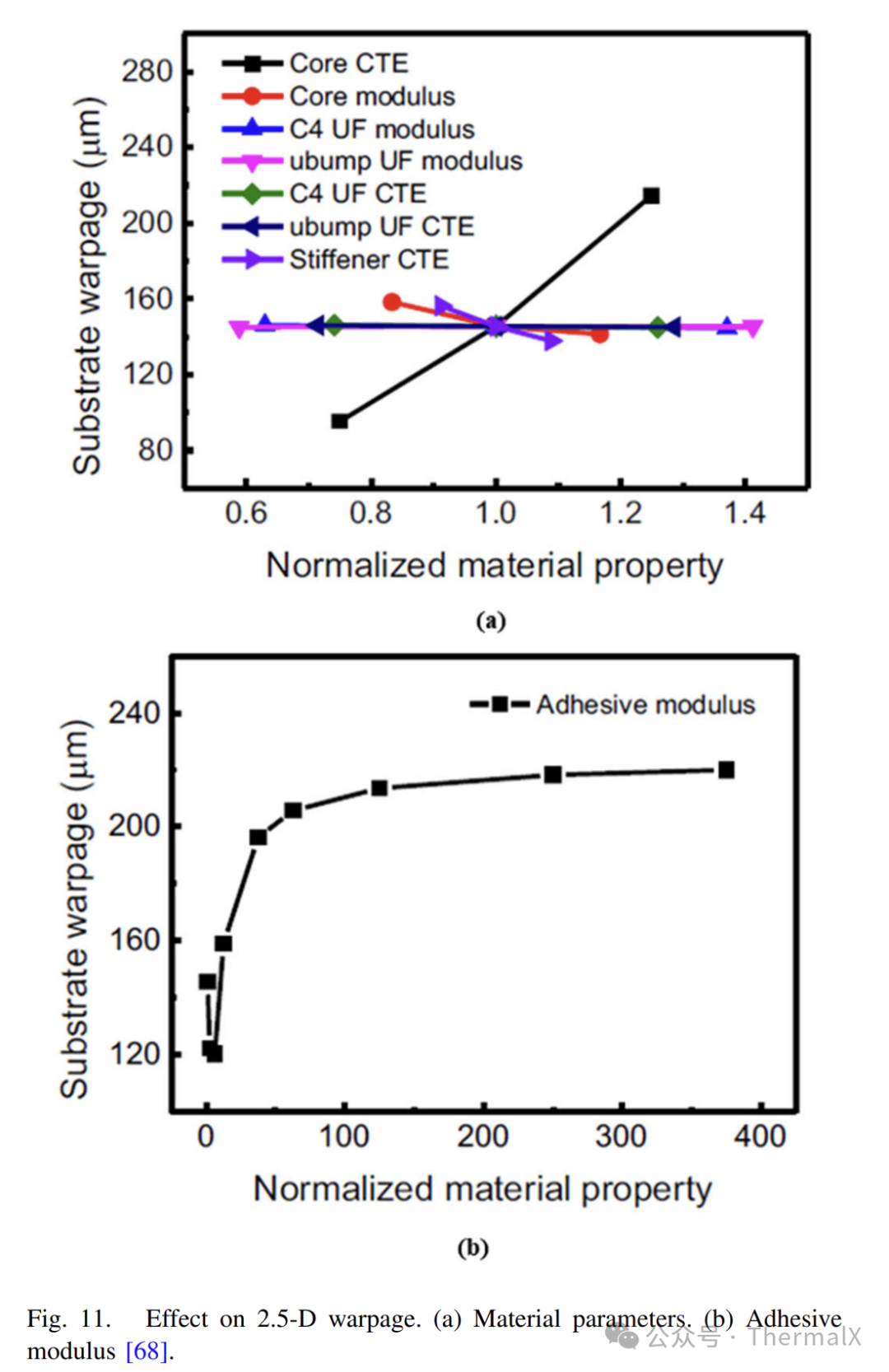
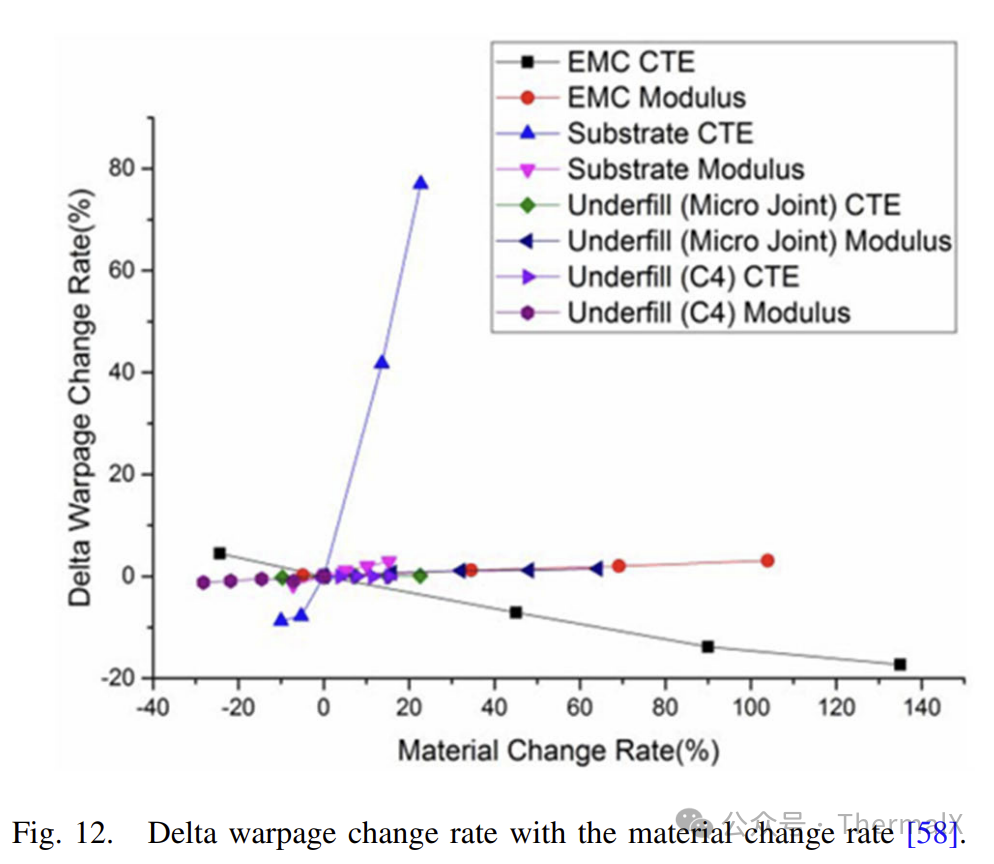
RA:Ring adhesive
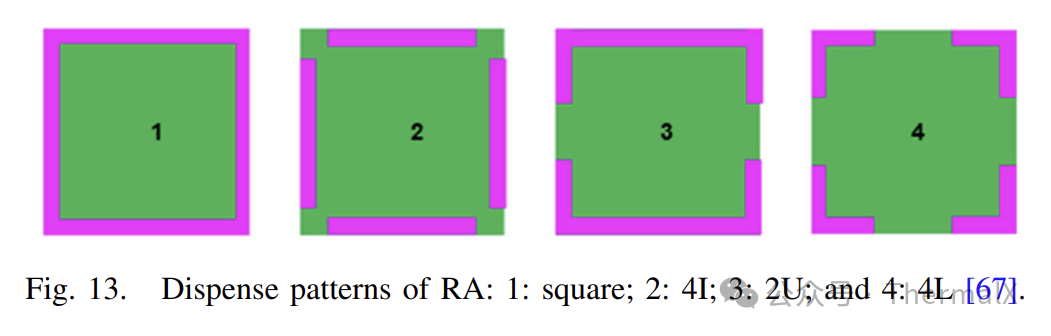
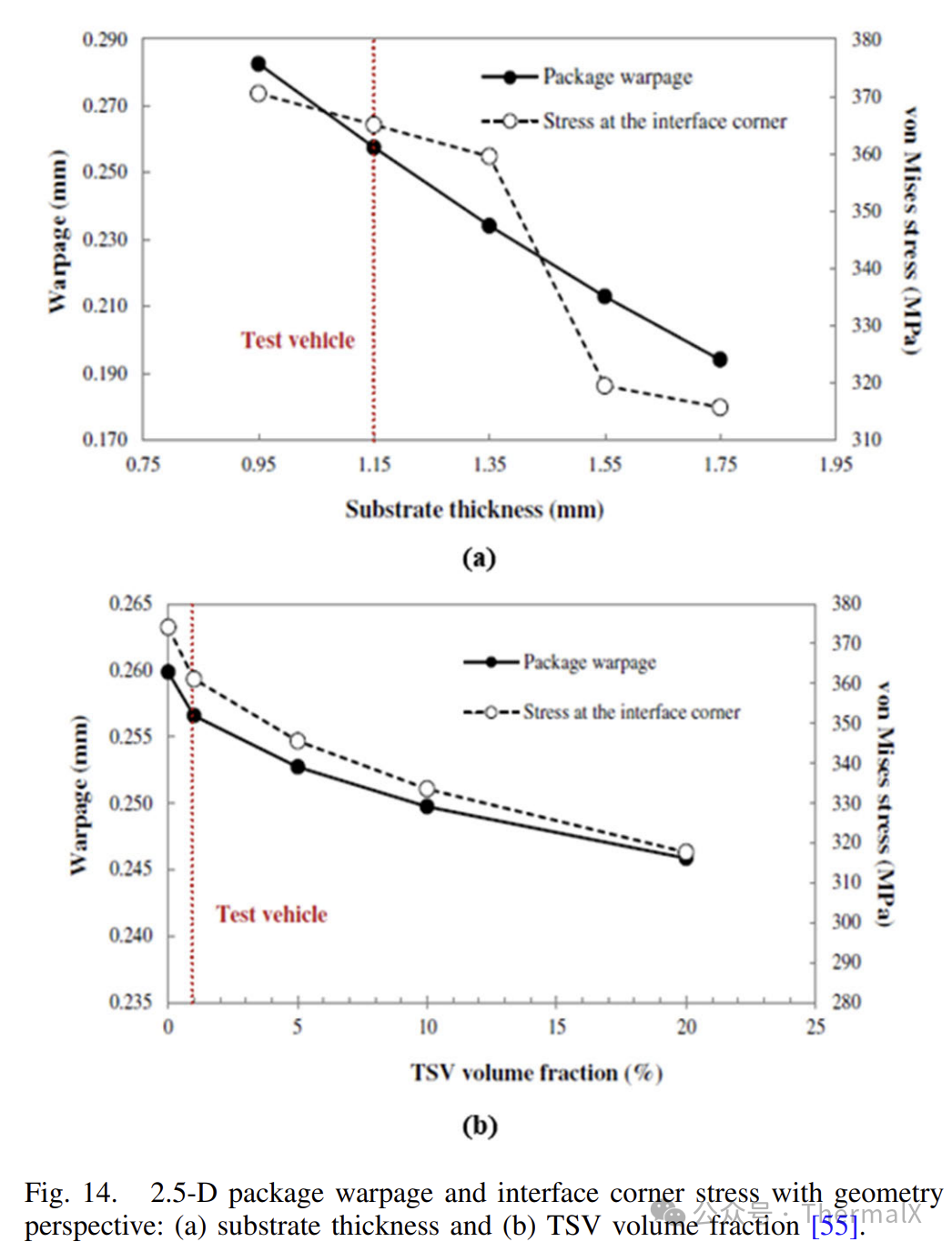
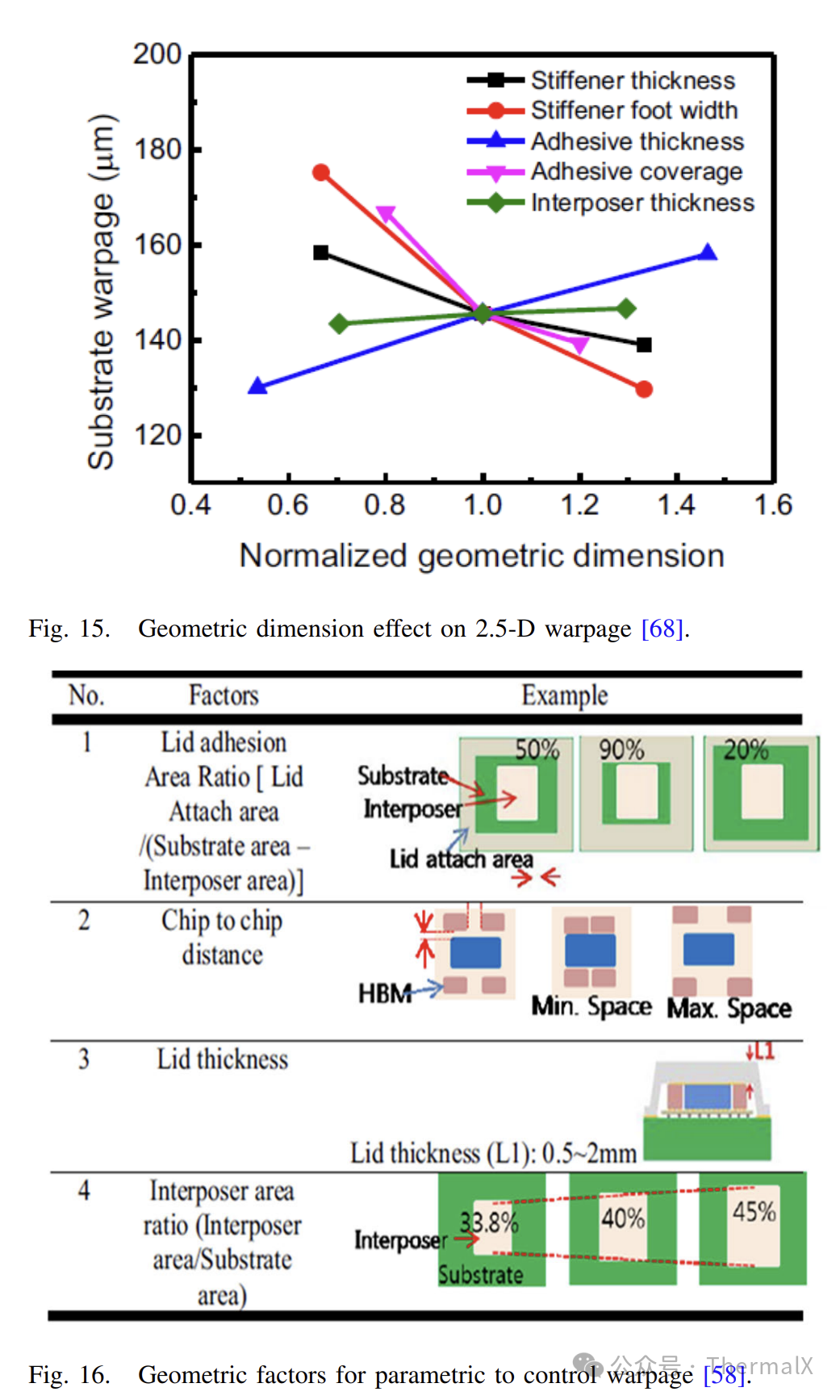
BGA疲勞壽命
焊點(diǎn)影響可靠性,從一些研究中,BGA相比C4或ubump的失效余量更小。本文主要分析thermal cycle和power cycle下BGA的疲勞失效。
Anand模型經(jīng)常用來(lái)評(píng)估SAC合金的非彈性變形。Anand 模型是一個(gè)統(tǒng)一的temperature-dependent 粘塑性本構(gòu)模型,考慮非彈性應(yīng)變率、微觀結(jié)構(gòu)和變形阻力。
疲勞壽命仿真的輸入為熱循環(huán)負(fù)載,計(jì)算其引起的力學(xué)數(shù)據(jù)如馮米塞斯應(yīng)力 、拉伸應(yīng)力,塑性應(yīng)變,應(yīng)變能密度,蠕變應(yīng)變和總應(yīng)變。根據(jù)這些力學(xué)數(shù)據(jù)再結(jié)合一些模型就可以計(jì)算出壽命,例如Darveaux模型。
Darveaux模型通過(guò)計(jì)算非彈性應(yīng)變能密度下的裂紋生長(zhǎng)速率、裂紋開(kāi)始時(shí)的次數(shù),結(jié)合焊點(diǎn)長(zhǎng)度,可得到焊點(diǎn)失效時(shí)的循環(huán)次數(shù)。

除了Darveaux模型,還有Syed模型、Coffin-Manson模型、Engelmaier–Wild模型等。
Thermal cycle的測(cè)試方法在JESD22-A104F
Power cycle的測(cè)試方法在JESD22-A122A
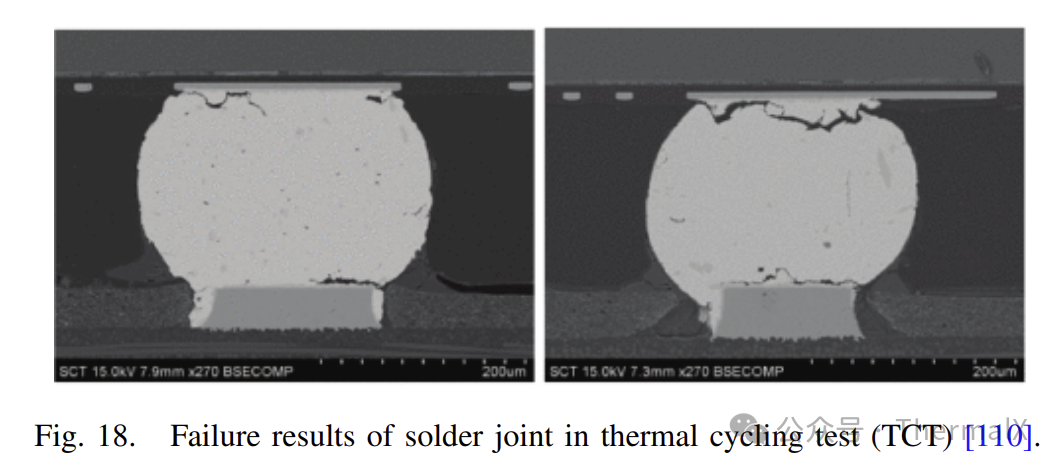
不同物性、結(jié)構(gòu)參數(shù)下BGA疲勞壽命分析:
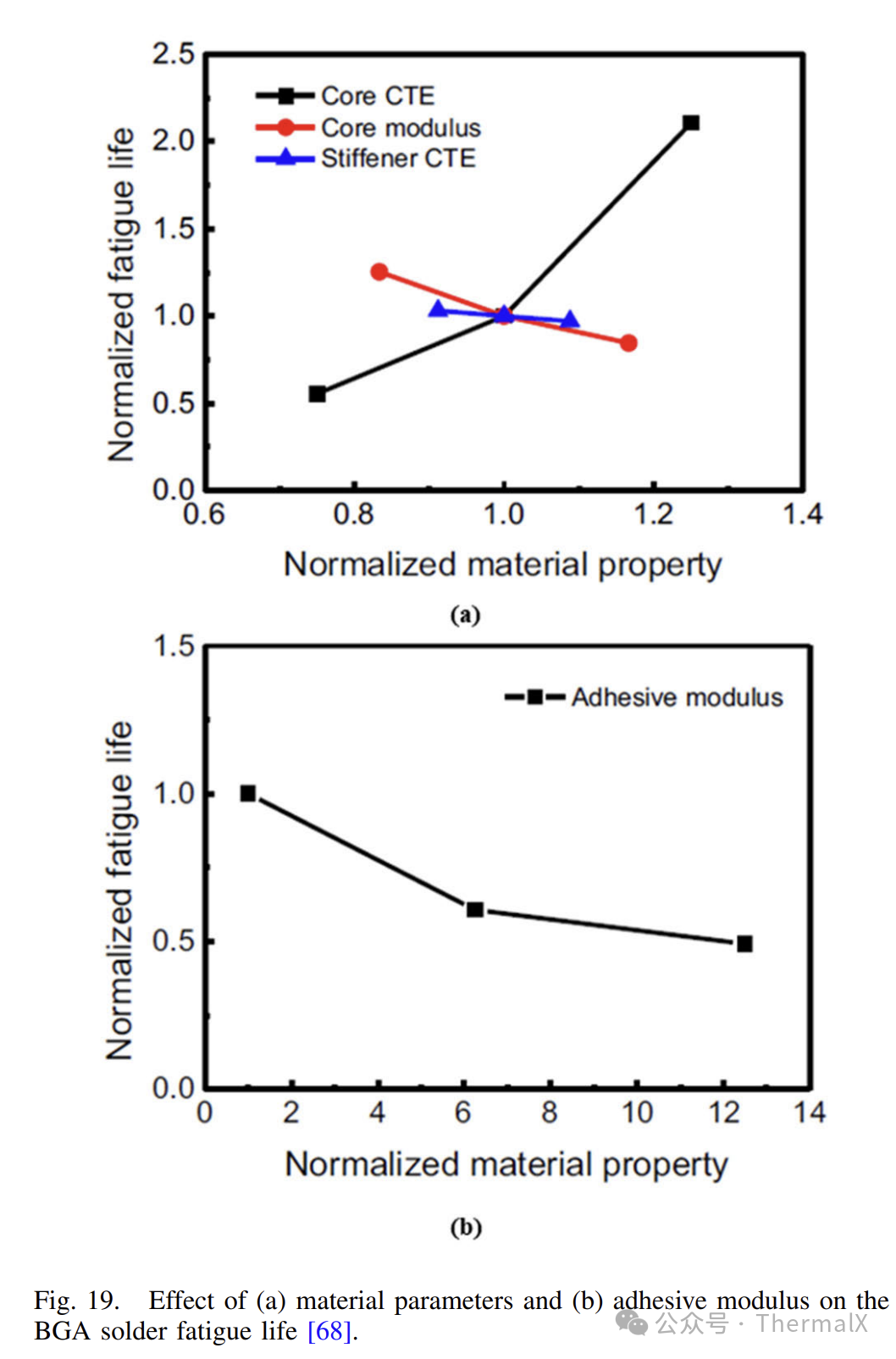
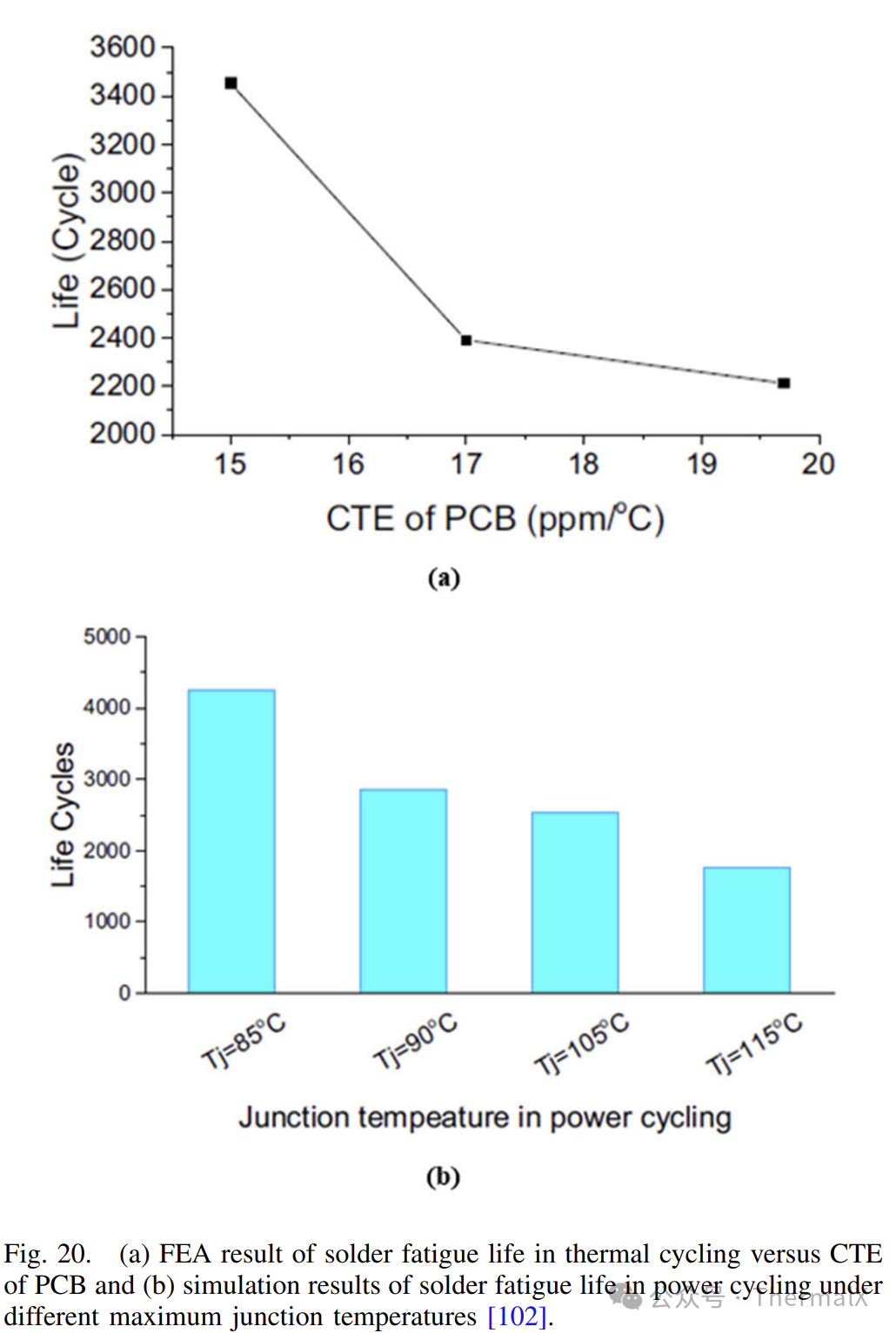
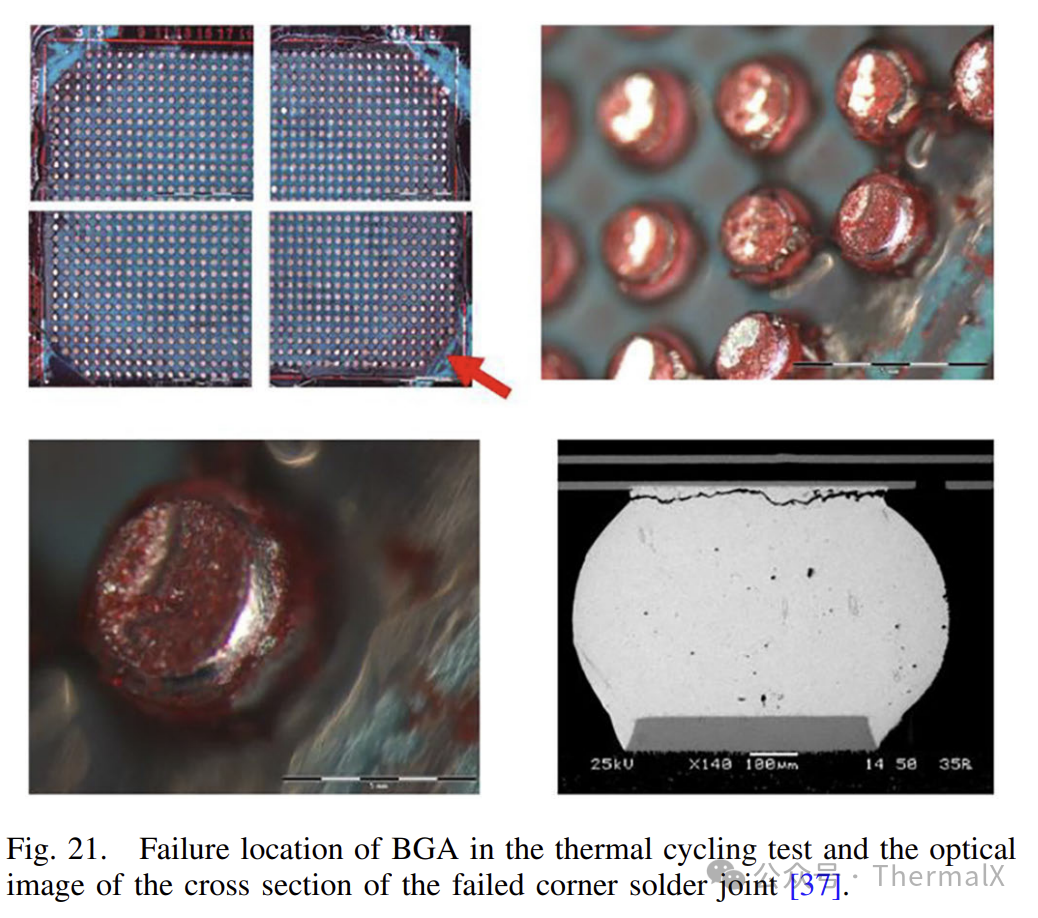
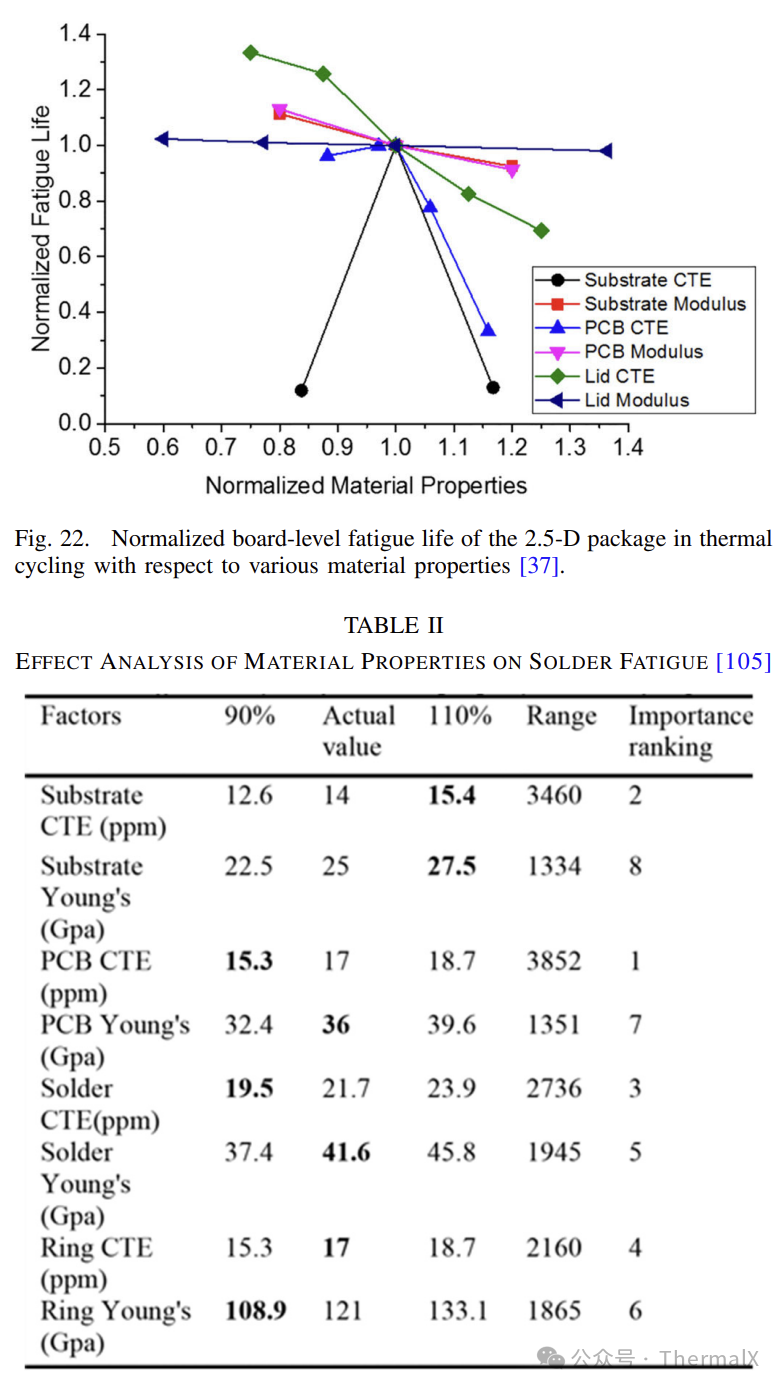
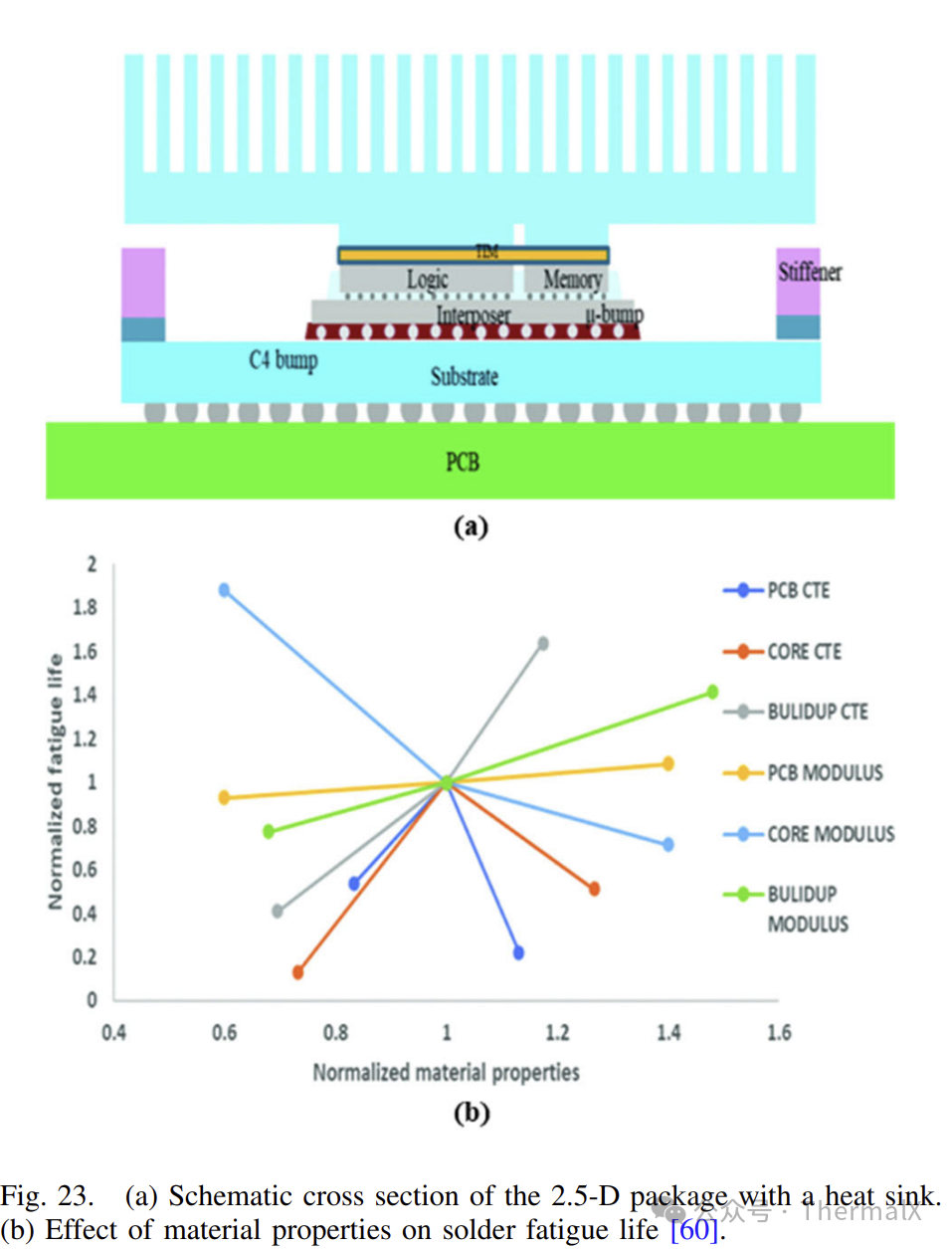
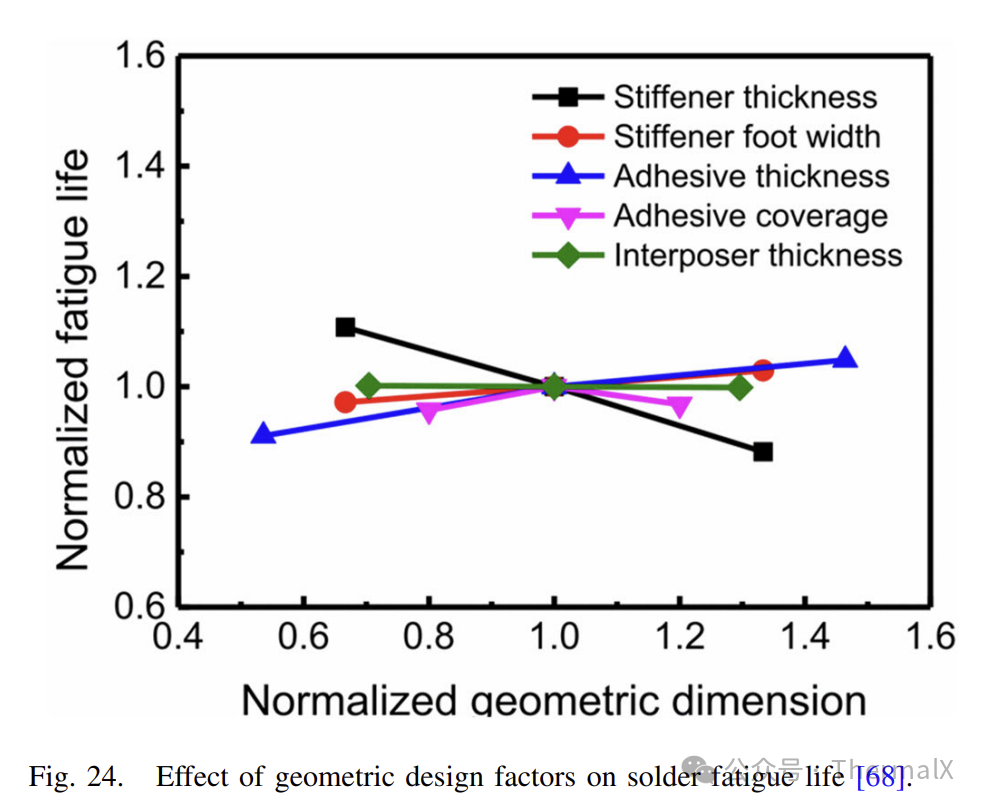
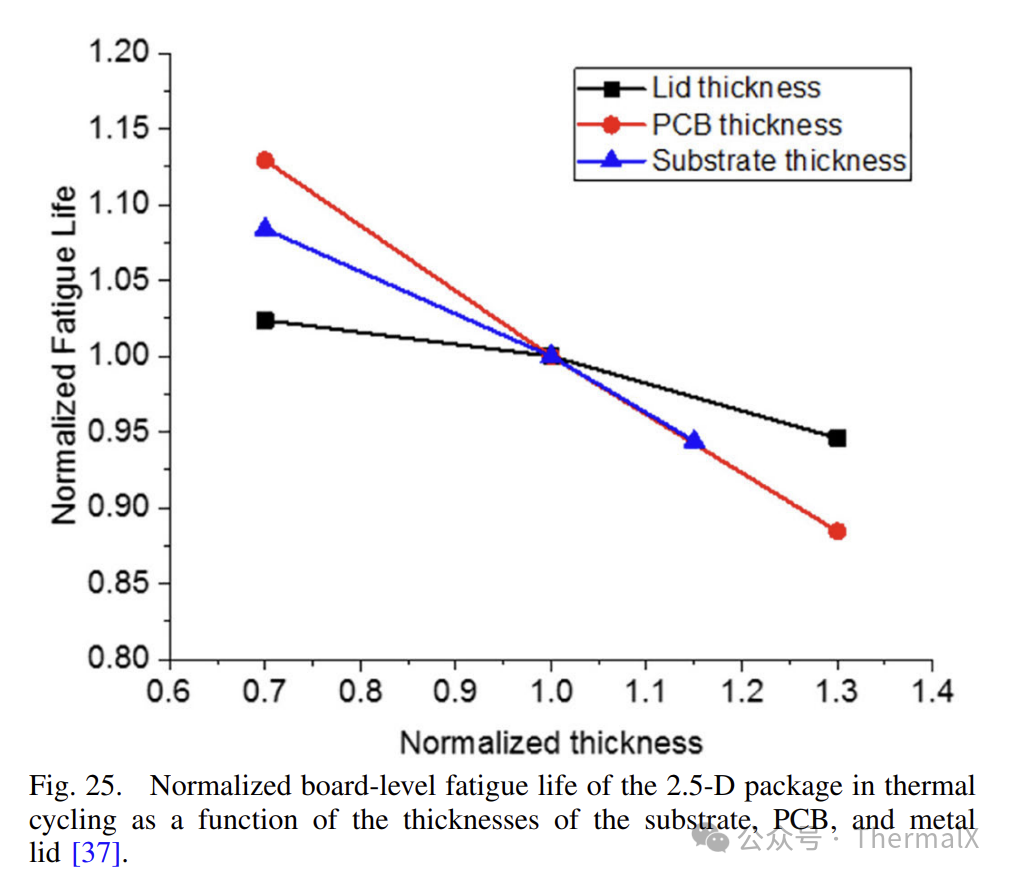
總結(jié)和展望
盡管對(duì) 2.5D 封裝的翹曲和 BGA 疲勞壽命進(jìn)行了諸多研究,但在準(zhǔn)確預(yù)測(cè)封裝行為方面仍存在挑戰(zhàn)。雖然按照 JEDEC 標(biāo)準(zhǔn)中的測(cè)試條件可進(jìn)行標(biāo)準(zhǔn)化實(shí)驗(yàn)測(cè)量,但由于缺乏全面的分析方法,仿真存在局限性。這阻礙了準(zhǔn)確有效地評(píng)估各種參數(shù)對(duì) 2.5D 封裝可靠性的影響,有限的準(zhǔn)確性甚至可能導(dǎo)致相同材料和幾何因素出現(xiàn)矛盾趨勢(shì)。這些局限性的原因是多方面的,可歸因于材料特性數(shù)據(jù)庫(kù)不足、等效模型過(guò)于簡(jiǎn)化、封裝組件間復(fù)雜的相互作用以及不同假設(shè)的理論模型。
-
BGA
+關(guān)注
關(guān)注
5文章
564瀏覽量
48096 -
2.5D封裝
+關(guān)注
關(guān)注
0文章
24瀏覽量
315
原文標(biāo)題:2.5D封裝的熱力挑戰(zhàn)
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
2.5D集成電路的Chiplet布局設(shè)計(jì)

2.5D封裝系統(tǒng)的存儲(chǔ)計(jì)算

新型2.5D和3D封裝技術(shù)的挑戰(zhàn)
2.5D/3D芯片-封裝-系統(tǒng)協(xié)同仿真技術(shù)研究
3D封裝與2.5D封裝比較
2.5D封裝應(yīng)力翹曲設(shè)計(jì)過(guò)程

智原推出2.5D/3D先進(jìn)封裝服務(wù), 無(wú)縫整合小芯片
2.5D和3D封裝的差異和應(yīng)用

探秘2.5D與3D封裝技術(shù):未來(lái)電子系統(tǒng)的新篇章!

深入剖析2.5D封裝技術(shù)優(yōu)勢(shì)及應(yīng)用

技術(shù)資訊 | 2.5D 與 3D 封裝

最全對(duì)比!2.5D vs 3D封裝技術(shù)
2.5D封裝為何成為AI芯片的“寵兒”?






 2.5D封裝的熱力挑戰(zhàn)
2.5D封裝的熱力挑戰(zhàn)











評(píng)論