三星計劃明年開始與臺積電在封裝先進芯片方面展開競爭,因而三星正在加速部署3D芯片封裝技術。
三星的3D芯片封裝技術,簡稱“Extended-Cube”或“X-Cube”,在本月中旬進行了演示,目前已經可以用于7納米制程。
三星的3D芯片封裝技術是一種采用垂直電連接代替導線的封裝解決方案,允許多層超薄疊加,并使用貫穿硅通孔技術構建邏輯半導體。
利用3D封裝技術,芯片設計人員在創建滿足其特殊要求的定制解決方案時具有更大的靈活性。
本月中旬向公眾展示時,三星透露他們的技術已經成功投入試產,可以提高芯片的運行速度和能效。
三星目前是全球第二大芯片制造商。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
459文章
52145瀏覽量
435930 -
三星電子
+關注
關注
34文章
15885瀏覽量
182123 -
封裝
+關注
關注
128文章
8474瀏覽量
144759
發布評論請先 登錄
相關推薦
熱點推薦
2.5D/3D封裝技術升級,拉高AI芯片性能天花板
2.5D/3D封裝和Chiplet等得到了廣泛應用。 ? 根據研究機構的調研,到2028年,2.5D及3D
回收三星S21指紋排線 適用于三星系列指紋模組
深圳帝歐電子回收三星S21指紋排線,收購適用于三星S21指紋模組。回收三星指紋排線,收購三星指紋排線,全國高價回收三星指紋排線,專業求購指紋
發表于 05-19 10:05
三星在4nm邏輯芯片上實現40%以上的測試良率
較為激進的技術路線,以挽回局面。
4 月 18 日消息,據韓媒《ChosunBiz》當地時間 16 日報道,三星電子在其 4nm 制程 HBM4 內存邏輯芯片的初步測試生產中取得了40% 的良率,這高于
發表于 04-18 10:52
芯片3D堆疊封裝:開啟高性能封裝新時代!
在半導體行業的快速發展歷程中,芯片封裝技術始終扮演著至關重要的角色。隨著集成電路設計復雜度的不斷提升和終端應用對性能、功耗、尺寸等多方面要求的日益嚴苛,傳統的2D

三星電容的封裝形式有哪些選擇?
三星電容提供多樣化的封裝形式,這些形式的選擇主要取決于電容的類型、物理尺寸以及其在特定應用中的需求。為了滿足不同場景下的使用要求,三星電容采用了多種封裝
三星否認HBM3E芯片通過英偉達測試
近日,有關三星的8層HBM3E芯片已通過英偉達測試的報道引起了廣泛關注。然而,三星電子迅速對此傳聞進行了回應,明確表示該報道并不屬實。
三星將于今年內推出3D HBM芯片封裝服務
近日,據韓國媒體報道,全球領先的半導體制造商三星即將在今年推出其高帶寬內存(HBM)的3D封裝服務。這一重大舉措是三星在2024年三星代工論
三星加強半導體封裝技術聯盟,以縮小與臺積電差距
據最新報道,三星電子正積極加強其在半導體封裝技術領域的聯盟建設,旨在縮小與全球半導體制造巨頭臺積電之間的技術差距。為實現這一目標,三星預計將





 三星為什么部署3D芯片封裝技術
三星為什么部署3D芯片封裝技術
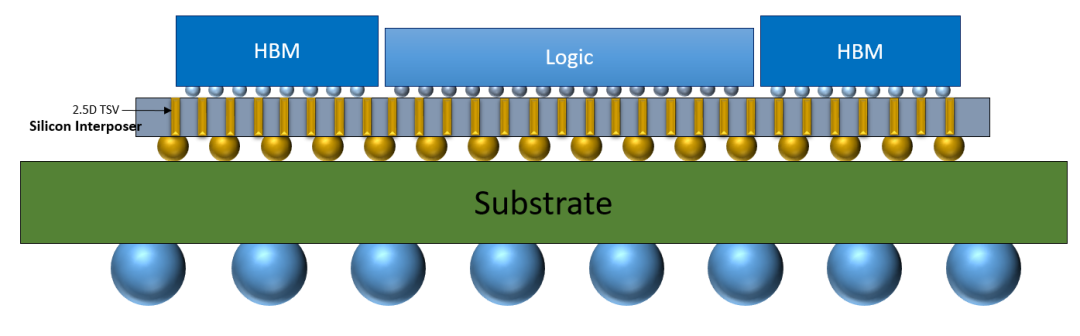
















評論