從草圖到產(chǎn)品,“半導(dǎo)體器件在制造前后往往面臨諸多危害,這將導(dǎo)致它們過早失效”。“芯片的工作環(huán)境惡劣,半導(dǎo)體行業(yè)已經(jīng)學(xué)會(huì)了如何應(yīng)對(duì)這些挑戰(zhàn)。但隨著制造尺寸越來越小或采用了新的封裝技術(shù),新的問題隨之出現(xiàn)。”設(shè)計(jì)、制造、靜電處理、關(guān)聯(lián)問題、操作……諸多細(xì)節(jié)都是導(dǎo)致芯片故障的元兇,本文就將具體介紹導(dǎo)致芯片之死的五大原因。
以下為譯文:
半導(dǎo)體器件包含數(shù)億個(gè)晶體管,它們?cè)跇O端溫度和惡劣環(huán)境下工作,因此,許多器件未能如預(yù)期那樣工作或壽命有限,這并不奇怪。有些器件永遠(yuǎn)無法走出實(shí)驗(yàn)室,還有許多器件則死于車間。人們希望發(fā)布到產(chǎn)品中的大多數(shù)器件在過時(shí)之前都能存活下來,但很多事情都可能發(fā)生,讓它們無法走到那一步。即使是運(yùn)行正常的器件也會(huì)受損,導(dǎo)致它們不能產(chǎn)生正確的結(jié)果。
器件失敗及其原因可以列出一大長串。但它們通常分為幾個(gè)類別,具體如下。
死于設(shè)計(jì)
Mentor/Wilson 的功能驗(yàn)證研究結(jié)果指出,2018 年 ASIC 芯片的一次投片成功率只有 26%,這個(gè)值低于之前的研究結(jié)果。成功率低的部分原因是新的工藝節(jié)點(diǎn)引起了一些尚未完全理解的問題。在此之前,已經(jīng)存在了一段時(shí)間的問題被整合到工具和流程中,使這些已知的問題不那么具有威脅性。然而,在 2018 年,混合信號(hào)接口、串?dāng)_(Crosstalk)、時(shí)序和 IR-Drop,所有這些已知的問題導(dǎo)致了芯片改版的比例大大上升。

導(dǎo)致芯片改版的 ASIC 缺陷類型 | 來源:2018 年功能驗(yàn)證研究報(bào)告,由 Wilson Research Group 和西門子 Mentor 事業(yè)部發(fā)布
“一些客戶的芯片之所以失敗,是因?yàn)樗鼈兊脑O(shè)計(jì)過程較為特殊。”Synopsys 的產(chǎn)品經(jīng)理 Kenneth Chang 說道。“一位客戶進(jìn)行了 block 級(jí)功耗分析,然后進(jìn)行了集成。他們認(rèn)為在那個(gè)階段他們可以修復(fù)問題,但是事與愿違,芯片也就失敗了——原因在于舊方法不再適用于新的先進(jìn)技術(shù)。”
并非說一個(gè)芯片只有在不能工作時(shí)才是失敗。Cadence 公司 Digital 和 Signoff 部門產(chǎn)品管理總監(jiān) Jerry Zhao 認(rèn)為,“如果一個(gè)芯片沒有達(dá)到性能目標(biāo),那也是失敗”,“如果芯片的運(yùn)行速度比預(yù)期低 10%,那么它在市場上可能就沒有競爭力了。”
電源正成為一個(gè)挑戰(zhàn),尤其是當(dāng)電源是在芯片上的時(shí)候。ARM 公司的物理設(shè)計(jì)團(tuán)隊(duì)高級(jí)解決方案營銷經(jīng)理 Lisa Minwell 表示,“電力傳輸網(wǎng)絡(luò)(PDN)是一個(gè)分布式 RLC 網(wǎng)絡(luò),可以分為三部分:片上、封裝和板上”,“片上需要更快的時(shí)鐘頻率、更低的工作電壓和更高的晶體管密度。雖然先進(jìn)的 finFET 技術(shù)實(shí)現(xiàn)了性能的持續(xù)提升,但功率密度的增加使 IR Drop 閉合成為一個(gè)挑戰(zhàn)。精確建模和最小化電壓裕度對(duì)于平衡能量效率和魯棒性至關(guān)重要。”
但裕度可能是悲觀的,從而限制了競爭力。盡管發(fā)現(xiàn)了問題,一些公司還是冒著風(fēng)險(xiǎn)繼續(xù)前進(jìn)。 “一家大型存儲(chǔ)器公司在明知有大量的 IR Drop 問題的情況下照樣出帶(tape out)”,Kenneth Chang 說道 ,“只要看起來不太糟糕,他們就會(huì)選擇 tape out,因?yàn)槿粘瘫韺?duì)他們來說更加重要。客戶正在學(xué)習(xí),在這種情況下,他們的芯片并沒有失敗。如果他們不失敗,他們就會(huì)繼續(xù)做他們正在做的。當(dāng)它們到達(dá)更具進(jìn)取性的節(jié)點(diǎn)時(shí),它們就需要變得更加受指標(biāo)驅(qū)動(dòng),并執(zhí)行 EMIR 分析。”
越來越多的問題也開始并發(fā)出現(xiàn),例如功率、IR Drop、發(fā)熱、時(shí)序、電遷移都是相互聯(lián)系的,但對(duì)大部分問題的分析都是分開進(jìn)行的。Jerry Zhao 指出,“電源噪音是個(gè)問題”,“電壓供應(yīng)正在下降,同時(shí)用戶希望獲得更高的性能。電池沒有提供太多動(dòng)力,也許有 850 毫伏,但你仍然想要 3GHz 的性能。電源噪聲會(huì)產(chǎn)生重大影響,尤其是當(dāng)晶片中存在變化時(shí),這種噪聲會(huì)隨時(shí)間和位置而變化。因此,不同位置的同一個(gè)電池可能會(huì)因電壓下降而失效,從而導(dǎo)致時(shí)序延遲。你必須在電壓下降的背景下分析電池,并進(jìn)行靜態(tài)電壓感知時(shí)序分析。有些路徑對(duì)電壓變化非常敏感。”
隨著問題得到更好的理解,工具可以執(zhí)行更好的分析,并且可以使用設(shè)計(jì)方法來規(guī)避問題。 “復(fù)雜性導(dǎo)致更大的功率密度,這反過來又在芯片內(nèi)產(chǎn)生局部加熱(熱點(diǎn))。” Moortec 公司的營銷副總裁 Ramsay Allen 解釋道,“柵極密度的增加也會(huì)導(dǎo)致供電電壓更大的下降。在整個(gè)設(shè)計(jì)中,高精度的溫度傳感器和電壓監(jiān)控器使系統(tǒng)能夠管理和適應(yīng)這些條件,通過為熱管理和電源異常檢測提供解決方案,提高設(shè)備可靠性并優(yōu)化性能。這在數(shù)據(jù)中心和人工智能設(shè)計(jì)中尤其重要,因?yàn)樾阅芤蟮奶岣呤乖O(shè)計(jì)在溫度和電壓方面承受了巨大的壓力。”
死于制造
半導(dǎo)體器件的制造涉及到僅有幾納米的結(jié)構(gòu)。作為參照,人類的 DNA 鏈直徑為 2.5 納米,而人類的頭發(fā)直徑為 80000 至 100000 納米。一粒灰塵可以摧毀晶圓上的幾個(gè)單元裸片。如果裸片的尺寸變大,隨機(jī)失效的幾率就會(huì)增加。對(duì)于成熟的工藝節(jié)點(diǎn),可以獲得 80% 到 90% 的出片率。然而,對(duì)于較新的節(jié)點(diǎn),出片率可能顯著低于 50%,盡管實(shí)際的數(shù)字是嚴(yán)格保密的。
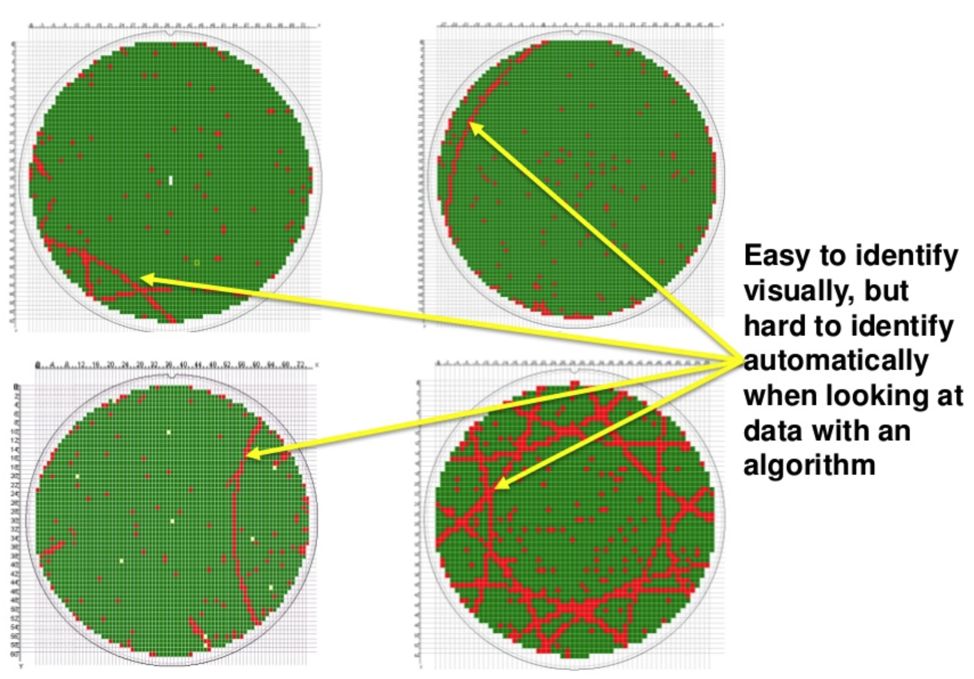
晶圓缺陷圖案 | 資料來源:Marvell Semiconductor,ITC 2015。
即使是不受災(zāi)難性影響的裸片也可能不被劃在可工作的范圍內(nèi)。制造步驟不完善時(shí),即使只有一個(gè)原子的工藝變化也會(huì)產(chǎn)生顯著的差異。雖然這可能不會(huì)對(duì)設(shè)計(jì)的某些部分產(chǎn)生影響,但如果工藝變化恰好與關(guān)鍵的時(shí)序路徑相吻合,則可能會(huì)使器件不符合規(guī)范。
ANSYS 公司的 ESD/Thermal/Reliability 產(chǎn)品經(jīng)理 Karthik Srinivasan 表明,“隨著設(shè)計(jì)演變?yōu)榫哂邢冗M(jìn)封裝的深亞微米技術(shù),現(xiàn)有的模擬工具和設(shè)計(jì)方法不能很好地捕捉到變異性及其對(duì)可靠性的影響”,“這會(huì)導(dǎo)致設(shè)計(jì)流程中出現(xiàn)漏洞,從而引發(fā)一些故障。”
設(shè)計(jì)流程越來越多地允許在開發(fā)早期就考慮到變化,以最大程度地減少其影響,而冗余等設(shè)計(jì)技術(shù)可以減少需要丟棄的“幾乎可以工作”的芯片的數(shù)量。“幾乎可以工作”的芯片在大型內(nèi)存陣列中非常常見,按照它們?cè)跍y試中表現(xiàn)出的性能進(jìn)行相應(yīng)的分類(binning)是常用于處理器的另一種做法。也就是,在高頻率下運(yùn)行的優(yōu)良器件可以以更高的價(jià)格出售,而那些只有在低頻率時(shí)才能成功工作的器件則以折扣價(jià)出售。
測試的作用是找出哪些裸片功能完好。那些處于臨界狀態(tài)的裸片通常會(huì)被丟棄,但是一些有功能缺陷的裸片也會(huì)被漏檢,并最終進(jìn)入正式產(chǎn)品中。
死于靜電處理
有很多種方法可以殺死芯片。如果將 0.5V 的電壓施加到芯片的外部,就會(huì)在 1 納米的電介質(zhì)上產(chǎn)生 0.5MV/m 的電場。這足以使高壓電線起弧。現(xiàn)在想象一下當(dāng)你接觸芯片的引腳時(shí)會(huì)發(fā)生什么。
“通常情況下,這是一個(gè)很高的電壓,根據(jù)引腳的接觸方式,會(huì)有不同的模型,例如人體模型或電荷分布模型(CDM)。”Jerry Zhao 解釋說,“這些模型定義了電流如何被引入引腳,這是一種隨時(shí)間變化的動(dòng)態(tài)波形。”
通常,芯片都會(huì)有靜電放電(ESD)保護(hù)。“對(duì)于封裝內(nèi)的單個(gè)裸片,它們的目標(biāo)是像 2KJ 這樣的標(biāo)準(zhǔn),”Karthik Srinivasan 指出,“像 HBM 這樣的多芯片解決方案的標(biāo)準(zhǔn)稍低一些。采用 2.5D 或 3D IC 的一個(gè)原因是為了性能,而 ESD 是性能的障礙。你試圖最小化 ESD,甚至在這些 Wide I/O 接口或任何類型的多芯片接口通道上消除它,這意味著你不能真正地按照針對(duì)單個(gè)裸片的相同標(biāo)準(zhǔn)來測試每個(gè)裸片。它們必須通過更專業(yè)的測試方法,因?yàn)樗鼈兊?ESD 保護(hù)非常小,甚至可能沒有 ESD 保護(hù)。”
即使在操作過程中,靜電放電事件也會(huì)引起問題。ARM 公司的 Minwell表示:“在便攜式電子產(chǎn)品中,ESD 可以導(dǎo)致許多類型的軟錯(cuò)誤。”在 ESD 事件期間,由于某些集成電路(振蕩器集成電路、CPU 和其他集成電路)的靈敏度,或由于其與配電系統(tǒng)(PDN)的場耦合,都可能導(dǎo)致在配電系統(tǒng)上產(chǎn)生噪聲。
死于關(guān)聯(lián)問題
“軟錯(cuò)誤可以以多種方式發(fā)生,如果是系統(tǒng)性的設(shè)計(jì)錯(cuò)誤,它可以使芯片看起來好像不工作。三維集成電路(3D IC)正在增加對(duì)電磁感知設(shè)計(jì)方法的需求,”Helic 公司的營銷副總裁 Magdy Abadir 指出,“這是因?yàn)楫a(chǎn)生的功率密度更高,疊加層的數(shù)量也在增加,從而引發(fā)了增加天線的風(fēng)險(xiǎn),這會(huì)放大整個(gè)設(shè)計(jì)過程中產(chǎn)生的磁場。”
供電不足也會(huì)帶來問題。Jerry Zhao 指出,“芯片的功能取決于晶體管的躍遷”,“這取決于供電電壓。如果它能在 1V 電壓下工作,它可能會(huì)再下降 10% 或 20% 也仍然可以正常工作。但時(shí)序會(huì)有所不同,因此可能需要降低最大時(shí)鐘頻率。”
隨著電壓的降低,電路更容易受到噪聲的影響。“電磁干擾(EMI)是芯片對(duì)環(huán)境產(chǎn)生的噪音,”Ansys 公司的半導(dǎo)體事業(yè)部首席技術(shù)專家 Norman Chang 表示,“噪聲源來自有源電路,它將在電源地線和信號(hào)線上產(chǎn)生電流。電源線/接地線將通過封裝到 PCB,如果它看到封裝或 PCB 有天線結(jié)構(gòu),就會(huì)引起空中輻射,然后通過天線結(jié)構(gòu)輻射到環(huán)境中并產(chǎn)生干擾。”
但出去的東西也會(huì)進(jìn)來。“電磁敏感性(EMS)是人們不得不擔(dān)心的一個(gè)新問題,” Norman Chang 指出,“電力注入測試是從 150kHz 開始注入 1W 電量,一直到 1GHz。在每個(gè)頻率,你將向系統(tǒng)注入 1W 的電量。如果你沒有足夠的保護(hù),就會(huì)破壞沿路徑進(jìn)入芯片的電路。測試的目的不是為了破壞芯片,而是測試這種噪聲是否會(huì)影響電路。或者引腳處的電壓可能過高,如果電壓過高,則會(huì)產(chǎn)生過電應(yīng)變。”
死于操作
此時(shí),芯片已經(jīng)到達(dá)“現(xiàn)場”并被認(rèn)為是可以工作的。“可靠性是個(gè)大問題,”Microchip 公司模擬電源和接口部門的首席產(chǎn)品營銷工程師Fionn Sheerin 指出,“在很多情況下,糟糕的熱設(shè)計(jì)并不會(huì)導(dǎo)致瞬間災(zāi)難性的故障,甚至不會(huì)產(chǎn)生平庸的產(chǎn)品。但是它會(huì)使器件的使用壽命縮短。觀察布局中的熱點(diǎn)或最佳布局實(shí)踐以及良好的層次規(guī)劃可能會(huì)產(chǎn)生不同的效果。這也是驗(yàn)證和可靠性測試真正重要的地方,同時(shí)也是汽車應(yīng)用的功能安全問題。”
西門子 Mentor 事業(yè)部的產(chǎn)品營銷總監(jiān) Joe Davis 也贊同這一觀點(diǎn),“發(fā)熱導(dǎo)致的問題不僅僅是你的手機(jī)在口袋里變熱。它會(huì)導(dǎo)致晶體管和它們之間的連接退化。這會(huì)影響性能和可靠性。”
熱量由兩個(gè)來源產(chǎn)生,“首先是路由層,” Jerry Zhao 分析表示,“這是與導(dǎo)線中的電流有關(guān)的熱量。模擬電路的電流比數(shù)字電路大。因此,模擬電路的設(shè)計(jì)人員不得不擔(dān)心的一個(gè)問題就是,如果溫度過高,會(huì)使電線熔化;第二個(gè)來源是晶體管。當(dāng)我們遷移到 finFET 時(shí),其中一個(gè)新的現(xiàn)象是自熱。熱量沿著弱電阻路徑運(yùn)動(dòng),然后從晶體管的散熱片中垂直逸出,這會(huì)增加電線中的熱量。”
當(dāng)高電流和高熱量聚集在一起時(shí),電遷移效應(yīng)會(huì)慢慢損壞導(dǎo)線。同樣地,負(fù)偏壓溫度不穩(wěn)定性(NBTI)等物理效應(yīng)也會(huì)有同樣的效果。當(dāng)電流很大時(shí)會(huì)對(duì)器件產(chǎn)生應(yīng)力,如果持續(xù)足夠長的時(shí)間,則會(huì)導(dǎo)致永久性損傷。
結(jié)論
本文僅僅包含了芯片從設(shè)計(jì)到產(chǎn)品,再到產(chǎn)品的整個(gè)生命周期中所面臨的一些挑戰(zhàn)。
芯片的工作環(huán)境惡劣,半導(dǎo)體行業(yè)已經(jīng)學(xué)會(huì)了如何應(yīng)對(duì)這些挑戰(zhàn)。但隨著制造尺寸越來越小或采用了新的封裝技術(shù),新的問題隨之出現(xiàn)。有時(shí),這些新的影響會(huì)導(dǎo)致器件失敗故障。但從歷史上看,該行業(yè)很快學(xué)會(huì)了規(guī)避新的問題或?qū)栴}最小化的方法。
-
芯片
+關(guān)注
關(guān)注
459文章
52505瀏覽量
440773 -
靜電
+關(guān)注
關(guān)注
2文章
528瀏覽量
37321
原文標(biāo)題:誰殺死了芯片?
文章出處:【微信號(hào):mcuworld,微信公眾號(hào):嵌入式資訊精選】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
五大常見氣密性測試儀故障及解決方法大揭秘-岳信儀器
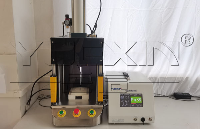
芯資訊|智能云打印機(jī)—廣州唯創(chuàng)電子五大語音芯片IC應(yīng)用方案解析

不只依賴光刻機(jī)!芯片制造的五大工藝大起底!

MOS管莫名燒毀?5大元兇與防護(hù)方案深度解析MDD

德州儀器分析服務(wù)器電源設(shè)計(jì)中的五大趨勢(shì)

解析愛普生RTC芯片選型的五大關(guān)鍵
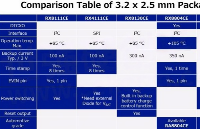
常見BGA芯片故障及解決方案
改造數(shù)據(jù)中心需要遵循這五大規(guī)則
邊緣計(jì)算網(wǎng)關(guān)五大核心特點(diǎn)
線上逛展 | 沉浸探索第三屆OpenHarmony技術(shù)大會(huì)五大展區(qū)
網(wǎng)管的五大功能是什么
IC芯片檢測新紀(jì)元:X-RAY設(shè)備的五大創(chuàng)新優(yōu)勢(shì)






 導(dǎo)致芯片故障的五大元兇
導(dǎo)致芯片故障的五大元兇












評(píng)論