
1 前言球柵陣列封裝技術(Ball grid array,BGA)具有十分高的封裝密度,同時又具有優良的電性能、低噪聲、低寄生電感電容等優點,在高速PCB設計中得到廣泛的使用。PCB 組件的高密度、高可靠性以及無鉛化的發展,使其對應用元件的封裝尺寸以及工藝的可生產性要求越來越高。在高速PCB 設計中,0.5mm、0.8mm 以及1mm 間距的BGA封裝已經非常普遍,這就給PCB 的設計制作以及工藝互聯帶來了更高的挑戰。大多數工程師都認為BGA 焊盤間距越小,PCB 互聯集成密度就越高,信號傳輸性能就越好。但對于工藝來說,會存在短路或者虛焊的情況,加大了工藝的難度。因此,如何選取BGA 封裝是設計師在加工PCB 之前應該考慮的問題,不僅僅需要考慮信號的完整性,同時還需要兼顧工藝的可生產性。
2 BGA信號傳輸在實際的工程運用中,BGA 的結構圖如圖1 所示,信號通過PCB 板上的過孔傳輸到BGA 球上,再通過BGA 球將信號傳輸出去。

圖1:BGA 的結構圖
圖2 為BGA 封裝常用的陣列
如圖2 所示,所有BGA 的焊盤尺寸一致,中間的BGA 球用于信號傳輸,其四周的球通常情況下接地。如圖所示,如果焊盤直徑為0.5mm,相鄰兩個焊盤的中心間距d 為0.8mm,邊緣間距為0.3mm(11.8mil)。顯然,焊盤之間的銅線越細,銅線與焊盤的間距越小,加工工藝難度越大,PCB 成本也就越高,可靠性也越差。同時對于焊接工藝來說,BGA 焊盤過密,會存在短路或者虛焊的情況,加大了工藝操作的難度。所以設計師不能一味的追求提高PCB 互聯集成密度,而忽視工藝的可操作性,這樣是既浪費時間又浪費資源的做法。
3 BGA信號傳輸的關鍵因素根據BGA 在實際工程中的應用情況,在HFSS 中建立仿真模型,如圖3 所示。信號通過PCB 板上的過孔傳輸到BGA 球上,再通過BGA 球將信號傳輸出去。模型中,PCB 板材采用厚度0.5mm 的FR-4,模型的參數初設值為:BGA焊盤直徑為0.5mm,焊盤盤心間距為0.8mm,過孔孔徑為0.25mm,孔盤為0.4mm,過孔孔心間距為0.65mm。
圖3:仿真模型

圖4:仿真結果(S 參數)
仿真結果如圖4 所示,從圖中可以看出,在工作頻段0 ~ 10GHz 內,該模型的S11/S22 ≤ -20dB。圖5 為該模型的電場分布圖。由此可見BGA 的傳輸并沒有增大孔鏈路的損耗,保證了信號的完整性。
圖5:模型的電場分布圖
為了驗證BGA焊盤間距對信號傳輸的影響,將BGA焊盤間距d分別設置為0.6mm、0.8mm 以及1.0mm,仿真結果如圖6 所示。

圖6:不同d 的仿真對比曲線
從圖6 中可以看出, 在工作頻段0 ~ 10GHz 以內,回波損耗S(1,1)隨著d的增加反而減小。
4 實物測試為了驗證BGA 的傳輸特性,本文加工了實驗進行測試驗證,圖7 是BGA 驗證實物測試現場,圖8是輸入輸出接頭分別經過BGA球后通過共面波導互聯后的測試曲線,圖9 是輸入輸出端經過BGA 球后分別鍵合到50 歐姆負載后的S11 和S22 曲線。從測試曲線中可以看出,經過BGA 參數仿真優化后,實物測試射頻信號在10GHz 時駐波在-15dB 以下,可以達到較好的傳輸效果。
圖7:BGA 驗證實物測試圖

圖8:輸入輸出端分別經過BGA 球后通過共面波導互聯的測試曲線

圖9:輸入輸出端經過BGA 連接50 歐負載測試曲線
5 結論基于HFSS 仿真驗證BGA 焊盤間距對信號傳輸的影響,回波損耗S(1,1)隨著BGA焊盤間距d 的增加反而減小。因此,設計師在選用BGA 封裝時,不僅僅只考慮PCB 互聯集成密度,更應該考慮的是信號傳輸的性能,測試結果證明,經過仿真優化,BGA 傳輸在10GHz 時仍具有良好微波特性。
-
pcb
+關注
關注
4352文章
23417瀏覽量
406719 -
BGA
+關注
關注
5文章
565瀏覽量
48137 -
hfss
+關注
關注
32文章
167瀏覽量
50797
原文標題:基于BGA的射頻/高速傳輸性能研究(仿真+測試)
文章出處:【微信號:gh_f97d2589983b,微信公眾號:高速射頻百花潭】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
基于LabVIEW和NI USRP進行射頻/通信物理層研究
藍牙產品怎么進行射頻性能進行測試?
如何研究帶有菊花鏈路由的BGA測試樣本?
ZigBee系統結構與射頻性能分析測試方法
怎么測試高速ADC的性能?
同樣是BGA扇出,為什么別人設計出來的性能就是比你好!
基于2.5GHz高速串行傳輸信號仿真的研究

LED的電熱光性能研究、仿真和測試
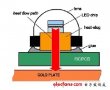
PCB | 高速BGA 封裝與PCB 差分互連結構的設計與優化
高速BGA封裝與PCB差分互連結構進行設計與優化






 如何使用仿真和測試進行BGA的射頻和高速傳輸的性能研究
如何使用仿真和測試進行BGA的射頻和高速傳輸的性能研究












評論