以下完整內容發表在「SysPro電力電子技術」知識星球-《功率芯片嵌入式封裝:從實驗室到量產的全鏈路解析》三部曲- 文字原創,素材來源:TMC現場記錄、西安交大、網絡、半導體廠商
- 本篇為節選,完整內容會在知識星球發布,歡迎學習、交流
- 1400+最新全球汽車動力系統相關的報告與解析已上傳知識星球
導語:在電動汽車與新能源技術迅猛發展的當下,芯片內嵌式PCB逆變器技術憑借其創新性與顛覆性,成為2025年汽車半導體領域的焦點。從Schweizer Electronic AG的p2Pack到保時捷&博世Dauerpower逆變器,從采埃孚的CIPB方案到麥格納嵌入式功率模塊,從舍弗勒的高壓嵌入式功率模組到威睿新一代內埋式封裝CEPU,一系列創新成果標志著車規級功率模塊封裝技術邁向新高度。作為電力電子系統的心臟,功率器件的性能直接決定了整個系統的能效與可靠性。傳統封裝方式在面對寬禁帶半導體(如SiC、GaN)時,暴露出散熱困難、寄生參數過大、集成度受限等瓶頸。芯片內嵌技術通過將功率芯片直接嵌入PCB基板內部,實現了電氣連接、散熱路徑和機械結構的全面優化,為電動汽車、新能源、工業自動化等領域帶來了顯著的性能提升。
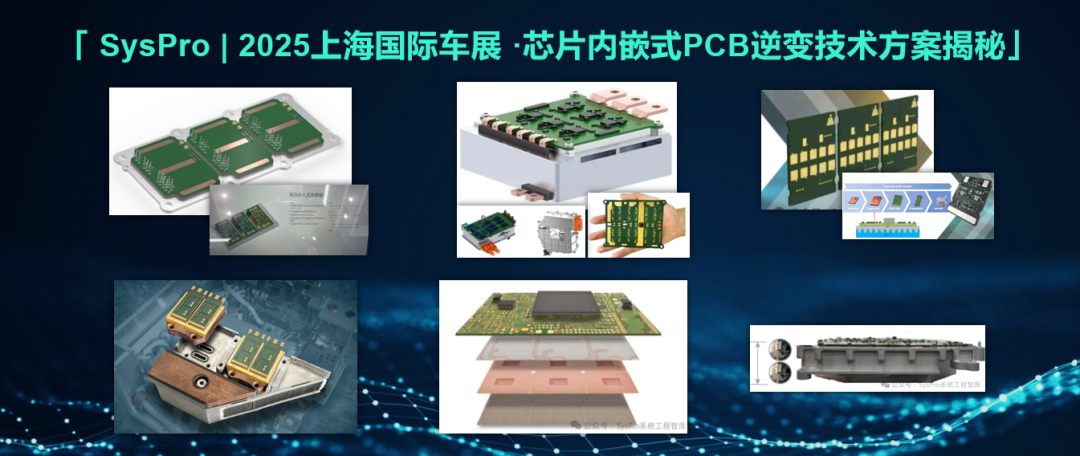
圖片來源:上海車展,SysPro拍攝
關于這一技術路線,我們已做過系統性的解讀:芯片內嵌式PCB封裝技術全面解析的"七部曲"。今年6月初,有幸參加了TMC2025,并聆聽了包括來自西安交通大學電氣工程學院的楊旭教授等諸多行業專家、學者關于功率芯片嵌入式封裝技術相關的主題報告,幫助我搞明白了這一技術方向的來龍去脈。本文,在基于前人研究的基礎上,結合實踐和市場上的產品技術方案,對芯片內嵌式PCB封裝技術進行了系統性解析,構建《功率芯片PCB內埋式封裝:從概念到量產的全鏈路解析》三部曲系列文章:
上篇,聚焦寬禁帶器件發展與封裝瓶頸,梳理電力電子器件發展脈絡,揭示傳統封裝在電性能、散熱與可靠性方面的挑戰,并分析電-熱-應力耦合問題,明確高性能封裝需圍繞電、熱、力學三大核心問題展開。
中篇,深入探討芯片內嵌PCB封裝的多維度協同創新,從空間維度(結構設計優化)、材料維度(基材性能突破)及可靠性維度(長期穩定性評估)三個方向,提出結構創新、材料改進與可靠性評估等綜合解決方案,攻克PCB封裝散熱差、熱應力大、絕緣可靠性低等短板。
下篇,聚焦工藝實踐,解析芯片內嵌PCB封裝全流程,并深度解析鍍銅芯片、Cell單元集成、PCB嵌入等關鍵工藝步驟,通過具體案例揭示理論方案如何轉化為實際產品,并探討其在電力電子系統中的創新應用與未來拓展方向。
本文旨在為工程實踐與技術產品落地提供系統性指導,助力行業突破封裝瓶頸,充分釋放寬禁帶器件潛力。
目錄
上篇:寬禁帶器件發展與封裝瓶頸
1. 電力電子器件發展歷程與封裝重要性
1.1 電力電子器件發展脈絡
1.2 封裝對器件性能的關鍵影響
2. 傳統封裝與寬禁帶器件封裝的挑戰
3. 封裝問題的綜合分析與解決方案(知識星球發布)
3.1 封裝涉及的主要問題
3.2 實現高性能、高密度封裝的解決思路
4. 現有器件封裝的維度劃分與分析(知識星球發布)
4.1 封裝的三個維度劃分
4.2 PCB封裝概念的出現
5. PCB作為封裝的優劣勢分析(知識星球發布)
5.1 PCB封裝的優勢
5.2 PCB封裝存在的"短板"
中篇:芯片內嵌PCB封裝的多維度協同創新-互聯、散熱、基材、絕緣可靠性
6. PCB封裝問題的綜合解決思路與維度劃分
6.1 綜合解決思路
6.2 三個維度的解釋
07 空間維度:結構創新與電路布局布線優化(知識星球發布)
7.1 結構創新
7.2 電路布局布線優化
8. 材料維度:PCB材料改進研究(知識星球發布)
8.1 材料改進的方向與目標
8.2 具體改進措施
8.3 性能優化驗證結果:5大維度
9. 芯片內嵌PCB封裝的絕緣問題解析(知識星球發布)
9.1 絕緣問題的分析方法和思路
9.2 絕緣失效背后的秘密:電樹枝+銅須
9.3 電樹枝生長的影響因素
9.4 直流電場下銅須生長的秘密
9.5 小結:芯片內嵌PCB封裝絕緣失效的"因果鏈"
下篇:芯片內嵌 PCB 封裝-主流工藝實踐的深度解析
10 芯片內嵌PCB封裝工藝方法指南
10.1 GaN期間的PCB內埋封裝
10.2 芯片內嵌PCB封裝工藝的全流程解析
10.3 Step2 - 鍍銅芯片 · 工藝制程解析(知識星球發布)
10.4 Step3 - Cell 單元 · 工藝制程解析(知識星球發布)
10.5 Step4 - PCB 嵌入 · 工藝制程解析(知識星球發布)
10.6 小結
11 總結
|SysPro備注:本文為概述,更多記錄與解讀請在知識星球中查閱
上篇:寬禁帶器件發展與封裝瓶頸
01
電力電子器件發展歷程與封裝重要性
1.1 電力電子器件發展脈絡
電力電子技術的發展史,本質上是器件技術的迭代史。1956年晶閘管的發明開啟了電力電子時代,其后的功率MOSFET和IGBT進一步推動了技術進步。2010年后,氮化鎵(GaN)和碳化硅(SiC)等寬禁帶器件的實用化,標志著第三次技術革命的到來。
以晶閘管為例,從發明到應用于直流輸電耗時16年;IGBT從發明到商業化應用用了15年。而SiC器件自2011年商業化以來,14年過去了,其推廣速度仍未達預期,這其中封裝技術是重要瓶頸。

圖片來源:西安交大
1.2 封裝對器件性能的關鍵影響
半導體器件的性能由芯片和封裝共同決定。芯片決定電磁場、熱場和載流子分布,而封裝直接影響:
可用電流和功率容量:封裝結構決定器件的電流承載能力
電壓頻率特性:寄生參數影響高頻性能
開關損耗:封裝電阻和電感導致額外能量損耗
傳統半導體封裝主要考慮成本、性能和功率密度三個方面。在大多數情況下,我們為了降低成本,封裝設計以成本優化為主,只有少部分會進行性能優化和功率密度優化。然而,高性能封裝往往需要付出更高的成本代價。這種傳統的封裝方式在面對寬禁帶器件時,逐漸暴露出諸多問題。那么,究竟有哪些挑戰呢?
02
寬禁帶器件封裝的挑戰
寬禁帶器件對封裝的挑戰主要在三方面:
電性能方面:寬禁帶器件,如SiC器件和GaN器件,開關速度比常規硅器件快10倍以上。若沿用傳統的硅器件TO塑封,不進行優化,雜散電感過大,會產生很高的電壓尖峰和寄生振蕩,導致器件擊穿、誤觸發等問題,無法充分發揮寬禁帶器件的優勢導致器件無法發揮其優勢,甚至可能因過電壓而燒毀。以常見的硅器件 TO 塑封為例,其雜散電感在某些情況下甚至會使芯片的實際工作性能降低 30% - 40%。
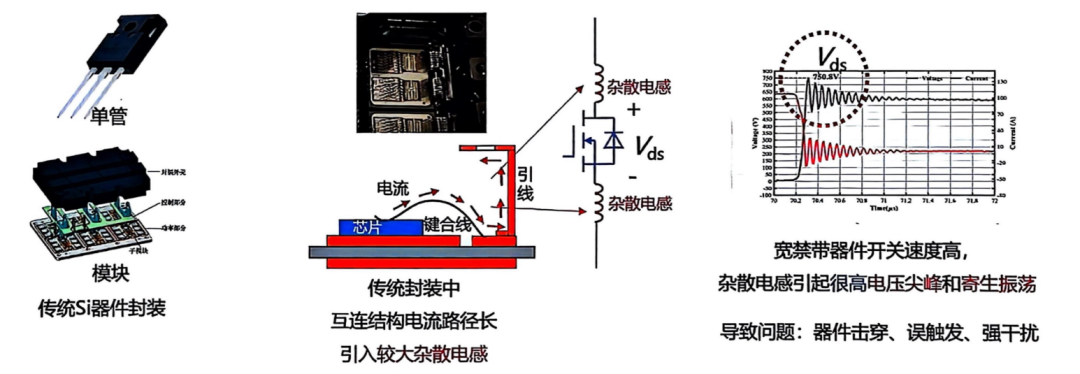
圖片來源:西安交大
散熱方面:寬禁帶器件芯片面積比Si器件小很多,碳化硅器件芯片面積更是比硅器件小3 - 5倍以上。在發熱相近的情況下,熱流密度會提高5 - 10倍,導致結溫顯著升高。雖然SiC允許較高的結溫,但封裝材料的限制使得器件難以達到如此高的溫度,傳統散熱方式無法有效控制結溫。
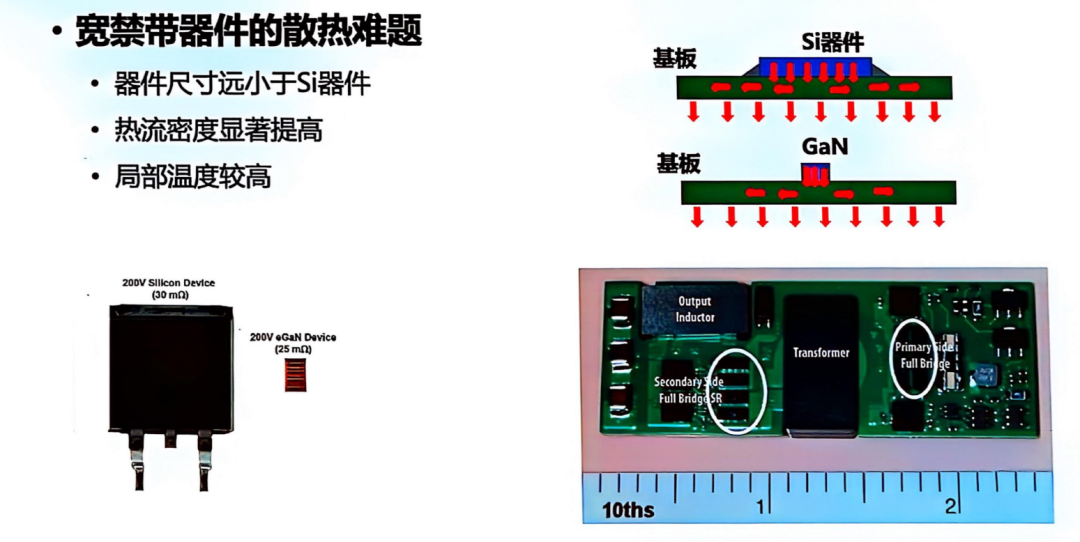
圖片來源:西安交大
可靠性方面:芯片尺寸小、溫度高會導致工作時的溫循較高;同時,由于芯片與封裝材料之間的熱膨脹系數不匹配,在溫度循環變化的過程中,會產生較大的熱應力,從而導致焊點開裂、鍵合線脫落等問題。據統計,在功率設備的故障中,約有 30% - 40% 是由封裝的可靠性問題引起的。

圖片來源:西安交大
耦合問題:最關鍵的是,上面所述這三大問題不是孤立的,而是相互 “糾纏”:
熱 - 電耦合:散熱差→溫度高→電性能(如電阻、載流子遷移率)變,電性能惡化又可能讓損耗、發熱更嚴重,惡性循環。
熱 - 應力耦合:溫度變化→熱應力→封裝結構變形、開裂,反過來影響散熱、電連接,可靠性暴跌。
電場 - 絕緣耦合、電流 - 應力耦合:電場分布影響絕緣,電流產生的電磁力、焦耳熱帶來應力,和電性能、散熱、可靠性問題交叉影響,復雜度直接拉滿。

圖片來源:西安交大
因此,封裝成為制約寬禁帶器件發展的重要瓶頸,好器件需要好封裝來匹配。為了最大程度的發揮出寬禁帶器件優勢,我們需要搞明白電、熱、可靠性層面的問題,以及它們的 “聯動搞事” 背后邏輯。那么,針對上述的挑戰,需要怎樣的分析方法,又有哪些有效的解決方案呢?我們接著聊。
03
封裝問題的綜合分析與解決方案
3.1 封裝涉及的主要問題
從上面解讀可知:封裝主要涉及電性能、散熱和可靠性三個方面的問題:
電性能問題:要求器件工作可靠,減少雜散電感等參數對性能的影響
散熱問題:需要有效將熱量散出,控制結溫
可靠性問題:則要減少應力,提高器件的使用壽命。
因此,先進封裝技術,要僅僅圍繞此三者開展。下面講講具體可以有哪些可選手段。
3.2 實現高性能、高密度封裝的解決思路
搞清楚了問題來源,下面解決問題。
這背后的核心邏輯是:我們需要找到一種封裝,攻克電、熱、力學層面的挑戰,充分發揮寬禁帶器件優勢。為了實現高性能、高密度的封裝。
因此,我們需要分電性能、熱性能、力學性能三條主線展開。
3.2.1 電性能維度(知識星球發布)...3.2.2 熱性能維度(知識星球發布)...3.2.3 力學性能維度(知識星球發布)...
再升華一個層次,其實上述所有問題最終真正的落腳點無非三處:基板、互聯、密封。具體怎么做呢?我們接著往下看。
04
現有器件封裝的維度劃分與分析
4.1 封裝的三個維度解析(知識星球發布)...
4.2 芯片內嵌PCB封裝的誕生(知識星球發布)...
05
PCB作為封裝的優劣勢分析
5.1 PCB封裝的優勢(知識星球發布)...
5.2 PCB封裝存在的"三點短板"(知識星球發布)...
那么,針對上述PCB封裝存在的先天問題,如何解決呢?我們在中篇繼續展開。
中篇
芯片內嵌PCB封裝的多維度協同創新:互聯、散熱、基材、絕緣可靠性
06
PCB封裝問題的綜合解決思路與維度劃分
6.1綜合解決思路
針對PCB作為封裝存在的問題,需要從互連、散熱、應力、絕緣等方面進行綜合解決。進一步分析可歸納為物理空間設計、材料本質特性、長期可靠性三維度個方向。
6.2 三個維度的解釋
1. 空間維度 → 聚焦 “結構設計”
針對的問題:互連、散熱(前文中的 PCB 封裝 “散熱差”“熱應力”,本質和空間結構設計有關)。
解決的思路:電熱耦合空間結構優化
|SysPro解釋:寬禁帶器件工作時,電、熱特性相互影響(電熱耦合),需要通過空間結構設計(比如布線布局、散熱通道、芯片與基板的堆疊方式),讓電性能(低寄生、高傳輸)和熱管理(高效散熱)協同優化,解決 “想密集布線提升性能,但容易熱量堆積” 的矛盾。
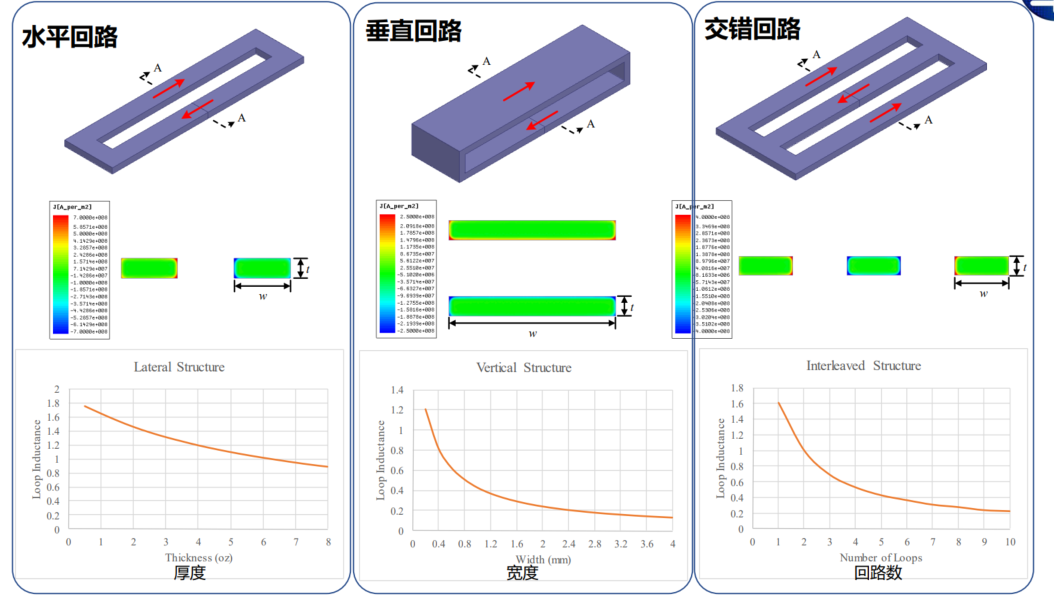
圖片來源:西安交大
2. 材料維度 → 聚焦 “基材突破”
針對的問題:應力、絕緣(前文中的 “熱應力大”“絕緣可靠性差”,和 FR-4 基材的性能缺陷直接相關)。
解決的思路:電熱力高性能 PCB 材料制備
|SysPro解釋:傳統 FR-4 材料在 “電(絕緣、寄生參數)、熱(導熱、膨脹系數)、力(機械強度、應力匹配)” 方面無法滿足寬禁帶器件需求,必須開發高性能 PCB 材料—— 比如更高導熱、低膨脹系數、高絕緣強度的基材,同時兼顧電、熱、力性能,從 “材料根上” 解決問題。
圖片來源:西安交大
3. 可靠性維度 → 聚焦 “長期穩定”
針對的問題:應力、絕緣(前文中的熱應力導致開裂、絕緣老化失效,都是 “可靠性” 范疇)。
解決的思路:應力 - 絕緣可靠性評估
|SysPro解釋:寬禁帶器件工作時,應力(熱應力、機械應力)和絕緣性能相互影響(比如應力集中會加速絕緣老化),需要建立可靠性評估體系—— 模擬實際工況(溫度循環、電壓沖擊等),量化分析“應力如何影響絕緣壽命”,通過模擬電場施加,觀察電損傷、電樹枝生長、電遷移等現象,提前發現潛在失效風險,保障長期穩定運行。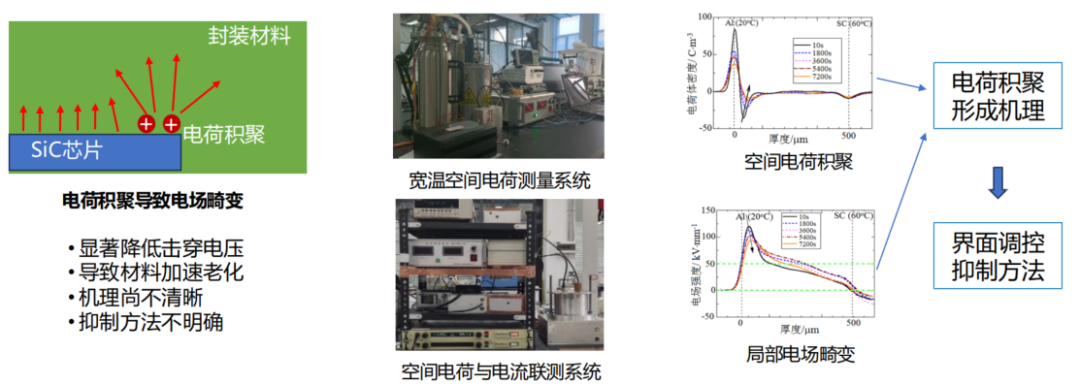
圖片來源:西安交大
| SysPro備注:此處先做概述,在后續章節中會展開講講,說明背后的機理和解決方法。
07
空間維度:結構創新與電路布局布線優化
7.1 結構創新(知識星球發布)
針對寬禁帶器件(如 SiC、GaN)對"低雜散電感、高性能散熱"的需求,從互連設計、散熱設計兩方面,來看看如何通過結構創新解決問題?主要有兩個方面。
7.1.1 低雜散電感、高密度互連的實現...
7.1.2 高性能散熱的實現...
7.2 電路布局布線優化(知識星球發布)...
08
材料維度:PCB材料改進研究
8.1 材料改進的方向與目標(知識星球發布)...
8.2 具體改進手段(知識星球發布)...
那么,這一解決方案效果如何呢?我們從導熱、膨脹、機械、介電、絕緣五大維度來看下測試結果。
8.3 性能優化驗證結果:5大維度(知識星球發布)
8.3.1 導熱性能...
8.3.2 膨脹系數...
8.2.3. 機械強度...
8.2.4 介電性能...
8.2.5 絕緣性能...
09
芯片內嵌PCB封裝的絕緣問題解析
9.1 絕緣問題的分析方法和思路
在可靠性維度下,絕緣問題是重點關注的內容,下面我們聚焦 “PCB 封裝的絕緣問題”,研究電熱耦合場下PCB封裝材料絕緣損傷失效機理和影響。
長期以來,人們普遍認為只有電壓高時才會出現絕緣問題,但實際上,在PCB中,即使電壓不是特別高,由于芯片表面邊角等因素導致的電場集中,也會引發絕緣失效。特別是在電力電子應用環境下,高溫、非正弦波、快速變化的方波等因素會對絕緣材料造成惡劣影響。
所以,想要完整還原 PCB 絕緣失效的 “因 - 果” 過程,采用以下邏輯開展這個工作:模擬真實放電試樣 → 施加多場耦合應力 → 觀測絕緣損傷(電樹枝、放電數據)。下面我們具體來看看。

圖片來源:西安交大
9.2 絕緣失效背后的秘密:電樹枝+銅須(知識星球發布)...
9.3電樹枝生長的影響因素(知識星球發布)...9.4 直流電場下銅須生長的秘密(知識星球發布)...9.5小結:芯片內嵌PCB封裝絕緣失效的"因果鏈"(知識星球發布)...
下篇芯片內嵌 PCB 封裝-主流工藝實踐的深度解析
導語:在上篇中,我們了解了為什么封裝是制約寬禁帶器件發展的重要瓶頸?明確了好器件需要好封裝來匹配。為了最大程度的發揮出寬禁帶器件優勢,我們需要搞明白電、熱、可靠性層面的問題,以及它們的“聯動搞事” 背后邏輯。
在中篇中,我們深入探討了寬禁帶器件封裝所面臨的電性能、散熱及可靠性等多維度挑戰,并從空間維度(結構設計優化)、材料維度(基材性能突破)及可靠性維度(長期穩定性評估)三個方向,系統闡述了PCB封裝技術的創新路徑與解決方案。
然而,技術突破不僅需理論支撐,更需實踐驗證。下篇,將聚焦芯片內嵌PCB封裝的主流工藝實踐,從內埋GaN器件的PCB封裝結構解析,到全流程工藝制程的深度拆解,再到關鍵工藝步驟(如鍍銅芯片、Cell單元集成、PCB嵌入等)的詳細說明,我們將通過具體工藝案例,揭示如何將理論方案轉化為實際產品,并探討該技術在電力電子系統中的創新應用與未來拓展方向。
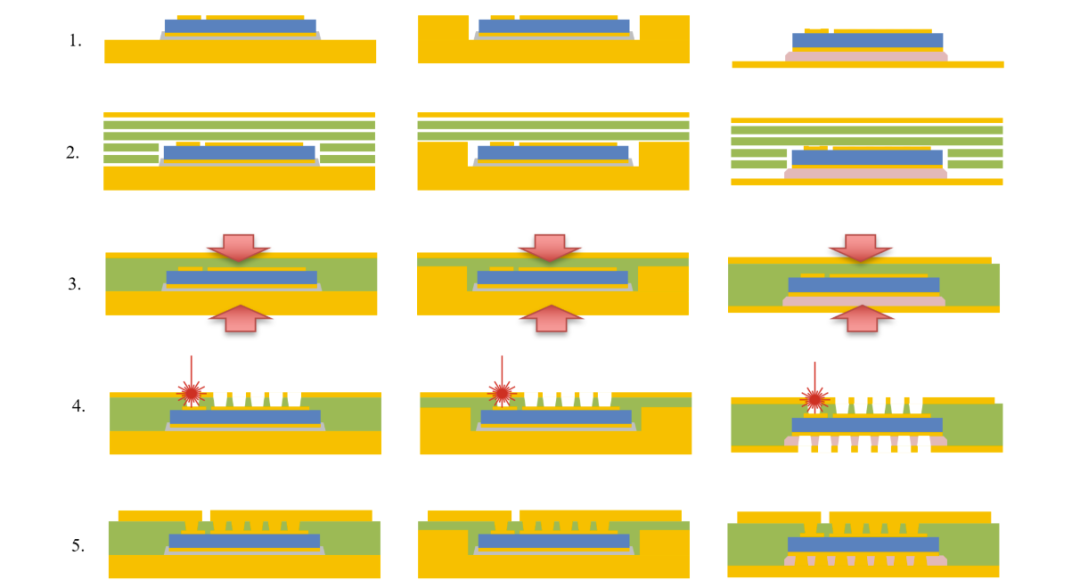
圖片來源:ASK
10
芯片內嵌PCB封裝工藝方法指南
10.1 內嵌GaN器件的PCB內埋式封裝結構說明
最后,我們聊一聊這一技術方案的工藝制程。
芯片內嵌PCB封裝的核心目標是通過將芯片(如SiC、GaN等功率半導體芯片)嵌入PCB內部,實現高集成度、高性能的封裝解決方案。正如我們上面所述,整個制程包含互連設計、結構優化、層壓工藝,只有掌握這些,才能為后續實踐打下基礎。
我們借助下圖,一起先來看看PCB內埋式封裝的基本結構。
下圖所示為芯片內嵌式PCB技術的概念圖 (Power Chip Embedding)。整體結構分為頂部連接(top connections)、隔離層(isolation)和底部連接(bottom connections),通過特殊的制程工藝,將功率芯片直接嵌入到PCB板間,實現器件與PCB的一體化。
簡單些理解,就是將傳統的三維結構功率半導體模塊轉化為平面化配置的形式,用鍍銅連接(Plated Cu Connections)替代了傳統的鍵合線工藝(Bonding Wires)。
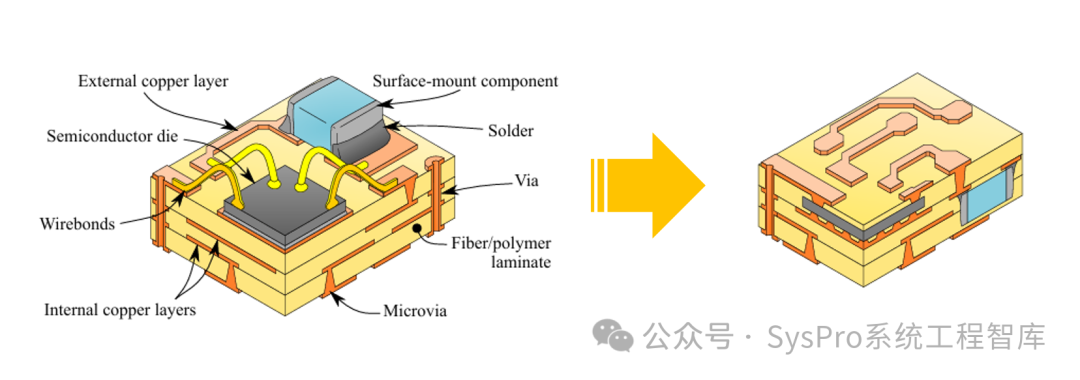
圖片來源:HAL
了解了PCB內埋式封裝的基本結構后,那么內埋PCB封裝工藝的全流程是什么樣子呢?我們接著往下看。
10.2 芯片內嵌PCB封裝工藝的全流程解析
(知識星球發布)
下圖芯片內嵌PCB封裝工藝的全流程。概述下來一共6個關鍵環節:...
下面我們對其中的最為關鍵的幾個環節進行展開,說明其中的細分工藝制程方法,關鍵!
10.3Step2 - 鍍銅芯片 · 工藝制程解析
(知識星球發布)
鍍銅芯片,指對晶圓進行鍍銅處理,目的是優化芯片的電氣連接和散熱性能。這一步至關重要,它直接關系到芯片與PCB之間互連的可靠性和性能。特別是在功率半導體應用中,高質量的鍍層能夠滿足高頻、高功率的需求。整個工藝流程包含十個關鍵環節,每一步都緊密相連,共同構建起高質量的銅電鍍層...
10.4Step3 -Cell 單元· 工藝制程解析
(知識星球發布)
下面我們接著看看另一個關鍵工藝:PCB封裝Cell單元的工藝,這一步用于將芯片與DTS層集成,形成可用于PCB封裝的功能單元。整個過程包含6個關鍵步驟...
10.5Step4 - 芯片PCB嵌入· 工藝制程解析
(知識星球發布)
下面我們聊聊整個工藝制程中最為重要的一部:芯片的PCB嵌入...
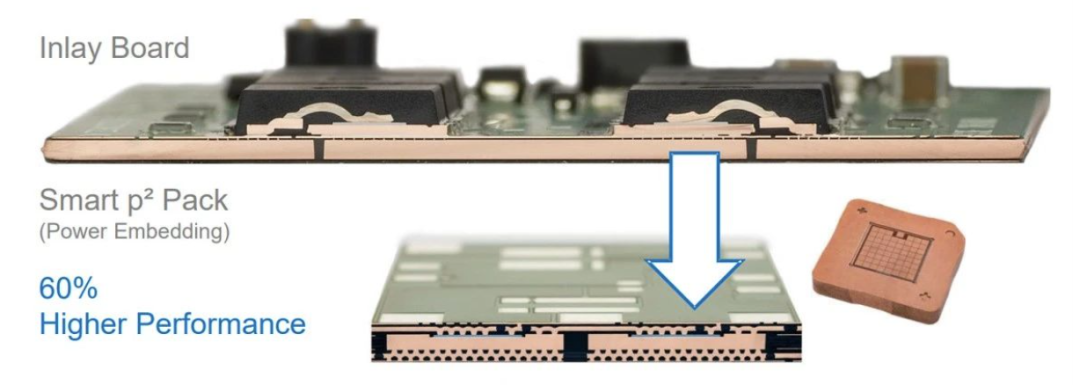
圖片來源:Schweizer
11
內埋式PCB封裝工藝的拓展和創新應用
(知識星球發布)
...
12 總結
到此,關于功率芯片PCB內埋式封裝 · 從概念到量產的全鏈路解析就基本結束了,內容比較多,我們再將上、中、下三篇串起來,進行總結。
在上篇中,我們了解了電力電子器件的發展歷程中,封裝技術的重要性日益凸顯。寬禁帶器件的開關速度快、功率密度高,對封裝技術提出了更高要求,尤其在電性能、散熱和可靠性方面。
傳統封裝技術在面對寬禁帶器件時暴露出諸多問題,如雜散電感過大、散熱困難、熱應力導致的可靠性下降等。這些問題相互耦合,形成復雜的技術挑戰。因此,先進封裝技術需圍繞電性能、散熱和可靠性三個核心問題展開。
【上篇 · 鏈接】功率芯片PCB內埋式封裝:從概念到量產的全鏈路解析

圖片來源:西安交大
在中篇中,針對這些挑戰,提出了多種解決方案。
在電性能方面,通過高密度多層布線和低寄生電感設計來提升性能;在散熱方面,選用高熱導率基板和優化散熱結構來強化熱管理;在可靠性方面,通過減小熱應力、優化材料匹配來提高器件壽命。

圖片來源:西安交大
PCB封裝作為一種有潛力的解決方案,通過高密度互連、集成化設計和成熟工藝,實現了低成本、高性能的封裝目標。然而,PCB封裝也面臨散熱差、熱應力大和絕緣可靠性等問題。針對這些問題,我們從空間維度、材料維度和可靠性維度出發,探討了了結構創新、材料改進和可靠性評估等綜合解決方案。
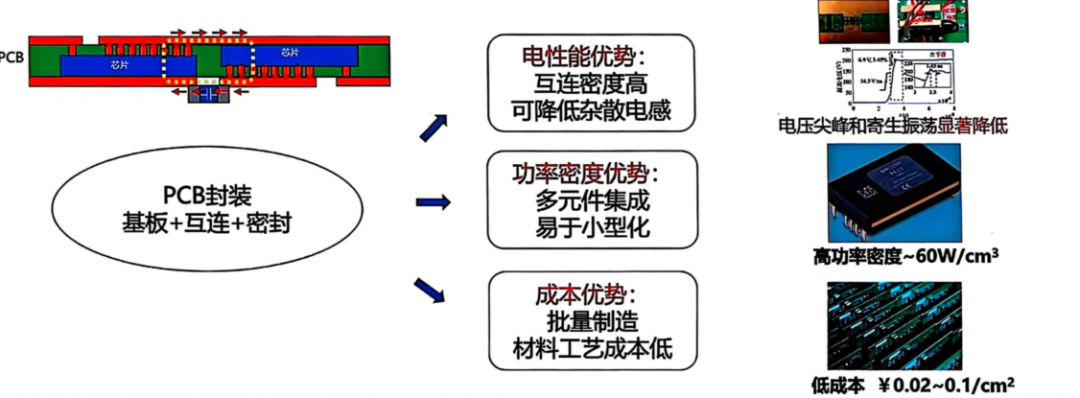
圖片來源:西安交大
從電、熱、力學維度出發,通過高密度布線降電感、高熱導基板強化散熱、匹配熱膨脹系數減應力;還創新 PCB 封裝,利用其高密度互連、集成化優勢適配寬禁帶特性,同時攻克其散熱、應力、絕緣短板。
【中篇 · 鏈接】功率芯片PCB內埋式封裝:從概念到量產的全鏈路解析(中篇)
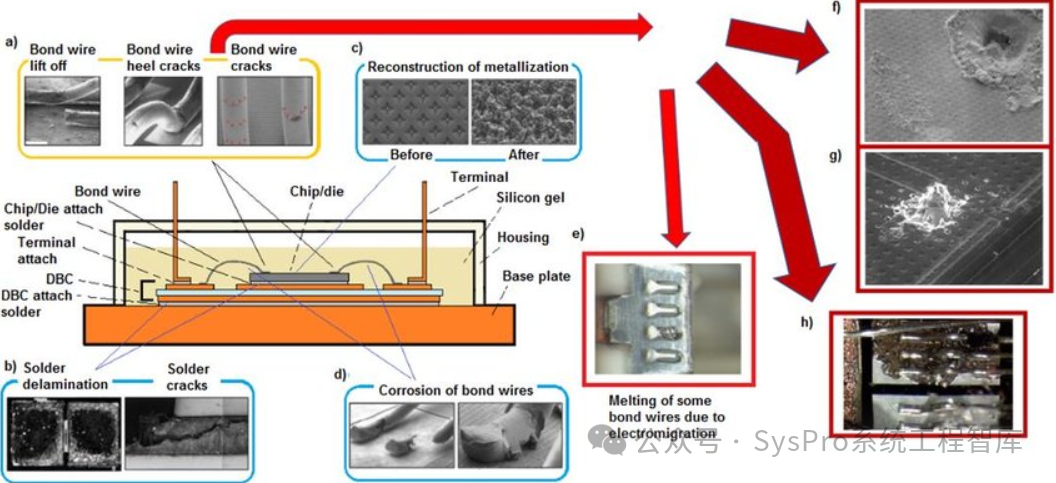
圖片來源:網絡
最后,在下篇中,我們學習、深度解讀芯片內嵌PCB封裝工藝的全流程,一共6大關鍵環節。我們了解了其核心是通過鍍銅芯片、Cell單元集成、PCB嵌入等關鍵工藝步驟,實現了功率半導體芯片與PCB的高質量集成,在此基礎上對上述三大工藝制程的細分步驟進行了詳細說明。
以上功率芯片PCB內埋式封裝從概念到量產的全鏈路解析。感謝你的閱讀,希望有所幫助!
以上《功率芯片PCB內埋式封裝:從概念到量產的全鏈路解析》的全集匯總(節選),完整內容、相關產品技術方案資料、深度解讀、視頻解析已在在知識星球「SysPro電力電子技術EE」中發布,全文18500字+,歡迎進一步查閱、學習,希望有所幫助!
-
pcb
+關注
關注
4371文章
23515瀏覽量
410386 -
功率芯片
+關注
關注
0文章
113瀏覽量
15656
發布評論請先 登錄
精密設備的"電力保鏢":優比施UPS如何守護數據與硬件安全?

地熱發電環網柜局放監測設備:清潔能源電網的&amp;quot;安全衛士&amp;quot;

為什么GNSS/INS組合被譽為導航界的&amp;quot;黃金搭檔&amp;quot;?

芯片內嵌式PCB封裝技術方案解析&amp;quot;七部曲&amp;quot; | 第二曲:市場主流玩家與技術方案解讀

人形機器人為什么要定制? ——揭秘工業場景的&quot;千面需求&quot;

中美貿易硬核破局!先積集成以中國&amp;quot;芯&amp;quot;智造筑牢供應鏈護城河

電纜局部放電在線監測:守護電網安全的&amp;quot;黑科技&amp;quot;

隧道管廊變壓器局放在線監測:為地下&amp;quot;電力心臟&amp;quot;裝上智能聽診器

【硬核測評】凌華DAQE雙雄爭霸:工業數據采集界的&amp;quot;速度與激情&amp;quot;實戰解析

傳統產線VS智能工控:華頡科技如何用模塊化設計撕掉&amp;quot;電老虎&amp;quot;標簽?

創新驅動未來:大為錫膏為高精尖散熱器技術注入&amp;quot;強芯&amp;quot;動力

onsemi LV/MV MOSFET 產品介紹 &amp;amp; 行業應用

思瑞浦車規級產品矩陣,全面覆蓋汽車級CAN&amp;amp;LIN、LDO需求






 功率芯片PCB內埋式封裝技術 · 從概念到量產的全鏈路解析"三部曲"(匯總篇)
功率芯片PCB內埋式封裝技術 · 從概念到量產的全鏈路解析"三部曲"(匯總篇)












評論