南京屹立芯創半導體科技有限公司
針對芯片失效的專利技術與解決方法
在后摩爾時代,隨著SOC、SIP等技術的快速崛起,集成電路向著更小工藝尺寸,更高集成度方向發展。對應的,在更高集成度、更精工藝尺寸,以及使用更多新材料的情況下,對應的產品新增失效問題也會越來越多,為了弄清楚各類異常所導致的失效根本原因,IC失效分析也同樣在行業內扮演著越來越重要的角色。一塊芯片上集成的器件可達幾千萬,因此進行集成電路失效分析必須具備先進、準確的技術和設備,并由具有相關專業知識的半導體分析人員開展分析工作。

失效分析技術的作用主要有以下方面:1.通過相關分析技術確定器件怎樣失效,為什么失效,以弄清楚是什么引起的失效和如何可以預防的過程。2.確定產品特征及調查產品質量是否符合質量規定、預期的要求或相關規格的過程。
失效分析技術所要達到的目的主要有以下方面:1.正確判斷失效模式,找到失效原因及失效機理。2.找到有效的糾正與預防措施,防止同類異常再次發生。3.針對目標產品提供包含設計修改、過程工藝更新等改進建議,從而降低產品的失效率和提高產品整體性能。4.記錄相關失效信息,并提供失效分析報告。5.保存失效的歷史記錄。
通常來說,失效分析的執行步驟應遵循非破壞分析、半破壞分析及破壞分析的順序。但根據不同類型的產品、不同機構的分析模式,失效分析往往采用的方式也是有所差距的,此處以某集成電路封裝體分級失效分析舉例。
1、器件外觀檢查
通常使用體視顯微鏡進行外觀確認,排除外觀方面明顯可能造成失效的原因。
2、伏安特性檢查
通常使用曲線圖示儀,顯示待檢產品的伏安特性,以此排除電性能方面可能造成失效的原因。
3、X射線檢查
使用X-Ray專用檢測設備,確認焊接質量情況,排除因焊點疲勞等相關方面可能造成失效的原因。
4、時域反射儀
通過測量反射波的電壓幅度,計算出阻抗的變化。只要測量出反射點到信號輸出點的時間值,就可以計算出傳輸路徑中阻抗變化點的位置。從而確認失效點發生的位置(Substrate/Bond/Bump/Die……)
5、超聲掃描顯微鏡檢查
通過不同模式SCAM的波形生成聲波圖像,排除封裝體內部空洞/分層/異物等相關方面可能造成失效的原因。
6、化學/激光開封及內部目視檢查
高分子的樹脂體在熱的濃硝酸(98%)或濃硫酸作用下,被腐蝕變成易溶于丙酮的低分子化合物,在超聲作用下,低分子化合物被清洗掉,從而露出芯片表層。開封后,使用掃描電子顯微鏡或高倍顯微鏡觀察封裝體內部狀態,排除芯片隱裂、IMC斷裂、芯片來料缺陷(晶圓缺陷)等相關方面可能造成失效的原因。
7、光發射電子顯微鏡及液晶分析
光發射電子顯微鏡利用電子發射的局部變化來產生圖像對比度。激發通常由紫外線,同步輻射或X射線源產生。通過收集發射的二次電子間接測量系數在吸收過程中隨著初級纖芯空穴的產生而在電子級聯中產生的電子。可以看見和捕獲會發射光子的動態事件,如閂鎖效應等,并同步進行晶體管尺度的定位。
液晶分析作為一項互補技術,在芯片表面涂覆一層液晶,通過正交偏振光觀察,不同狀態時呈現為不同的顏色。向列相液晶為乳白色,偏振光顯微鏡下則為彩虹色。各向同列相為透明色,而偏振光顯微鏡下則為黑色。使液晶從一種液相轉變為另外一種液相的溫度稱為清亮點,當缺陷位置發熱使溫度達到清亮點以上時,這個熱點馬上會變成黑色。以此排除大的漏電,異常的大電流,短路等方面導致的失效原因。
8、EDX能譜分析
當芯片表面或切面存在未知異物時,可采用EDX能譜分析的方法,由于不同元素發出的特征X射線具有不同頻率,根據能量公式E=hν可知,不同元素具有不同的能量。因此,只要檢測不同光子的波長,即可確定目標位置中的元素種類及對應含量,以此確定異物成分,并分析導致失效的深層原因。
9、其失效分析技術
Cross section(切片分析)、P-lapping(平磨分析)、Pad cratering test(彈坑測試)、IMC coverage(金屬間化合物覆蓋比)

對于倒裝芯片底部填充工藝來說,填充后Void的存在與否是影響產品可靠性的重點之一。且由于填充位置為芯片底部,故在常規情況下,一般檢驗方式無法直接確認是否存在氣泡。為了能夠快速判斷產品是否存在此類異常,即需引入失效分析方法。
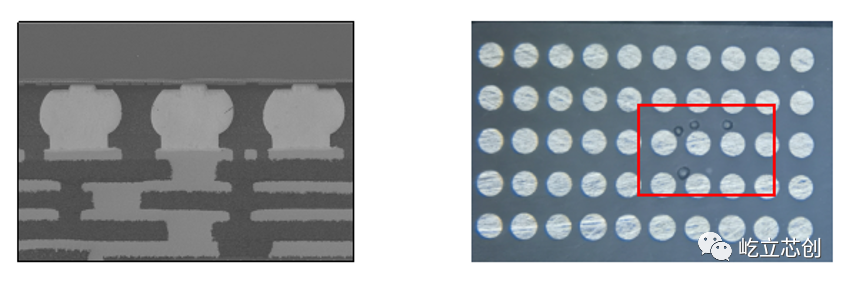
一般來說,采用超聲掃描顯微鏡檢查是判斷此類異常最常規的手段之一。
聲波圖像可以顯示具體的Void位置及大小,但要精確判斷氣泡是否存在連接Bump空間,則需要進一步進行分析,此類失效分析一般采用的是切片、平磨等處理方式。切片可以縱向察看Bump切面狀態,平磨則可以分析水平面整體填充狀態。
審核編輯 黃宇
-
芯片
+關注
關注
459文章
52492瀏覽量
440640
發布評論請先 登錄
LED芯片失效和封裝失效的原因分析

漢思新材料取得一種PCB板封裝膠及其制備方法的專利

無刷雙饋電機專利技術發展
輪邊驅動電機專利技術發展
新能源汽車驅動電機專利信息分析
高密度封裝失效分析關鍵技術和方法

深入解讀NimbleTrack靈動式三維掃描系統背后的專利技術

芯片的失效性分析與應對方法

從外觀到參數,芯片失效的檢測方法

LCR數字電橋的常見故障及解決方法
季豐對存儲器芯片的失效分析方法步驟
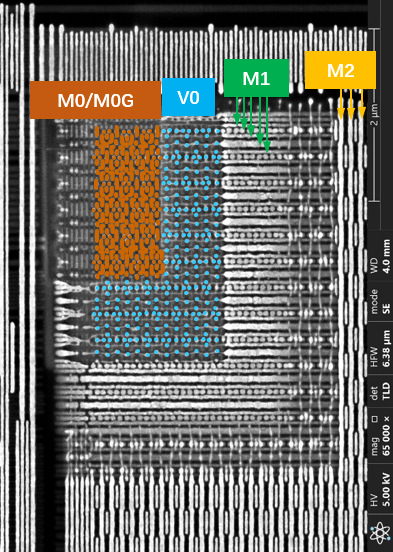





 針對芯片失效的專利技術與解決方法
針對芯片失效的專利技術與解決方法














評論