無潤濕開焊(Non Wet Open,NWO)的詳細解析與改進建議
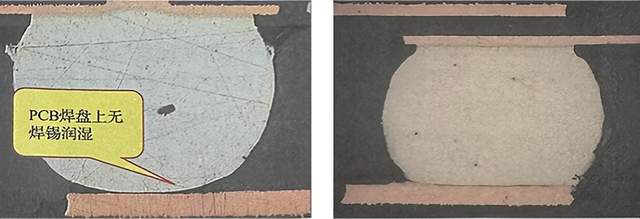
一、定義與典型特征
無潤濕開焊(Non Wet Open,NWO)指的是在PCB(印刷電路板)上,BGA(球柵陣列)焊盤沒有實現良好潤濕的開焊焊點。其切片圖的典型特征表現為PCB焊盤上全部或部分區域缺乏焊錫的潤濕,如圖1-1所示(此處雖未附圖,但描述清晰)。
二、產生原因
BGA翹曲導致焊膏拉起
形成階段:無潤濕開焊焊點通常開始形成于再流焊接的升溫階段(160~190℃)。
形成機理:如圖1-2所示,BGA發生翹曲,將焊膏帶到BGA焊球上,由于焊膏與焊盤分離,導致無法形成良好的焊點。

圖 1-2 無潤濕開焊焊點的形成機理
其他導致開焊焊點的情況
焊膏漏印:焊膏未正確印刷到焊盤上。
焊盤氧化:焊盤表面氧化,影響焊錫的潤濕性。
焊盤上有污物或焊劑工藝問題:焊盤表面存在污物或焊劑使用不當,導致焊錫無法良好潤濕。
根本原因
產生此缺陷的根本原因在于BGA的變形,并將焊膏拉起。華為公司的朱愛蘭等人對焊膏拉起的原因進行了深入研究,發現焊膏拉起現象與其低溫活性、高溫黏結力及黏結力穩定性等因素無直接相關性。但通過低溫過爐(低于焊膏熔化點)直接起拔的方法研究焊膏的拉起現象,結果表明焊膏被拉起的概率為0~7.6%,至少表明這種現象是存在的。通過降低回流溫度可明顯降低翹曲以及NWO的失效概率。
三、識別方法
無潤濕開焊現象可以通過X-Ray識別。由于焊膏被覆蓋到焊球上,通常焊點會明顯比周圍焊點大。如果這種現象與失效焊點對應,基本就可以確認為出現了無潤濕開焊現象。
四、改進建議
針對無潤濕開焊現象,需要具體情況具體分析,但一般應遵循以下改進建議:
PCB上線前表面清潔
確保PCB在上線前進行徹底的表面清潔,去除焊盤表面的氧化層、污物等,提高焊錫的潤濕性。
采用SPI監控焊膏印刷質量
使用SPI(焊膏印刷檢查機)監控焊膏印刷質量,防止漏印的單板流入后續工序。通過SPI可以實時檢測焊膏的印刷量、印刷位置等參數,確保焊膏印刷質量符合要求。
其他改進措施
優化焊接工藝參數:根據PCB和BGA的特性,優化再流焊接的溫度曲線、時間等參數,確保焊錫能夠充分潤濕焊盤。
加強BGA的固定:在PCB上增加BGA的固定措施,如使用膠水、支架等,減少BGA在焊接過程中的翹曲變形。
定期檢查和維護設備:定期對焊接設備進行檢查和維護,確保設備的精度和穩定性,減少因設備問題導致的焊接缺陷。
審核編輯 黃宇
-
pcb
+關注
關注
4362文章
23458瀏覽量
408284 -
BGA
+關注
關注
5文章
570瀏覽量
48343
發布評論請先 登錄
激光焊錫中虛焊產生的原因和解決方法
電機疑難故障原因分析及解決措施
回流焊中花式翻車的避坑大全
解析SMT工藝中的半潤濕現象
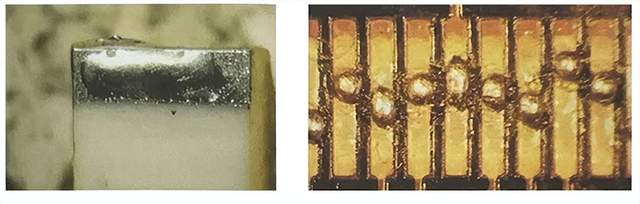
晶硅切割液潤濕劑用哪種類型?
虛焊現象的發生及其預防對策
分析波峰焊時產生連錫(短路)的原因以及解決辦法

怎么理解錫膏的潤濕性?
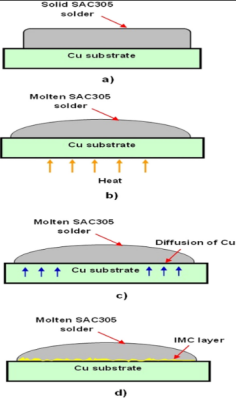
簡述自激振蕩產生的原因
PCBA錫膏加工虛焊和假焊的危害有哪些?
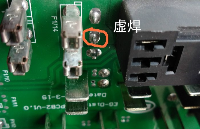
簡述時鐘抖動的產生原因
貼片電容代理-貼片電容虛焊的原因
SMT錫膏使用中產生假焊現象的原因及解決方法






 詳解無潤濕開焊的產生原因及改進措施
詳解無潤濕開焊的產生原因及改進措施












評論