電子發燒友網綜合報道,5月28日,浙江力積存儲科技股份有限公司(以下簡稱"力積存儲")向港交所提交上市申請書,獨家保薦人為中信證券(香港)有限公司。
力積存儲是中國領先的內存芯片設計公司及AI存算解決方案供應商。憑借深厚的技術積累、國際化的研發佈局、全面的產品矩陣以及產業鏈深度合作伙伴關係,擁有廣泛的客戶群體并實現產品及解決方案的大規模商業化。
2022年、2023年及2024年的收入分別為人民幣609.9百萬元、人民幣580.3百萬元及人民幣646.4百萬元。2022年、2023年及2024年錄得凈虧損分別為人民幣139.0百萬元、人民幣244.3百萬元及人民幣108.9百萬元。于2023年凈虧損增加,主要是由于年內產生大量股份支付費用。

四大產品線
根據弗若斯特沙利文的資料,按2024年利基DRAM收入計,力積存儲在全球利基DRAM市場的中國內地公司中排名第四。根據弗若斯特沙利文的資料,公司是中國AI存算行業的先
行者,掌握了WoW 3D異構集成核心技術,在積極推進并力爭成為率先實現高帶寬內存產品量產的中國內地公司之一。為多種應用提供完整的定制化存儲解決方案,包括消費電子及網絡通信(如Wi-Fi路由器及智能家用電器)、物聯網設備、汽車電子、能源及工業控制設備。
? 內存芯片:自主設計的內存芯片,經過嚴格的封裝和測試,廣泛應用于嵌入式系統,在商業級與工業級領域有廣泛應用。其中,商業級內存芯片主要應用于消費電子和網絡通信(如機器人、智能音響及Wi-Fi設備等),而工業級內存芯片則專為更高要求的工業控制應用服務,尤其能夠滿足極低溫環境下的可靠性要求,確保在極端使用條件下的穩定性和長壽命。
? 內存模組:由存儲芯片顆粒與PCB主板經過精密封裝工藝整合而成,廣泛應用于高端運算產品,如行業級PC和企業級服務器等。通過高效的封裝與模塊化設計,內存模組能夠提供卓越的性能和穩定性,滿足不同應用場景對存儲密度、速度及可靠性的嚴苛要求。
? 內存KGD晶圓:主要為SoC廠商提供定制化內存KGD晶圓。在芯片設計階段,針對客戶需求進行精準的晶圓測試,并將合格的晶圓交付給下游廠商用于后續封裝加工。通過與客戶深度合作,晶圓都符合客戶的高標準技術要求。
? AI存算解決方案:開發中的AI存算解決方案涵蓋AI存算用存儲芯片、AI存算用高帶寬WoW 3D堆疊產品、以及AI存算用新型存儲器周邊產品及服務,產品及解決方案可以廣泛應用于人工智能推理、邊緣計算、智能駕駛等前沿領域,預計可有效紓緩數據密集型AI應用的存儲瓶頸,尤其是在邊緣運算和AI推理等場景中,提升計算效率和存算一體化性能。
2025年4月,公司與力積電簽署了基于19納米及以下制程開發內存產品的合作協議。該項目達成后,預計將為中國國內芯片設計公司目前可用的最先進制程,這也將使其成為少數擁有該等先進工藝能力的中國內地芯片設計公司之一。2025年5月,已實現專為高密度互連應用設計的硅中介層解決方案的商業化。
客戶方面,所在的行業包括消費電子、網絡通信、汽車電子、能源及工業控制設備。截至2024年12月31日止三個年度,來自五大客戶的收入分別約為人民幣390.2百萬元、人民幣387.6百萬元及人民幣336.1百萬元,分別占相應年度總收入的約64.0%、66.8%及52.0%。
截至2024年12月31日止三個年度,向前五大供應商采購的金額分別約為人民幣672.8百萬元、人民幣475.9百萬元及人民幣451.1百萬元,分別占相應年度采購總額約97.0%、88.6%及76.2%。
力積電一直是公司唯一的第三方代工供應商。截至2022年、2023年及2024年12月31日止年度,從力積電的采購價值分別占相應期間總采購額的34.4%、49.1%及42.4%。此外,亦從有限數量的外包半導體封裝和測試公司采購封裝、測試及組裝服務,包括福懋科技及南茂科技。
混合堆疊內存HSM 2026年量產
高帶寬內存產品是未來AI應用突破存儲壁壘的重要助力,正在逐漸成為GPU主流內存解決方案。力積存儲自主研發了基于“Wafer-on-Wafer 3D異構集成技術”的“1層邏輯晶圓+1層內存晶圓”解決方案,將邏輯晶圓與內存晶圓在垂直方向上使用TSV硅通孔技術,通過混合鍵合技術封裝在一起,形成了領先的高帶寬3D堆疊內存解決方案。
傳統方法是利用TSV和微凸塊技術垂直堆疊多片內存晶圓,再輔以邏輯控制晶圓進行運作管理。該等堆疊式內存芯片再透過CoWoS封裝與邏輯芯片互連。這種設計范例可有效滿足AI工作負載的高速資料處理需求和帶寬需求。例如,最新的DDR5產品可提供約5,600 Mbps的資料傳輸速率及約50 GB/s的帶寬,而領先的以HBM為中心的解決方案則可達到超過9.6Gbps的傳輸速率和超過每秒1TB的帶寬。預計在2026年將以存儲為中心的高帶寬內存芯片(稱為“混合堆疊內存HSM)”)商業化。HSM芯片代表了多層堆疊技術的一大進步。透過采用混合接合技術進行芯片裸片堆疊,其于TSV間距、熱分佈和整體性能方面都優于現有的解決方案。
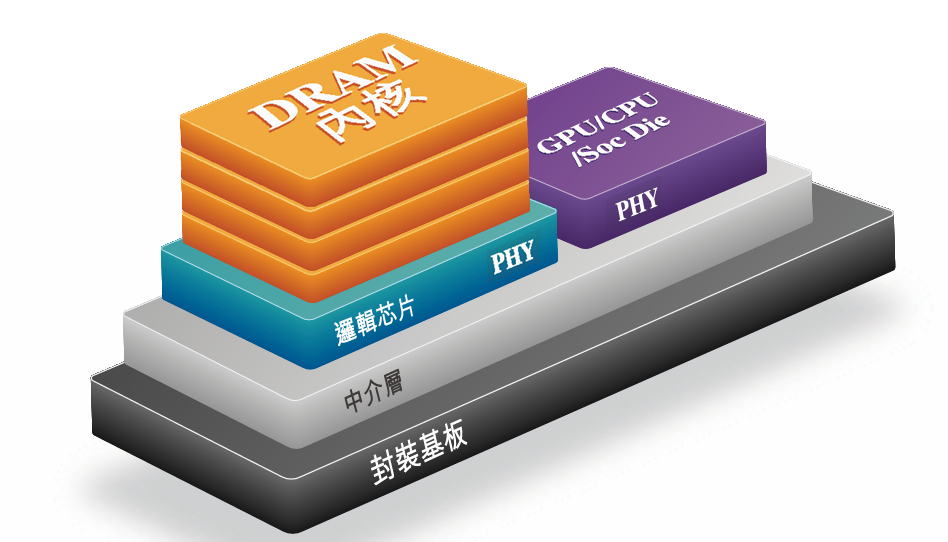
堆疊存儲的優點在于可降低每比特能耗。然而,這種方法伴隨著大量的輸入╱輸出介面,通常會導致大量的總功耗。因此,其可能會引起熱管理的挑戰。為解決這個問題,從熱源到散熱器的有效散熱至關重要。
在采用微凸塊的堆疊方案中,熱量擴散主要局限于凸塊與晶圓之間的鍵合面。此外,諸如非導電薄膜(NCF)這類底部填充材料具有較高的熱阻,這進一步阻礙了熱量傳遞。相比之下,無凸塊混合鍵合的WoW方案展現出卓越的熱擴散性能。由于不存在凸塊,熱傳導面積得以增加,而且采用極薄拋光晶圓能顯著加快熱量在多層結構中的擴散速度。
根據弗若斯特沙利文的資料,從2025年至2029年,全球算力規模預計將增長2倍、AI服務器出貨量將增長1倍,預計將成為推動高帶寬堆疊DRAM市場增長的核心因素。2024年全球高帶寬堆疊內存產品市場規模達到人民幣1,189億元,預計2024年至2029年將保持超過25.2%的復合年增長率。現有高帶寬堆疊內存產品供應遠不能滿足市場需求。
國產AI芯片的加速推出和應用,正推動市場對高帶寬堆疊內存產品國產化的需求。根據弗若斯特沙利文的資料,2024年國產芯片在中國AI芯片市場份額為20%以上,2025年預計進一步提升至逾30%。預計力積存儲將于2026年正式推出HSM產品,成為國內高帶寬3D堆疊內存芯片生產和商業化的先驅。憑借強大的政策支持、不斷擴展的下游應用以及對創新的承諾,有望在未來幾年持續增長并引領市場。
發布評論請先 登錄
DeepSeek推動AI算力需求:800G光模塊的關鍵作用

曙光存儲構建先進存力中心,打通中國存儲產業
存算一體架構創新助力國產大算力AI芯片騰飛
【「算力芯片 | 高性能 CPU/GPU/NPU 微架構分析」閱讀體驗】--全書概覽
存力與算力并重:數據時代的雙刃劍
科技新突破:首款支持多模態存算一體AI芯片成功問世






 力積存儲港股IPO,蓄力研發AI存算方案
力積存儲港股IPO,蓄力研發AI存算方案













評論