隨著時間的推移,采用 BGA 封裝的器件密度不斷提高,焊球數量也越來越多。由于器件之間的間距較小,焊球數量龐大且間距縮小,如今即使是一些簡單的器件,也需要采用盤中孔的 HDI 工藝。為了確保良率,在組裝時需要特別注意這些器件,并通過有針對性的 X 射線檢查,確保成功焊接。
進入大批量生產階段后,通常會面臨降低成本的壓力。為此,人們往往從高焊球數器件上的焊膏印刷入手。更換材料后,最常見的一種降本措施是減少耗材使用,而焊料是 PCB 組裝過程中消耗量最大的材料。

BGA 組裝良率
BGA 的焊接通常需要額外在裸 PCB 的焊盤圖案上涂覆一些焊膏。雖然不同的組裝廠可能采用不同的指南,但基本原則不變:涂覆焊膏是確保標準焊盤尺寸上有足夠焊料的唯一方法。在 CAD 工具默認應用的助焊層數據中,焊膏將涂覆在整個 BGA footprint 上,包括功能性和非功能性 BGA 焊盤。
功能性與非功能性 BGA 焊盤
在 BGA 焊膏印刷中,“非功能性焊盤”并非指通孔焊盤,而是BGA 上沒有任何功能的焊盤(或焊球)。它們可能是保留的引腳或明確未連接的引腳,或者具有功能但當前未被使用的引腳。焊接流程通常包括印刷焊膏(選擇性印刷)或使用模板將焊膏沉積在焊盤圖案上,然后通過回流焊爐。
對于許多器件(如涂覆處理器),大多數焊盤都是功能性的,未連接或保留的可能只有不到 10%。而在采用 BGA footprint 的 FPGA 中,開發人員可以自由分配引腳和接口,因此在生產環境中,可能存在更多未引出的非功能性焊盤。
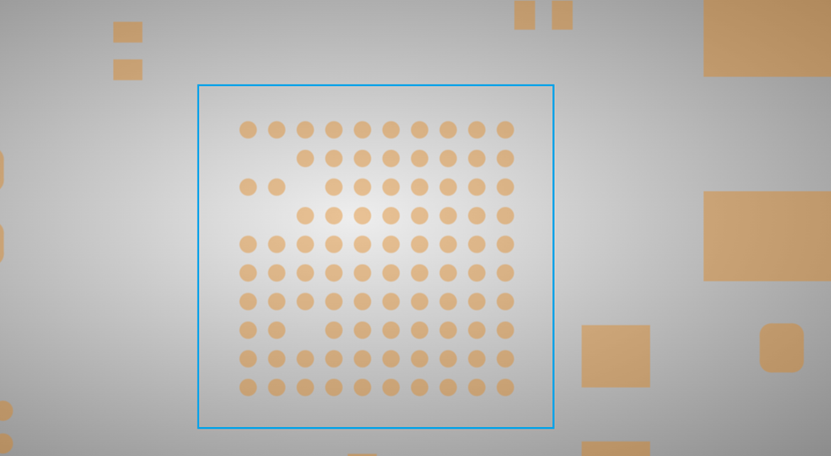
0.4 mm 間距 BGA 上的助焊層開口。
取消焊膏印刷會影響成本嗎?
減少組裝材料確實可以降低成本,但從產品開發和整體生產成本來看,這種降低可能微不足道。因為除了未使用的焊膏成本,我們還要考慮數量和返修問題。在焊盤圖案中印刷焊膏時,僅需使用少量焊膏,但當大批量生產時,這部分成本就會增加到不可忽略的程度。
為了降低大批量涂覆成本,通常會選擇去除非功能性焊盤上的焊膏。為此,需要從焊膏模板上移除相應焊盤的開口。此操作可以在相關器件的 PCB footprint 中完成,或在 Gerber 數據中直接刪除助焊層上的掩模開口。
BGA 焊盤上的焊膏不可去除
盡管在大批量生產時出于成本考慮,會試圖去除部分焊盤上的焊膏,但非功能性焊盤仍與功能性焊盤一樣印刷焊膏。雖然這會帶來額外的焊膏成本,但與回流焊過程中因組裝失敗而產生的返修成本相比,這點投入微不足道。更糟糕的是,一旦產品在使用過程中出現故障,不僅會引發昂貴的召回,還可能對品牌信譽造成重大打擊。
保留 BGA footprint 中所有焊盤上的焊膏,主要有以下兩點原因:
1
電氣功能與熱傳導功能
盡管 BGA 封裝中的焊盤可能不具備電氣功能,但它們仍具有熱傳導功能。根據封裝類型,這些焊盤可能直接與封裝(如晶圓級芯片規模封裝)的裸片連接。它們仍具有熱傳導性,可以將裸片上的熱量傳導至 PCB 基板。使用焊膏進行充分的焊接,可確保提供一條低熱阻路徑,實現從裸片到 PCB 基板的熱量傳導。
2
應力集中
如果器件承受應力,無論是因電路板加熱還是器件本身受到沖擊,應力都會集中在焊點上。去除助焊層會導致焊料量不足,非功能性 BGA 焊盤上的焊點物理尺寸會變小,焊點強度也會變弱。如此一來,在經歷反復的振動應力、機械沖擊或溫度循環后,應力集中程度加劇,從而顯著增加故障的風險。在所有焊盤上涂覆焊料,有助于將應力均勻分布在 BGA 中的所有焊點上。
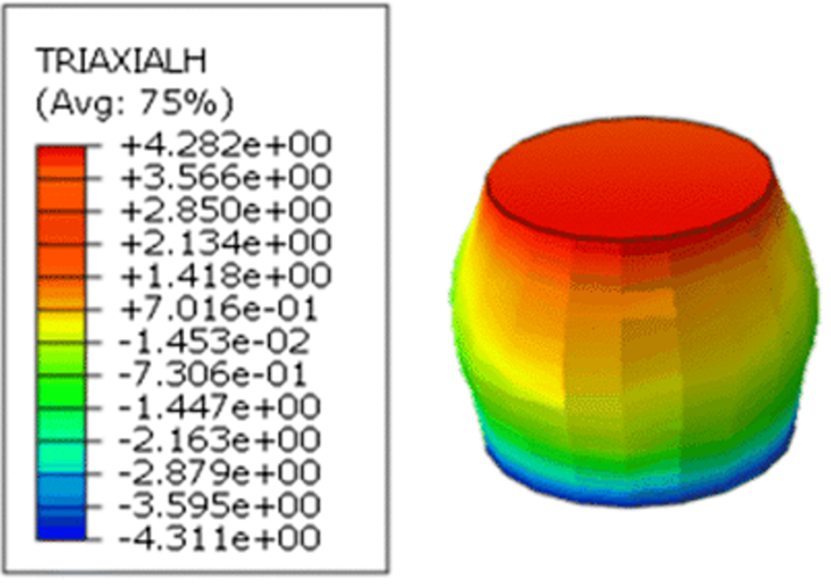
應力集中在 BGA 上焊球最薄弱的部分。如果焊球頸部較為薄弱,應力集中會導致疲勞累積,造成焊點斷裂。
總結
簡言之,如果在 BGA 的 PCB footprint 中應用了 IPC 標準化焊盤尺寸指南,應在所有焊盤上涂覆焊膏,以提升組裝的可靠性。確保 footprint 中包含充足的助焊層開口,以便在 PCB 組裝過程中,在 BGA 中形成牢固可靠的焊點。
在 Allegro X PCB Designer 中,可以使用規則管理器對 BGA 焊盤進行規則設置。報名參加報名參加五月直播課程:規則設置,讓每一塊 PCB 都有望成為可靠性與性能的標桿,解鎖高效高質量設計新維度。
-
BGA
+關注
關注
5文章
566瀏覽量
48147 -
器件
+關注
關注
4文章
334瀏覽量
28261 -
焊膏
+關注
關注
0文章
50瀏覽量
10511
發布評論請先 登錄


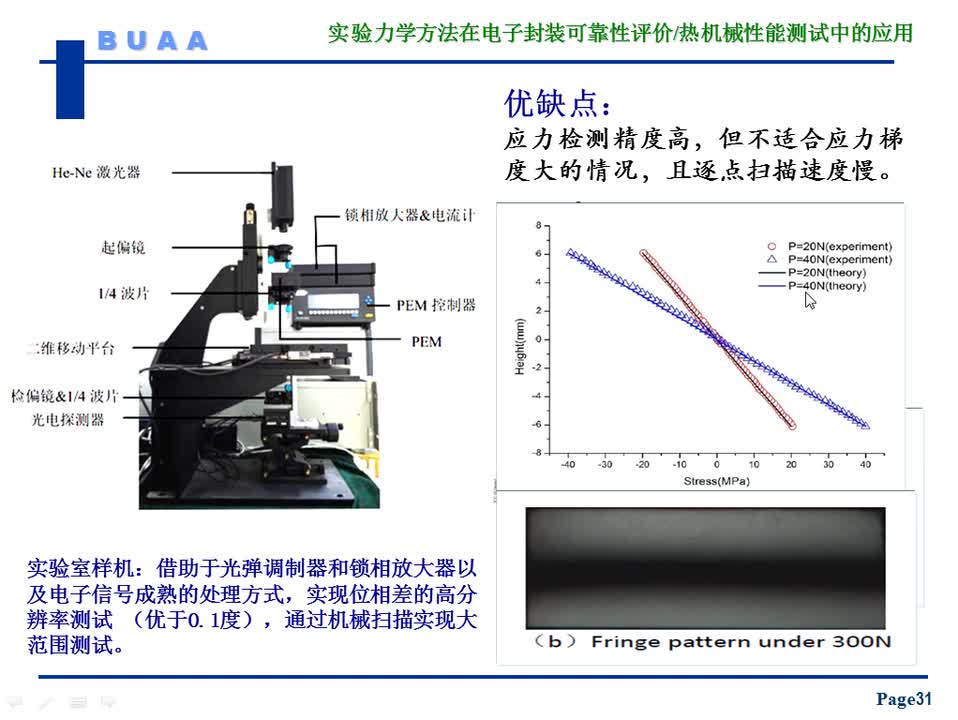
PCB選擇性焊接技術介紹
PCB選擇性焊接技術詳細
PCB選擇性焊接技術詳細
【轉】PCB選擇性焊接技術
BGA焊接工藝及可靠性分析
什么是高可靠性?
單片機應用系統的可靠性與可靠性設計
BGA封裝的PCB布線可靠性
PCB選擇性焊接技術詳解
BGA封裝焊球推力測試解析:評估焊點可靠性的原理與實操指南






 技術資訊 | 選擇性 BGA 焊膏的可靠性
技術資訊 | 選擇性 BGA 焊膏的可靠性











評論