氮化鎵(GaN)功率器件系列能夠設計出體積更小,成本更低,效率更高的電源系統,從而突破基于硅的傳統器件的限制。
這里我們給大家介紹一下GaNPX?和PDFN封裝器件的熱設計。
應用筆記--GaNPX?封裝器件的熱設計
1. 控制器件溫度的重要性
- ?溫度對電氣參數的影響?:Rds(on)(導通電阻)和跨導gm隨溫度升高而增加,導致導通損耗和開關損耗增加。
- ?熱設計目標?:通過良好的熱設計降低結溫Tj,防止熱失衡,提高系統可靠性和效率。
- ?實例對比?:在大功率應用中,GaN Systems的絕緣金屬基板(IMS)設計相比FR4 PCB能顯著減小散熱器體積,提高功率密度。
2. 功耗與散熱基礎
- ?功耗機制?:開關器件的能耗主要包括硬開關、同步整流和零電壓軟開關模式下的損耗。
- ?散熱方式?:傳導、對流和輻射是三種主要的散熱方式,熱阻類比于電阻,熱容類比于電容。
- ?結溫計算?:Tj = Ta + P × RθJA,其中RθJA是結到環境的熱阻。
3. 頂部散熱設計考量
- ?散熱介質材料(TIM)選擇?:關鍵因素包括絕緣強度、機械強度和成本。
- ?安裝考量?:推薦使用適當的安裝壓力和方式,避免PCB彎曲造成的應力。
- ?電壓絕緣距離?:設計需滿足規定的爬電距離和絕緣間隙標準。
- ?彎曲度與壓力測試?:通過測試確保器件在壓力下的變形和漏電流在安全范圍內。
- ?熱阻測量?:通過實驗測量結到散熱器和結到殼的熱阻,評估散熱性能。
4. 底部散熱設計考量
- ?FR4 PCB底部散熱設計?:通過散熱通孔設計、增加PCB層數和銅厚來降低熱阻。
- ?IMS底部散熱設計?:適用于大功率場合,通過緊湊設計提高功率密度,需注意焊接空洞對散熱性能的影響。
- ?性能比較?:IMS相比FR4 PCB在熱阻方面表現更優,但成本較高。
5. 基于熱的考慮來選擇器件
- ?單顆器件散熱性能?:不同封裝和散熱方式的器件功耗與結溫關系圖展示了散熱設計對系統最大功率的影響。
- ?并聯提高散熱性能?:并聯GaN器件可以同時降低電氣損耗和熱阻,提高系統功率。
- ?實驗證明?:并聯使用GS66516B器件在硬開關情況下能均流高負載電流,且結溫溫差小。
6. 功耗及熱模型
- ?SPICE模型?:提供L1和L3兩個級別的模型,L3模型包含熱模型及封裝的寄生電感,適用于熱仿真。
- ?PLECS模型?:支持器件級和系統級仿真,能夠分析寄生參數對開關性能的影響,提供開關損耗、導通損耗等建模工具。
- ?在線仿真工具?:GaN Systems提供基于PLECS模型的在線仿真工具,方便用戶進行系統設計和優化。
總結
- ?核心要點?:良好的散熱設計對于提高GaN晶體管和系統的性能至關重要。通過優化頂部和底部散熱設計、選擇合適的散熱材料和安裝方式、以及利用功耗和熱模型進行仿真分析,可以有效降低器件溫度,提高系統效率和可靠性。
- ?應用建議?:在實際應用中,應根據具體需求選擇合適的封裝和散熱方案,并利用提供的建模工具進行仿真驗證,以確保系統設計的優化和可靠性。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
GaN
+關注
關注
19文章
2167瀏覽量
76079 -
熱設計
+關注
關注
11文章
132瀏覽量
26912
發布評論請先 登錄
相關推薦
熱點推薦
功率器件封裝結構熱設計綜述
在有限的封 裝空間內,如何把芯片的耗散熱及時高效的釋放到外界環境中以降低芯片結溫及器件內部各封裝材料的工作溫度,已成 為當前功率器件封裝設計階段需要考慮的重要問題之一。本文聚焦于功率

功率器件熱設計基礎(六)——瞬態熱測量
功率半導體熱設計是實現IGBT、碳化硅SiC高功率密度的基礎,只有掌握功率半導體的熱設計基礎知識,才能完成精確熱設計,提高功率器件的利用率,降低系統成本,并保證系統的可靠性。功率器件

電子封裝和熱沉用鎢銅材料
隨著大規模集成電路和大功率電子器件的發展,20世紀90年代鎢銅材料作為新型電子封裝和熱沉材料得到了發展,并以其明顯的優勢得到日益廣泛的應用。目前鎢銅材料主要用于大規模集成電路和大功率微波器中作為基片
發表于 05-04 08:07
LED封裝器件的熱阻測試及散熱能力評估
%的電能轉換成光,其余的全部變成了熱能,熱能的存在促使我們金鑒必須要關注LED封裝器件的熱阻。一般,LED的功率越高,LED熱效應越明顯,因熱效應而導致的問題也突顯出來,例如,芯片高溫的紅移現象;結溫
發表于 07-29 16:05
VS2508AE -20V -55A P管 PDFN3*3封裝 MOS管 場效應管
專業賣中底壓MOS管 VS2508AE -20V -55A P管 PDFN3*3封裝 MOS管 場效應管***(微信同號),
發表于 03-05 14:54
LED封裝器件熱阻測試
。通常,LED器件在應用中,結構熱阻分布為芯片襯底、襯底與LED支架的粘結層、LED支架、LED器件外掛散熱體及自由空間的熱阻,熱阻通道成串
發表于 05-26 15:45
?3581次閱讀
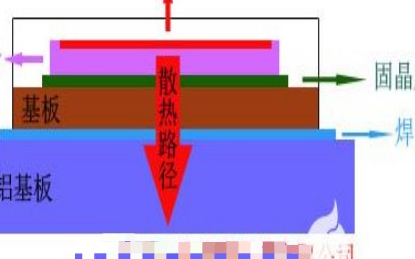
IC封裝的熱特性
為確保產品的高可靠性,在選擇IC封裝時應考慮其熱管理指標。所有IC在有功耗時都會發熱,為了保證器件的結溫低于最大允許溫度,經由封裝進行的從IC到周圍環境的有效散熱十分重要。本文有助于設計人員和客戶
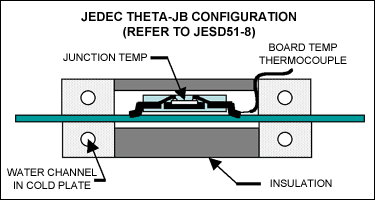
半導體器件為什么熱阻參數經常被誤用?
一些半導體器件集成了專用的熱二極管,根據校準后的正向電壓與溫度曲線精確測量結溫。由于大多數器件沒有這種設計,結溫的估計取決于外部參考點溫度和封裝的熱
發表于 09-25 09:32
?2593次閱讀

功率器件熱設計基礎知識
功率器件熱設計是實現IGBT、碳化硅SiC等高功率密度器件可靠運行的基礎。掌握功率半導體的熱設計基礎知識,不僅有助于提高功率器件的利用率和系
新潔能車規級PDFN 5x6雙面散熱功率器件介紹
在汽車電子行業飛速發展的今天,提升可靠性、效率和散熱性能成為了功率器件設計的重要方向。車規級 PDFN5*6 雙面散熱產品,以其優異的散熱性能和緊湊的封裝設計,成為新一代汽車應用中的明星產品。
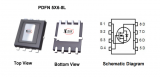
基于RC熱阻SPICE模型的GaNPX?和PDFN封裝的熱特性建模
能夠通過添加界面材料和散熱片將其熱模型擴展到其系統中。 附詳細文檔免費下載: *附件:基于RC熱阻SPICE模型的GaNPX?和PDFN封裝






 GaNPX?和PDFN封裝器件的熱設計
GaNPX?和PDFN封裝器件的熱設計

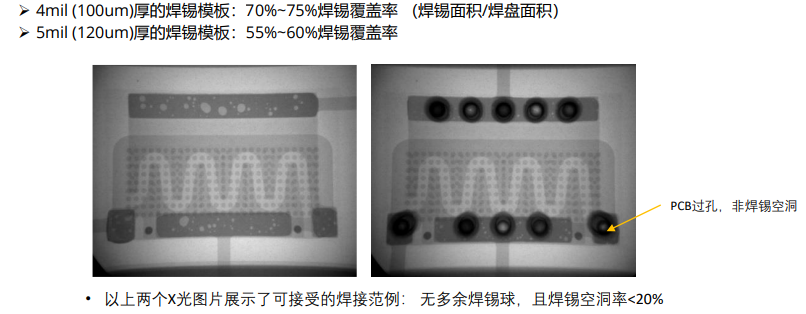










評論