本文將系統(tǒng)介紹光阻的組成與作用、剝離的關(guān)鍵工藝及化學(xué)機(jī)理,并探討不同等離子體處理方法在光阻去除中的應(yīng)用。
一、光阻(Photoresist,PR)的本質(zhì)與作用
光阻是半導(dǎo)體制造過(guò)程中用于光刻工藝的核心材料。它由高分子樹脂、光敏劑、溶劑及添加劑組成。其特性直接影響芯片圖形化的精度。
光阻的作用:
圖形轉(zhuǎn)移:通過(guò)曝光顯影,在硅片表面形成納米級(jí)圖案,作為后續(xù)刻蝕或離子注入的掩膜。
保護(hù)作用:阻擋刻蝕劑或離子對(duì)非目標(biāo)區(qū)域的損傷。
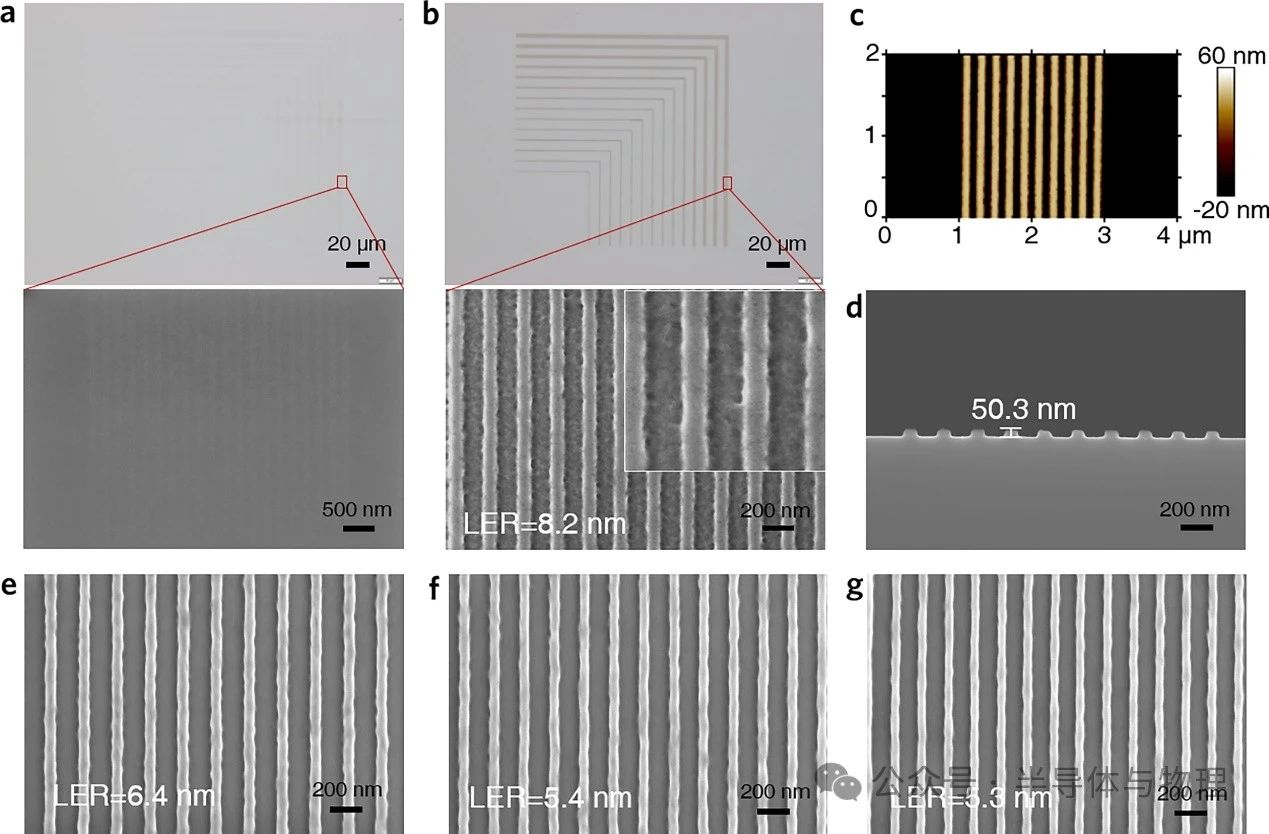
二、光阻剝離(PR Strip)
完成掩膜使命后的光阻需徹底去除,否則殘留物會(huì)導(dǎo)致:
后續(xù)工藝污染(如金屬沉積時(shí)引入缺陷)
器件短路或斷路(殘留光阻阻礙導(dǎo)電層連接)
可靠性下降(界面結(jié)合力劣化)
剝離目標(biāo):徹底清除光阻,同時(shí)避免損傷硅片表面材料(如金屬、氧化物、低k介質(zhì)等)。
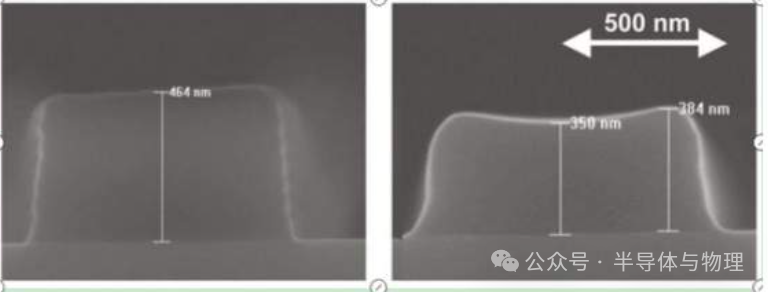
三、光阻剝離的工藝流程與化學(xué)機(jī)理
原理:利用等離子體中的活性自由基轟擊光阻,切斷高分子鏈。
關(guān)鍵步驟與材料:
1.氧氣等離子體(O? Plasma)
設(shè)備:反應(yīng)離子刻蝕(RIE)或電感耦合等離子體(ICP)設(shè)備。
反應(yīng)機(jī)理:活性氧攻擊光阻中的C-H鍵,生成CO、CO?和H?O揮發(fā)。
2.混合氣體增強(qiáng)剝離
CF?/O?混合氣體:增強(qiáng)對(duì)交聯(lián)光阻的刻蝕速率。
H?/N?混合氣體:減少對(duì)金屬層的氧化損傷。
(CH)x+O--CO?+H?O,
CxSiyOz+F--CO?+SiF4+O?Cx

流程示例:
1.真空腔室加載:硅片置于等離子體反應(yīng)腔。
2.氣體注入:通入O?(或混合氣體),氣壓5-50 mTorr。
3.等離子體激發(fā):射頻功率100-500 W,持續(xù)1-5分鐘。
4.灰化產(chǎn)物排出:通過(guò)真空泵抽走氣態(tài)產(chǎn)物。
-
光刻
+關(guān)注
關(guān)注
8文章
338瀏覽量
30592 -
半導(dǎo)體制造
+關(guān)注
關(guān)注
8文章
441瀏覽量
24564
原文標(biāo)題:光阻剝離(PR Strip)
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
電感基礎(chǔ)知識(shí)
光器件BOSA的基礎(chǔ)知識(shí)
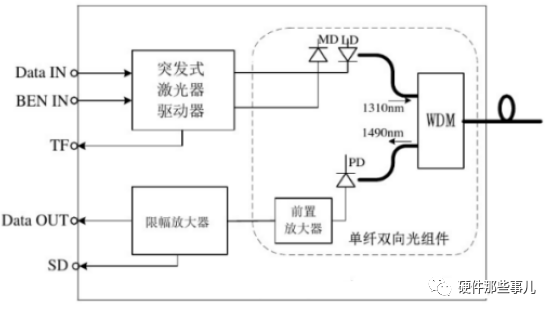
labview基礎(chǔ)知識(shí)
通信基礎(chǔ)知識(shí)教程
液晶基礎(chǔ)知識(shí)
led芯片基礎(chǔ)知識(shí)
光耦合器的基礎(chǔ)知識(shí)
光耦基礎(chǔ)知識(shí)全集
使用Eclipse基礎(chǔ)知識(shí)
電源管理基礎(chǔ)知識(shí)電源管理基礎(chǔ)知識(shí)電源管理基礎(chǔ)知識(shí)






 光阻的基礎(chǔ)知識(shí)
光阻的基礎(chǔ)知識(shí)










評(píng)論