前言
一、CoWoS 技術概述
定義與結構:CoWoS(Chip on Wafer on Substrate)是一種 2.5D 先進封裝技術,由 Chip on Wafer(CoW)和基板(Substrate)連接整合而成。其核心在于將不同芯片堆疊在同一硅中介層上,實現(xiàn)多芯片互聯(lián),從而提高芯片的集成度和性能。
發(fā)展歷程:
2011 年:臺積電開發(fā)出第一代 CoWoS-S,硅中介層最大面積為 775mm2,接近掩膜版曝光尺寸極限(858mm2)。
2014 年:第二代 CoWoS-S 硅中介層面積達到 1150mm2。
后續(xù)迭代:第三代至第六代硅中介層面積分別為 1245mm2、1660mm2、2500mm2、3320mm2,集成芯片數(shù)量從 1 個 SoC + 4 個 HBM(內(nèi)存 16GB)增至 2 個 SoC + 12 個 HBM(內(nèi)存 128GB)。
技術分類:
CoWoS-S(Silicon Interposer):使用硅中介層,具有高密度 I/O 互連,適用于高性能計算(HPC)、人工智能(AI)加速器和高端服務器。
CoWoS-R(RDL Interposer):使用重新布線層(RDL)中介層,具有更大的設計靈活性,適用于網(wǎng)絡設備、通信基站等。
CoWoS-L(Local Silicon Interconnect and RDL Interposer):結合局部硅互連和 RDL 中介層,適合復雜的系統(tǒng)集成,如消費類電子產(chǎn)品和中端服務器。
二、CoWoS 的優(yōu)勢與挑戰(zhàn)
優(yōu)勢:
高度集成:多個芯片可在同一封裝內(nèi)實現(xiàn)高度集成,滿足空間效率要求高的行業(yè)需求,如互聯(lián)網(wǎng)、5G 和人工智能。
高速和高可靠性:芯片與晶圓直接相連,提高信號傳輸速度和可靠性,縮短信號傳輸距離,減少傳輸時延和能量損失,適用于高性能計算和數(shù)據(jù)密集型應用。
高性價比:簡化封裝步驟,降低制造和封裝成本,提高生產(chǎn)效率,相比傳統(tǒng)封裝技術具有更高的成本效益。
挑戰(zhàn):
信號完整性:邏輯晶圓到基板的互連在高數(shù)據(jù)速率下,由于 TSV 的寄生電容和電感,互連的信號傳輸會變差,需優(yōu)化 TSV 設計。
電源完整性:CoWoS 封裝通常用于高性能應用,數(shù)據(jù)切換率高、工作電壓低,容易受到電源完整性挑戰(zhàn),如電源噪聲和電壓波動。
制造復雜性:作為 2.5D/3D 集成技術,制造過程復雜,涉及多個芯片的精確對準和連接,導致芯片成本增加。
集成和良率挑戰(zhàn):2.5D 和 3D 集成電路測試復雜,每個晶圓芯片在安裝到中介層之前需要單獨測試,安裝后還需再次測試,硅通孔(TSV)也需要測試,大型硅中介層易受制造缺陷影響,導致產(chǎn)量損失。
電氣挑戰(zhàn):
散熱挑戰(zhàn):中介層和基板之間的熱膨脹系數(shù)(CTE)不同,易產(chǎn)生散熱問題,導致芯片溫度過高,影響性能和可靠性。使用有機中介層和底部填充材料可在一定程度上緩解散熱問題。
三、產(chǎn)業(yè)市場現(xiàn)狀
市場規(guī)模增長:
全球市場:2020 年全球半導體先進封裝市場規(guī)模為 300 億美元,2023 年上升至 439 億美元,年復合增長率為 13.5%。預計 2024 年將進一步上升至 472.5 億美元。
中國市場:2020 年中國半導體先進封裝市場規(guī)模為 351.3 億元,預計 2025 年將超過 1100 億元,年復合增長率為 26.5%。
CoWoS 需求上升:
高性能 GPU:CoWoS 主要應用于 AI 算力芯片及 HBM 領域。英偉達是主要需求大廠,在臺積電的 CoWoS 產(chǎn)能中占比超過 50%。受益于英偉達 Blackwell 系列 GPU 量產(chǎn),臺積電預計從 2025 年第四季度開始,將 CoWoS 封裝工藝從 CoWoS-S 轉向 CoWoS-L 制程,使 CoWoS-L 成為其 CoWoS 技術的主要制程。到 2025 年第四季度,CoWoS-L 將占臺積電 CoWoS 總產(chǎn)能的 54.6%,CoWoS-S 占 38.5%,CoWoS-R 占 6.9%。
HBM:隨著 AI 加速器、圖形處理單元及高性能計算應用的蓬勃發(fā)展,HBM 銷量急劇攀升。2029 年全球 HBM 行業(yè)市場規(guī)模預計達 79.5 億美元;2020 - 2023 年中國 HBM 市場規(guī)模自 3 億元上升至 25.3 億元,年復合增長率為 204%。HBM 需要 CoWoS 等 2.5D 先進封裝技術實現(xiàn),其產(chǎn)能受 CoWoS 產(chǎn)能制約,需求激增加劇了 CoWoS 封裝供不應求情況。
四、中國大陸主要參與企業(yè)
長電科技:
技術優(yōu)勢:擁有高集成度的晶圓級 WLP、2.5D/3D、系統(tǒng)級(SiP)封裝技術和高性能的 Flip Chip 和引線互聯(lián)封裝技術。
市場表現(xiàn):2024 年 9 月 28 日完成對晟碟半導體(上海)有限公司 80% 股權的收購,增強與全球存儲巨頭西部數(shù)據(jù)的合作關系,受益于存儲芯片需求提升。2024 年 2 季度歸母凈利潤環(huán)比增長 258%,營收創(chuàng)同期歷史新高,實現(xiàn)收入為人民幣 86.4 億元,同比增長 36.9%,環(huán)比增長 26.3%。
通富微電:
技術優(yōu)勢:超大尺寸 2D + 封裝技術及 3 維堆疊封裝技術均獲得驗證通過,大尺寸多芯片 chip last 封裝技術獲得驗證通過,國內(nèi)首家 WB 分腔屏蔽技術研發(fā)及量產(chǎn)獲得突破。
市場表現(xiàn):2019 - 2023 年公司營收持續(xù)增長,2023 年實現(xiàn)營收 222.69 億元,歸母凈利潤為 1.69 億元。
華天科技:
技術優(yōu)勢:已掌握 SiP、FC、TSV、Bumping、Fan-Out、WLP、3D 等集成電路先進封裝技術,推進 FOPLP 封裝工藝開發(fā)和 2.5D 工藝驗證,具備 3D NAND Flash 32 層超薄芯片堆疊封裝能力。
市場表現(xiàn):2024 年前三季度實現(xiàn)營收預計 105.31 億元,同比增長 30.52%。2019 - 2023 年研發(fā)投入持續(xù)增長,分別為 4.02、4.62、6.5、7.08、6.94 億元。
五、CoWoS 技術發(fā)展趨勢
CoWoS-L 成為主流:CoWoS-L 結合了 CoWoS-S 和 InFO 技術的優(yōu)點,使用中介層與 LSI 芯片進行芯片間互連,并用 RDL 層進行功率和信號傳輸,提供最靈活集成。其中介層包括多個局部硅互連(local silicon interconnect,LSI)芯片和全局重布線(global redistribution layers),形成一個重組的中介層(reconstituted interposer,RI),以替代 CoWoS-S 中的單片硅中介層。LSI 芯片保留了硅中介層的所有優(yōu)秀特性,包括保留亞微米銅互連、硅通孔(TSV)和嵌入式深溝槽電容器(eDTC),以確保良好的系統(tǒng)性能,同時避免了單個大型硅中介層的良率損失問題。在電氣性能方面,CoWoS 平臺引入第一代深溝槽電容器(eDTC)提升電氣性能,配備第一代 eDTC 的 CoWoS 可以將系統(tǒng)電源分配網(wǎng)絡(PDN)的阻抗降低 93%,壓降比沒有使用 eDTC 的情況低 72%。此外,HBM VDDQ 的同步開關噪聲(SSN)可以在 3.2 GHz 時比沒有 eDTC 的情況減少到 38%,信號完整性也可以得到改善。新一代的 eDTC 可以提供 1100 nF/mm2 的電容密度,高電容密度為高速計算的電源效率提供了巨大的優(yōu)勢。出于良率考慮,單個硅芯片上 eDTC 的最大面積上限約為 300 平方毫米。通過連接所有 LSI 芯片的電容,CoWoS-L 搭載多個 LSI 芯片,可以顯著增加 RI 上的總 eDTC 電容。




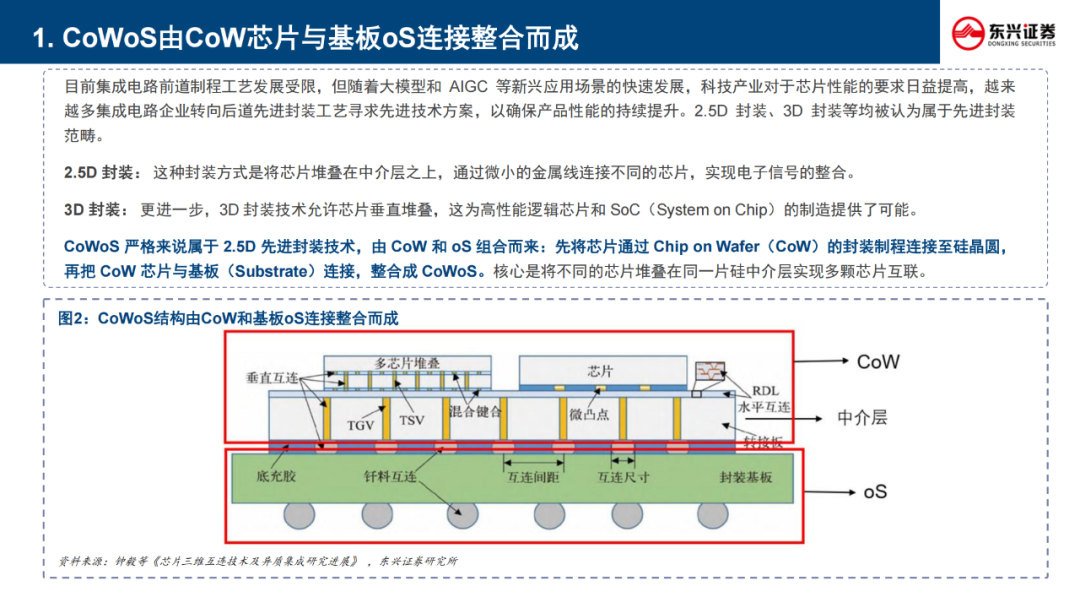










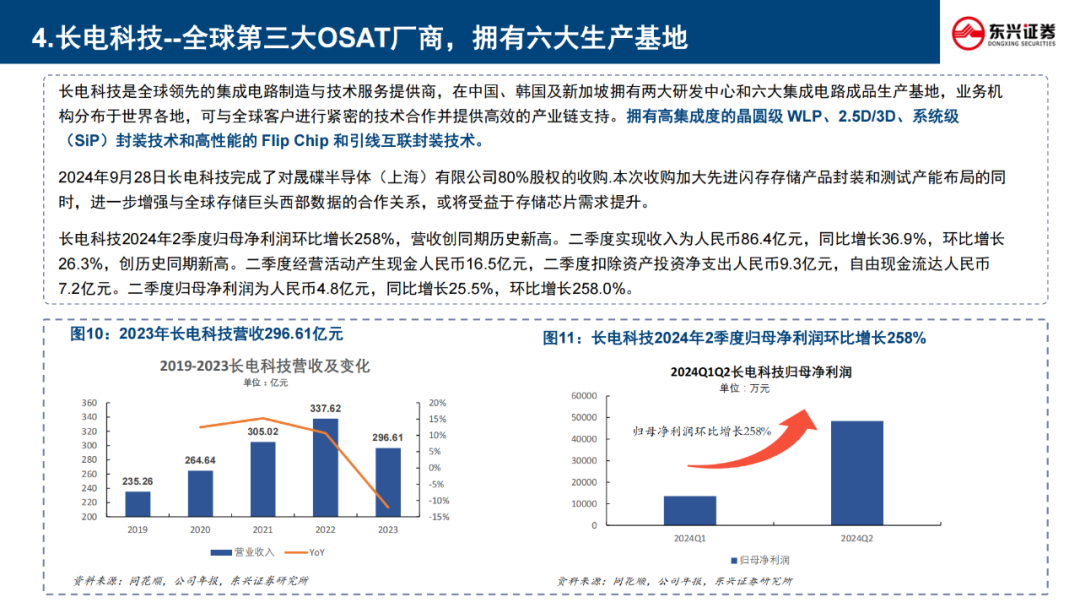


-
CoWoS
+關注
關注
0文章
154瀏覽量
10952 -
先進封裝
+關注
關注
2文章
460瀏覽量
501
原文標題:新技術前瞻專題系列(七):先進封裝行業(yè):CoWoS五問五答
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
問界M8發(fā)布!“尚界”來了!鴻蒙智行集齊“五界”

臺積電CoWoS產(chǎn)能未來五年穩(wěn)健增長
日月光擴大CoWoS先進封裝產(chǎn)能
臺積電先進封裝大擴產(chǎn),CoWoS制程成擴充主力
快訊:華晨寶馬連續(xù)兩年獲得“汽車行業(yè)五星級綠色供應鏈管理企業(yè)”五星好評
CoWoS工藝流程說明
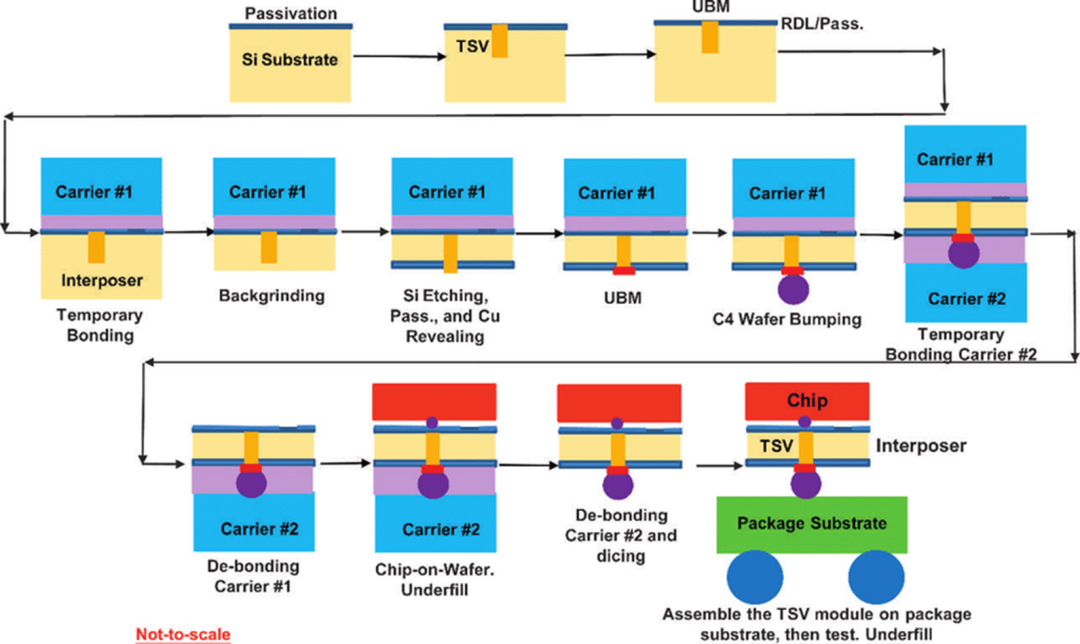





 先進封裝行業(yè):CoWoS五問五答
先進封裝行業(yè):CoWoS五問五答












評論