鈍化層刻蝕對(duì)厚鋁鋁須缺陷影響的研究
國(guó)產(chǎn)中微機(jī)臺(tái)在鈍化層刻蝕工藝應(yīng)用中發(fā)現(xiàn)容易導(dǎo)致后續(xù)的鋁薄膜濺射工藝出現(xiàn)鋁須缺陷(Whisker),進(jìn)而造成產(chǎn)品出現(xiàn)開(kāi)路/短路良率異常。影響 AL whisker 的因素很多,主要有兩方面:一是由于 AL film 和上下地間 TiN film 之間熱應(yīng)力的不匹配容易導(dǎo)致 AL whisker,其主要由鋁濺射自身工藝能力決定;二是前層表面狀況的影響。討論中微機(jī)臺(tái)刻蝕后的表面殘留導(dǎo)致 Al 濺射后出現(xiàn)鋁須缺陷的現(xiàn)象,并對(duì)其成因進(jìn)行系統(tǒng)性分析,同時(shí)對(duì)其解決方案進(jìn)行詳細(xì)的介紹。
關(guān)鍵詞:集成電路制造;鈍化層刻蝕;表面殘留;鋁晶須缺陷;開(kāi)路/短路良率失效
1 引言
隨著器件尺寸的不斷縮小對(duì)于后端金屬布線低電阻阻抗和良好散熱的要求越來(lái)越苛刻,金屬布線進(jìn)入銅互連時(shí)代。但由于鋁表面更容易形成氧化鋁鈍化層從而阻止自身被進(jìn)一步氧化和腐蝕,所以頂層金屬連線基于封裝引線的要求仍然選擇更具穩(wěn)定性的鋁線工藝[1-4]。
中微機(jī)臺(tái)在 55LP 鈍化層刻蝕工藝展開(kāi)階段產(chǎn)品上反饋有開(kāi)路/短路良率異常,良率失效主要分布在晶片(wafer)邊緣區(qū)域,良率損失約 2~4%。開(kāi)路/短路良率失效分布跟在線 APL-DEP 站點(diǎn)后檢測(cè)到的鋁須缺陷分布高度一致,如圖 1 所示。
通過(guò)對(duì)產(chǎn)品缺陷進(jìn)行 TEM 剖面分析發(fā)現(xiàn)由于缺陷的存在導(dǎo)致兩條鋁線之間的間距區(qū)域底部存在鋁殘留,而這也是導(dǎo)致產(chǎn)品出現(xiàn)開(kāi)路/短路良率失效的原因所在,如圖 2 所示。
2 鋁須缺陷造成良率失效實(shí)驗(yàn)和數(shù)據(jù)分析
鋁薄膜濺射工藝過(guò)程中的鋁須缺陷(whisker)是業(yè)界普遍存在的問(wèn)題,很難徹底消除,尤其是鋁膜厚度超過(guò) 20 k? 的厚鋁工藝。但業(yè)界對(duì) whisker通常的認(rèn)知是不會(huì)對(duì)產(chǎn)品良率造成負(fù)面的影響,實(shí)際上通過(guò)了解業(yè)內(nèi)幾個(gè)主流 IC 制造 FAB 的情況來(lái)看,普遍存在較嚴(yán)重的 whisker 缺陷問(wèn)題,同時(shí)這種類型的缺陷也確實(shí)沒(méi)有造成產(chǎn)品良率失效。
但華力 55LP 平臺(tái)產(chǎn)品上良率跟鋁須缺陷之間的出現(xiàn)了很強(qiáng)相關(guān)性,究其原因存在以下兩種可能:(1)華力 55LP 產(chǎn)品平臺(tái)由于產(chǎn)品設(shè)計(jì)上的需要主要采用的是 28 k? 鋁膜厚度,其屬于典型的厚鋁工藝,鋁濺射薄膜厚度越厚鋁須缺陷的工藝窗口約小,whisker 缺陷越難以控制。(2)在產(chǎn)品版圖設(shè)計(jì)上鋁線之間的間距相對(duì)較小,因此產(chǎn)品對(duì)晶須缺陷的容忍度越低,對(duì)鋁須缺陷的要求也越高。華力 55LP 產(chǎn)品鋁線最小設(shè)計(jì)尺寸約 1.8μm。當(dāng) whisker 缺陷尺寸(通常在 1~2μm)跟鋁線寬 space 可以相比擬時(shí),這種缺陷就可能會(huì)造成鋁線之間的短路,最終造成產(chǎn)品出現(xiàn)良率問(wèn)題。
通過(guò)對(duì)產(chǎn)品進(jìn)行逐層跟蹤分析(見(jiàn)圖 3),可以看到當(dāng)鋁須缺陷恰好落在很窄的兩條鋁線 Space 附近的時(shí)候?qū)?huì)造成鋁線之間的短路,當(dāng)然這種情況的發(fā)生存在一定的幾率,但當(dāng)鋁須缺陷達(dá)到一定的數(shù)量時(shí),這種幾率將不可以被忽視;因此可以看出華力 55LP 平臺(tái)產(chǎn)品對(duì)鋁須缺陷的容忍度更低,要求更高。
3 中微機(jī)臺(tái)鋁須缺陷成因分析
3.1由刻蝕主因造成的 whisker 缺陷機(jī)理分析
影響 AL whisker 的因素很多,主要有兩個(gè)方面:(1)由于 AL film 和上下地間 TiN film 之間熱應(yīng)力的不匹配容易導(dǎo)致 AL whisker,其主要由鋁濺射自身工藝能力決定。(2)前層表面狀況的影響,如前層鈍化層刻蝕后的表面狀況、刻蝕后濕法腐蝕去除表面聚合物(polymer)能力等。
55LP 鈍化層刻蝕基準(zhǔn)條件是 LAM FlexDD 機(jī)臺(tái),相對(duì) LAM 基準(zhǔn)條件中微機(jī)臺(tái)的鋁須缺陷狀況明顯要差。基于 Al whisker 缺陷形成機(jī)理懷疑中微機(jī)臺(tái)刻蝕后 wafer 表面聚合物過(guò)重,從而造成其后的鋁濺射薄膜工藝過(guò)程中形成較嚴(yán)重的鋁須缺陷。因此在中微機(jī)臺(tái)腔體進(jìn)行聚合物(polymer)惡化實(shí)驗(yàn)以確認(rèn) wafer polymer 跟 Al whisker 之間的相關(guān)性。
實(shí)驗(yàn)結(jié)果表明:過(guò)重的 wafer 表面 polymer將導(dǎo)致嚴(yán)重 Al whisker 缺陷,同時(shí) wafer 邊緣鋁須缺陷明顯嚴(yán)重,其分布跟產(chǎn)品開(kāi)路/短路失效分布一致。圖 4,聚合物惡化實(shí)驗(yàn)@AMEC 出現(xiàn) worse 鋁須缺陷分布。
通過(guò)使用掃描電子顯微鏡,對(duì)刻蝕后的 wafer 表面狀態(tài)進(jìn)行比對(duì)分析發(fā)現(xiàn),AMEC 機(jī)臺(tái) wafer 邊緣 polymer 狀態(tài)相對(duì) LAM 基準(zhǔn)條件明顯要差(如圖 5 所示),這也跟 wafer 邊緣容易出現(xiàn)嚴(yán)重鋁須缺陷吻合。
3.2 中微機(jī)臺(tái)刻蝕聚合物狀況分析
基于以上分析,中微機(jī)臺(tái)刻蝕后的 wafer 邊緣表面 polymer 較重,這也是導(dǎo)致 wafer 邊緣鋁須缺陷的原因所在。
以 LAM 機(jī)臺(tái)作為基準(zhǔn),下面我們?cè)囍鴱膰?guó)產(chǎn)中微機(jī)臺(tái)的工藝條件、腔體結(jié)構(gòu),部件材料等多個(gè)角度進(jìn)行系統(tǒng)性的比對(duì)分析,從而確認(rèn) wafer 邊緣表面polymer 較重的根本原因有以下三個(gè)方面:RF 系統(tǒng)差異;上電極(Shower head)材質(zhì)差異;工藝條件差異。分別進(jìn)行闡述。
(1)RF 系統(tǒng)差異。中微機(jī)臺(tái) Source RF 采用了 60 MHz 高頻,而 LAM 采用 27 MHz 相對(duì)低頻的 RF交流電源。采用更高的 Source RF 頻率反應(yīng)氣體將更容易發(fā)生電離,相對(duì) 27 MHz RF,同一工藝條件下 60 MHz RF 等離子濃度高約 50%,更高的等離子體(plasma)濃度將會(huì)產(chǎn)生更多的聚合物,如圖 6 所示。
(2)上電極(Shower head)材質(zhì)差異:中微機(jī)臺(tái)上電極采用 SiC 材質(zhì),LAM 采用存 Silicon 材質(zhì)。Si-Si 鍵能 222 KJ/mol, 而 Si-C 鍵能達(dá)到 318 KJ/mol,由于 Si-C 具有更強(qiáng)的鍵能,使得 Si-C 材質(zhì)物理特性更穩(wěn)定,具有更高的抗刻蝕性能。所以相對(duì)于純 Si 上電極,等離子體中與 SiC 材質(zhì)上電極產(chǎn)生反應(yīng)的 CF* 活性成分更少,也就是更多的 CF* 成分與 wafer 介質(zhì)進(jìn)行反應(yīng),因此也產(chǎn)生更多的聚合物。
(3)工藝條件差異:中微機(jī)臺(tái)采用 CF4/CHF3刻蝕工藝氣體,同時(shí)上電極工藝溫度設(shè)定 120℃,而 LAM 主要采用 CF4 工藝氣體,上電極工藝溫度設(shè)定為 80℃,如圖 7 所示。
CF4/CHF3 刻蝕工藝氣體由于 CHF3 的存在將產(chǎn)生更低 F/C 比例的等離子體,因此將產(chǎn)生更多的polymer。同時(shí)更高的上電極工藝溫度設(shè)定將會(huì)促使刻蝕工藝過(guò)程中聚合物更容易趨向于 wafer,從而在wafer 表面形成更重的 polymer。
4 改善方案探討
針對(duì)聚合物產(chǎn)生的原因分析,為解決刻蝕后表面聚合物狀態(tài)過(guò)重問(wèn)題,并最終解決后續(xù) Al 濺射過(guò)程中產(chǎn)生鋁須缺陷的問(wèn)題。考慮從 2 個(gè)方向進(jìn)行改善。
(1)聚焦環(huán)部件優(yōu)化。針對(duì)原因 1 和原因 2,通過(guò)優(yōu)化聚焦環(huán)部件來(lái)改善 wafer 邊緣 polymer 聚集狀況。
聚焦環(huán)部件優(yōu)化基于原因 1 和原因 2,可以看出由于中微機(jī)臺(tái)的腔體結(jié)構(gòu)的特性造成工藝 polymer 相對(duì) LAM 較重,尤其在 wafer 邊緣區(qū)域。為此,通過(guò)聚焦環(huán)部件尺寸來(lái)改善 wafer 邊緣聚合物聚集狀況,如圖 8 所示。
通過(guò)增加 wafer 與聚焦環(huán)之間的縱向間距(從0.18 mm 增加至 0.88 mm),從而在 wafer edge/bevel區(qū)域引入 plasma 以幫助清除 wafer edge/bevle 區(qū)域的polymer,進(jìn)而改善 wafer 邊緣的聚合物狀況。
(2)工藝條件優(yōu)化。針對(duì)原因 3,優(yōu)化工藝配方通過(guò)去除 CHF3 polymer gas 以降低 polymer。同時(shí)上電極溫度設(shè)定從 120℃ 降低到 80℃,促使刻蝕工藝過(guò)程中聚合物更容易趨向于 wafer。從而在 wafer 表面形成更重的 polymer。
圖 9,相同倍率下新/舊聚焦環(huán) wafer 邊緣表面狀態(tài)比對(duì)。圖 10,新條件缺陷及良率結(jié)果。
5 結(jié)語(yǔ)
(1)55LP 鈍化層刻蝕后表面的 polymer 過(guò)重容易導(dǎo)致鋁膜濺射工藝出現(xiàn)較嚴(yán)重的鋁須缺陷,并造成出現(xiàn)開(kāi)路/短路良率失效。
(2)國(guó)產(chǎn)中微機(jī)臺(tái)由于腔體結(jié)構(gòu)設(shè)計(jì)以及工藝條件設(shè)定上的差異造成刻蝕后 wafer 邊緣聚合物過(guò)重,并且很難被后續(xù)的濕法腐蝕去除。
(3)通過(guò)聚焦環(huán)部件優(yōu)化、刻蝕程式優(yōu)化及上電極溫度調(diào)整有效地改善刻蝕后 wafer 邊緣聚合物狀況,并最終解決避免出現(xiàn)鋁須缺陷的問(wèn)題。
本論文借助于 SEM、TEM 等多種分析工具找出了中微機(jī)臺(tái)鈍化層刻蝕開(kāi)路/短路良率失效的根本原因,并通過(guò)系統(tǒng)化分析給出了有效的解決方案,從而及時(shí)解決了國(guó)產(chǎn)中微機(jī)臺(tái)在量產(chǎn)過(guò)程中出現(xiàn)的低良率問(wèn)題,確保機(jī)臺(tái)產(chǎn)能滿足公司的量產(chǎn)需求,同時(shí)為國(guó)產(chǎn)機(jī)臺(tái)在工藝應(yīng)用推廣方面做出貢獻(xiàn)。
參考文獻(xiàn)
[1] MiCHAEL Quirk,Julian Seada,韓鄭生.半導(dǎo)體制造技術(shù)[M]. 北京:電子工業(yè)出版社,2004.
[2] K.A.Jackson,屠海令,萬(wàn)群.半導(dǎo)體工藝[M]. 北京:科學(xué)出版社,1999.
[3] A. Agarwal, S. Banna, V. Todarow, S. Rauf, and K. Collins.Trans[J]. Plasma Sci, 2011, 39(2516).
[4] The science and Engineering of Microelectronic Fabrication, Stephen A[M]. Campbell, 2001.
-
刻蝕
+關(guān)注
關(guān)注
2文章
202瀏覽量
13328 -
集成電路制造
+關(guān)注
關(guān)注
0文章
11瀏覽量
7062
原文標(biāo)題:鈍化層刻蝕對(duì)厚鋁鋁須缺陷影響的研究
文章出處:【微信號(hào):appic-cn,微信公眾號(hào):集成電路應(yīng)用雜志】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
熱仿真在鋁基板設(shè)計(jì)中的實(shí)戰(zhàn)應(yīng)用
如何選擇合適的鋁殼電阻
一文了解鋁基覆銅板






 鈍化層刻蝕對(duì)厚鋁鋁須缺陷影響的研究
鈍化層刻蝕對(duì)厚鋁鋁須缺陷影響的研究
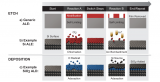










評(píng)論