本文主要討論硅拋光片的主要技術指標、測試標準以及硅片主要機械加工參數的測量方法。
硅片機械加工參數
硅拋光片的主要技術指標和測試標準可以參照SEMI標準、ASTM標準以及其他相關標準。
1.1 硅片機械加工參數的測量方法
進行宏觀的常規檢驗,這通常在暗場或暗室中進行,通過目視或顯微鏡檢測硅片表面的宏觀缺陷,如劃痕、波紋、橘皮、蝕坑、小丘、霧及雜質條紋等。
1.2 硅片表面狀態質量參數
這些參數主要包括硅片表面的宏觀缺陷(如劃痕、波紋等)、表面顆粒含量、表面金屬雜質沾污含量、表面納米形貌及表面損傷、應力等。
這些參數反映了硅片表面的質量和純凈度,對于半導體器件的性能和可靠性有著重要影響。
晶向測量解析
在半導體行業中,硅單晶棒或晶片的晶向測量是確保IC芯片電路性能和質量的關鍵步驟。以下晶向測量的方法。
X射線衍射法:X射線衍射法是最常被采用的測量硅單晶棒或晶片晶向的方法。
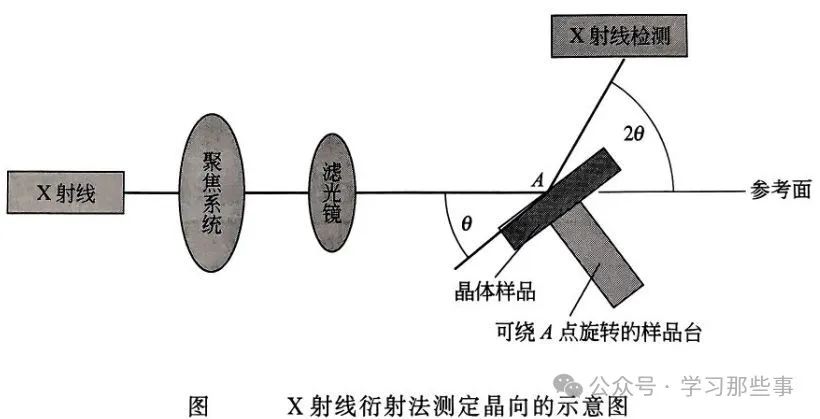
其原理是利用X射線在晶體中的衍射現象,通過測量衍射角來確定晶體的晶向。
布拉格定律:nλ=2dsinθ,其中n為反射次數,d為相鄰的結晶平面的間距,θ為入射X射線與反射面之間的夾角(布拉格角)。
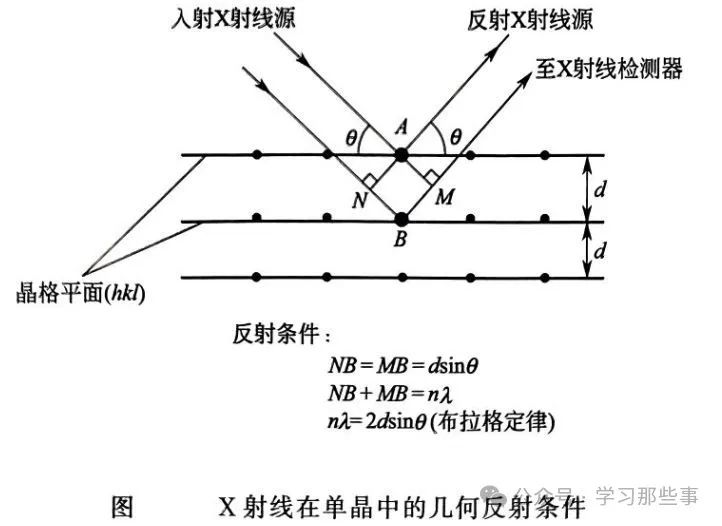
晶面間距計算:對于立方晶系,晶面間距d可以通過公式d=a/(h2+k2+l2)1/2計算,其中a為晶格常數,h、k、l為米勒指數。
其他方法:除了X射線衍射法外,還可以借助可直接觀察的一些可辨別的特征(如腐蝕坑)或借助專用設備(如電子背散射衍射儀)來進行測量。
硅單晶棒或晶片的晶向測量是半導體行業中的一項重要技術,其準確性和可靠性對于確保IC芯片電路的性能和質量具有重要意義。
導電類型的測量解析
導電類型是半導體材料的一個重要電學參數,它決定了半導體材料的導電機制和性能。以下是對導電類型測量方法的詳細解析:
3.1 導電類型的分類
根據硅單晶制備時所摻的元素不同,硅單晶可分為N型和P型兩大類:
N型硅單晶:多數載流子是電子,依靠電子導電,又稱電子半導體。摻雜物為VA族元素磷、砷、銻等。
P型硅單晶:多數載流子是空穴,依靠空穴導電,又稱空穴半導體。摻雜物為ⅢA族元素硼等。
3.2 導電類型的測量方法
測量半導體材料導電類型的方法有多種,常采用的有整流效應法和溫差電動勢法。具體測試方法包括:
點接觸整流法:
原理:通過兩個探針與半導體材料接觸,一個為歐姆接觸,一個為整流接觸,利用整流接觸的單向導電性判斷導電類型。
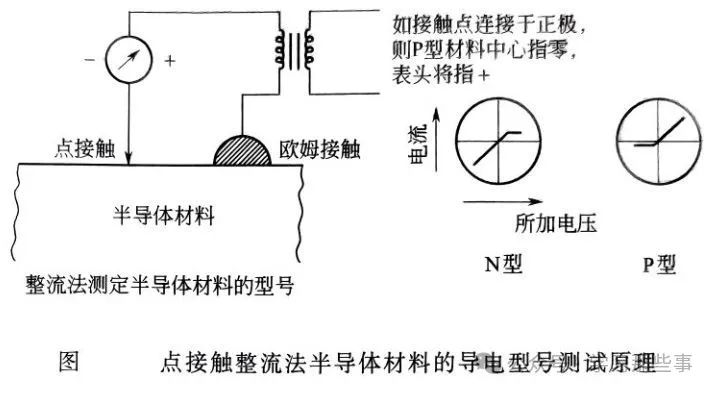
操作:將半導體材料和直流微安表與交流電源連接成串聯電路,一個探針保證歐姆接觸,另一個探針為整流接觸。根據電流方向判斷導電類型。
冷熱探針法:
原理:利用兩根不同溫度的金屬探針與半導體材料接觸,根據溫差電動勢的方向判定導電類型。
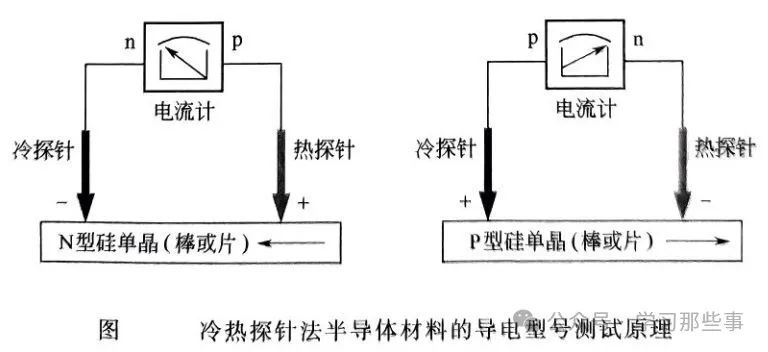
操作:將冷熱兩根探針與半導體材料接觸,根據檢流計指針方向判斷導電類型。熱探針相對于冷探針的電性可指示半導體材料的導電類型。
實際操作注意事項
在使用冷熱探針法時,探針的溫度應保持在一定范圍內(如40~80℃),對探針施加的壓強要適中。熱探針常用不銹鋼或鎳制成,探針的尖端一般呈圓錐體形狀,以確保良好的接觸和測溫準確性。在進行整流效應法測量時,需要確保一個探針觸點為歐姆接觸,另一個為整流接觸,以準確判斷導電類型。
綜上,導電類型的測量是半導體材料性能測試中的重要環節。選擇合適的測試方法和遵循相應的測試標準,可以確保測量結果的準確性和可靠性。
-
測試
+關注
關注
8文章
5628瀏覽量
128294 -
半導體
+關注
關注
335文章
28599瀏覽量
232491 -
硅片
+關注
關注
13文章
377瀏覽量
35053
原文標題:硅片測試
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
Pea Puffer非球面:周長優化的非球面CCP拋光
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】了解芯片怎樣制造
材料的9種力學性能衡量指標和測量方法

硅的晶體缺陷測量方法

請問為ADC選Driver主要要看哪幾項技術指標呢?
輸電線路故障精確定位裝置 技術指標 外掛架構
ADC采樣保持電路的工作原理和技術指標
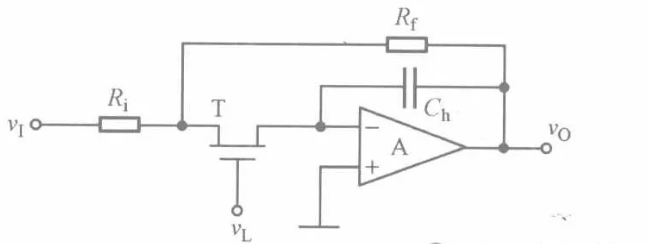
安泰功率放大器的主要技術指標有哪些方面






 硅拋光片的主要技術指標、測試標準及硅片加工參數的測量方法
硅拋光片的主要技術指標、測試標準及硅片加工參數的測量方法













評論