在電子信息制造業(yè)的快速發(fā)展中,數(shù)字化和智能化已成為推動行業(yè)發(fā)展的雙引擎。5G技術的普及,更是為"電子+"趨勢提供了強有力的支撐。"電子+"戰(zhàn)略指的是通過電子和通信技術的廣泛應用,實現(xiàn)非電子產(chǎn)品的電子化和簡單電子產(chǎn)品的智能化。5G網(wǎng)絡的"低延遲、大帶寬、廣連接"特性,為生產(chǎn)設備、消費終端等萬物互聯(lián)提供了理想的網(wǎng)絡環(huán)境,智能汽車等新興領域的快速發(fā)展便是這一趨勢的生動體現(xiàn)。
1 現(xiàn)代電子裝聯(lián)工藝技術的概述
電子裝聯(lián)工藝的發(fā)展經(jīng)歷了多個階段,從電子管時代到晶體管時代,再到集成電路時代、表面安裝時代,直至今天的微組裝時代。裝聯(lián)工藝技術經(jīng)歷了三次重大革命:通孔插裝、表面安裝和微組裝。器件封裝技術也經(jīng)歷了從QFP、BGA、CSP、DCA到MCM的演變。隨著小型和超小型器件的涌現(xiàn),高密度組裝技術的發(fā)展推動了相關工藝和組裝設備的創(chuàng)新。
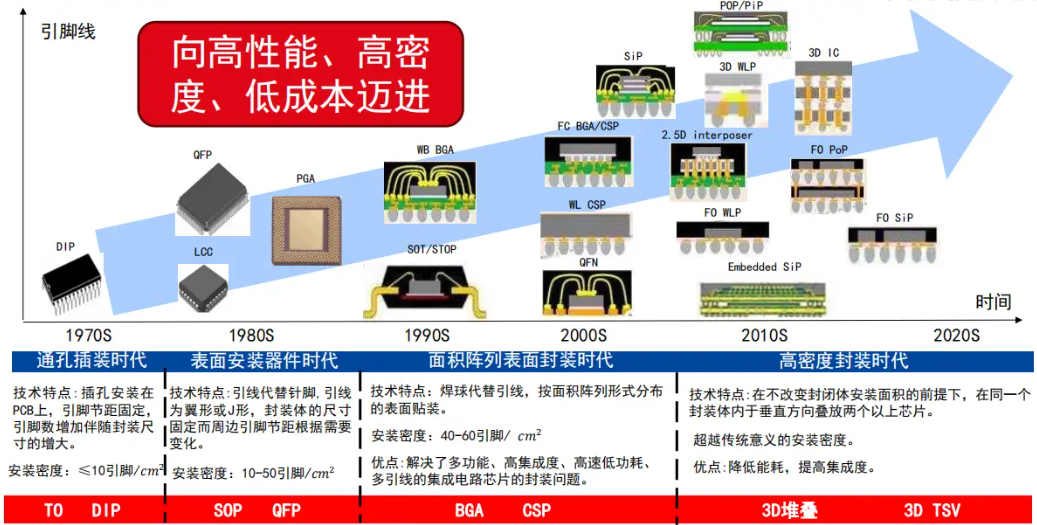
現(xiàn)代電子裝聯(lián)工藝主要包括裝聯(lián)前的準備、PCB組裝和整機組裝。裝聯(lián)前的準備包括元器件和PCB的可焊性測試、元器件引線的預處理、導線的端頭處理、PCB的復驗和預處理。PCB組裝通常包括通孔插裝、表面安裝和混合安裝,電氣互連技術包括手工焊接、波峰焊接、再流焊接、激光焊接、壓接、繞接等,清洗方式也多種多樣。整機組裝則涉及機械安裝、電氣互連、電纜組裝件制作、防護與加固等多個環(huán)節(jié)。
2 現(xiàn)代電子裝聯(lián)工藝技術更新現(xiàn)狀
2.1 系統(tǒng)級封裝技術-SIP
SIP技術融合了傳統(tǒng)的SMT組件制程工藝與芯片封裝工藝,其應用日益廣泛,尤其在AIoT產(chǎn)品與可穿戴電子產(chǎn)品領域。SIP技術可以實現(xiàn)多功能的集中,具有輕便性、超薄性、微小化、高傳輸性等特點。隨著技術要求與生產(chǎn)工藝難度的提高,整合封裝工藝和組件工藝,增強功能性,面臨著諸多挑戰(zhàn)。
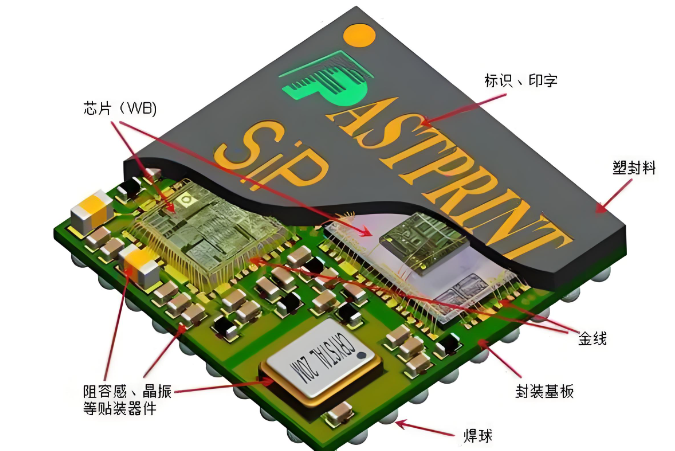
在小型化消費電子市場的快速發(fā)展推動下,SiP技術得到了廣泛應用。預計到2025年,系統(tǒng)級封裝市場規(guī)模將達到188億美元,復合年增長率為6%。SiP技術的應用主要是將各類功能的有源電子元件與可選無源器件進行組裝,形成具有一定功能的單個標準封裝件,實現(xiàn)多類型功能芯片的集成封裝。
從SiP封裝工藝的運用分析,是按照一定的工序,在封裝基班上,進行器件的組裝互連,同時將芯片包封保護。按照芯片與基板的連接方式,SiP封裝制程可以備劃分為兩類,即引線鍵合封裝和倒裝焊兩種。以引線鍵合封裝流程為例,主要流程如下:(1)晶圓研磨。指的是采用機械或者CMP方式,完成研磨作業(yè),將圓片處理到一定的薄度適合進行封裝作業(yè)。一般來說,主要包括貼膜、背面研磨、去膜三個環(huán)節(jié)。(2)晶圓切割。根據(jù)工藝流程,需要進行貼片,目的是防止芯片在收割時散落,同時也是方便后續(xù)芯片切單環(huán)節(jié)拾取芯片。芯片切單也就是芯片切割,可采用刀片切割法和激光切割方法。切割之后,全部的芯片都完全分離,放入到晶圓框架盒內(nèi),開展下道工序。
2.2 高密度先進封裝HDAP
高密度先進封裝HDAP已成為芯片封裝技術發(fā)展的熱點。這種技術采用先進的設計思路與集成工藝,實現(xiàn)芯片的封裝級重構(gòu),提高功能密度。先進封裝技術包括裝焊、晶圓級封裝(WLP)、2.5D封裝(RDL)、3D封裝(TSV)等。與傳統(tǒng)封裝工藝不同,先進封裝創(chuàng)新了封裝工藝,無Bonding Wire,且封裝集成度高,體積小,內(nèi)部互聯(lián)短,系統(tǒng)性能得到全面提升。
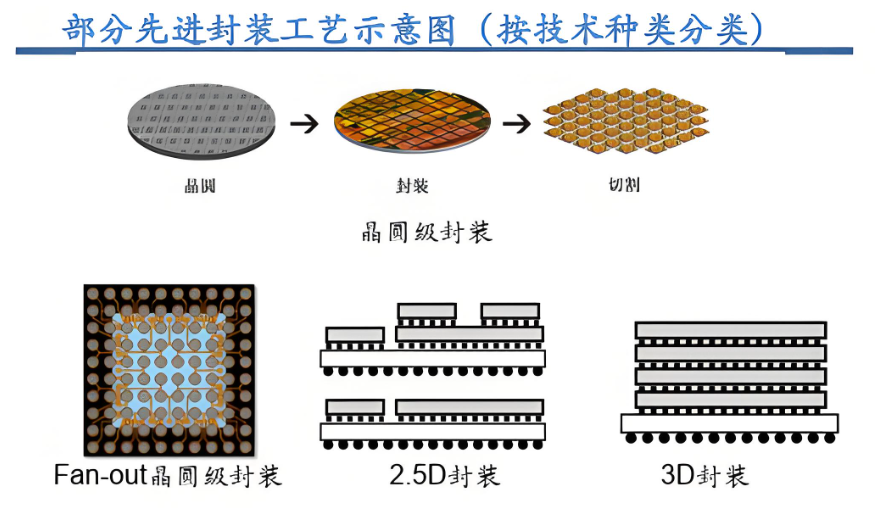
先進封裝的四個要素為:Bump、RDL、Wafer、TSV。其中,Bump為一種金屬凸點,自從倒裝焊Flip Chip出現(xiàn)就已經(jīng)實現(xiàn)了廣泛應用,主要分為球狀與柱狀或者塊狀。隨著工藝技術水平的不斷提高,Bump尺寸可以越做越小。混合鍵合最為突出的特點就是無凸點的鍵合結(jié)構(gòu),在實際應用中可以達到高集成密度的水平。
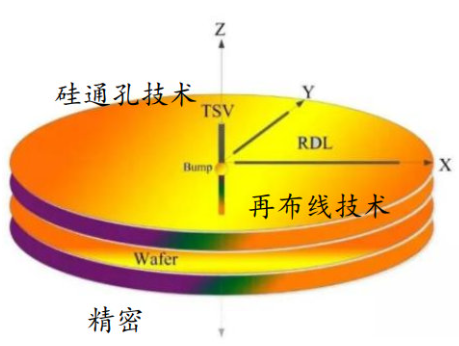
RDL重布線層,XY平面電氣延伸和互聯(lián)。從實際應用的角度來說,進行芯片設計與制造,通常來說IO Pad分布在芯片的邊沿或四周圍,如果是Bond Wire工藝較為方便,但對于Flip Chip不適合。因此,RDL有了發(fā)揮空間。其在晶元表面沉積金屬層以及介質(zhì)層,并且能夠形成金屬布線,實現(xiàn)進行IO端口的重新布局,布置到占位更加充足的區(qū)域,同時形成面陣列排布效果。從RDL的具體應用分析,在FIWLP中,此技術為關鍵技術之一,能夠?qū)O Pad進行扇入Fan-In,或者扇出Fan-Out,能夠形成多種類型的晶圓級封裝。如果是2.5D IC集成中,此技術的應用也比較重要,通過RDL將網(wǎng)絡互聯(lián)并且分部到相應的位置,最終實現(xiàn)硅基板上方芯片的Bump與基板下方的Bump的連接。如果是3D IC集成,當堆疊上下不是一樣的芯片,利用此技術重布線層促使上下層芯片的IO對準,最終完成電氣互聯(lián)。
Wafer晶圓被認為有著廣泛用途的技術,不僅能作為芯片制造的基底,也能夠在Wafer上制作硅基班實現(xiàn)2.5D集成。此外,還可以用于WLP晶圓級封裝,當作WLP的承載晶圓。不同于傳統(tǒng)的封裝技術,WLP在Wafer的基礎上先進行封裝,之后切割分片,全面提高了作業(yè)的效率,并且節(jié)約了一定的成本。從Wafer的尺寸變化來看,由最初的6英寸和8英寸,到當前的12英寸,未來會發(fā)展到18英寸。
TSV硅通孔的功能為Z軸電器延伸和互聯(lián)。根據(jù)集成類型進行劃分,主要為2.5D TSV與3D TSV。在一定的時間背景下,先進封裝僅僅是個概念,隨著技術的發(fā)展未來也會變成“傳統(tǒng)封裝”。根據(jù)四要素內(nèi)在的先進性進行排序,具體為Bump、RDL、Wafer、TSV。
2.3 先進封裝與SiP的對比
SiP技術和先進封裝技術都是半導體產(chǎn)業(yè)鏈關注的焦點。從兩個技術的不同點分析,主要如下:(1)關注點。SiP技術重點是系統(tǒng)在封裝內(nèi)部的實現(xiàn),因此系統(tǒng)為技術的主要關注對象。與Sip系統(tǒng)級封裝相對的是單芯片封裝。這里所述的先進封裝,更加注重封裝技術和工藝的先進性,與其相對的是傳統(tǒng)封裝。(2)技術范疇不同。例如,單芯片的FIWLP、FOWLP以及FOPLP為先進封裝,不過不在SiP范疇內(nèi);FliP Chip和2.5D integration以及3D integration在HDAP范疇內(nèi),同時也可以應用在SiP。

這兩項技術都具有小型化、低功耗、高性能的特點,為電子系統(tǒng)集成提供解決方案。盡管兩項技術自身不存在瓶頸,但在裸芯片的供應鏈和芯片之間的接口標準方面,仍需進一步完善。
3 現(xiàn)代電子裝聯(lián)工藝技術的發(fā)展
3.1 借助自然原理
自然原理在生產(chǎn)過程中的應用是技術研究的重要內(nèi)容。自然界中的物質(zhì)對象極為復雜,它們通過耦合無數(shù)相同的元素來形成自身,如DNA雙螺旋線。這些結(jié)構(gòu)在熱動力學平衡中不依賴共價化學鍵結(jié)合,比較容易被機械力影響,不過能夠持續(xù)地修復,進行自我的調(diào)整,同時也能夠借助每個顆粒的屬性實現(xiàn)構(gòu)建,其中涵蓋表面張力與分子之間的耦合力。
從合成技術的角度來說,自組裝工藝技術的應用,要處于相應的條件中實現(xiàn)控制,進而獲得理想的結(jié)構(gòu)或?qū)傩裕热绶肿訔l件和壓力條件等。隨著半導體設備日益的微小化,帶動著現(xiàn)代電子裝聯(lián)工藝技術研究在這些方面進行。
3.2 封裝差距
隨著半導體尺寸的不斷縮小,許多機械組裝技術已無法滿足需求,先進封裝技術的應用研究因此受到廣泛關注。封裝差距指的是微型和中間規(guī)模的組裝封裝差距。按照摩爾定律,那么可能會遇到組裝問題。傳統(tǒng)的電子元器件封裝中,實現(xiàn)系統(tǒng)級封裝,有著一定的成本壓力。隨著新封裝技術的應用和發(fā)展,系統(tǒng)級封裝的水平將得到提高,封裝成本也將降低。
(未完,接下篇)
審核編輯 黃宇
-
激光
+關注
關注
20文章
3465瀏覽量
67131 -
焊錫
+關注
關注
0文章
314瀏覽量
18970
發(fā)布評論請先 登錄
SMT技術的核心優(yōu)勢與行業(yè)影響
武漢鐳宇科技激光焊錫技術助力智能3C行業(yè)提升效率與焊接精度
電力電子技術的應用與發(fā)展趨勢
光模塊技術發(fā)展趨勢 光模塊常見故障及解決方法
開關電源的最新技術發(fā)展趨勢
激光雷達技術的發(fā)展趨勢
智能駕駛技術發(fā)展趨勢
精密電子焊接挑戰(zhàn):激光軟釬焊技術的優(yōu)勢與應用

大研智造激光焊錫機:電子制造業(yè)的微型焊接技術革新

激光焊錫機:麥克風(咪頭)制造的精密焊接工藝
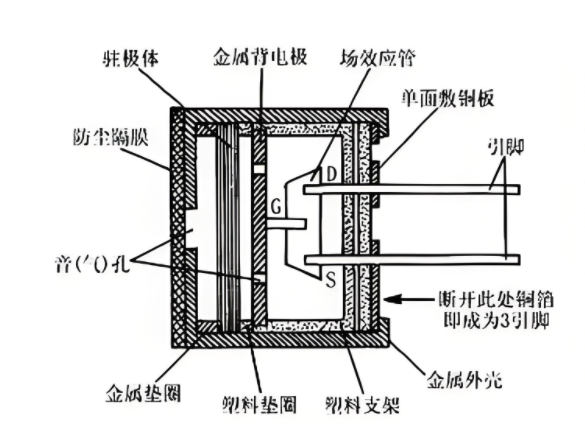
精密連接的創(chuàng)新者:激光焊錫機在傳感器制造中的優(yōu)勢
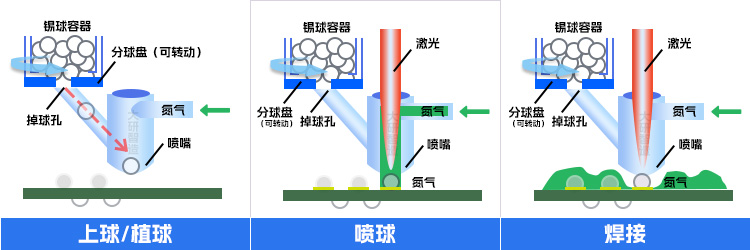
軍工電子制造的關鍵:激光焊錫技術深度解析






 電子裝聯(lián)工藝技術發(fā)展趨勢及激光焊錫技術的優(yōu)勢(上)
電子裝聯(lián)工藝技術發(fā)展趨勢及激光焊錫技術的優(yōu)勢(上)












評論