共讀好書

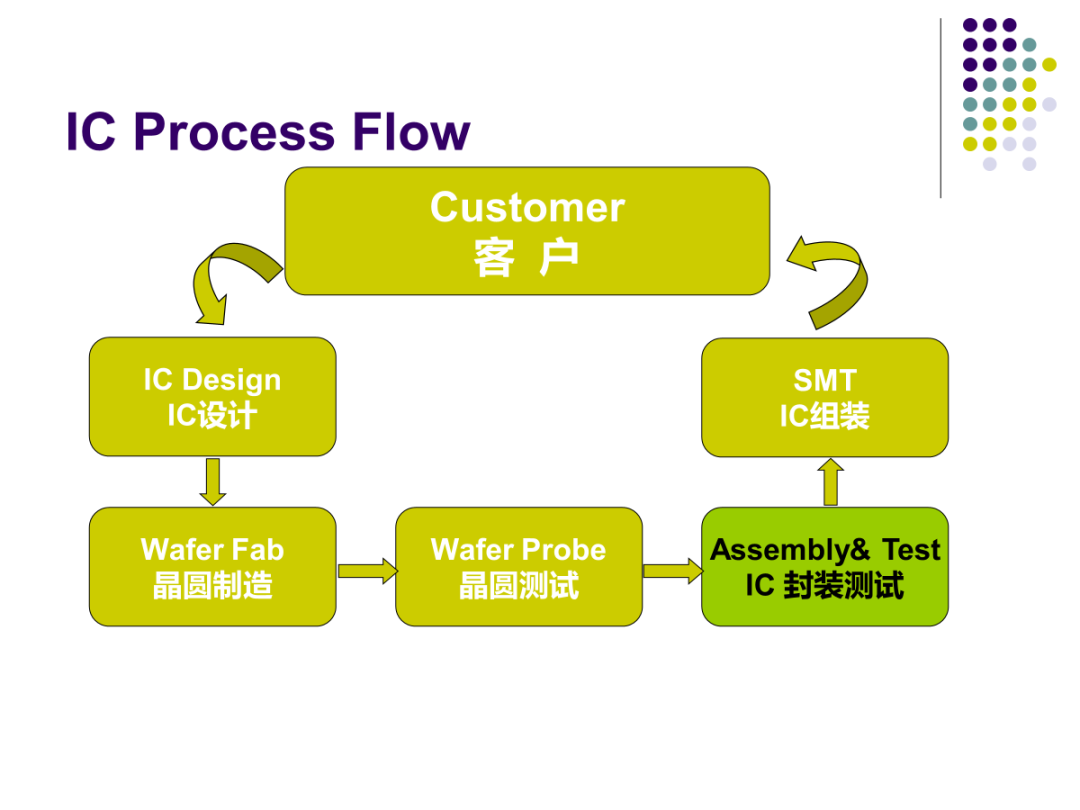


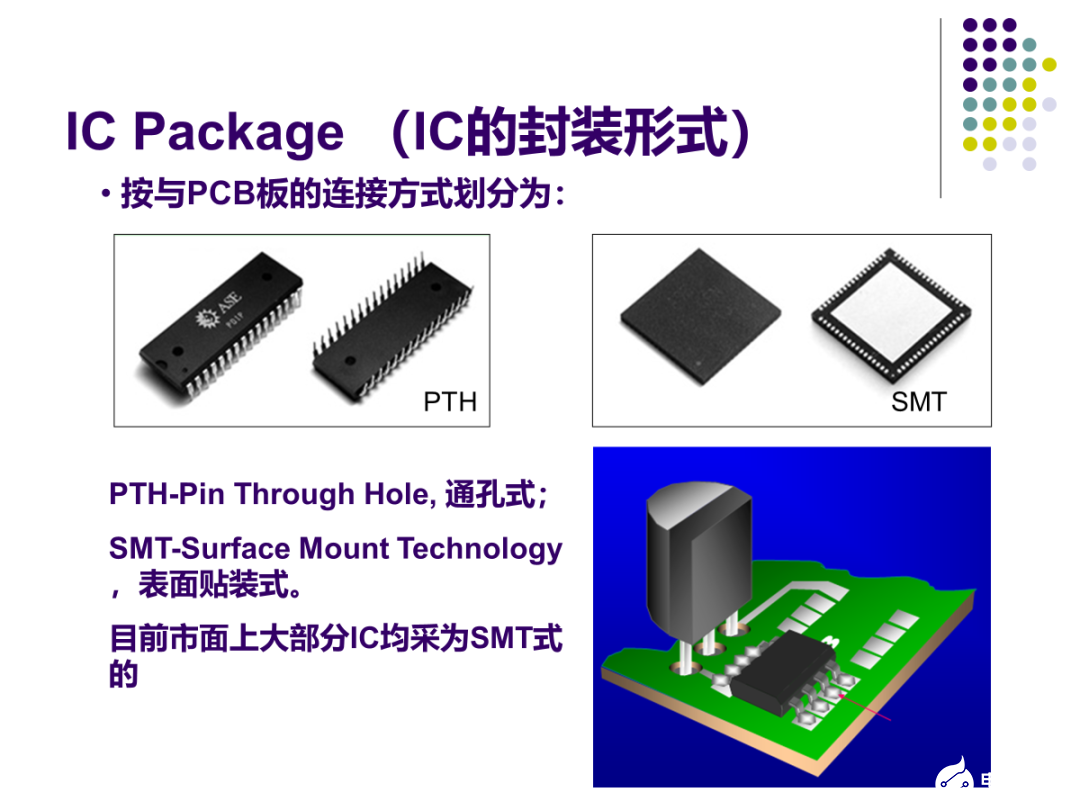


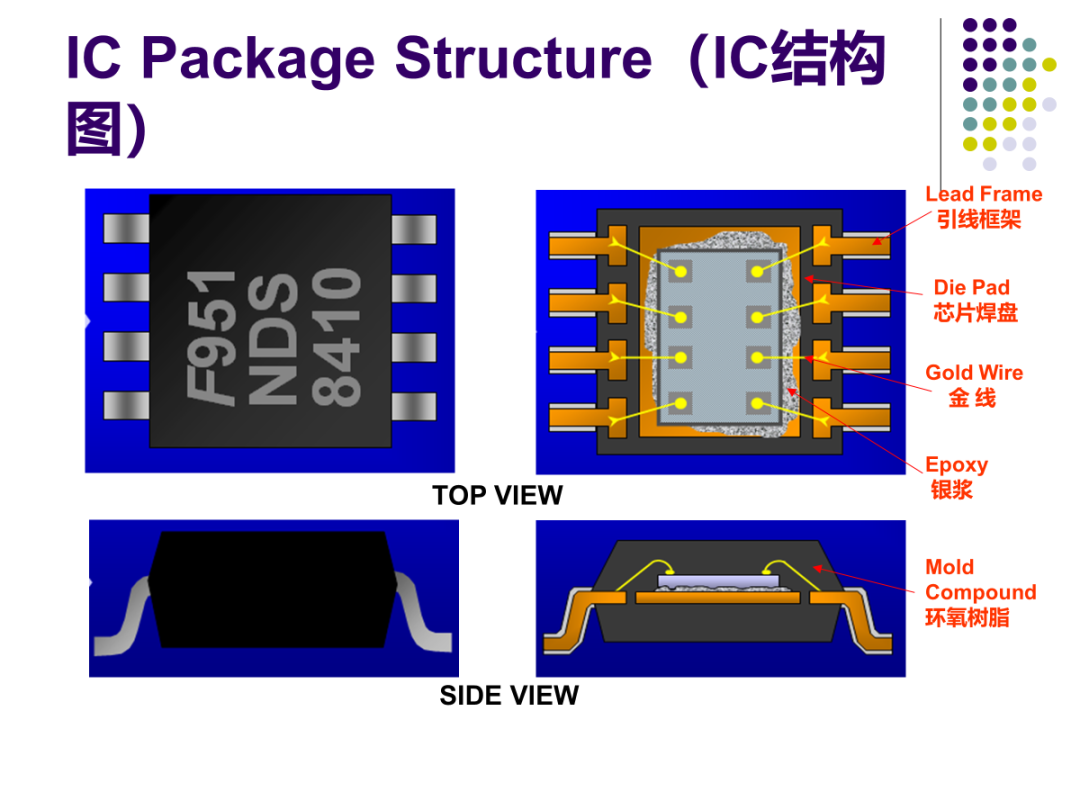

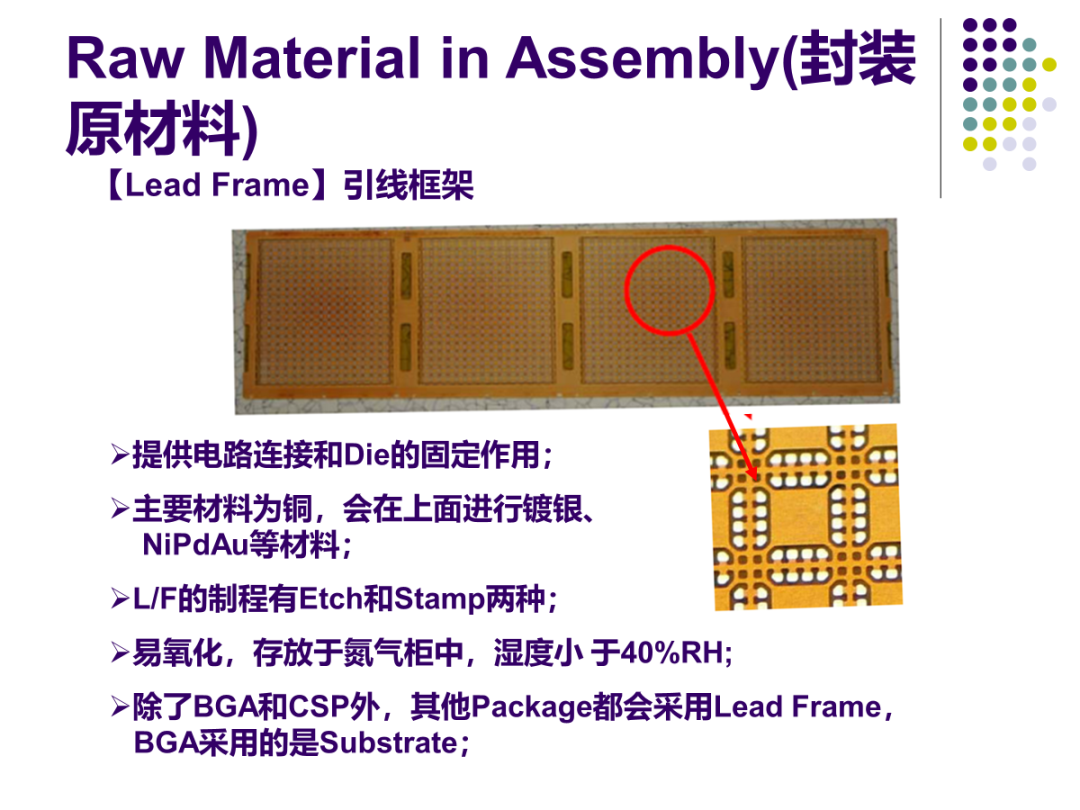



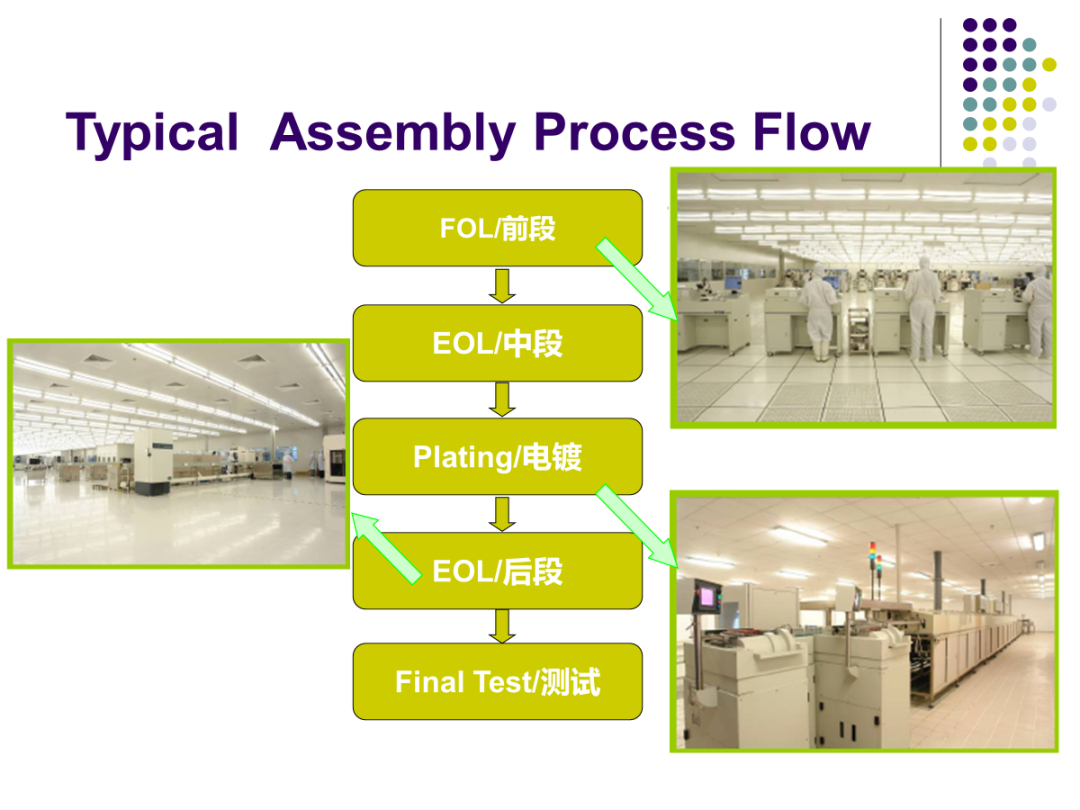
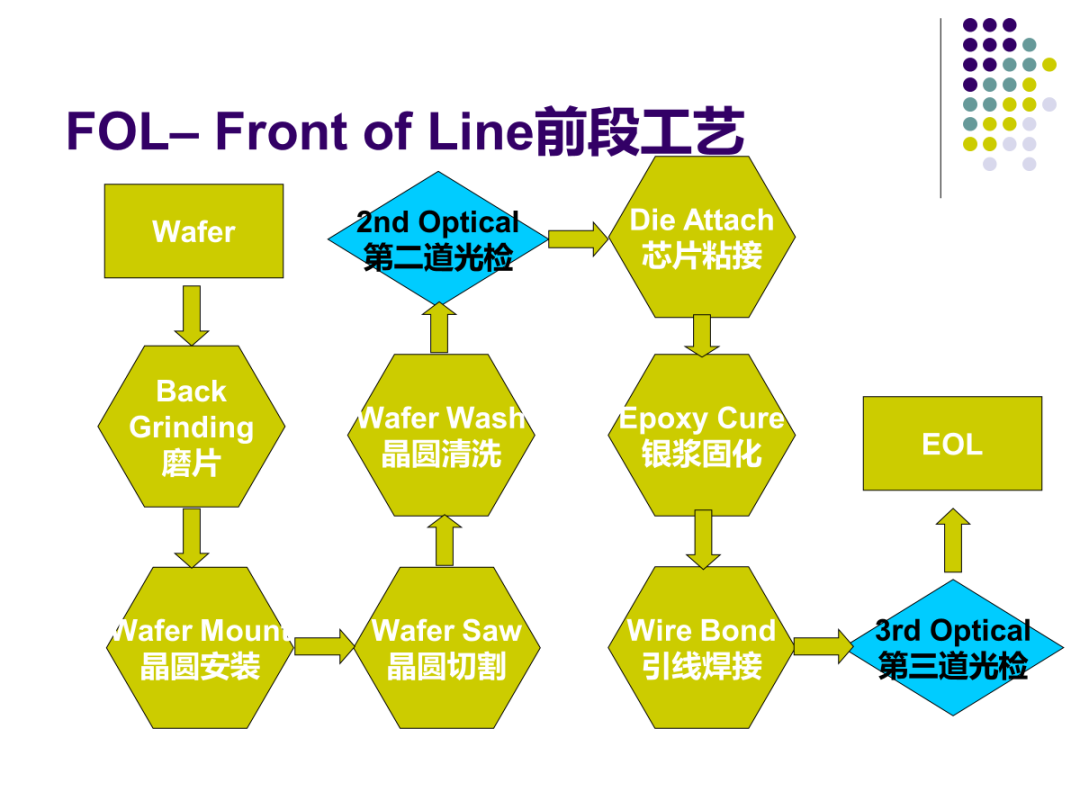
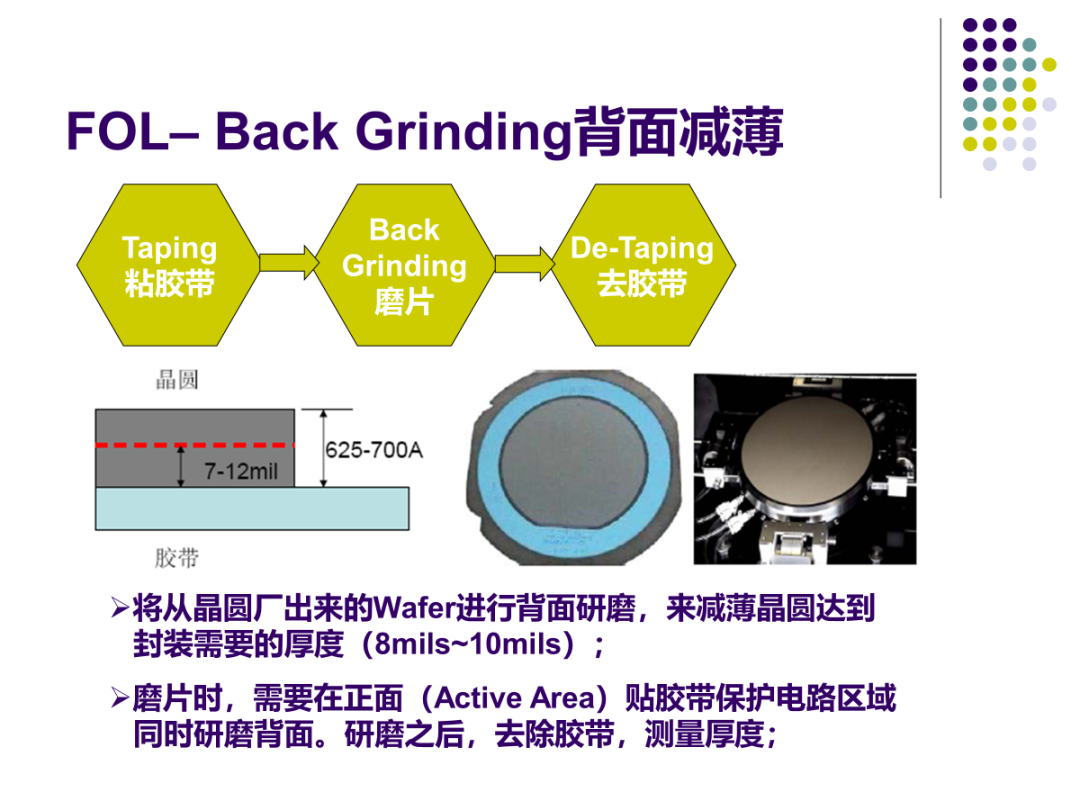
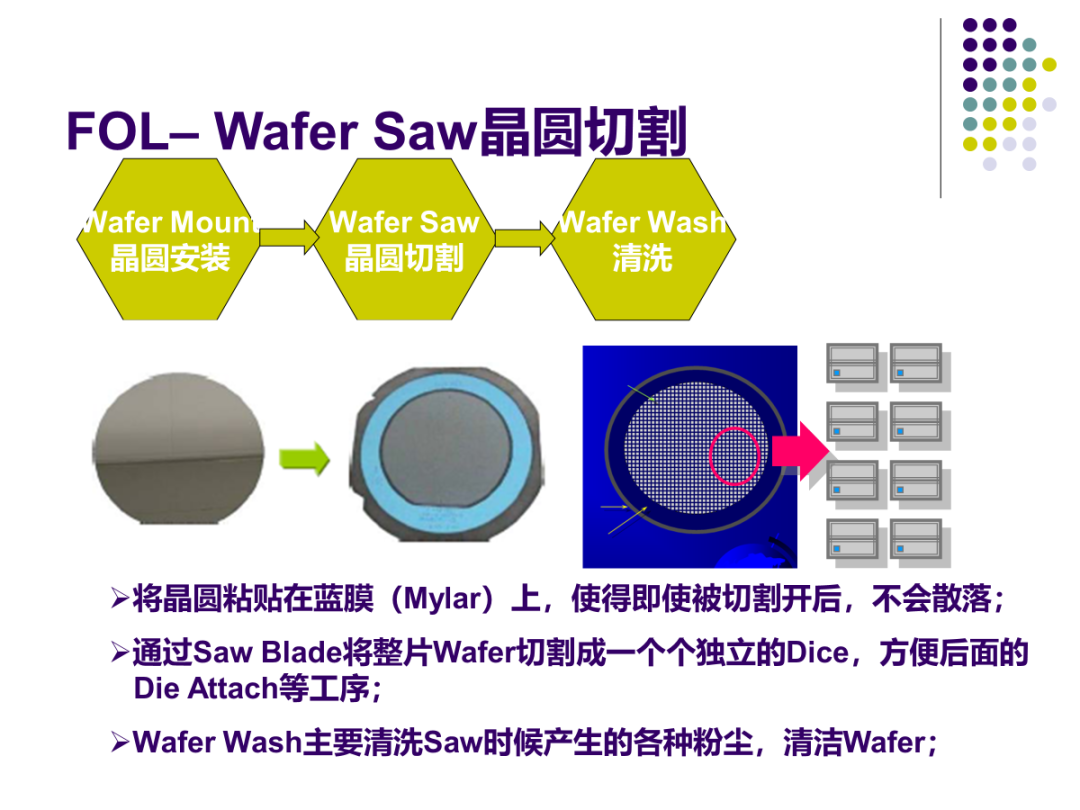




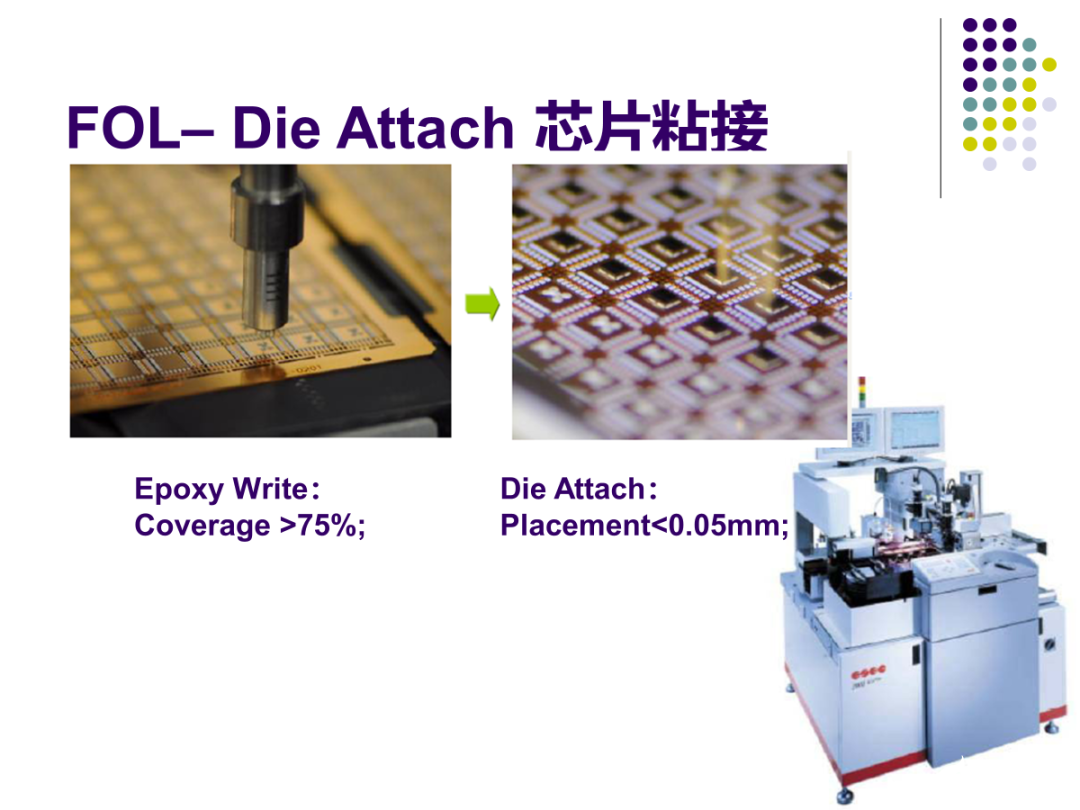





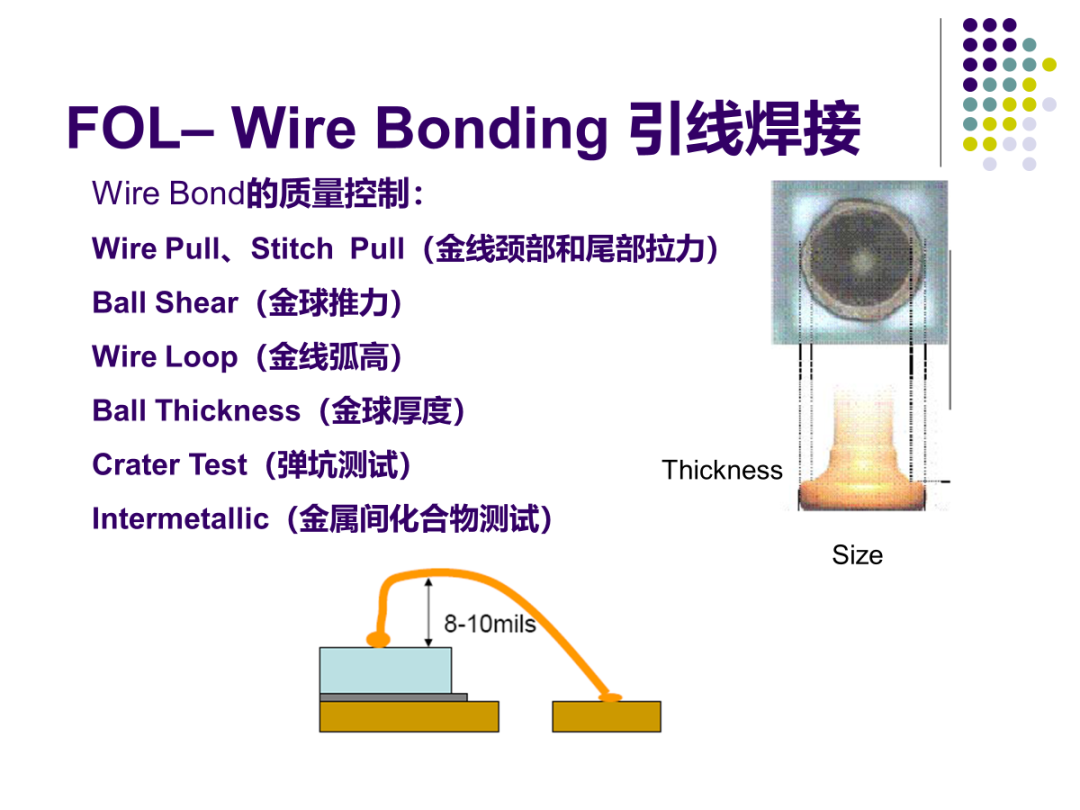

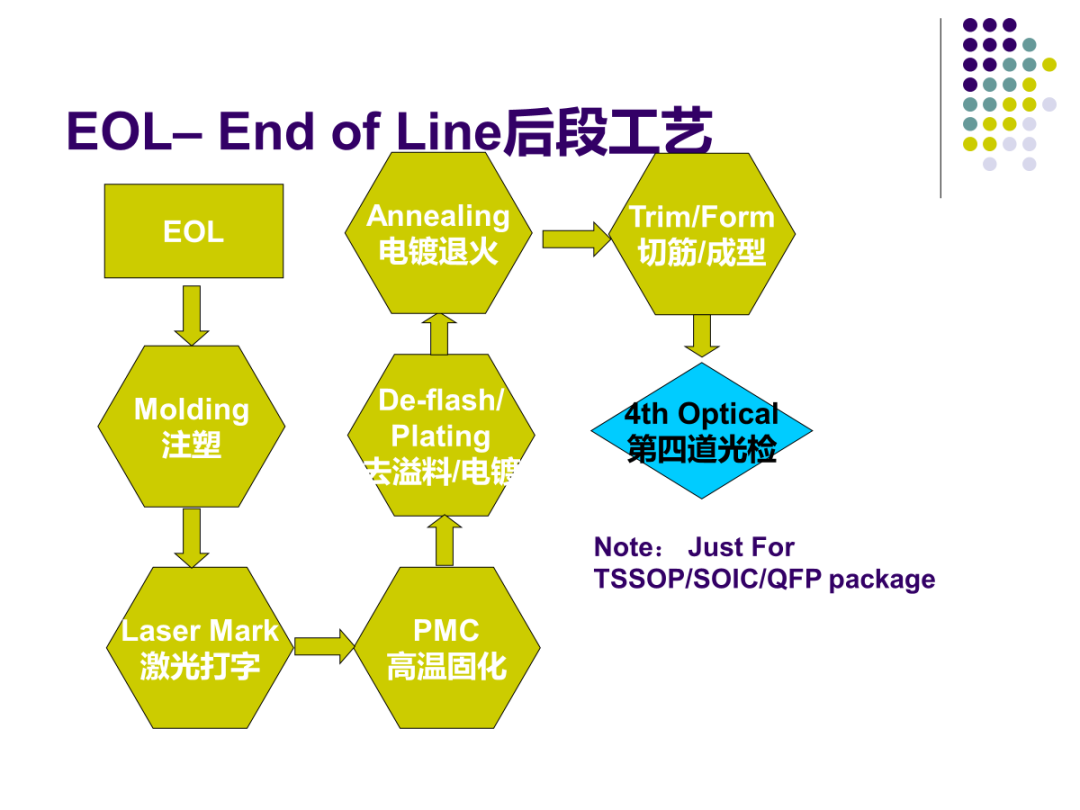
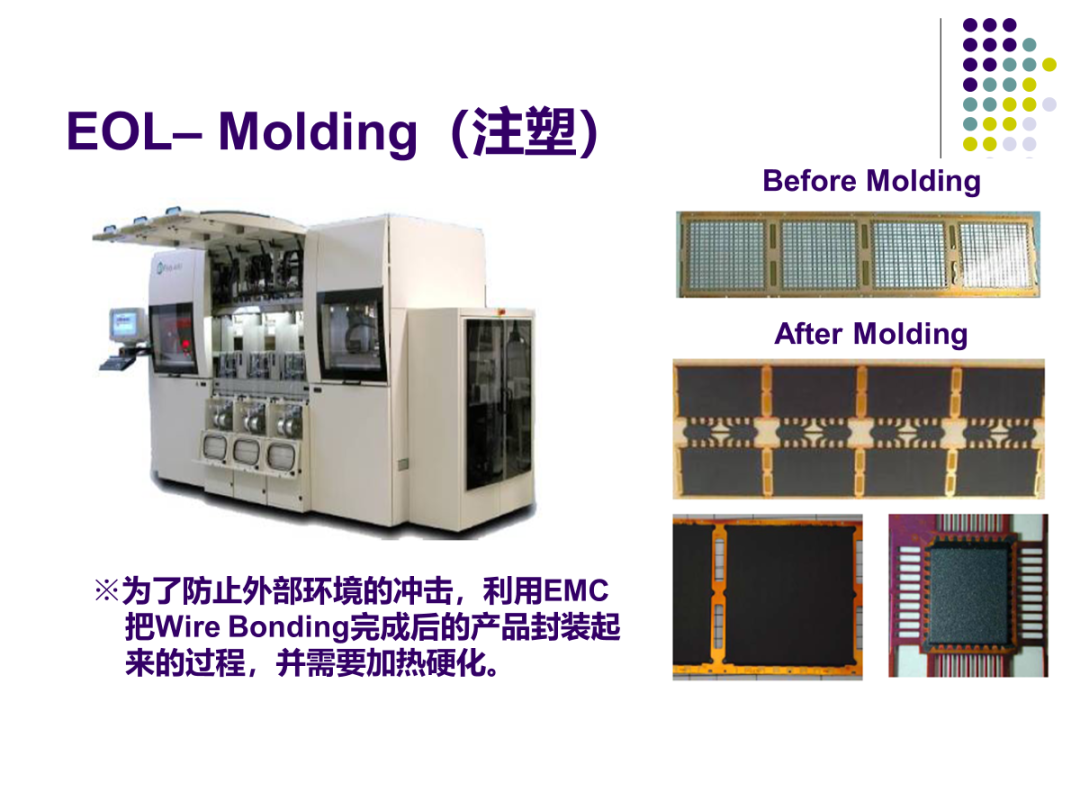
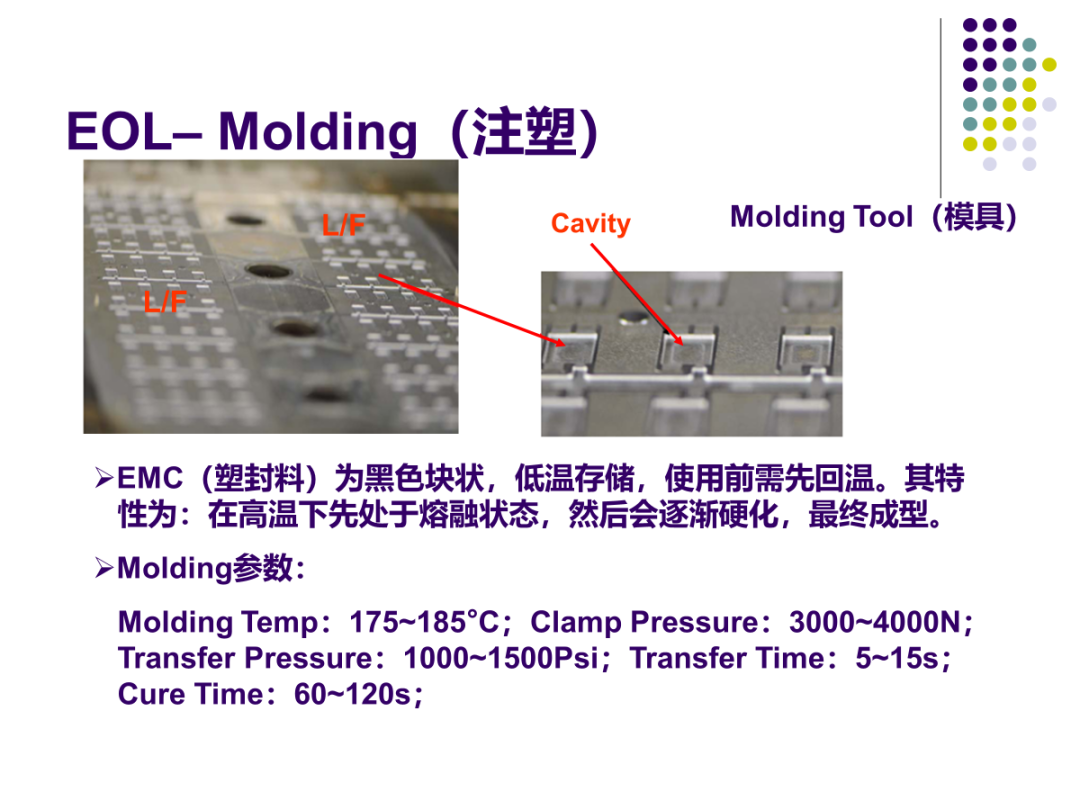
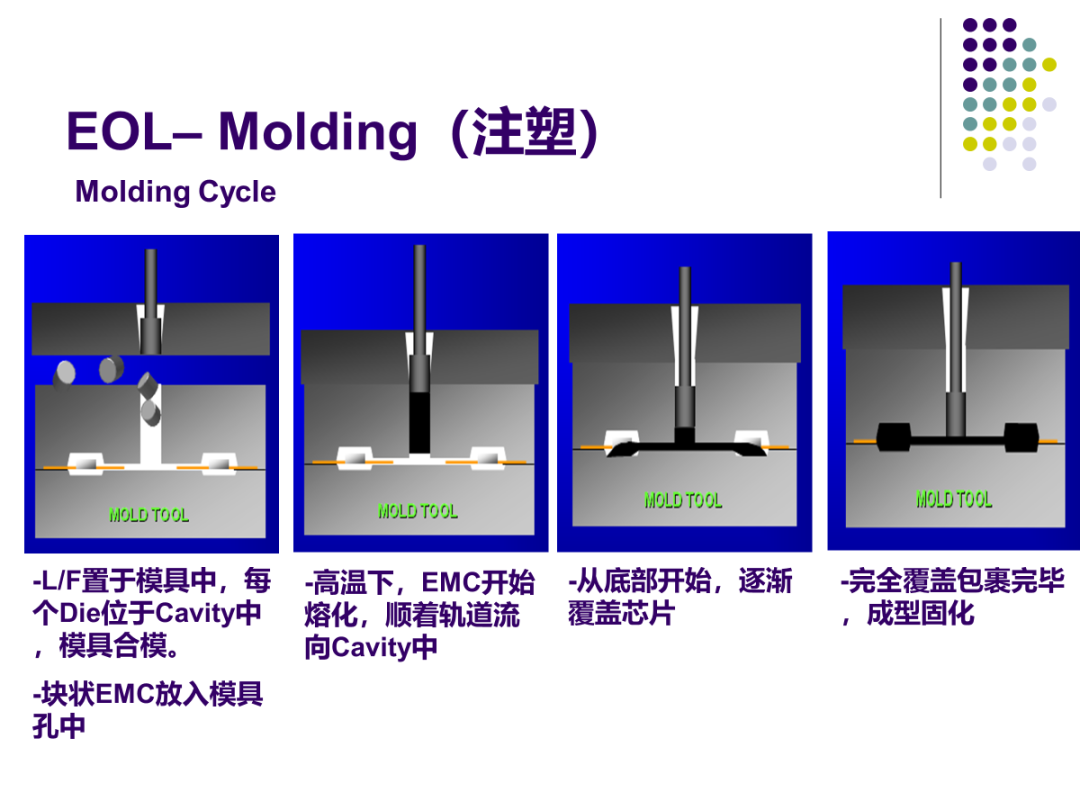
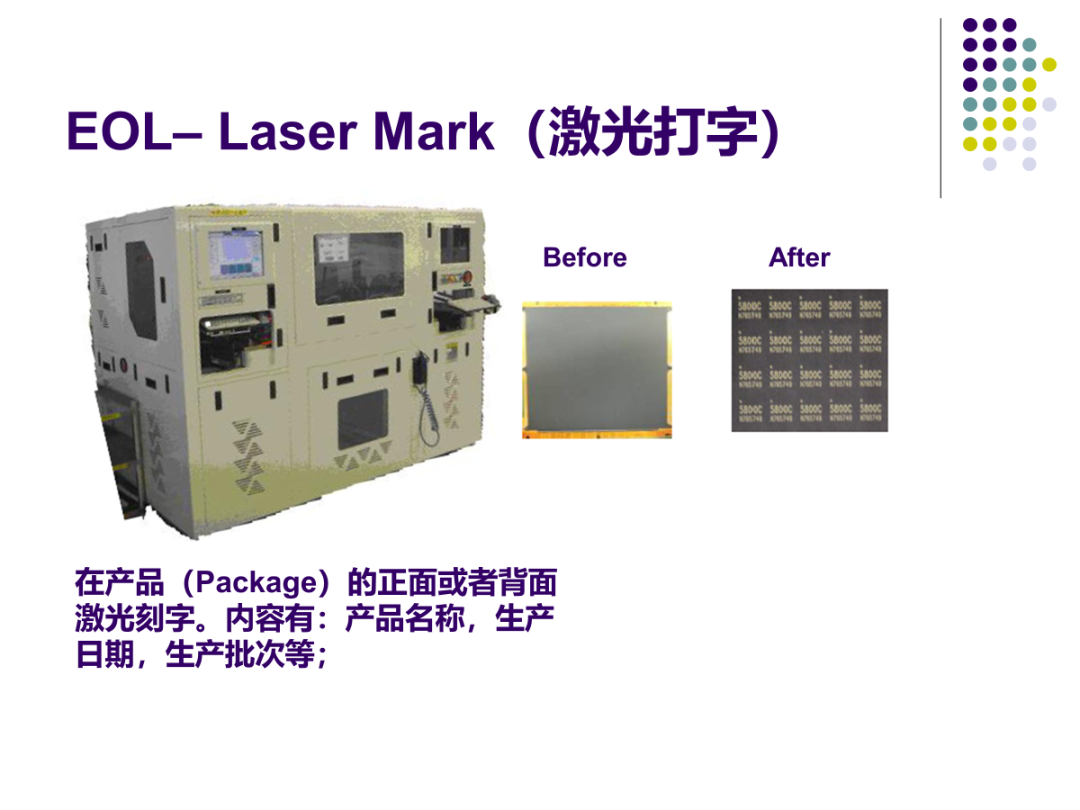
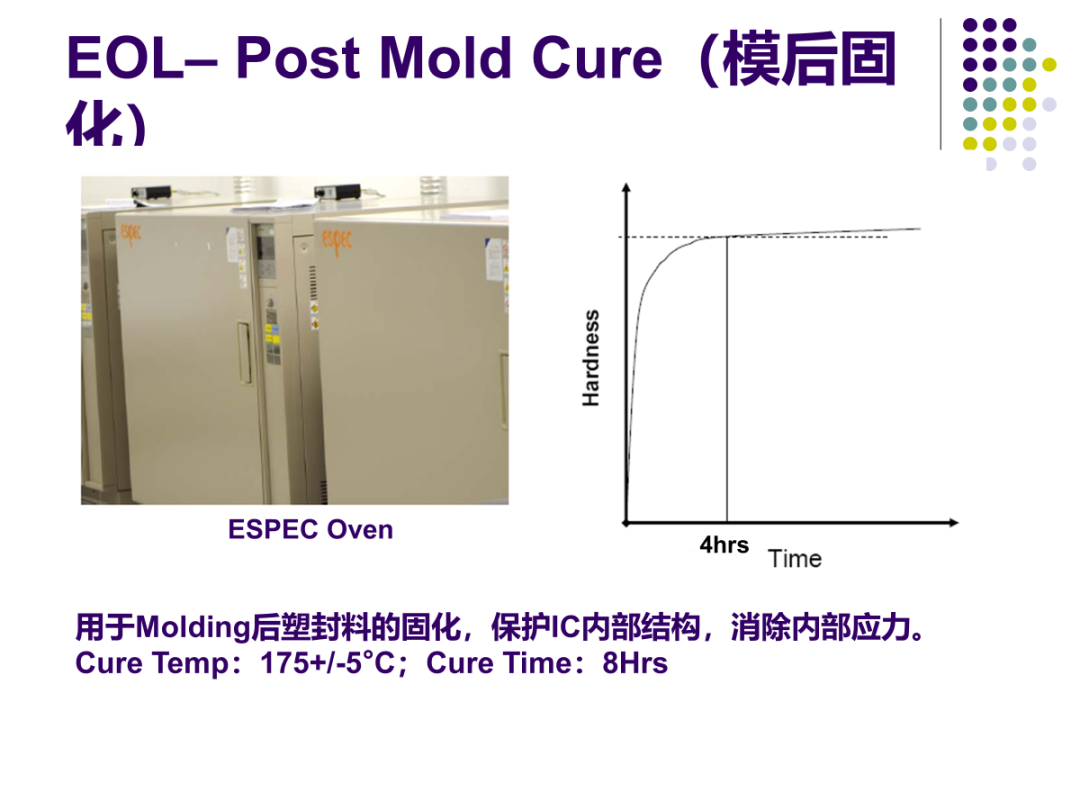
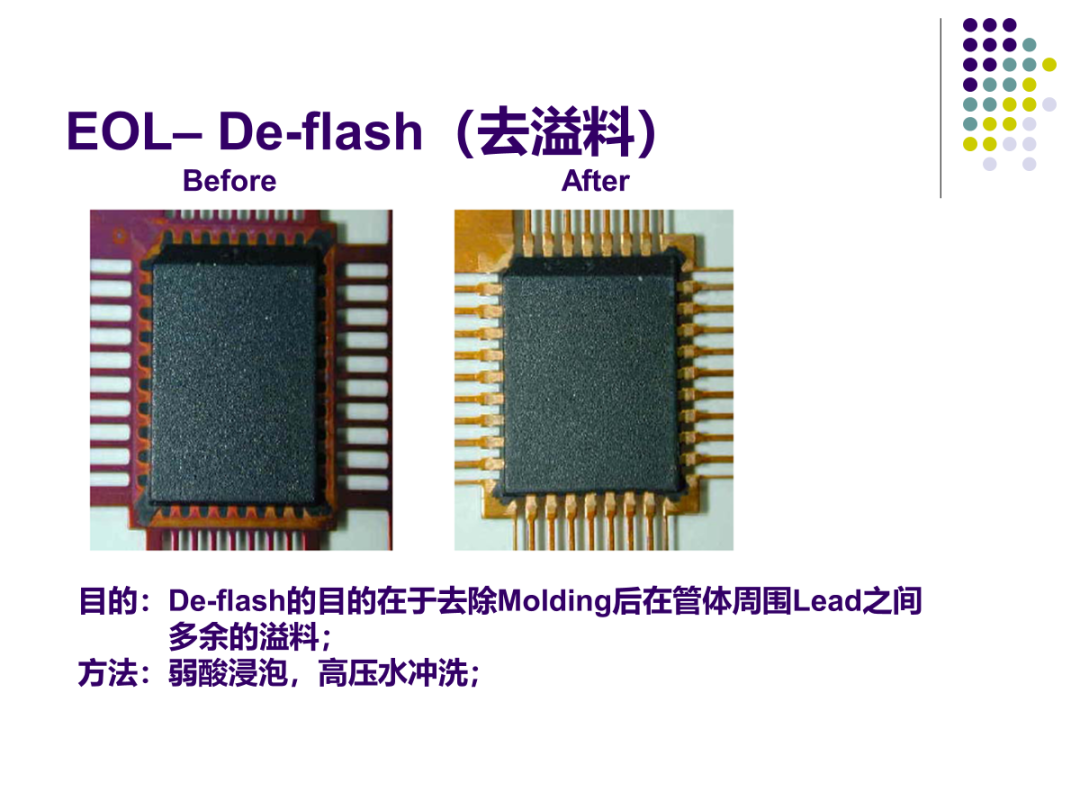
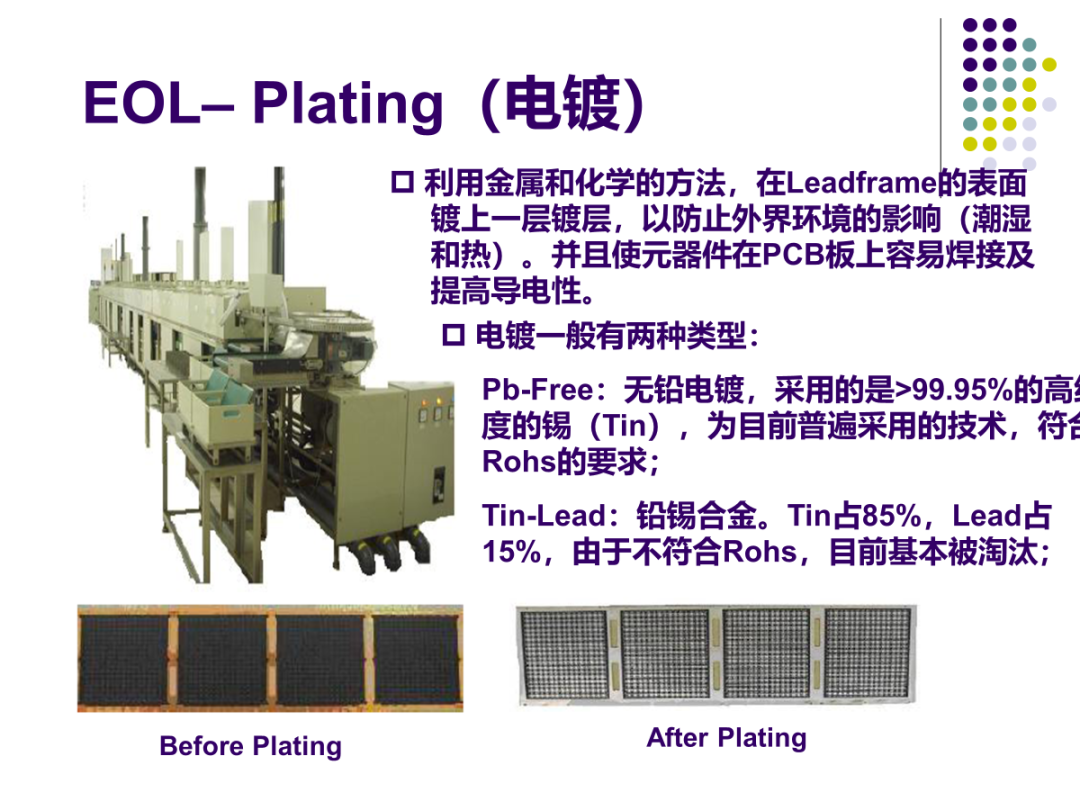
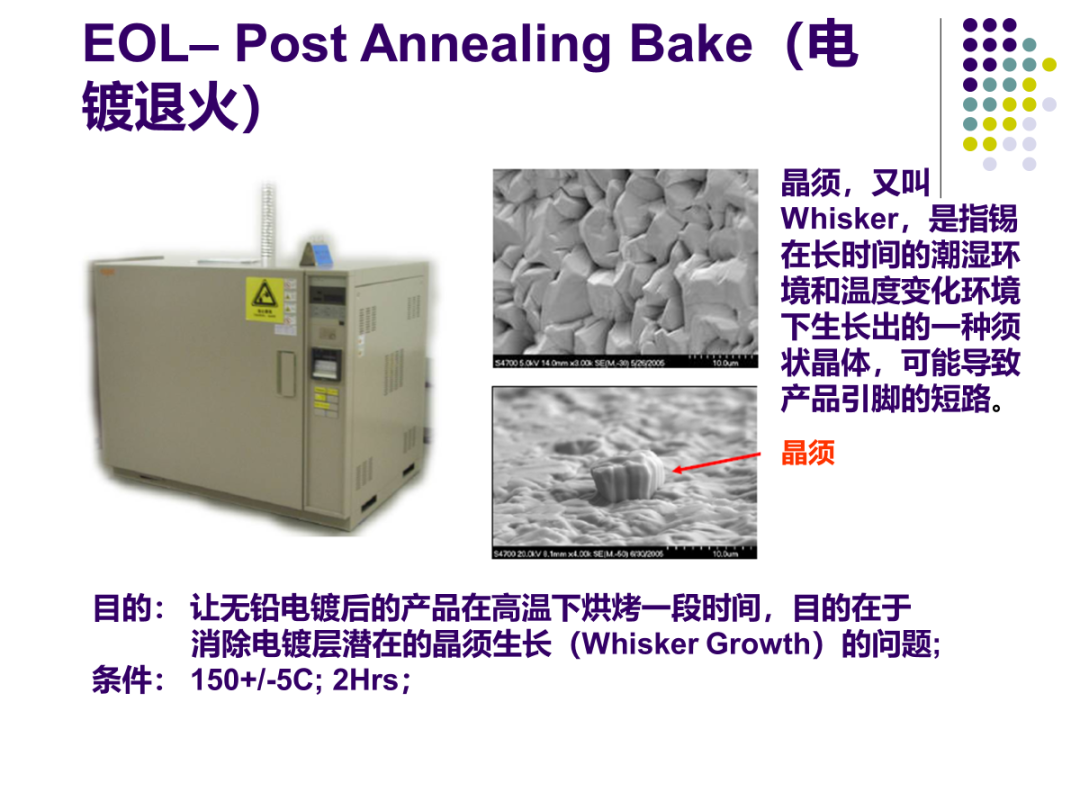




審核編輯 黃宇
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
IC封裝
+關注
關注
4文章
187瀏覽量
27127
發布評論請先 登錄
相關推薦
熱點推薦
半導體封裝工藝流程的主要步驟
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、上焊錫、打碼、外觀檢查、成品測試和包裝出庫,涵蓋了前段(FOL)、中段(EOL)、電鍍(plating)、后段(EOL)以及終測(final test)等多個關鍵環節。

芯片封裝工藝詳解
封裝工藝正從傳統保護功能向系統級集成演進,其核心在于平衡電氣性能、散熱效率與制造成本?。 一、封裝工藝的基本概念 芯片封裝是將半導體芯片通過特定工藝
半導體貼裝工藝大揭秘:精度與效率的雙重飛躍
隨著半導體技術的飛速發展,芯片集成度不斷提高,功能日益復雜,這對半導體貼裝工藝和設備提出了更高的要求。半導體貼裝工藝作為半導體封裝過程中的關鍵環節,直接關系到芯片的性能、可靠性和成本。本文將深入分析半導體貼

一文詳解2.5D封裝工藝
2.5D封裝工藝是一種先進的半導體封裝技術,它通過中介層(Interposer)將多個功能芯片在垂直方向上連接起來,從而減小封裝尺寸面積,減少芯片縱向間互連的距離,并提高芯片的電氣性能指標。這種

封裝工藝簡介及元器件級封裝設備有哪些
? 本文介紹了封裝工藝簡介及元器件級封裝設備有哪些。 概述 電子產品制造流程涵蓋半導體元件制造及整機系統集成,以晶圓切割成芯片為分界,大致分為前期工序與后期工序,如圖所示。后期工序主要包含芯片封裝

倒裝封裝(Flip Chip)工藝:半導體封裝的璀璨明星!
在半導體技術的快速發展中,封裝技術作為連接芯片與外部世界的橋梁,其重要性不言而喻。其中,倒裝封裝(Flip Chip)工藝以其獨特的優勢和廣泛的應用前景,成為當前半導體封裝領域的一顆璀

功率模塊封裝工藝
封與雙面散熱模塊 1 常見功率模塊分類 一、智能功率模塊(IPM)封裝工藝 工藝特點: 塑封、多芯片封裝,包括ICBT、FRD及高低壓IC等元器件。 采用引線框架、DBC(直接敷銅板)

瑞沃微:一文詳解CSP(Chip Scale Package)芯片級封裝工藝
在半導體技術的快速發展中,封裝技術作為連接芯片與外部世界的橋梁,其重要性不言而喻。CSP(Chip Scale Package),即芯片級封裝技術,正是近年來備受矚目的一種先進封裝技術。今天,請跟隨瑞沃微的腳步,一起深入了解CS

芯片封裝工藝集成工程師的必修課程指南
隨著信息技術的飛速發展,芯片作為現代電子設備的核心部件,其重要性日益凸顯。而芯片封裝工藝集成工程師作為芯片制造過程中的關鍵角色,需要掌握一系列復雜的課程知識,以確保芯片的性能、穩定性和可靠性。本文將從多個方面詳細闡述芯片封裝工藝集成工程師需要掌握的課程知識。
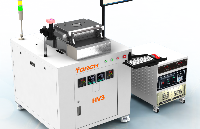
Nand Flash常用的封裝工藝
隨著目前電子產品小型化的需求越來越多,且可穿戴設備的逐漸普及,工程師們對于芯片小型化的需求也越來越強烈,這個就涉及到了芯片的封裝工藝。
mos封裝工藝是什么,MOS管封裝類型
MOS封裝工藝是指將制造好的MOS管芯片通過一系列步驟封裝到外殼中的過程。以下是MOS封裝工藝的詳細步驟和相關信息:





 IC封裝工藝講解
IC封裝工藝講解
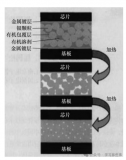











評論