一、什么是芯片封裝?
芯片封裝作為設(shè)計(jì)和制造電子產(chǎn)品開(kāi)發(fā)過(guò)程中的關(guān)鍵技術(shù)之一日益受到半導(dǎo)體行業(yè)的關(guān)注和重視。封裝的作用主要有保護(hù)電路免受外界環(huán)境的影響、避免噪聲信號(hào)的污染,屏蔽外場(chǎng)的串?dāng)_,支撐封裝體內(nèi)機(jī)械機(jī)構(gòu)、電氣互連,緩解封裝體內(nèi)部的機(jī)械應(yīng)力,提供從封裝體內(nèi)功率器件到外界環(huán)境的熱傳遞路徑,使芯片間的引線從封裝體牢固地引出而非直接裝配在基片上等功能。封裝技術(shù)的優(yōu)劣直接關(guān)系到芯片自身性能的發(fā)揮以及與芯片連接的PCB(印制電路板)的設(shè)計(jì)和制備,因此封裝是至關(guān)重要的。
高密度封裝應(yīng)半導(dǎo)體技術(shù)的發(fā)展,實(shí)現(xiàn)電子器件由二維(2D)平面堆集到沿Z方向的高密度集成,以緩解、延續(xù)或超越摩爾定律的發(fā)展。
二、摩爾定律及后摩爾時(shí)代
1965年,美國(guó)仙童半導(dǎo)體公司的Gordon Moore博士提出了著名的Moore定律:當(dāng)價(jià)格不變時(shí),集成電路上可容納的元器件數(shù)目,每隔18-24個(gè)月就會(huì)增加一倍。
這一定律準(zhǔn)確預(yù)測(cè)了過(guò)去五十年半導(dǎo)體行業(yè)的發(fā)展。隨著電子信息產(chǎn)業(yè)的不斷升級(jí),半導(dǎo)體集成電路正在向超大規(guī)模、超高速、高密度、大功率方向發(fā)展,當(dāng)晶體管特征尺寸達(dá)到納米級(jí)后,進(jìn)一步減小晶體管尺寸無(wú)疑是困難且昂貴的,這也意味著摩爾定律接近尾聲。
基于這種情況,業(yè)界提出了超越摩爾定律(More-Than-Moore,MTM),試圖從其它的一些途徑來(lái)延續(xù)摩爾定律的發(fā)展趨勢(shì),并且從摩爾定律的“更多更快”,發(fā)展到MTM的“更好更全面”。如通過(guò)優(yōu)化晶體管的設(shè)計(jì),尋找硅的替代品和發(fā)展先進(jìn)封裝技術(shù)等,使一塊集成電路芯片能夠同時(shí)具有多種功能,這不僅可以降低芯片的生產(chǎn)成本還能提高電路的等效集成度。其中先進(jìn)封裝技術(shù)的應(yīng)用無(wú)疑是后摩爾時(shí)代集成電路發(fā)展最有效的解決方法之一,特別是電子封裝維度從二維(2D)向三維(3D)發(fā)展,通過(guò)三維片上集成、硅通孔(TSV)芯片互連和三維封裝堆疊的形式,在晶體管特征尺寸不變的情況下,可以成倍的增加集成電路密度,從而更好的延續(xù)摩爾定律。
封裝的結(jié)構(gòu)方式包括引線鍵合(wire bonding,WB)、載帶自動(dòng)鍵合(Tape Automated Bonding)、倒裝芯片(flip chip,FC)、硅通孔技術(shù)(Through Silicon Via)等。
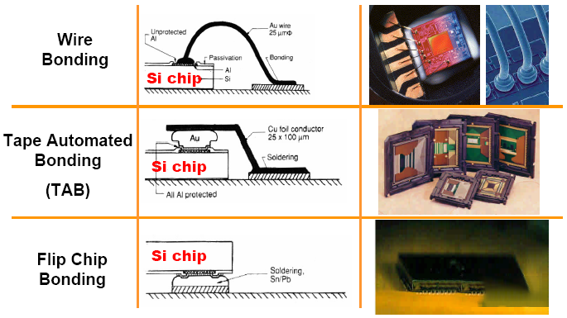
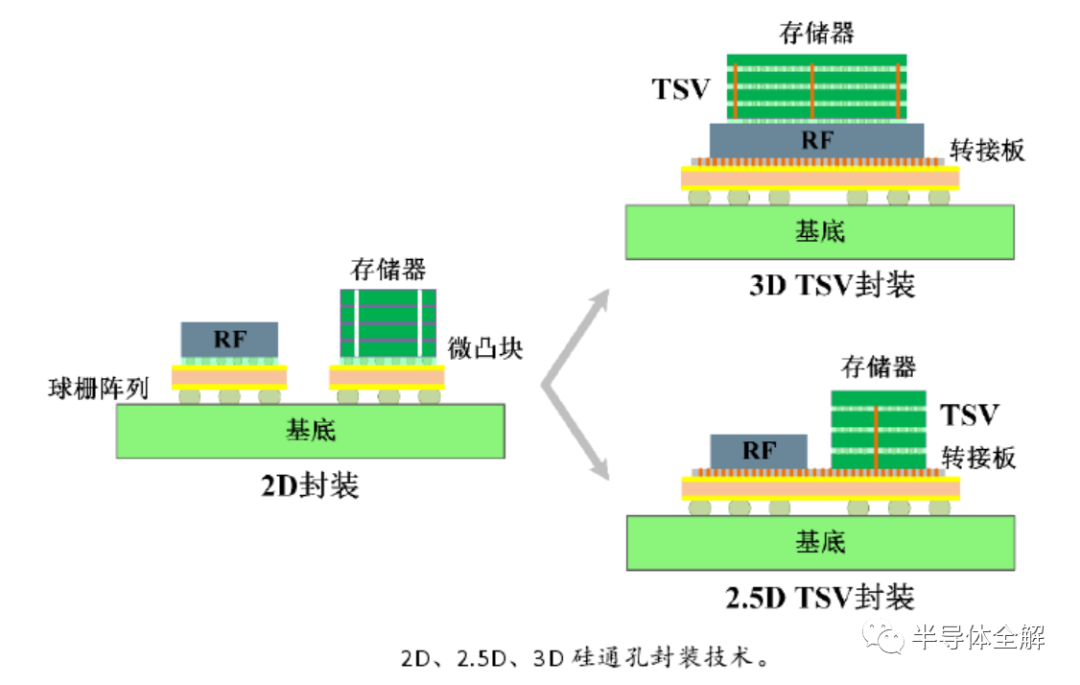 ?
?
三、倒裝芯片(FC)底部填充的原因
電子封裝結(jié)構(gòu)也由雙列直插式封裝(Dualin-line package, DIP)、小外型封裝(Small out-line package, SOP)、四側(cè)引腳扁平封裝(Quad flat package, QFP)等傳統(tǒng)封裝形式向倒裝芯片(Flip-chip, FC)、倒裝芯片-球柵陣列(FC-BGA)、扇入型晶圓級(jí)封裝(Fan-inwafer level package, FIWLP)、扇出型晶圓級(jí)封裝(Fan-out wafer level package, FOWLP)、嵌入式芯片封裝(Embedded chip package, ECP)等先進(jìn)封裝形式發(fā)展。其中由FC與BGA技術(shù)融合而產(chǎn)生的FC-BGA封裝已成為廣泛采用的主流封裝技術(shù)之一。


但FC封裝中硅基芯片與高分子基封裝基板之間熱膨脹系數(shù)(Coefficient of Thermal Expansion, CTE)不匹配產(chǎn)生的熱應(yīng)力易造成焊點(diǎn)在熱載荷作用下過(guò)早產(chǎn)生疲勞斷裂乃至失效。1987年日本日立(Hitachi)公司Nakano首次提出在環(huán)氧樹(shù)脂中加入SiO2并將其填充在芯片與基板之間來(lái)提高焊點(diǎn)的疲勞壽命,這種填充樹(shù)脂后來(lái)逐漸發(fā)展成為底部填充膠(Underfill),也稱為底部填充劑或底填膠等。
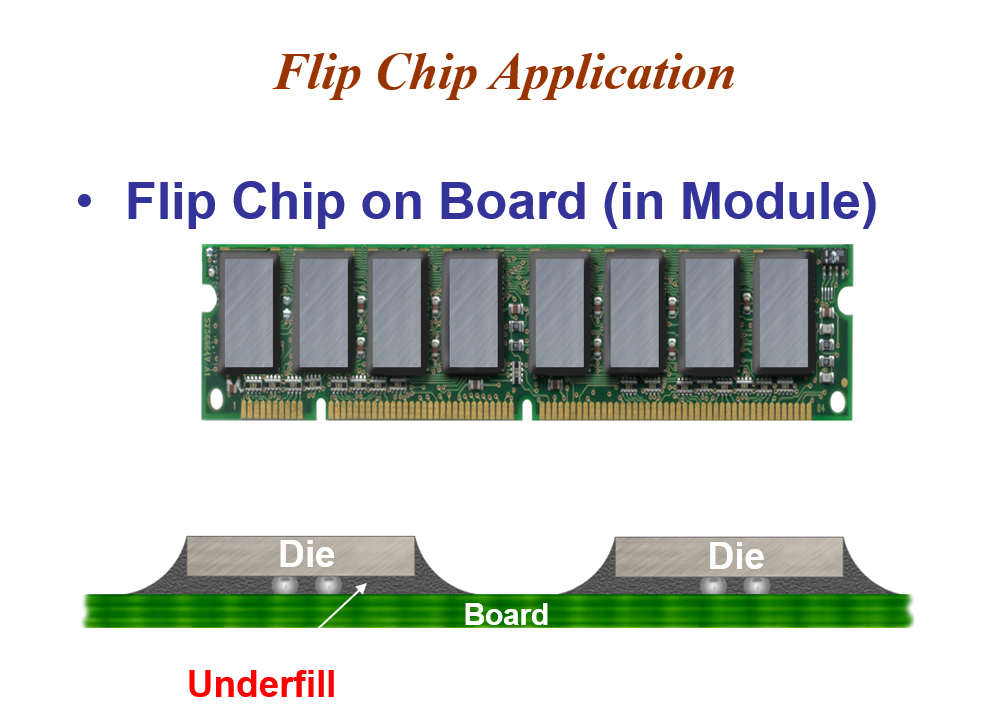
審核編輯:劉清
-
集成電路
+關(guān)注
關(guān)注
5417文章
11942瀏覽量
367032 -
PCB板
+關(guān)注
關(guān)注
27文章
1466瀏覽量
53011 -
芯片封裝
+關(guān)注
關(guān)注
11文章
571瀏覽量
31235 -
TSV
+關(guān)注
關(guān)注
4文章
120瀏覽量
81830 -
硅通孔
+關(guān)注
關(guān)注
2文章
26瀏覽量
11965
原文標(biāo)題:一文了解芯片封裝及底部填充(Underfill)技術(shù)(上)
文章出處:【微信號(hào):閃德半導(dǎo)體,微信公眾號(hào):閃德半導(dǎo)體】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
什么是芯片封裝?倒裝芯片(FC)底部填充的原因
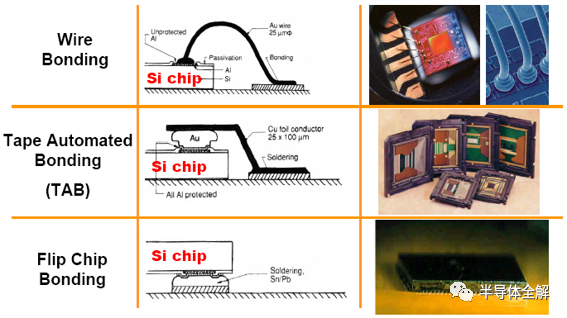
芯片封裝及底部填充(Underfill)技術(shù)詳解

底部填充膠膠水如何填充芯片
underfill底部填充工藝用膠解決方案

漢思HS700系列underfill膠水芯片底部填充膠

芯片封裝膠underfill底部填充膠點(diǎn)膠工藝基本操作流程

先進(jìn)封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹






 一文了解芯片封裝及底部填充(Underfill)技術(shù)(上)
一文了解芯片封裝及底部填充(Underfill)技術(shù)(上)



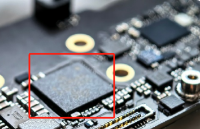














評(píng)論