據行業報道,臺灣制造商盟立已成功通過應用材料認證,得以首度擔任其合格供應商,首次涉足新型玻璃基板封裝用EFEM(晶圓傳送)設備領域,有望于今年上半年開始向臺灣大型載板企業直接交貨,同時間接向美國IDM廠商供貨。至于針對個別客戶訂單的評價,盟立未予置評。
值得注意的是,在此次IFS晶圓代工會議上,英特爾公布了最新的3D先進封裝技術并再次強調,玻璃基板封裝將于2026年全面投入生產。
業內普遍認為,由于市場對計算速度的要求不斷提升,單個封裝體內所包含的小型芯片數量激增,導致封裝區域日益增大。為了解決有機基板的膨脹和翹曲問題,玻璃基板封裝將會成為下一代AI芯片競爭的核心因素。
盟立此次與應用材料聯手,采用此前在面板領域積累的扇出型封裝(FoPLP)等相關技術,共同研發適用于玻璃基板封裝的EFEM設備,以實現穩固的上下料操作以及有效解決載板彎曲難題。
根據盟立發布的財務報告,由于1月份面板客戶需求減少及與東南亞訂單延期交付的影響,公司當月營收僅為5.18億新臺幣,同比下滑29%。
-
英特爾
+關注
關注
61文章
10194瀏覽量
174650 -
3D
+關注
關注
9文章
2959瀏覽量
110723 -
先進封裝
+關注
關注
2文章
474瀏覽量
623
發布評論請先 登錄
三星進軍玻璃基板市場,尋求供應鏈合作
IC 封裝載板用有機復合基板材料研究進展
LG進軍半導體玻璃基板市場
傳統封裝方法所用材料的特性






 盟立獲應用材料認證,進軍玻璃基板封裝用EFEM市場
盟立獲應用材料認證,進軍玻璃基板封裝用EFEM市場



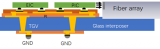




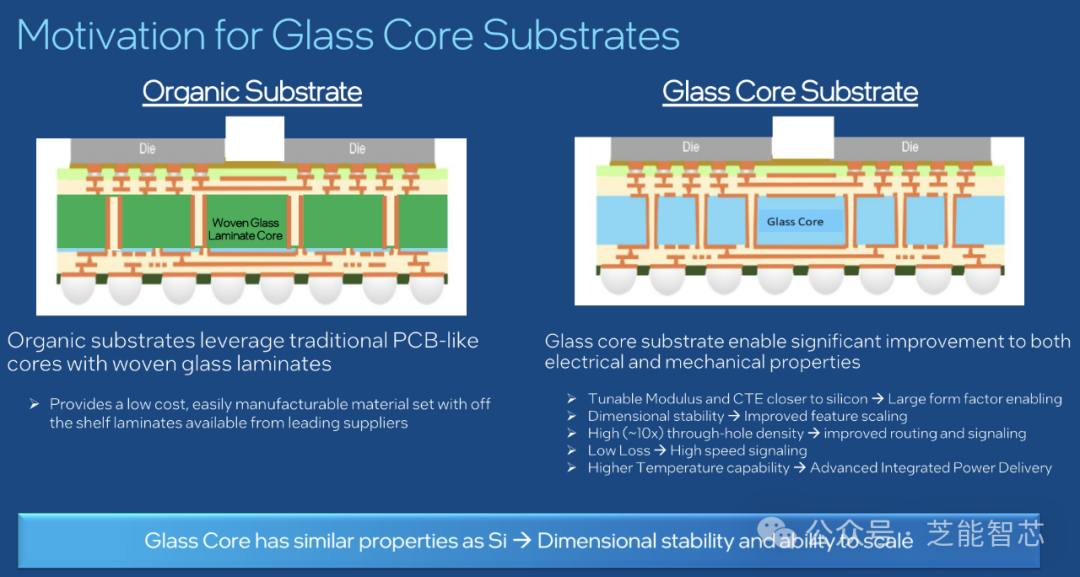

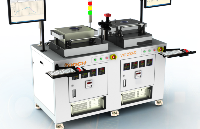










評論