共讀好書
熊化兵,李金龍,胡 瓊,趙光輝,張文烽,談侃侃
(中國電子科技集團公司)
摘要:
研究了 18 、25 、 30 μ m 三種金絲和 25 、 32 、 45 μ m 三種硅鋁絲鍵合引線在不同溫度循環次數下的鍵合強度衰減規律,并研究了拉斷模式的比例。結果表明,所有試驗樣品,無論是否經歷溫度循環,均達到了 GJB548B-2005 方法 2011.1 中的最小鍵合強度要求,均未出現焊點拉脫的現象。隨著溫度循環次數的增加,金絲鍵合強度先略微增大,后緩慢減小并趨于平緩。硅鋁絲鍵合強度先較快減小,后緩慢減小,并趨于平緩。相比于金絲,硅鋁絲在 0~50 次的溫度循環下鍵合強度衰減較快。通過曲線擬合,獲得不同絲徑下的鍵合強度衰減變化方程。
0 引言
在微電子封裝工藝中,引線鍵合技術具有極其廣泛的應用 [1-3 ] 。在高可靠封裝領域,主要使用金絲或硅鋁絲將芯片 Al 焊盤引線鍵合至管殼鍍金內引腳上,因鍵合絲與芯片焊盤及管殼內引腳表面金屬材料不同,須考慮金鋁系統之間的界面效應。 J.W.Park 等人[ 4 ] 的研究表明,Au-Al 系統在高溫長時間環境下的失效原因主要是界面缺陷、金屬間化合物(IMC )以及 Kirkendall 孔洞的形成。在 Au / Al擴散過程中,不僅會生成 IMC ,還會在 Au / Al 界面留下一部分空位,這一部分空位不斷聚集,形成孔洞,即 Kirkendall 孔 洞,隨著 保溫 時間 的延 長, Kirkendall 孔洞急劇增加,導致鍵合強度迅速降低,甚至出現某些鍵合點強度為零,即焊點脫離的情況。
現有文獻對 300℃ 不同保溫時間下的強度衰減規律及現有鍵合工藝的可靠性有比較清晰的認識,然而關于鍵合強度在溫度循環下的衰減規律并沒有詳細的數據可參考,所以有必要研究溫度循環條件下的鍵合強度衰減規律,并對當前鍵合工藝可靠性進行評估。
1 試驗方法
芯片鍵合焊盤為 Al ,每只芯片 15 個焊盤,每只樣品共計 15 根鍵合線,管殼采用 HTCC 鍍金外殼。試驗過程為:管殼清洗 → 燒結貼片 → 引線鍵合 → 封前烘焙 → 封帽 → 檢漏 → 可靠性試驗 → 開蓋 → 鍵合強度測試。
以 18 、25 、 30 μ m 三種金絲和 25 、 32 、 45 μ m 三種硅鋁絲為例,可靠性試驗參考標準 GJB548B-2005方法 1010.1 ,試驗條件 C ( -65 ℃ 至 150 ℃ ),研究鍵合引線分別在溫度循環 5 、10 、 50 、 100 、 200 次下的鍵合強度衰減規律。
2 結果與討論
2.1 金絲鍵合強度隨溫度循環次數的關系
金絲在溫度循環后的鍵合強度隨循環次數的關系如圖 1 所示。測試結果表明,樣品無論是否經歷溫度循環,均達到了 GJB548B-2005 方法 2011.1 中的最小鍵合強度要求(18 μ m / 1.5g 、 25 μ m / 2.5g 、30 μ m / 3.2g )。

由金絲在溫度循環后的鍵合強度隨循環次數的關系可見,隨著溫度循環次數的增加,其鍵合強度先略微增大,后緩慢減小并趨于平緩。所有試驗樣品均未出現焊點拉脫的現象。
鍵合壓點發生脫鍵,是金絲鍵合強度值急劇下降的轉折點,在大量的脆性 IMC 和 Kirkendall 孔洞形成之前,金絲的拉斷位置全部集中在頸部。 L.N.SUN 等人[ 5 ] 認為,在EFO ( ElectronicFlameOff )成球的過程中,金絲尖端溫度迅速達到熔點, EFO結束后,又快速降溫淬火,導致在頸部形成了大量的晶格缺陷和結構應力 [6 ] ,強度最低的位置距離頸部約 100~200 μ m ,比引線的其他任何部分都脆弱,這個區域的強度只有其他區域的 20% ,被稱為熱影響
區域( HeatAffectZone ,HAZ )。 HAZ 具有中等大小的晶粒尺寸,是最大晶粒與正常晶粒大小的過度區域,在后期的強度測試中為主要的斷開點。
在初始的溫度循環階段(0~10 次),隨著循環次數的增加,晶粒之間發生重結晶,晶格缺陷逐漸減少,應力逐漸釋放,晶粒緩慢生長,所以 HAZ 的拉斷力略微增大,即為圖 1 中所示的鍵合強度略微上升區域,在 出 現 壓 點 脫 鍵 前,拉 斷 力 與 IMC 及Kirkendall 孔洞無關。
在后續的溫度循環階段(10~200 次),晶粒尺寸逐漸生長,晶界能降低,較小的晶界面積和大的晶粒尺寸降低了 HAZ 的強度,所以,此階段鍵合強度緩慢下降。
溫度循環 10 次及以后的鍵合強度變化呈線性規律,對其進行線性擬合,獲得不同絲徑下的衰減變化線性方程,如圖 2 所示。通過線性擬合獲得 18 、25 、 30 μ m 金絲鍵合強度 Force (/ g )與溫度循環次數 N的 關 系: Force18 = -0.0021 N +5.112 、 Force 25 =-0.0063 N +10.895 、 Force 30 =-0.0095 N +15.955。

2.2 硅鋁絲鍵合強度隨溫度循環次數的關系
硅鋁絲在溫度循環后的鍵合強度隨循環次數的關系如圖 3 所示。測試結果表明,樣品無論是否經歷溫度循環,均達到了 GJB548B-2005 方法 2011.1中的最小鍵合強度要求(25 μ m / 1.5g 、 32 μ m / 2.0g 、45 μ m / 2.5g )。由硅鋁絲在溫度循環后的鍵合強度隨循環次數的關系可見,隨著溫度循環次數的增加,硅鋁絲鍵合強度先較快減小,后緩慢減小,并趨于平緩。所有試驗的樣品均未出現焊點拉脫的現象。相比于金絲,硅鋁絲在 0~50 次的溫度循環下強度衰減較快。

L.YANG 等人[ 7 ] 的研究表明,在溫度循環過程中,溫度循環導致的缺陷主要聚集在材料缺陷的尖端,并且逐漸向鍵合材料中擴展,形成塑性區域,此塑性區域沿著界面缺陷向材料中傳播,如圖 4 所示。 Y.YAMADA 等人 [8 ] 通過對功率器件進行溫度循環試驗,發現了同樣的界面缺陷。 A.HAMIDI等人 [9 ] 對 IGBT 功率模塊進行了功率循環,其試驗方法與溫度循環具有相似之處,從試驗結果上亦觀察到了界面缺陷的形貌。

以上試驗結果及理論分析表明,硅鋁絲鍵合溫度循環下的強度衰減模式主要為:熱膨脹系數不同導致應力與應變增大,從而導致松弛狀態的產生,其缺陷主要聚集在鍵合引線的頸部,并且逐漸向鍵合材料中擴展,形成塑性區域,此塑性區域沿著界面缺陷向材料中傳播,最終形成鍵合點頸部的裂紋或缺陷。 0~50 次的溫度循環使硅鋁絲鍵合頸部靠近焊接的接觸面處產生微裂紋或晶格缺陷,最終使鍵合線頸部強度降低。因硅鋁絲與管殼鍍金層熱膨脹系數差異較大,所以斷開點主要集中在管殼端。
A.HAMIDI 等人[ 9 ] 通過EBSD 和定向誤差圖進行分析,結果表明,在 50 次及后續的溫度循環試驗下,隨著循環次數的增加,未見明顯的重結晶過程。經過溫度循環后的應變完全小于初始狀態,表明鋁線中的應力在溫度循環過程中得到了釋放,最終,鍵合強度趨于平緩。
溫度循環 5 次及以后的變化呈指數級減小,使用指數方程對其進行非線性擬合,獲得不同絲徑下的衰減曲線,如圖 5 所示。通過非線性擬合得到,25 、 32 、 45 μ m 硅鋁絲鍵合強度 Force (/ g )與溫度循環次 數 N 的關 系分 別為: Force25 =9.11 N-0.06、Force 32 =9.71 N-0.04、Force 45 =11.98 N-0.06。

2.3 溫度循環后鍵合線的拉斷模式比例
所有樣品在經歷溫度循環后做破壞性鍵合強度測試,只存在 a1 (引線在緊縮點靠芯片端斷開)和 a2(引線在緊縮點靠管殼端斷開)兩種拉斷模式,未出現焊點直接拉脫的現象。
前面的試驗結果分析表明,在經歷溫度循環試驗后,影響金絲鍵合強度的主要因素為 HAZ ,所以金絲鍵合拉力測試的主要斷開點集中在芯片端,而影響鋁絲鍵合強度的主要原因為熱膨脹系數不同導致應力與應變增大,所以鋁絲鍵合拉力測試的主要斷開點集中在管殼端。為了分析兩者的差異,統計分析了金絲和鋁絲在不同絲徑下經歷不同次數的溫度循環后拉斷模式 a1 所占比例( a1 /( a1+ a2 )) ×100% ,如圖 6 所示。

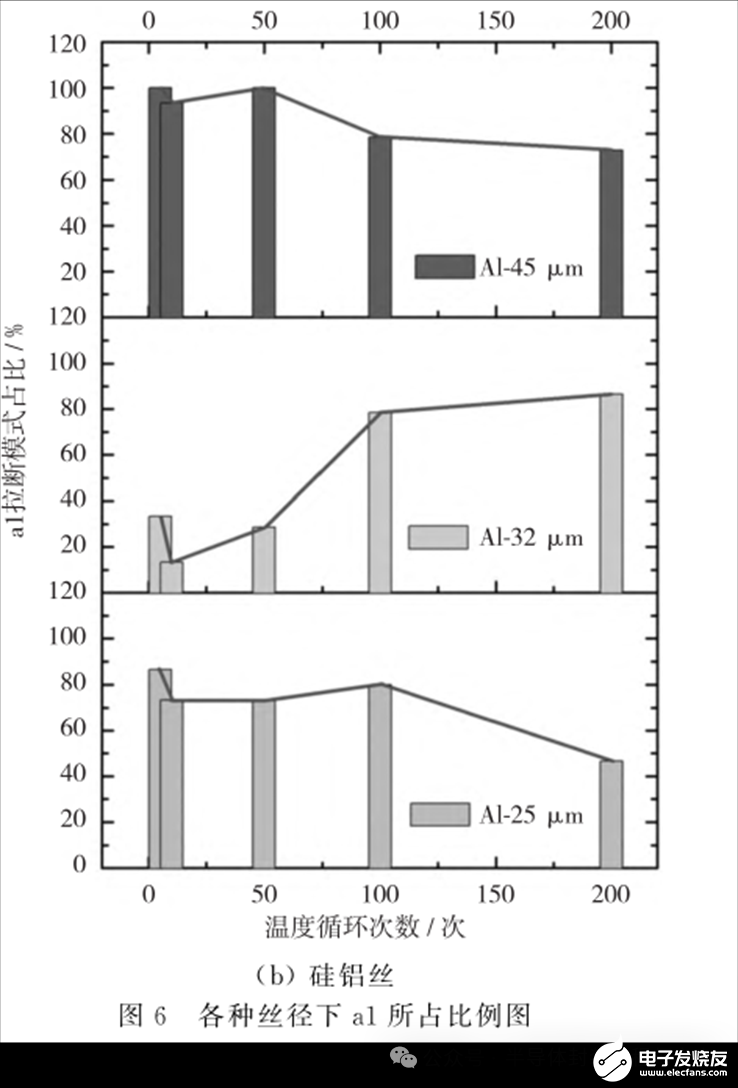
由各種絲徑下 a1 所占比例可見,金絲的 a1 明顯多于硅鋁絲,約占總拉斷模式的 90% 及以上,即金絲主要在芯片上斷開。硅鋁絲的 a1 占比小,約占總拉斷模式的 30% 及以上,即硅鋁絲主要在管殼引腳上斷開。兩種材料鍵合絲的拉斷模式對于絲徑、隨溫度循環的次數并沒有呈現規律性的變化。
3 結論
所有試驗樣品,無論是否經歷溫度循環,均達到了 GJB548B-2005 方法 2011.1 中的最小鍵合強度要求,均未出現焊點拉脫的現象。
隨著溫度循環次數的增加,金絲鍵合強度先略微增大,后緩慢減小并趨于平緩,硅鋁絲鍵合強度先較快減小,后緩慢減小,并趨于平緩。相比于金絲,硅鋁絲強度在 0~50 次的溫度循環下衰減較快。由各種絲徑下的拉斷模式所占比例分析表明,金絲的a1 明顯多于硅鋁絲,即金絲主要在芯片上斷開,硅鋁絲主要在管殼引腳上斷開。但兩種材料鍵合絲的拉斷模式隨溫度循環次數的增加并沒有呈現規律性的變化。
審核編輯 黃宇
-
芯片
+關注
關注
459文章
52145瀏覽量
435732 -
引線鍵合
+關注
關注
2文章
25瀏覽量
8372
發布評論請先 登錄
順絡電子引線鍵合(Wire Bonding)NTC熱敏電阻 -SDNC系列

銅線鍵合IMC生長分析

引線鍵合檢測的基礎知識
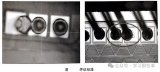
帶你一文了解什么是引線鍵合(WireBonding)技術?

半導體制造的鍵合線檢測解決方案
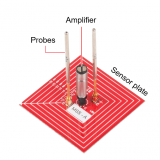





 引線鍵合在溫度循環下的鍵合強度衰減研究
引線鍵合在溫度循環下的鍵合強度衰減研究



















評論