碳化硅(SiC)是一種寬禁帶半導體材料,具有高熱導率、高擊穿場強、高飽和電子漂移速率和高鍵合能等優(yōu)點。由于這些優(yōu)異的性能,碳化硅在電力電子、微波射頻、光電子等領域具有廣泛的應用前景。然而,由于碳化硅材料的生長和加工難度較大,其特色工藝模塊的研究和應用成為了當前碳化硅產(chǎn)業(yè)發(fā)展的關鍵。
碳化硅特色工藝模塊主要包括以下幾個方面:
注入摻雜
在碳化硅中,碳硅鍵能較高,雜質(zhì)原子難以在其中擴散。因此,在制備碳化硅器件時,PN結的摻雜必須通過高溫下離子注入的方式來實現(xiàn)。
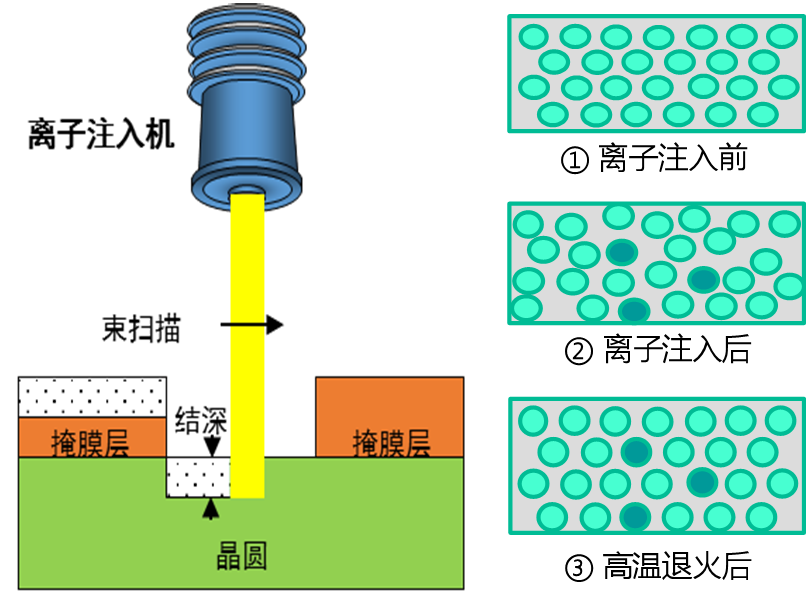
碳化硅晶片切割技術
柵結構成型
SiC/SiO2界面的質(zhì)量對MOSFET溝道遷移和柵極可靠性具有重要影響。因此,需要開發(fā)特定的柵氧及氧化后退火工藝,通過引入特殊原子(如氮原子)來補償SiC/SiO2界面處的懸掛鍵,從而滿足高質(zhì)量SiC/SiO2界面和器件高遷移性能的要求。主要的工藝技術包括柵氧高溫氧化、LPCVD和PECVD。

碳化硅薄膜制備技術
碳化硅薄膜具有低損耗、高導熱、耐高溫等特點,廣泛應用于微電子器件、光電子器件等領域。目前,主要的碳化硅薄膜制備技術有化學氣相沉積法(CVD)、物理氣相沉積法(PVD)和原子層沉積法(ALD)等。其中,CVD法具有設備簡單、成本低等優(yōu)點,但其薄膜質(zhì)量受到氣體組分和溫度等因素的影響。PVD法和ALD法雖然可以獲得高質(zhì)量的碳化硅薄膜,但設備復雜、成本高。因此,如何實現(xiàn)低成本、高質(zhì)量的碳化硅薄膜制備技術是當前研究的關鍵。
形貌刻蝕
由于碳化硅材料在化學溶劑中具有惰性,因此要實現(xiàn)精確的形貌控制,只能通過干法刻蝕方法來實現(xiàn)。在這個過程中,需要根據(jù)碳化硅材料的特性來選擇掩膜材料、掩膜蝕刻方法、混合氣體、側壁控制、蝕刻速率和側壁粗糙度等。主要的工藝技術包括薄膜沉積、光刻、介質(zhì)膜腐蝕和干法刻蝕工藝。
金屬化
在器件的源電極制作過程中,需要確保金屬與碳化硅形成良好的低電阻歐姆接觸。這需要通過調(diào)控金屬淀積工藝來控制金屬-半導體接觸的界面狀態(tài),同時采用高溫退火的方式降低肖特基勢壘高度,從而實現(xiàn)金屬-碳化硅歐姆接觸。主要的工藝技術包括金屬磁控濺射、電子束蒸發(fā)和快速熱退火。
總之,碳化硅特色工藝模塊的研究和應用對于推動碳化硅產(chǎn)業(yè)的發(fā)展具有重要意義。通過不斷優(yōu)化和完善各種工藝技術,有望實現(xiàn)碳化硅材料在各領域的廣泛應用。
-
半導體
+關注
關注
335文章
28886瀏覽量
237544 -
SiC
+關注
關注
31文章
3222瀏覽量
65176 -
碳化硅
+關注
關注
25文章
3064瀏覽量
50451
發(fā)布評論請先 登錄





 碳化硅特色工藝模塊簡介
碳化硅特色工藝模塊簡介











評論