GaN因其特性,作為高性能功率半導(dǎo)體 材料而備受關(guān)注,近年來其開發(fā)和市場導(dǎo)入不斷加速。垂直型GaN功率器件比水平型更適合高電壓和大電流,這使得垂直GaN能夠為最苛刻的應(yīng)用提供動力,但也存在成本等問題。
近日,第九屆國際第三代半導(dǎo)體論壇(IFWS)&第二十屆中國國際半導(dǎo)體照明論壇(SSLCHINA)于廈門召開。期間,“氮化鎵功率電子器件技術(shù)分論壇”上,華南師范大學(xué)尹以安研究員做了“具復(fù)合柵極和階梯結(jié)構(gòu)的新型GaN垂直晶體管研究”的主題報,分享了最新研究成果。研究內(nèi)容涉及復(fù)合柵極結(jié)構(gòu)、能帶調(diào)制技術(shù)路線、電場調(diào)制技術(shù)路線、低導(dǎo)通電阻的技術(shù)路線等。
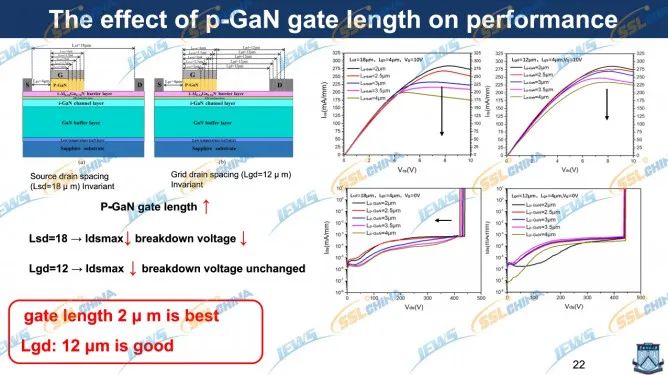
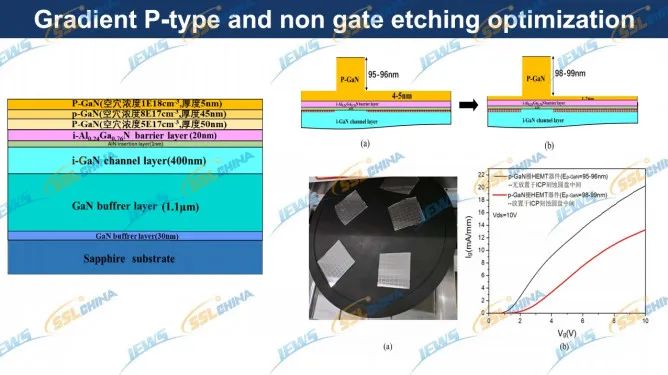
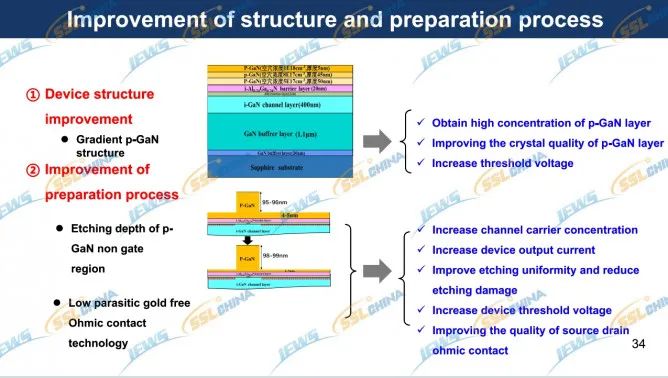
增強型p-GaN柵極HEMT器件研究涉及實驗增強型p-GaN柵極HEMT、p-GaN柵極長度對性能的影響、漸變P型和非柵區(qū)刻蝕優(yōu)化、源極-漏極刻蝕深度對器件性能的影響、無金歐姆接觸的研制等。垂直HEMT器件的實現(xiàn)研究方面,涉及主流垂直器件基板的選擇、EC直接剝離GaN的原理、垂直HEMT器件的實驗驗證等。
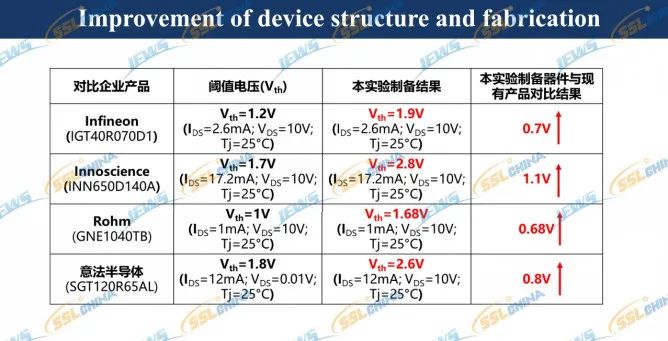
報告指出,結(jié)合 Mis結(jié)構(gòu)、p柵極及階梯式的P型埋層可獲得:高Vth:4.14V,高BV:3065V 低RON:1.45mΩ·cm2,FOM :6.56GWcm-2。漸變p-GaN結(jié)構(gòu)++優(yōu)化非p柵區(qū)的蝕刻深度++優(yōu)化源極-漏極蝕刻深度++最優(yōu)化p柵極長度++無金歐姆接觸:獲得Emode,高Vth:2.6V,p柵極長度為2μm。柵極和漏極之間的間距為12μm是最佳的。源極-漏極蝕刻深度為8-10nm。實現(xiàn)垂直HEMT器件的低成本低缺陷:EC直接剝離藍(lán)寶石襯底成為可能。
審核編輯:劉清
-
led
+關(guān)注
關(guān)注
242文章
23700瀏覽量
670895 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28599瀏覽量
232513 -
晶體管
+關(guān)注
關(guān)注
77文章
9979瀏覽量
140651 -
肖特基二極管
+關(guān)注
關(guān)注
5文章
978瀏覽量
35751 -
GaN
+關(guān)注
關(guān)注
19文章
2176瀏覽量
76149
原文標(biāo)題:尹以安研究員:具復(fù)合柵極和階梯結(jié)構(gòu)的新型GaN垂直晶體管研究
文章出處:【微信號:第三代半導(dǎo)體產(chǎn)業(yè),微信公眾號:第三代半導(dǎo)體產(chǎn)業(yè)】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
多值電場型電壓選擇晶體管結(jié)構(gòu)
晶體管電路設(shè)計(下)
晶體管柵極結(jié)構(gòu)形成
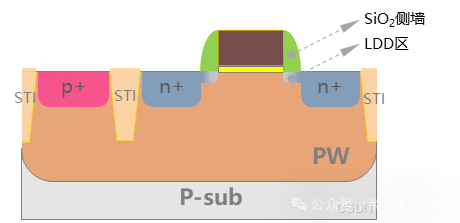
互補場效應(yīng)晶體管的結(jié)構(gòu)和作用

日本開發(fā)出用于垂直晶體管的8英寸氮化鎵單晶晶圓
NMOS晶體管和PMOS晶體管的區(qū)別
GaN晶體管的命名、類型和結(jié)構(gòu)

晶體管的主要材料有哪些
GaN晶體管的應(yīng)用場景有哪些
GaN晶體管和SiC晶體管有什么不同
GaN晶體管的基本結(jié)構(gòu)和性能優(yōu)勢
什么是光電晶體管?光電晶體管的工作原理和結(jié)構(gòu)
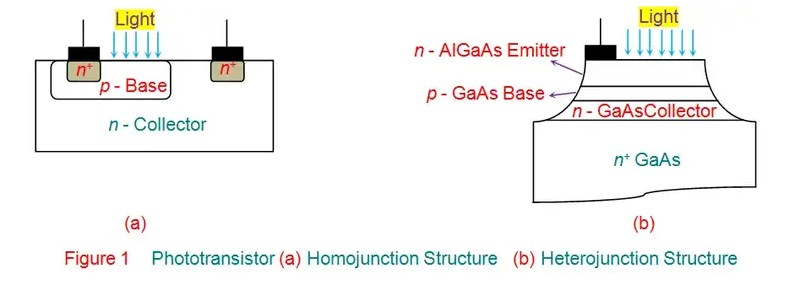
PNP晶體管符號和結(jié)構(gòu) 晶體管測試儀電路圖
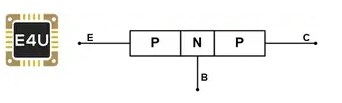





 具復(fù)合柵極和階梯結(jié)構(gòu)的新型GaN垂直晶體管研究
具復(fù)合柵極和階梯結(jié)構(gòu)的新型GaN垂直晶體管研究
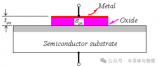
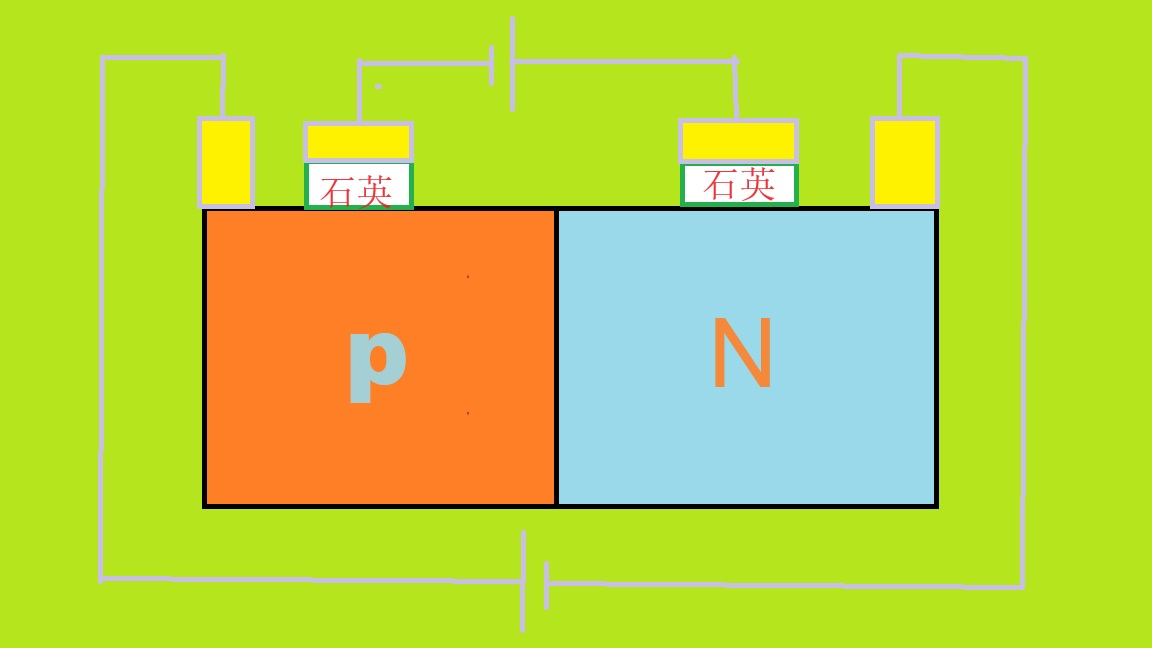










評論