基于大語言模型的人工智能(AI)技術(shù)在過去十幾個月的時間里呈現(xiàn)出爆發(fā)式發(fā)展,全球已有多家企業(yè)向公眾開放其大模型產(chǎn)品,并且不乏多模態(tài)、內(nèi)容生成等進階應(yīng)用。然而,算力需求和部署速度之間的落差仍是推進生成式AI應(yīng)用落地的主要障礙之一。據(jù)測算,從小模型發(fā)展到大模型,10年間AI對算力的需求提升了40萬倍——這一增長速度遠超摩爾定律。許多處于全球前列的半導(dǎo)體企業(yè),都在致力于探索新的創(chuàng)新路徑。
封測作為后摩爾時代承載半導(dǎo)體產(chǎn)業(yè)創(chuàng)新的重要環(huán)節(jié),受到整個產(chǎn)業(yè)的關(guān)注。以異構(gòu)異質(zhì)、高密度互連為主要特征的高性能封裝技術(shù),將為半導(dǎo)體在人工智能、云計算領(lǐng)域的應(yīng)用提供無限機會。
芯片成品制造承載產(chǎn)業(yè)創(chuàng)新
行業(yè)步入“后摩爾時代”,晶體管微縮集成逼近物理極限,并且由此帶來的研發(fā)、制造成本已經(jīng)超出了摩爾定律所定義的比率,這也直接引發(fā)了AI所需高算力的成本顯著上升。
此時,摩爾定律中提到的微系統(tǒng)集成,給產(chǎn)業(yè)帶來轉(zhuǎn)換創(chuàng)新賽道的機會:從晶體管微縮,到微系統(tǒng)集成,意味著主要的創(chuàng)新環(huán)節(jié)從晶圓制造向后道成品制造轉(zhuǎn)移——這一轉(zhuǎn)變事實上正在發(fā)生。
面向AI等高性能計算的核心芯片,目前業(yè)界聚焦小芯片(Chiplet)技術(shù)實現(xiàn)微系統(tǒng)集成,從而搭建算力密度更高且成本更優(yōu)的高密集計算集群。封裝創(chuàng)新對促進高性能計算的發(fā)展越發(fā)重要,并體現(xiàn)在以下三個方面:
1一是通過2.5D/3D封裝,包括基于再布線層(RDL)轉(zhuǎn)接板、硅轉(zhuǎn)接板或硅橋,以及大尺寸倒裝等技術(shù)開發(fā)人工智能應(yīng)用,以實現(xiàn)小芯片上更高的密度和微系統(tǒng)內(nèi)更高的互連速度。
2二是通過系統(tǒng)/技術(shù)協(xié)同優(yōu)化(STCO)開發(fā)小芯片等具有微系統(tǒng)級集成的設(shè)備。STCO在系統(tǒng)層面對芯片架構(gòu)進行分割及再集成,以高性能封裝為載體,貫穿設(shè)計、晶圓制造、封裝和系統(tǒng)應(yīng)用,以滿足更復(fù)雜的AIGC應(yīng)用需求。
3三是通過SiP可以打造更高水平的異構(gòu)集成,賦予不同類型的芯片和組件(包括無源組件)更大的靈活性,實現(xiàn)多種封裝類型的混合封裝。
重塑集成電路產(chǎn)業(yè)協(xié)作方式
半導(dǎo)體發(fā)展到高性能封裝帶動微系統(tǒng)創(chuàng)新這一階段,產(chǎn)業(yè)鏈的合作方式也在發(fā)生改變。例如,應(yīng)用場景需求對芯片成品制造的驅(qū)動作用更加顯著,相應(yīng)地,企業(yè)也更加注重以具體解決方案為核心的產(chǎn)品開發(fā)機制。作為全球領(lǐng)先的芯片成品制造企業(yè),長電科技積極與產(chǎn)業(yè)鏈伙伴合作,持續(xù)推出創(chuàng)新解決方案,更好地滿足市場應(yīng)用需求。
不僅如此,隨著應(yīng)用側(cè)與后道成品制造的聯(lián)系愈發(fā)緊密,協(xié)同設(shè)計、協(xié)同制造在行業(yè)中的比重增加,整個產(chǎn)業(yè)鏈的協(xié)作模式將從線性轉(zhuǎn)向融合。
這些變化,推動半導(dǎo)體行業(yè)的創(chuàng)新方法論迭代。例如上文提到系統(tǒng)/技術(shù)協(xié)同優(yōu)化(STCO)。STCO對于開發(fā)像Chiplet這樣具有微系統(tǒng)級集成的產(chǎn)品變得越來越重要。
作為AI基礎(chǔ)設(shè)施的提供者,集成電路在性能及成本上的創(chuàng)新,將為前者帶來更大的成長空間。同時AI的發(fā)展和普及,也為集成電路乃至整個半導(dǎo)體行業(yè)帶來新的市場增量。高性能封裝作為微系統(tǒng)集成創(chuàng)新的有力推手,其發(fā)展前景值得期待。
長電科技是全球領(lǐng)先的集成電路制造和技術(shù)服務(wù)提供商,提供全方位的芯片成品制造一站式服務(wù),包括集成電路的系統(tǒng)集成、設(shè)計仿真、技術(shù)開發(fā)、產(chǎn)品認證、晶圓中測、晶圓級中道封裝測試、系統(tǒng)級封裝測試、芯片成品測試并可向世界各地的半導(dǎo)體客戶提供直運服務(wù)。
通過高集成度的晶圓級(WLP)、2.5D/3D、系統(tǒng)級(SiP)封裝技術(shù)和高性能的倒裝芯片和引線互聯(lián)封裝技術(shù),長電科技的產(chǎn)品、服務(wù)和技術(shù)涵蓋了主流集成電路系統(tǒng)應(yīng)用,包括網(wǎng)絡(luò)通訊、移動終端、高性能計算、車載電子、大數(shù)據(jù)存儲、人工智能與物聯(lián)網(wǎng)、工業(yè)智造等領(lǐng)域。長電科技在中國、韓國和新加坡設(shè)有六大生產(chǎn)基地和兩大研發(fā)中心,在20多個國家和地區(qū)設(shè)有業(yè)務(wù)機構(gòu),可與全球客戶進行緊密的技術(shù)合作并提供高效的產(chǎn)業(yè)鏈支持。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
460文章
52505瀏覽量
440826 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28909瀏覽量
237813 -
AI
+關(guān)注
關(guān)注
88文章
35136瀏覽量
279795 -
長電科技
+關(guān)注
關(guān)注
5文章
376瀏覽量
32919
原文標題:芯片成品制造創(chuàng)新推動微系統(tǒng)集成發(fā)展,產(chǎn)業(yè)加速向AI滲透
文章出處:【微信號:gh_0837f8870e15,微信公眾號:長電科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
12家上市汽車系統(tǒng)集成商2024年業(yè)績情況

ATA-2161高壓放大器在介電電泳微流控芯片研究中的應(yīng)用
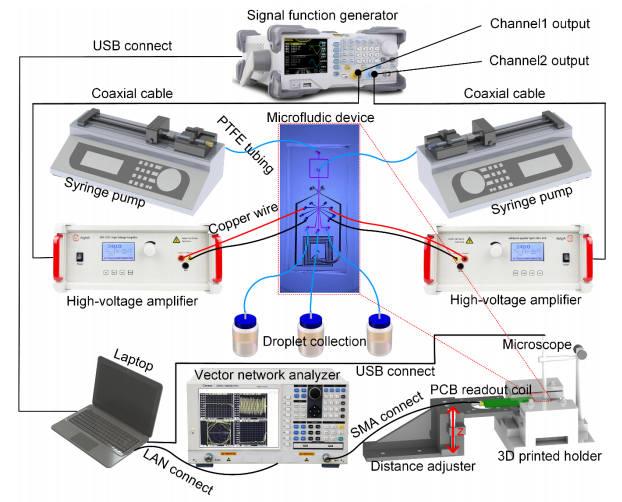
表面貼裝技術(shù)(SMT):推動電子制造的變革
Banana Pi 與瑞薩電子攜手共同推動開源創(chuàng)新:BPI-AI2N
3D打印技術(shù),推動手板打樣從概念到成品的高效轉(zhuǎn)化
IBMS系統(tǒng)集成的功能有哪些
守護半導(dǎo)體精度的穩(wěn)定之錨——抗微震平臺

芯片極限能力、封裝成品及系統(tǒng)級測試
可與MES系統(tǒng)集成的數(shù)據(jù)采集監(jiān)控平臺
天合跟蹤:跟蹤支架系統(tǒng)集成創(chuàng)新價值分析
智慧園區(qū)系統(tǒng)集成解決方案應(yīng)用
長電微電子晶圓級微系統(tǒng)集成高端制造項目正式通線

TAS2563終端系統(tǒng)集成指南

系統(tǒng)集成提升醫(yī)院能耗管理效率和質(zhì)量






 芯片成品制造創(chuàng)新推動微系統(tǒng)集成發(fā)展
芯片成品制造創(chuàng)新推動微系統(tǒng)集成發(fā)展











評論