芯片鍵合,作為切割工藝的后道工序,是將芯片固定到基板(substrate)上的一道工藝。引線鍵合(wire bonding)則作為芯片鍵合的下道工序,是確保電信號(hào)傳輸?shù)囊粋€(gè)過程。wire bonding是最常見一種鍵合方式。

Gold Bonding Wire: 半導(dǎo)體鍵合金線/金絲
用于半導(dǎo)體封裝工藝中的芯片鍵合。
Wire Bond/金線鍵合:指在對(duì)芯片和基板間的膠粘劑處理以使其有更好的粘結(jié)性能后,用高純金線把芯片的接口和基板的接口鍵合。
成分為金(純度為99.999%),摻雜銀、鈀、鎂、鐵、銅、硅等元素。
摻雜不同的元素可以改變金線的硬度、剛性、延展度、電導(dǎo)率等參數(shù)。
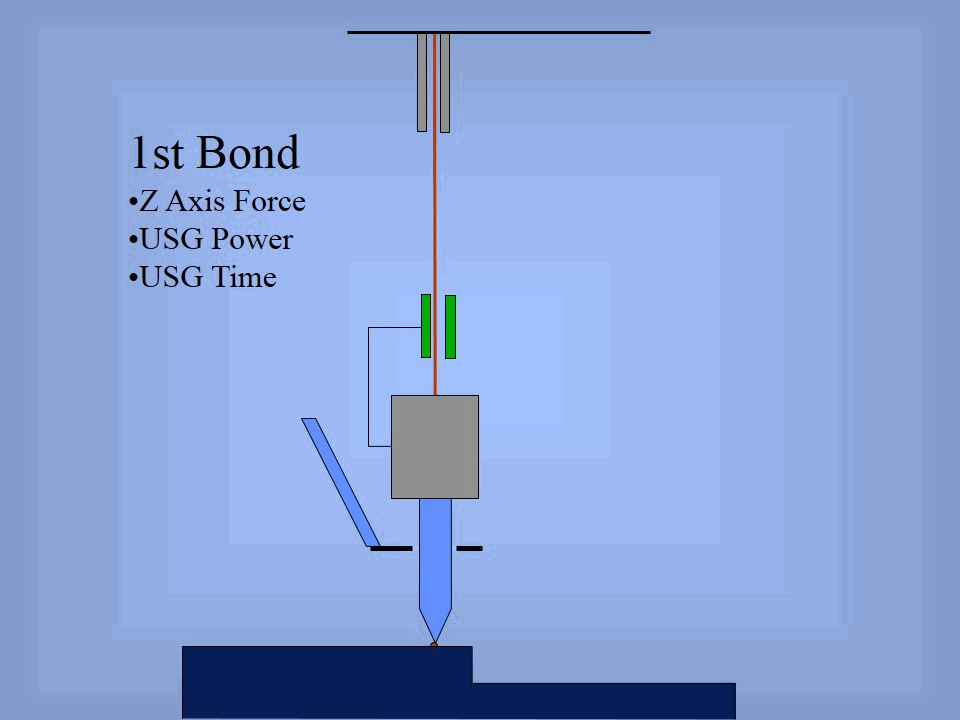
一、 目的:建立基本的 wire bonding 標(biāo)準(zhǔn),制定生產(chǎn)過程中產(chǎn)品合格/不合格的判斷標(biāo)準(zhǔn)。
二、 范圍:本標(biāo)準(zhǔn)只適用于金線球焊工藝。
三、 基本焊接條件:熱壓超聲波焊接用于金線鍵合,所需的溫度、壓力、超聲波功率及時(shí)間視不同機(jī)型、不同材料有很大不同,具體根據(jù)機(jī)型、材料特性科學(xué)設(shè)定。
四、 品質(zhì)判斷標(biāo)準(zhǔn):
1) 球形標(biāo)準(zhǔn),如下圖所示:
① 球的直徑:以2.5φ-3.5φ為標(biāo)準(zhǔn) ,低于2.5φ為球小,大于3.5φ為球大。
② 球的厚度:以0.5φ-1.5φ為標(biāo)準(zhǔn),低于0.5φ為球扁,大于1.5φ為球厚。
③ 球畸形:焊線偏離焊球中心超過1/2φ為球畸形。
注:以上φ為金線直徑,以下類同。
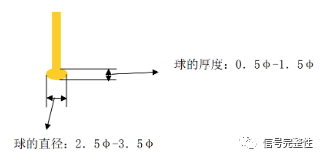
線形標(biāo)準(zhǔn):
① 線形不良:線擺動(dòng)以≤3φ、S 形≤2φ為標(biāo)準(zhǔn),超過此標(biāo)準(zhǔn)為線形不良。線形擺動(dòng)如下圖所示
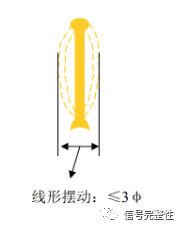
② 線受損:以≤1/4φ為標(biāo)準(zhǔn),超過1/4φ為線受損不可接受。
③ 弧形標(biāo)準(zhǔn):晶粒邊距金線垂直距離至少1.5φ,少于1.5φ為線低;晶粒面距線形最高不超過 200um,如下圖所示。
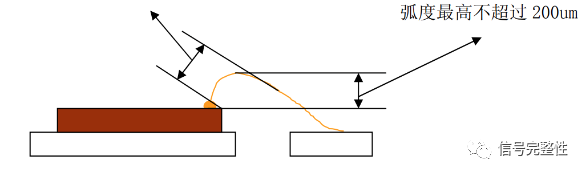
④ 跪線:如下圖所示,圓圈處所指的金線貼在焊接表面上為跪線,不可接受。標(biāo)準(zhǔn)線形為圓圈處所指的金線與焊接表面應(yīng)有一定角度。
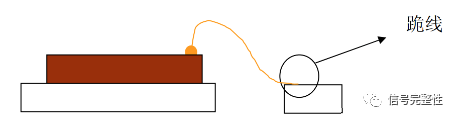
3)焊口標(biāo)準(zhǔn):
① 焊口:長為0.8φ—1.5φ,寬為1.5φ—2.5φ,且瓷咀印必須完整,超出此規(guī)格范圍為不可接受,如下圖所示:
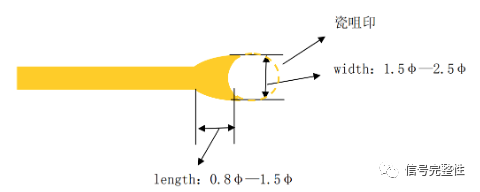
② 線尾:線尾長度必須≤1φ,大于1φ時(shí)為線尾長,不可接受。跪線 length:0.8φ—1.5φ width:1.5φ—2.5φ 瓷咀印
③ 虛焊、脫焊:焊球與Die面接觸,焊口與Frame 表面接觸,拉力測試為0時(shí)為虛焊;焊球或焊口中有一個(gè)不與焊接表面接觸時(shí)為脫焊。如下圖所示
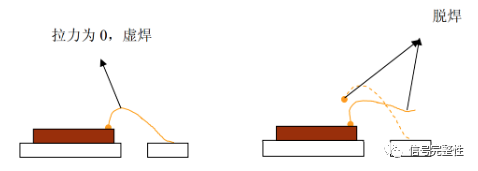
4) 位置標(biāo)準(zhǔn):
① 走位:球走位:焊球須在IC pad位置內(nèi)或恰好壓在 Pad 邊上,超出pad位置為球走位。焊口走位:焊點(diǎn)須在PCB金手指內(nèi),焊口離金手指邊至少 1φ。超出金手指 為焊口走位。

② 漏線:應(yīng)焊線的位置沒有焊線。
③ 焊錯(cuò)位:金線沒有焊在指定 Pad 上而是焊在別的 Pad 上。
5) 拉力及推球標(biāo)準(zhǔn):
① 拉力測試方法:拉力測試時(shí)以靠近焊球金線弧形最高處為基準(zhǔn),如下圖所示:
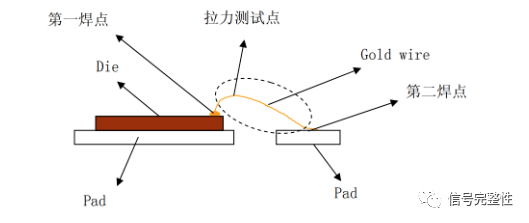
金線拉力管制,如下表:

備注:23、23J 為同一直徑的金線,對(duì) SOT-54、SOT-23 產(chǎn)品 Wire bonding 時(shí)有兩個(gè)引線方向,方向不同金線的管制拉力不同,用J來區(qū)分,其余類同。
③ 推球不良:推球時(shí)使用推球機(jī)做推力實(shí)驗(yàn),推球力至少16g以上,金線在pad上殘留量≥60%,不滿足此規(guī)格為推球不良。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
459文章
52505瀏覽量
440765 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28909瀏覽量
237756 -
封裝工藝
+關(guān)注
關(guān)注
3文章
65瀏覽量
8155 -
引線鍵合
+關(guān)注
關(guān)注
2文章
26瀏覽量
8462
原文標(biāo)題:芯片金線生產(chǎn)工藝標(biāo)準(zhǔn)
文章出處:【微信號(hào):半導(dǎo)體封裝工程師之家,微信公眾號(hào):半導(dǎo)體封裝工程師之家】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
介紹芯片鍵合(die bonding)工藝
什么是倒裝芯片 倒裝芯片技術(shù)的優(yōu)點(diǎn) 倒裝芯片封裝工藝流程

半導(dǎo)體引線鍵合清洗工藝方案
招聘半導(dǎo)體封裝工程師
《炬豐科技-半導(dǎo)體工藝》用于半導(dǎo)體封裝基板的化學(xué)鍍 Ni-P/Pd/Au
半導(dǎo)體生產(chǎn)封裝工藝簡介
半導(dǎo)體封裝:鍵合銅絲的性能優(yōu)勢與主要應(yīng)用問題
集成電路封裝工藝——鋁線鍵合特性及優(yōu)勢

半導(dǎo)體封裝技術(shù)簡介 什么是倒裝芯片技術(shù)?

半導(dǎo)體封裝工藝的研究分析

半導(dǎo)體芯片鍵合裝備綜述

鋁帶鍵合點(diǎn)根部損傷研究:提升半導(dǎo)體封裝質(zhì)量
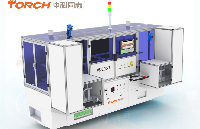





 用于半導(dǎo)體封裝工藝中的芯片鍵合解析
用于半導(dǎo)體封裝工藝中的芯片鍵合解析

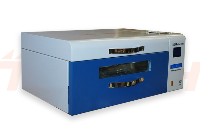











評(píng)論