摘要:
芯片粘接質量是電路封裝質量的一個關鍵方面,它直接影響電路的質量和壽命。文章從芯片粘接強度的失效模式出發,分析了芯片粘接失效的幾種類型,并從失效原因出發對如何在芯片粘接過程中提高其粘接強度提出了四種解決途徑和方法,對提高芯片粘接強度和粘接可靠性具有參考價值。文章還指出了芯片粘接強度測試過程中的一些不當或注意點及其影響,并對不當的測試方法給出了改進方法,能有效地避免測試方法不當帶來的誤判。
1 引言
在集成電路芯片裝片或封裝后的篩選中,以及電路考核鑒定驗收時,常需要確定芯片粘接質量是否符合要求。最有效的方法之一就是在同一批封裝(或裝片)的電路中,隨機抽取一定數量的電路,并對這些電路進行抗剪或抗拉強度測試,根據測量結果和分離界面的形貌來判斷芯片粘接質量,并分析芯片粘接情況,特別是粘接脫開的相關因素,從而對芯片粘接材料、裝片工藝等加以控制和優化來提高芯片粘接強度,滿足芯片粘接可靠性的要求。
2 芯片粘接失效模式
聚合物類材料裝片影響芯片粘接強度的因素教較多,涉及粘接材料、工藝條件、外殼襯底 / 基座的質量和芯片背面的粗糙度、潔凈度等。芯片粘接的失效模式主要有:(1)從芯片硅表面與裝片粘接材料分離;(2)裝片粘接材料層斷裂;(3)裝片粘接材料與外殼襯底 / 基座分離。參見圖 1、圖 2、圖 3。
根據芯片失效的脫落界面及形貌分析脫落的原因和可能性,再針對引起失效的原因在生產中加以控制和解決。
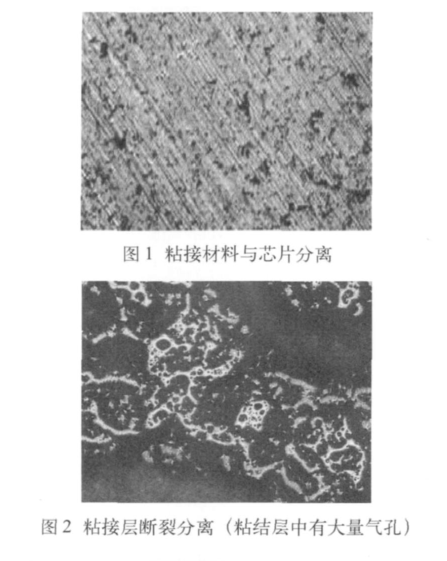
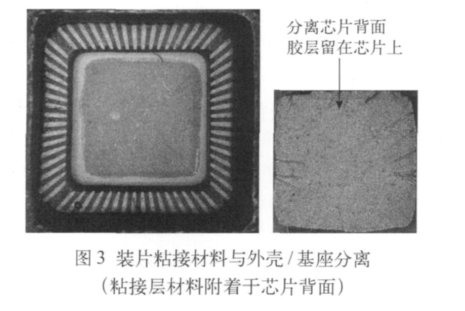
3 芯片粘接強度提高途徑
增強芯片粘接強度可通過對裝片粘接材料的優選、粘接工藝方面的優化和控制來提高粘接質量,保證高可靠的粘接強度。
3.1 芯片背面潔凈度、粗糙度的控制
為降低封裝熱阻、厚度以及封裝劃片等工藝的要求,前道工藝制造的圓片較厚,均需進行減薄。在圓片背部磨削減薄時,芯片背面即芯片的粘接面會有微細的硅粉塵存在,微細的硅粉塵使芯片本體材料不能完全與粘接材料接觸,芯片裝片后必然會對粘接強度造成影響。減薄后的清洗對提高芯片粘接強度是非常重要的步驟,具備條件的同時還應借助化學方法對硅屑進行充分徹底地清除。減薄時若芯片背面太光,像鏡面一樣光滑,不利于增大粘接材料與芯片的接觸面積,也不利于芯片與膠的鰲合,因此增加芯片粗糙度,可提高芯片的粘接性強度。
圖 4 是芯片背面光滑,恒加時導致芯片脫落失效,失效樣品芯片背面只有少許導電膠存在;圖5樣品增加了芯片背面粗糙度,芯片粘接強度得到顯著提高,試驗后導電膠完全留在芯片背面。

3.2 外殼等在裝片前烘烤,增強粘接強度
外殼生產過程中如清洗不干凈,表面會有沾污或清洗殘留物;另外,外殼在貯存過程中,表面會吸附空氣中的水汽等,在裝片前對外殼進行烘烤等處理,可去除部分外殼生產過程中的殘留物及表面吸附的水汽,以提高粘接面的粘接性能。
圖 6 是外殼經烘烤后,裝片的樣品做芯片粘接強度測試的界面,粘接材料大部分留于外殼鍍金層上,說明裝片粘接材料與鍍金基座擁有較好的粘接強度。而未進行烘烤的外殼,裝片后強度測試粘接材料與外殼鍍金層發生了完全分離的現象,這說明了粘接材料與鍍金層之間的接觸不良,造成兩者之間強度較弱,參見圖 7。
3.3 優選芯片粘接材料以提高粘接強度
在氣密封裝中,粘接劑需具備:高的粘附強度、熱分解溫度及高穩定性、少量甚至不含溶劑、低的水汽含量。
為了提高電路芯片的粘接強度,對芯片粘接材料需進行優選,選擇較高的溫度 T g 、與芯片及基板匹配的低 CTE 膨脹系數且彈性模量低的粘接材料,使粘接后的粘接層的內應力較低;同時,選擇在固化過程中和固化后重量損失率低的粘接材料,材料結構致密且固化后孔隙率較低,從而提高芯片的粘接強度,保證芯片粘接的可靠性。
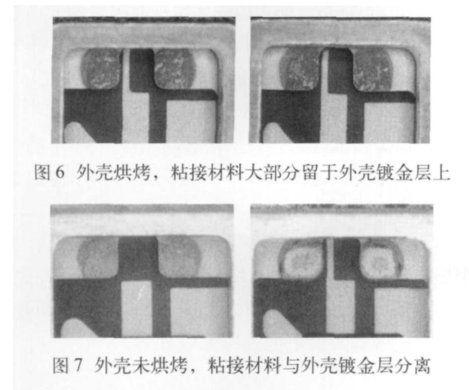
圖 8 使用的高溫導電膠裝片粘接材料熱失重百分比低、固化后的組織結構致密,從 X 射線圖片中可看到,芯片粘接層中只有個別的小孔隙,芯片有效粘接面積在98%以上,5.0mm×5.0mm的樣品抗剪、抗拉強度測試值都大于10kg,滿足了芯片粘接可靠性要求。
圖 9 使用的絕緣玻璃粘接材料,固化后粘接材料中存在大量氣孔,粘接層強度低,分離基本在粘接層中,大部分樣品抗剪、抗拉強度測試參數小于2.0kg,不能滿足芯片粘接可靠性要求,此種材料完全不能應用于有強度要求的粘接。
3.4 控制粘接劑固化后的余留厚度,提高粘接可靠性
裝片操作中如將粘接層設置過薄,必將影響芯片的粘接強度,合適的粘接層厚度在芯片 - 粘接層受到外界的各種應力時可起到應力緩沖的作用,從而提高粘接的可靠性。
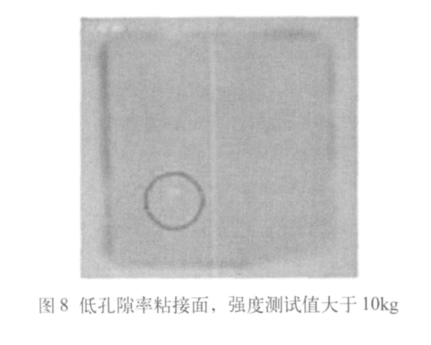

粘接層厚度需根據芯片的尺寸和粘接材料固化后的收縮特性來設置粘接劑的厚度。一般情況下,芯片面積與粘接劑的厚度近似成正比,芯片面積大粘接層厚度可適當厚一些。粘接材料在固化過程中會有部分溶劑或低分子揮發物揮發掉,固化后的厚度會比分配時的厚度要薄一些,因此在設置時需根據粘接劑固化前、后的參數變化值,確定粘接層厚度,從而提高芯片粘接的強度要求。
3.5 優化固化工藝曲線,降低粘接材料中孔隙率
固化是裝片工藝的關鍵所在,粘接層中的孔隙率若偏高,使芯片有效粘接面積降低,從而影響芯片的粘接強度;另外大量孔隙的存在使芯片的導熱性能下降,使器件的可靠性受影響,因此對粘接層中的孔隙率要加強控制。
粘接材料在固化期間,溶劑或水汽會釋放出來,若氣體聚集則會產生空隙,固化后孔隙將殘留在粘接層中,從而影響芯片的粘接強度。針對這種情況,需優化固化工藝曲線,使粘接材料中的揮發性氣體均勻逸出,從而不會因升溫過快使膠體表面先“結殼”,加劇產生孔隙而影響結合強度。固化后通過 X 射線儀來檢查和分析粘結層以及粘接界面是否存在孔隙等,來確定固化曲線設置的優劣。
4 芯片粘接強度的測量方法及影響
4.1 芯片粘接強度的測量方法
控制芯片粘接強度,必須對芯片粘接進行正確、有效地測量。芯片粘接強度的測量方法有兩
種 [2] :剪切強度測試、抗拉強度測試。芯片剪切強度測試如圖 10 所示。施加平行于芯片的長邊的力,將芯片剪切下來的力的大小直接反映出芯片與粘接層、粘接層、粘接層與外殼 / 基座間的粘接強度。
芯片抗拉強度測試如圖11 所示。在芯片上施加垂直于表面的作用力,以檢測粘接面積大于5mm 2 的芯片與粘接層、粘接層、粘接層與外殼 / 基座間的附著強度。
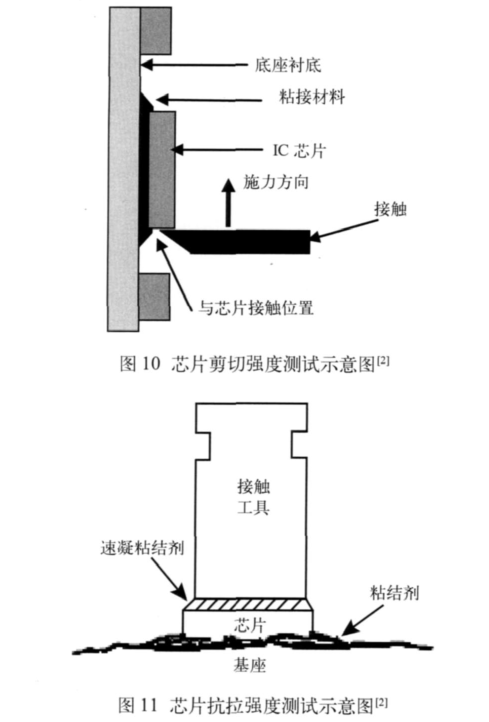
4.2 測量中需要注意的幾個問題
為了能夠正確地測量出芯片的剪切強度,測量時需要注意以下幾個問題:
(1)接觸工具的移動不要過快(負載加載速率)。否則芯片容易被剪碎或造成測量失敗,也更易使測量值比實際值大。
(2)測試接觸工具與芯片接觸位置至少要大于芯片厚度的1/2,如果測試接觸工具與芯片接觸的位置小于芯片厚度的1/2,芯片容易被剪碎;但也不能接觸粘接層,更不能與外殼 / 基座接觸。否則,測試值不能真實反應芯片實際粘接強度。
(3)施加的力的方向始終保持與外殼 / 基座上的芯片平行。如果施力的方向不平行,芯片邊緣容易被剪碎,且測試值會偏離芯片實際的剪切強度。
(4)芯片或芯片連同粘接層已從外殼/基座上分離時,測量的接觸工具要及時停止,以防止其繼續移動碰到外殼/基座或其他物體,避免繼續施力使測量值大于實際抗剪強度。
(5) 芯片較薄(如180μm等)、芯片面積過大(如5.0mm×5.0mm)則不適合使用抗剪強度測試來檢測芯片的粘接質量,因測試接觸面相對較小,硅芯片在分離前已經碎了,無法測量出剪切強度。
芯片抗拉強度測量還需注意:
(1)接觸工具與芯片的接觸面積應≥60% 的芯片面積,否則不能真實反映粘接強度,為不可信數據,其遠小于真實值。
(2) 快速凝固粘結劑不允許流出芯片表面,否則快速凝固粘結劑會將芯片與裝片粘接材料、外殼/基座粘接,測試施加的力會大于芯片本身實際的抗拉強度,此測試數據也應作無效處理。
5 結論
根據芯片的強度測試,對芯片施加力的大小、及在該力作用下產生的失效類型(如出現失效)以及殘留的芯片附著材料和外殼 / 基座各粘接界面的形貌,進行正確的分類并分析引發失效或強度弱的相關因素,找出相關原因,針對性地從粘接材料、封裝工藝實施改進,從而提高芯片粘接的可靠性。
審核編輯:湯梓紅
-
芯片
+關注
關注
459文章
52115瀏覽量
435570 -
半導體
+關注
關注
335文章
28538瀏覽量
231944 -
失效模式
+關注
關注
0文章
25瀏覽量
10284
原文標題:芯片粘接失效模式及粘接強度提高途徑
文章出處:【微信號:半導體封裝工程師之家,微信公眾號:半導體封裝工程師之家】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
彈性粘接技術在客車上的應用
LED燈條透鏡粘接用什么_LED燈條透鏡粘接技術詳解
UV膠水粘接亞克力制品的粘接方法都有哪幾種
使用UV膠時如何提高粘度和粘接剝離的強度
如何選擇合適的塑料粘接UV膠水
快干膠的粘接影響因素有哪些呢
半導體芯片封裝膠水的粘接原理






 芯片粘接失效模式和芯片粘接強度提高途徑
芯片粘接失效模式和芯片粘接強度提高途徑



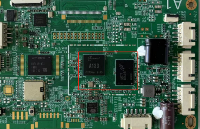











評論