電子發燒友網報道(文/吳子鵬)溫度控制在半導體制造領域的應用非常廣泛。比如,在單晶爐中,溫度變化會影響到晶體的生長;在芯片測試系統里,溫度在一定范圍的變化,可以看到芯片在工作溫度范圍里,在內部熱應力、漏電電流和電氣性能等關鍵性能方面的變化;在封裝環節,出色的溫度控制能夠應對晶圓和PCB板的翹曲問題。這樣的案例不勝枚舉。
近日,在ERS媒體見面會上,該公司分享了他們為半導體行業提供的創新的溫度測試解決方案,包括用于晶圓測試的溫度卡盤、熱拆鍵合/翹曲矯正一體機,以及獨立的翹曲矯正設備等。
用于晶圓測試的溫度卡盤
探針臺作為晶圓測試的關鍵設備,將測試機輸出激勵信號進行互通與信號反饋,最終完成測試數據的獲取采集。在晶圓測試的探針臺里,溫度卡盤的作用是提供測試所需要的溫度環境,比如晶圓測試可能會需要300℃的溫度環境,或者500℃的溫度環境。
在極端的溫度下,如果溫度卡盤本身的質量不過關,那么就可能導致出現嚴重的熱漂移問題,影響探針和Pad點的對準。ERS自1970年開始涉足晶圓針測溫度控制技術研究,深知溫度對設備的測試結果有著重大影響,致力于推出溫度卡盤系統,以滿足市場對溫度測試的需要。公司副總裁兼ERS中國總經理周翔指出,“隨著科技的發展,終端電子產品的種類越來越豐富,對芯片測試的需求也就越多,其中最重要的參數便是溫度,比如廣泛應用在汽車內的芯片,就必須要保證在極寒天氣正常運作。”
媒體會上,ERS向參會媒體展示了該公司旗艦溫度卡盤系統——AC3 Fusion。

AC3 Fusion,圖源:ERS
AC3 Fusion是AC3系列升級迭代的產品,不僅系統本身精進了能耗控制技術,也能夠更好地賦能芯片產業以及下游終端產業響應全球主要國家和地區推行的“碳中和”目標。AC3 Fusion主要有以下幾點優勢:
? 溫度范圍廣:-60℃- +400℃
? 使用CDA空氣作為制冷劑
? 無與倫比的可靠性和極長的使用壽命
? 近乎于零的維護要求
? 升溫速度極快
? -40℃ - +150℃范圍內均勻性穩定在±0.5℃
? fA級的超低噪聲指標性能
? 適用于各類手動、半自動、全自動探針臺
除了上述性能有優勢以外,AC3 Fusion還提供了三種工作模式,包括AC3模式、Turbo模式和ECO模式。其中,AC3模式沿用傳統AC3溫度卡盤系統;Turbo模式與AC3相比,轉換時間提高40%,特別適用于零下40度及以下的低溫測試環境;ECO模式節約能耗最高可達65%,是理想的室溫或高溫晶圓針測解決方案。
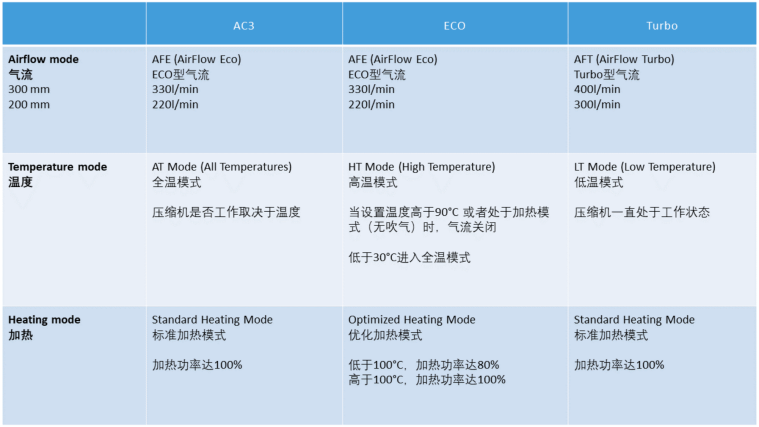
圖源:ERS electronic
除了主打產品溫度卡盤,ERS也提供很多定制卡盤,比如高壓大電流卡盤、溫度高均勻性卡盤、強真空卡盤、超低噪聲卡盤等,以滿足市場上的差異化需求。
ERS賦能先進封裝發展
在半導體領域,目前先進封裝概念大熱,主要應用面向高性能計算、高端服務器等領域,擁有倒裝芯片(FlipChip,FC)結構封裝、晶圓級封裝(WaferLevelPackage,WLP)、2.5D封裝、3D封裝等多種形式。知名半導體分析機構Yole預計,到2025年先進封裝的市場規模將占到整個封裝市場的49.4%,成為后續封裝市場的主要增長引擎。
面向先進封裝領域,本次媒體會上,ERS介紹了該公司的扇出型晶圓級/面板級熱拆鍵合/翹曲矯正機。
周翔稱,晶粒偏移(Die Shift)和翹曲(Warpage)是目前扇出型封裝面臨的主要問題。ERS公司提供的全自動熱拆鍵合/翹曲矯正一體機ADM330,全自動翹曲矯正機WAT330,以及全自動面板級熱拆鍵合機APDM650等設備,能夠幫助行業更好地應對這些難題。
ADM330的主要性能優勢有:
? 支持300/330mm晶圓
? 集成晶圓翹曲控制系統
? 翹曲測量和激光標記流程化
? 處理過程中對晶圓僅施加極小的壓力
? 溫度范圍:20℃ - 240℃
? 獨特的溫度卡盤設計使其兼具強真空性能
? 符合GEM300標準,適用于工業4.0
WAT330的主要性能優勢有:
? 可處理化合物晶圓規格:300mm
? 搭載ERS三溫滑動專利技術
? 矯正晶圓翹曲能力:±5mm
? 輸出翹曲典型值:<1mm
? 全程檢測并矯正翹曲
APDM650的主要性能優勢有:
? 最大可處理的面板規格:650x650mm
? 溫度均勻性可穩定在 ±3℃ @200℃
? 自動脫粘
? 搭載三溫滑動專利技術
? 根據不同的EFEM配置實現定制化
? 全程安全操作
另外,慕尼黑當地時間5月31日,ERS宣布開發了一種史無前例的晶圓翹曲測量和分析設備——Wave3000。得益于其先進的光學掃描測量方法,Wave3000可以準確地測量晶圓在特定處理位置的變形,并提供全面精準的翹曲分析,這對于確保先進封裝設備的質量至關重要。
持續看好中國市場
根據周翔的介紹,ERS自2018年進入中國市場,發展非常迅速。2022年,該公司中國區營收已經占到總營收的40%,有著驚人的增速。并且,后續ERS將加大對中國市場的投入。
慕尼黑當地時間6月29日,ERS宣布,公司與上海晶毅電子科技有限公司聯手在上海成立ERS中國實驗室。這一合作建立的實驗室將為雙方提供一個為客戶展示產品demo、提供現場產品測試的平臺。通過技術交流和資源共享,更準確地了解客戶的需求,精準定位,從而加速產品開發和市場推廣速度。

圖源:ERS
周翔表示,“共同建立實驗室,是與晶毅合作以來一個重要的里程碑。通過共享技術和資源,我們將能夠更敏銳地了解市場動態以及客戶需求,從而為客戶提供更及時更優質的解決方案。”
發布評論請先 登錄
先進封裝技術- 6扇出型晶圓級封裝(FOWLP)






 ERS:專注晶圓溫度針測和扇出型先進封裝,繼續深耕中國市場
ERS:專注晶圓溫度針測和扇出型先進封裝,繼續深耕中國市場





















評論