封裝
經(jīng)過(guò)之前幾個(gè)工藝處理的晶圓上會(huì)形成大小相等的方形芯片(又稱“單個(gè)晶片”)。下面要做的就是通過(guò)切割獲得單獨(dú)的芯片。剛切割下來(lái)的芯片很脆弱且不能交換電信號(hào),需要單獨(dú)進(jìn)行處理。這一處理過(guò)程就是封裝,包括在半導(dǎo)體芯片外部形成保護(hù)殼和讓它們能夠與外部交換電信號(hào)。整個(gè)封裝制程分為五步,即晶圓鋸切、單個(gè)晶片附著、互連、成型和封裝測(cè)試。
1、晶圓鋸切
要想從晶圓上切出無(wú)數(shù)致密排列的芯片,我們首先要仔細(xì)“研磨”晶圓的背面直至其厚度能夠滿足封裝工藝的需要。研磨后,我們就可以沿著晶圓上的劃片線進(jìn)行切割,直至將半導(dǎo)體芯片分離出來(lái)。
晶圓鋸切技術(shù)有三種:刀片切割、激光切割和等離子切割。
刀片切割是指用金剛石刀片切割晶圓,這種方法容易產(chǎn)生摩擦熱和碎屑并因此損壞晶圓。
激光切割的精度更高,能輕松處理厚度較薄或劃片線間距很小的晶圓。
等離子切割采用等離子刻蝕的原理,因此即使劃片線間距非常小,這種技術(shù)同樣能適用。
2、單個(gè)晶片附著
所有芯片都從晶圓上分離后,我們需要將單獨(dú)的芯片(單個(gè)晶片)附著到基底(引線框架)上。基底的作用是保護(hù)半導(dǎo)體芯片并讓它們能與外部電路進(jìn)行電信號(hào)交換。附著芯片時(shí)可以使用液體或固體帶狀粘合劑。
3、互連
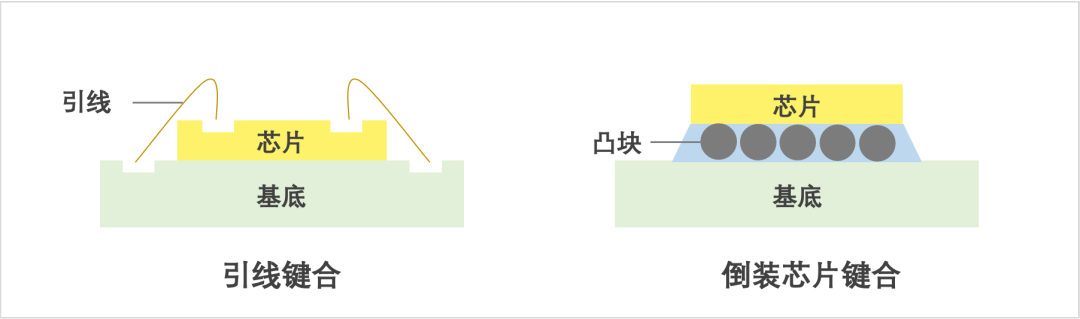
在將芯片附著到基底上之后,我們還需要連接二者的接觸點(diǎn)才能實(shí)現(xiàn)電信號(hào)交換。這一步可以使用的連接方法有兩種:使用細(xì)金屬線的引線鍵合和使用球形金塊或錫塊的倒裝芯片鍵合。引線鍵合屬于傳統(tǒng)方法,倒裝芯片鍵合技術(shù)可以加快半導(dǎo)體制造的速度。
4、成型
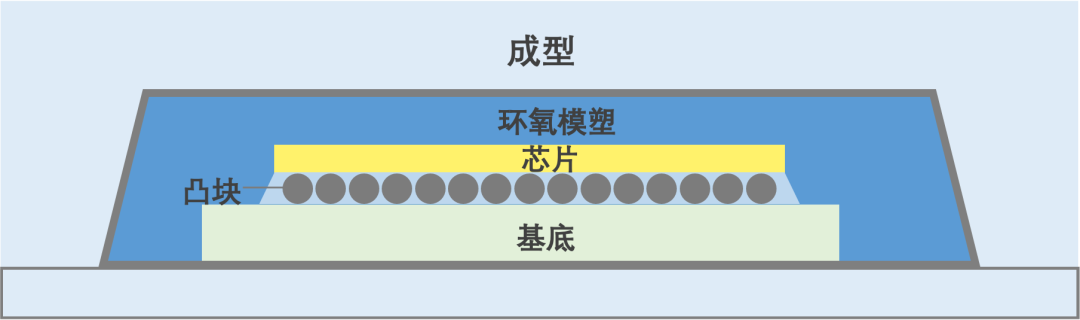
完成半導(dǎo)體芯片的連接后,需要利用成型工藝給芯片外部加一個(gè)包裝,以保護(hù)半導(dǎo)體集成電路不受溫度和濕度等外部條件影響。根據(jù)需要制成封裝模具后,我們要將半導(dǎo)體芯片和環(huán)氧模塑料 (EMC) 都放入模具中并進(jìn)行密封。密封之后的芯片就是最終形態(tài)了。
5、封裝測(cè)試
已經(jīng)具有最終形態(tài)的芯片還要通過(guò)最后的缺陷測(cè)試。進(jìn)入最終測(cè)試的全部是成品的半導(dǎo)體芯片。它們將被放入測(cè)試設(shè)備,設(shè)定不同的條件例如電壓、溫度和濕度等進(jìn)行電氣、功能和速度測(cè)試。這些測(cè)試的結(jié)果可以用來(lái)發(fā)現(xiàn)缺陷、提高產(chǎn)品質(zhì)量和生產(chǎn)效率。
隨著芯片體積的減少和性能要求的提升,封裝在過(guò)去數(shù)年間已經(jīng)歷了多次技術(shù)革新。面向未來(lái)的一些封裝技術(shù)和方案包括將沉積用于傳統(tǒng)后道工藝,例如晶圓級(jí)封裝(WLP)、凸塊工藝和重布線層 (RDL) 技術(shù),以及用于前道晶圓制造的的刻蝕和清潔技術(shù)。
1)晶圓級(jí)封裝
傳統(tǒng)封裝需要將每個(gè)芯片都從晶圓中切割出來(lái)并放入模具中。晶圓級(jí)封裝(WLP)則是先進(jìn)封裝技術(shù)的一種, 是指直接封裝仍在晶圓上的芯片。WLP的流程是先封裝測(cè)試,然后一次性將所有已成型的芯片從晶圓上分離出來(lái)。與傳統(tǒng)封裝相比,WLP的優(yōu)勢(shì)在于更低的生產(chǎn)成本。
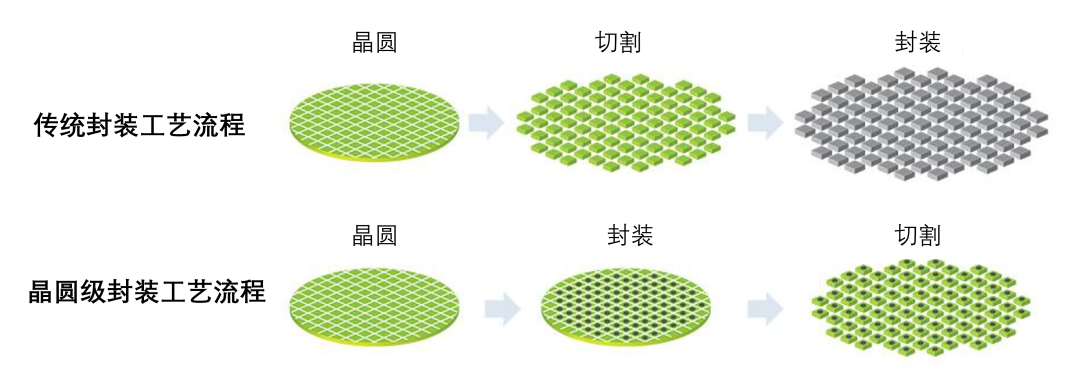
2)先進(jìn)封裝
先進(jìn)封裝可劃分為2D封裝、2.5D封裝和3D封裝。
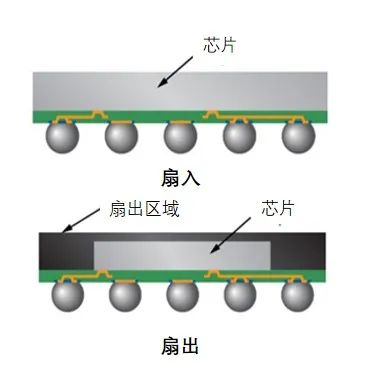
更小的2D封裝
如前所述,封裝工藝的主要用途包括將半導(dǎo)體芯片的信號(hào)發(fā)送到外部,而在晶圓上形成的凸塊就是發(fā)送輸入/輸出信號(hào)的接觸點(diǎn)。這些凸塊分為扇入型(fan-in) 和扇出型 (fan-out) 兩種,前者的扇形在芯片內(nèi)部,后者的扇形則要超出芯片范圍。我們將輸入/輸出信號(hào)稱為I/O(輸入/輸出),輸入/輸出數(shù)量稱為I/O計(jì)數(shù)。I/O計(jì)數(shù)是確定封裝方法的重要依據(jù)。如果I/O計(jì)數(shù)低就采用扇入封裝工藝。由于封裝后芯片尺寸變化不大,因此這種過(guò)程又被稱為芯片級(jí)封裝 (CSP) 或晶圓級(jí)芯片尺寸封裝 (WLCSP)。如果I/O計(jì)數(shù)較高,則通常要采用扇出型封裝工藝,且除凸塊外還需要重布線層 (RDL) 才能實(shí)現(xiàn)信號(hào)發(fā)送。這就是“扇出型晶圓級(jí)封裝 (FOWLP)”。
2.5D 封裝
2.5D封裝技術(shù)可以將兩種或更多類型的芯片放入單個(gè)封裝,同時(shí)讓信號(hào)橫向傳送,這樣可以提升封裝的尺寸和性能。最廣泛使用的2.5D封裝方法是通過(guò)硅中介層將內(nèi)存和邏輯芯片放入單個(gè)封裝。2.5D封裝需要硅通孔 (TSV)、微型凸塊和小間距RDL等核心技術(shù)。

3D 封裝
3D封裝技術(shù)可以將兩種或更多類型的芯片放入單個(gè)封裝,同時(shí)讓信號(hào)縱向傳送。這種技術(shù)適用于更小和I/O計(jì)數(shù)更高的半導(dǎo)體芯片。TSV可用于I/O計(jì)數(shù)高的芯片,引線鍵合可用于I/O計(jì)數(shù)低的芯片,并最終形成芯片垂直排列的信號(hào)系統(tǒng)。3D封裝需要的核心技術(shù)包括TSV和微型凸塊技術(shù)。
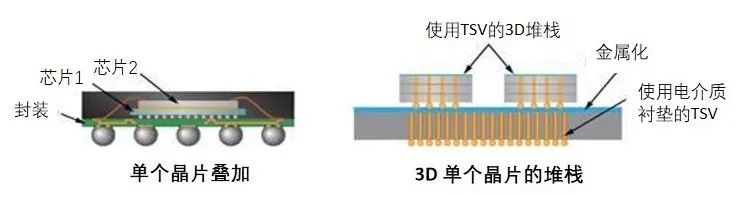
-
劃片機(jī)
+關(guān)注
關(guān)注
0文章
169瀏覽量
11347
發(fā)布評(píng)論請(qǐng)先 登錄
晶圓隱裂檢測(cè)提高半導(dǎo)體行業(yè)效率

減薄對(duì)后續(xù)晶圓劃切的影響

馬波斯VBI破刀偵測(cè):變革半導(dǎo)體生產(chǎn)的劃片機(jī)
探索MEMS傳感器制造:晶圓劃片機(jī)的關(guān)鍵作用

【博捷芯12寸雙軸全自動(dòng)劃片機(jī)】半導(dǎo)體切割高效解決方案 | 精準(zhǔn)穩(wěn)定,產(chǎn)能翻倍

聚焦:國(guó)產(chǎn)半導(dǎo)體劃片機(jī)在消費(fèi)電子、智能設(shè)備芯片切割領(lǐng)域的關(guān)鍵應(yīng)用

從晶圓到芯片:劃片機(jī)在 IC 領(lǐng)域的應(yīng)用
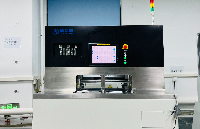
全自動(dòng)晶圓劃片機(jī)的應(yīng)用產(chǎn)品優(yōu)勢(shì)

半導(dǎo)體晶圓制造工藝流程

半導(dǎo)體劃片機(jī)在鐵氧體劃切領(lǐng)域的應(yīng)用






 劃片機(jī):晶圓加工第八篇—半導(dǎo)體芯片封裝完結(jié)篇
劃片機(jī):晶圓加工第八篇—半導(dǎo)體芯片封裝完結(jié)篇















評(píng)論