ALD介紹
原子層沉積(Atomic layer deposition,ALD)是一種可以沉積單分子層薄膜的特殊的化學氣相沉積技術 。
有別于化學氣相沉積(CVD)和物理氣相沉積(PVD),這兩種方式要么是通過氣體的化學反應在晶圓表面沉積所需物質,要么是通過轟擊離子束的物理過程沉積所需物質。 ALD利用順序暴露的化學反應物,每種反應物在分隔的時間內進行自限制(Self-limiting)的沉積 。
在CVD中,化學反應發生于氣相中或在襯底的表面上,但 在ALD中,化學反應僅在襯底表面發生,從而阻止了氣相的化學反應 。簡單來說,如果想在晶圓表面上沉積薄薄的一層A物質,則要先備好經反應后可生成A物質的反應物B和C。反應物B必須是容易被晶圓表面吸附的氣體(前驅體,Precursor),反應物C則應具有較強的反應活性。
在ALD中,先把氣體B吸附到晶圓表面,如果氣體B之間很難相互吸附,晶圓表面將形成一層由氣體B組成的原子層。然后,除去剩余氣體B并輸入氣體C, 使吸附在晶圓表面上的氣體B和氣體C發生反應 ,形成A物質和其他副產物氣體,再除去多余的氣體C和副產物氣體。
以生長ALD-Al2O3薄膜為例,可以非常好的解釋,ALD利用順序暴露的化學反應物。下圖中(a) Al(CH3)3(三甲基鋁,TMA)和OH·Si反應,生成AlO(CH2)2·Si和CH4 。
通過化學反應移除副產物CH4和尚未反應的TMA,如圖(b)所示。下圖(c)中, AlO(CH3)2·Si和H2O發生反應,產生AlO(OH)2·Si和CH4 。通過化學反應移除副產物CH4和未反應的水,如圖(d)所示。兩個反應不斷重復發生,以生成ALD-Al2O3薄膜。

參考ALD-AL2O3薄膜的化學式,可以發現,薄膜的厚度只取決于反應周期的次數。不斷重復上述過程,以單原子膜形式一層一層地在基底表面鍍膜。 這也顯示了ALD技術主要受限于其沉積速率,因為ALD一個周期只能沉積一層原子層,需要逐次沉積,沉積速率也慢了下來 。
OH·Si+Al(CH3)3->AlO(CH3)2·Si+CH4
AlO(CH3)2·Si+2H2O->AlO(OH)2·Si+2CH4
總結
未來集成電路技術所需薄膜越來越薄,雖然ALD自身存在著沉積速率低的問題,但在電容、柵極和互連線上,ALD顯示了其獨特的優勢。
-
半導體
+關注
關注
335文章
28584瀏覽量
232429 -
PVD
+關注
關注
4文章
51瀏覽量
17296 -
CVD
+關注
關注
1文章
76瀏覽量
10923
發布評論請先 登錄
泛林集團宣布推出一種用于沉積低氟填充鎢薄膜的新型原子層沉積 (ALD) 工藝
原子層沉積(ALD)工藝助力實現PowderMEMS技術平臺
原子層沉積(Atomic Layer Deposition,ALD)
Beneq和LZH合作開發空間ALD系統,可快速在復雜光學元件上鍍膜
ALD技術工藝原理、優勢及應用

原子層沉積ALD技術實現邊緣鈍化,TOPCon電池效率提高0.123%

原子層沉積(ALD)制備高透光摻鈮SnO?電子傳輸層(ETL)實現高效鈣鈦礦太陽能電池






 原子層ALD沉積介紹
原子層ALD沉積介紹
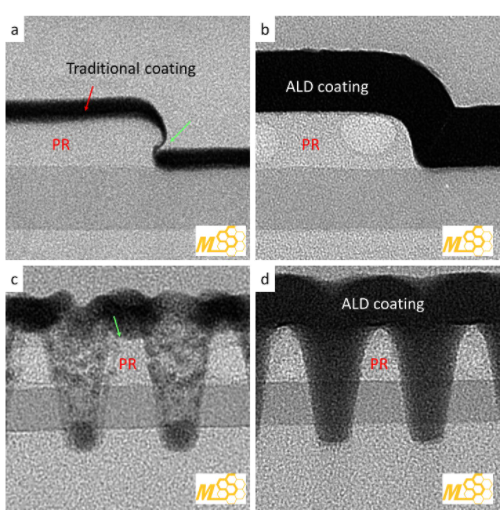

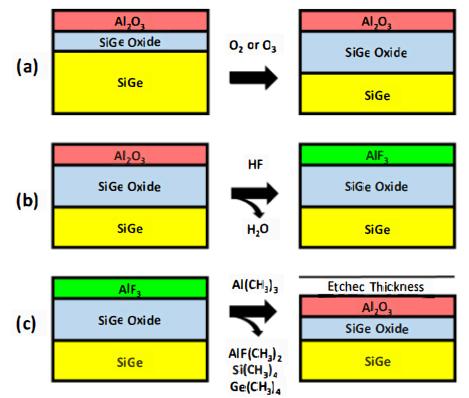


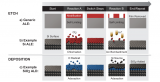
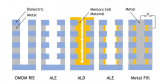










評論