摘要:
本文以半導(dǎo)體封裝技術(shù)為研究對(duì)象,在論述半導(dǎo)體封裝技術(shù)及其重要作用的基礎(chǔ)上,探究了現(xiàn)階段半導(dǎo)體封裝技術(shù)的芯片保護(hù)、電氣功能實(shí)現(xiàn)、通用性、封裝界面標(biāo)準(zhǔn)化、散熱冷卻功能等諸多發(fā)展趨勢(shì),深入研究了半導(dǎo)體前端制造工藝對(duì)封裝技術(shù)的影響,探究了各種半導(dǎo)體封裝內(nèi)部連接方式之間的相互關(guān)系,旨在為我國(guó)半導(dǎo)體封裝技術(shù)應(yīng)用水平的快速提升帶來(lái)更多參考和啟迪。
就半導(dǎo)體制造產(chǎn)業(yè)而言,半導(dǎo)體工藝制造流程主要包括前道部分和后道部分,其中,前道部分的半導(dǎo)體制造涉及內(nèi)容較繁雜且技術(shù)要求精度較高,整個(gè)工藝制造流程數(shù)可高達(dá)數(shù)百個(gè),且半導(dǎo)體各工藝流程、批次、設(shè)備之間往往存在著相互影響、相互關(guān)聯(lián)和相互依托的緊密關(guān)系,是半導(dǎo)體前道工序供應(yīng)生產(chǎn)的典型特征,也是當(dāng)今社會(huì)公認(rèn)的最為復(fù)雜的產(chǎn)品制造過(guò)程。就半導(dǎo)體后道封裝工藝而言,封裝工藝相比前道工藝流程較簡(jiǎn)單,但由于半導(dǎo)體設(shè)備批量較小、品種較多,且部分產(chǎn)品分批、合批等操作復(fù)雜,操作步驟較多,因此,半導(dǎo)體后道封裝工序仍舊是混合型和復(fù)雜型的工藝制造過(guò)程。就我國(guó)現(xiàn)階段半導(dǎo)體企業(yè)后道封裝工藝生產(chǎn)而言,其生產(chǎn)技術(shù)和半導(dǎo)體后道封裝效率提升仍舊存在一定難題。因此,本文圍繞半導(dǎo)體封裝技術(shù)進(jìn)行深入探討與研究,也就具備重要理論意義和現(xiàn)實(shí)價(jià)值。
1 半導(dǎo)體封裝技術(shù)及其作用
傳統(tǒng)模式下,人們對(duì)半導(dǎo)體封裝技術(shù)的理解較為局限,更多地將其局限于半導(dǎo)體連接以及一個(gè)批次間的組裝,其整體涉及范圍較窄,且將半導(dǎo)體封裝技術(shù)以普通的生產(chǎn)技術(shù)對(duì)待,并未充分發(fā)掘半導(dǎo)體封裝技術(shù)的重要價(jià)值。隨著近年來(lái)電子信息產(chǎn)業(yè)的進(jìn)一步發(fā)展,半導(dǎo)體封裝技術(shù)逐步與電子產(chǎn)業(yè)工程相連接,在電子信息技術(shù)的支持下得到了更長(zhǎng)足的發(fā)展和進(jìn)步。
縱觀我國(guó)現(xiàn)階段半導(dǎo)體封裝技術(shù)以及世界半導(dǎo)體封裝技術(shù)發(fā)展過(guò)程可知,目前半導(dǎo)體封裝技術(shù)的發(fā)展已然可歸納為五大發(fā)展階段,目前絕大部分國(guó)家正朝著第四階段和第五階段邁進(jìn)。具體而言,半導(dǎo)體封裝技術(shù)的第一階段為 20 世紀(jì) 70 年代以前,該時(shí)間期限內(nèi)的半導(dǎo)體封裝技術(shù)主要采用通孔插裝型封裝技術(shù),封裝方式主要包括金屬圓形封裝或塑料雙列直插封裝等諸多形式。第二階段即為 20世紀(jì) 70 年代到 20 世紀(jì) 80 年代后期,該時(shí)間段內(nèi)的半導(dǎo)體封裝技術(shù)主要采用表面貼裝型封裝方式,典型的封裝外觀有塑料引線(xiàn)片封裝或無(wú)線(xiàn)四邊扁平封裝等。第三階段為 20 世紀(jì) 80 年代到 20 世紀(jì)90 年代,主要包括焊球陣列封裝或芯片尺寸封裝技術(shù)等,通常可借助陶瓷焊球陣列封裝或倒裝芯片焊球陣列封裝等方式實(shí)現(xiàn)。第四階段為 20 世紀(jì)末期,該時(shí)間段內(nèi)半導(dǎo)體封裝技術(shù)主要采用多芯片組件封裝或系統(tǒng)封裝方式,甚至部分先進(jìn)國(guó)家進(jìn)一步采用了三維立體封裝技術(shù),典型的封裝結(jié)構(gòu)主要包括多層陶瓷基板封裝模式或多層薄膜基板封裝模式。第五階段為 21 世紀(jì)初期,該時(shí)間段內(nèi)的半導(dǎo)體封裝結(jié)構(gòu)封裝技術(shù)主要為系統(tǒng)級(jí)的單芯片封裝模式或微電子機(jī)械結(jié)構(gòu)的封裝模式。整體而言,全世界范圍內(nèi)的半導(dǎo)體封裝技術(shù)主流發(fā)展仍處于第三階段的成熟期和技術(shù)快速進(jìn)步發(fā)展期,焊球陣列封裝和芯片尺寸封裝技術(shù)基本是現(xiàn)階段半導(dǎo)體封裝技術(shù)大規(guī)模生產(chǎn)和使用的關(guān)鍵技術(shù)類(lèi)型。
總體而言,半導(dǎo)體封裝技術(shù)主要包括以下作用:
(1)半導(dǎo)體封裝技術(shù)能夠保證半導(dǎo)體設(shè)備元件的正常工作,確保其預(yù)期功能的正常發(fā)揮;
(2)半導(dǎo)體封裝技術(shù)能夠保證半導(dǎo)體內(nèi)部信息數(shù)據(jù)的正常存儲(chǔ)與讀取,且能夠以功能化模塊結(jié)構(gòu)的形勢(shì),實(shí)現(xiàn)數(shù)據(jù)存儲(chǔ)功能要求;
(3)半導(dǎo)體封裝技術(shù)能夠通過(guò)各功能塊之間的強(qiáng)強(qiáng)結(jié)合,構(gòu)成半導(dǎo)體系統(tǒng)結(jié)構(gòu)裝置,實(shí)現(xiàn)其整體功能;
(4)半導(dǎo)體封裝技術(shù)能夠便于人和機(jī)器設(shè)備之間的信息交互,能夠建立更加方便快捷且響應(yīng)速度更快的人機(jī)界面;
(5)半導(dǎo)體封裝技術(shù)能夠進(jìn)一步加強(qiáng)半導(dǎo)體作為商品的附加價(jià)值,增強(qiáng)其市場(chǎng)競(jìng)爭(zhēng)力。
2 半導(dǎo)體封裝技術(shù)的現(xiàn)狀及動(dòng)向
2.1 芯片保護(hù)
隨著 21 世紀(jì)信息技術(shù)的進(jìn)一步發(fā)展,半導(dǎo)體內(nèi)部搭載多個(gè)芯片甚至多芯片封裝以及封裝內(nèi)系統(tǒng)或系統(tǒng)封裝等技術(shù)進(jìn)一步普及與發(fā)展,伴隨著大規(guī)模集成電路封裝技術(shù)逐步朝著小型化、薄型化方向理論體系的進(jìn)一步成熟,半導(dǎo)體封裝技術(shù)在遵從傳統(tǒng)模式下嚴(yán)格狀態(tài)的氣密性封裝,向現(xiàn)階段更加簡(jiǎn)易、便于操作的樹(shù)脂型封裝技術(shù)方向發(fā)展,而隨著大規(guī)模集成電路封裝尺寸的進(jìn)一步縮小和半導(dǎo)體疊層結(jié)構(gòu)應(yīng)用技術(shù)的進(jìn)一步成熟,半導(dǎo)體封裝技術(shù)除了滿(mǎn)足傳統(tǒng)模式下半導(dǎo)體封裝的保護(hù)芯片要求、運(yùn)行可靠性要求等基本要求外,更應(yīng)將半導(dǎo)體搭載于母板結(jié)構(gòu)降低其應(yīng)力緩沖以及保證半導(dǎo)體搭載連接可靠性。
2.2 電氣功能的實(shí)現(xiàn)
隨著近年來(lái)電源接地系統(tǒng)穩(wěn)定層穩(wěn)定要求的進(jìn)一步拔高,為最大限度降低半導(dǎo)體運(yùn)行過(guò)程中電流感應(yīng)、直流電阻甚至寄生電容等對(duì)半導(dǎo)體內(nèi)部結(jié)構(gòu)的影響,應(yīng)盡可能地發(fā)揮半導(dǎo)體封裝過(guò)程中的電器功能。在此過(guò)程中,半導(dǎo)體電氣信號(hào)布線(xiàn)應(yīng)隨著輸入和輸出端子數(shù)的進(jìn)一步增加盡可能縮短布線(xiàn)長(zhǎng)度,實(shí)現(xiàn)電源接地系統(tǒng)的阻攔和抗擊匹配,降低系統(tǒng)中電感、直流電阻甚至寄生電容等的不良影響。因此,為實(shí)現(xiàn)大規(guī)模集成電路中電氣功能目標(biāo),在以設(shè)計(jì)為主導(dǎo)的戰(zhàn)略觀念的支持下,充分考慮大規(guī)模集成電路的回路設(shè)計(jì)與封裝技術(shù)應(yīng)用,研究搭載封裝技術(shù)的模板結(jié)構(gòu)設(shè)計(jì),保證半導(dǎo)體電氣功能的圓滿(mǎn)達(dá)成。
2.3 通用性及封裝界面標(biāo)準(zhǔn)化
隨著半導(dǎo)體產(chǎn)業(yè)的進(jìn)一步成熟和完善,未來(lái)封裝技術(shù)中平面陣列端子型封裝技術(shù)將成為半導(dǎo)體封裝的常用技術(shù),而隨著半導(dǎo)體材料應(yīng)用范圍的進(jìn)一步拓寬,半導(dǎo)體結(jié)構(gòu)設(shè)計(jì)的多樣化與復(fù)雜性增強(qiáng),僅依賴(lài)傳統(tǒng)模式下的平面陣列端子型封裝技術(shù)并不能滿(mǎn)足半導(dǎo)體產(chǎn)業(yè)發(fā)展的多樣化要求。例如,當(dāng)半導(dǎo)體結(jié)構(gòu)檢查時(shí),利用平面陣列端子的電氣接觸技術(shù),將半導(dǎo)體安裝于母板后對(duì)待連接的部位進(jìn)行檢查,但現(xiàn)階段薄型封裝技術(shù)中的拾取技術(shù)并不能滿(mǎn)足其基本要求,因此,對(duì)封裝技術(shù)中的拾取技術(shù)進(jìn)行深入分析是未來(lái)半導(dǎo)體封裝通用性以及封裝界面標(biāo)準(zhǔn)化發(fā)展的重要趨勢(shì)。同時(shí),關(guān)于半導(dǎo)體封裝后端子節(jié)距、封裝尺寸以及封裝材料等的創(chuàng)新,甚至半導(dǎo)體與模板實(shí)裝界面的標(biāo)準(zhǔn)化設(shè)計(jì)等,都應(yīng)是未來(lái)半導(dǎo)體封裝技術(shù)發(fā)展的重要內(nèi)容。
2.4 散熱冷卻功能
進(jìn)一步探究半導(dǎo)體芯片性能可知,大規(guī)模集成電路中的特性線(xiàn)寬要求在日益發(fā)達(dá)的現(xiàn)代信息社會(huì)即將進(jìn)入亞 0.1nm 時(shí)代,因此,為確保先進(jìn)芯片的性能能夠滿(mǎn)足智能化社會(huì)發(fā)展目標(biāo),對(duì)半導(dǎo)體芯片的性能預(yù)測(cè)進(jìn)行探究,在未來(lái)的半導(dǎo)體發(fā)展過(guò)程中,幾乎所有電子設(shè)備使用大規(guī)模集成電路的功耗都將進(jìn)一步增加,而大規(guī)模集成電路的功能大約在 2~3w 以上,此時(shí)需在半導(dǎo)體封裝技術(shù)應(yīng)用過(guò)程中增加散熱片或增加熱沉,以此增加半導(dǎo)體散熱冷卻功能。在5~10W 以上時(shí),則必須采取強(qiáng)制冷卻手段,保證半導(dǎo)體散熱冷卻功能的正常發(fā)揮。當(dāng)半導(dǎo)體功能損耗值在 50~100W 以上時(shí),則應(yīng)該采取空冷技術(shù)。總之,上述所有散熱冷卻技術(shù)在未來(lái)一段時(shí)間內(nèi)都將是半導(dǎo)體封裝技術(shù)的重要發(fā)展方向。
3 半導(dǎo)體前端制造工藝對(duì)封裝技術(shù)的影響
半導(dǎo)體前端制造工藝對(duì)半導(dǎo)體封裝技術(shù)的影響,將直接快速地反應(yīng)到半導(dǎo)體后端生產(chǎn)技術(shù)上。眾所周知,現(xiàn)階段通用的大規(guī)模集成電路中的線(xiàn)寬由以往的 0.09 微米進(jìn)一步縮小,在 2008 年達(dá)到了0.057 微米,2018 年進(jìn)一步縮小到 0.018 微米。與此同時(shí),大規(guī)模集成電路中引線(xiàn)鍵合的焊盤(pán)間距在同一時(shí)間內(nèi)隨著大規(guī)模集成電路線(xiàn)寬的不斷縮小,從 35 微米進(jìn)一步縮小到了 20 微米,而倒裝芯片焊盤(pán)間距也進(jìn)一步由以往模式下的 150 微米進(jìn)一步縮小到現(xiàn)階段的70 微米左右,總體而言,半導(dǎo)體前端制造工藝焊盤(pán)間距將隨著前端線(xiàn)寬的不斷降低而不斷減小。也就是說(shuō),焊盤(pán)間距將進(jìn)一步隨著前端線(xiàn)寬參數(shù)值的不斷降低而減小,該趨勢(shì)也是未來(lái)較長(zhǎng)時(shí)間內(nèi)半導(dǎo)體封裝技術(shù)應(yīng)用時(shí)內(nèi)部連接方式發(fā)展的重要趨勢(shì)。同時(shí),作為大規(guī)模集成電路中的半導(dǎo)體芯片,由芯片到下一級(jí)封裝或印刷電路板的連接方式及整個(gè)內(nèi)部連接結(jié)構(gòu),受到封裝技術(shù)以及連接對(duì)象物理尺寸的限制,焊盤(pán)間距并不像半導(dǎo)體前端線(xiàn)寬一樣呈現(xiàn)出持續(xù)縮短的穩(wěn)定變化規(guī)律,而是在達(dá)到一定臨界值后,呈現(xiàn)出不再變化特征,這是半導(dǎo)體封裝技術(shù)不同于前端制造工藝的重要特點(diǎn),也是半導(dǎo)體技術(shù)中應(yīng)用封裝技術(shù)應(yīng)關(guān)注的重要內(nèi)容。
4 各種半導(dǎo)體封裝內(nèi)部連接方式的相互關(guān)系
目前,半導(dǎo)體封裝結(jié)構(gòu)中 90% 以上的封裝管腳采用引線(xiàn)鍵合連接模式,倒裝芯片的內(nèi)部連接模式整體增長(zhǎng)速度盡管較快,但直到 2018 年,我國(guó)半導(dǎo)體產(chǎn)業(yè)仍就以引線(xiàn)鍵合方式作為半導(dǎo)體芯片內(nèi)部連接的主導(dǎo)技術(shù),無(wú)論是在半導(dǎo)體封裝行業(yè)或其他權(quán)威預(yù)測(cè)均表明引線(xiàn)鍵合內(nèi)部連接方式是現(xiàn)階段半導(dǎo)體封裝甚至是半導(dǎo)體產(chǎn)業(yè)低端封裝內(nèi)部最主流的連接方式。基于引線(xiàn)鍵合方式的工藝硅膠凸點(diǎn),能夠進(jìn)一步生成倒裝芯片的關(guān)鍵工序內(nèi)容,并對(duì)倒裝芯片連接方式中的諸多常規(guī)步驟進(jìn)行融合,這一優(yōu)勢(shì)是引線(xiàn)鍵合連接方式長(zhǎng)期存續(xù)且在半導(dǎo)體內(nèi)部封裝技術(shù)應(yīng)用中源源不竭的重要特征。盡管倒裝芯片封裝技術(shù)發(fā)展較為迅速,但仍舊受到運(yùn)行可靠性和運(yùn)行成本高昂的限制,無(wú)法在大規(guī)模的市場(chǎng)環(huán)境中進(jìn)行推廣,更遑論取代以往引線(xiàn)鍵合方式成為半導(dǎo)體封裝技術(shù)內(nèi)部的主流連接方法。
總之,倒裝芯片的半導(dǎo)體封裝方式在現(xiàn)階段的半導(dǎo)體封裝技術(shù)應(yīng)用過(guò)程中受到高昂的成本限制和運(yùn)行安全可靠性等諸多因素的不良影響,并不能夠在大范圍商業(yè)用途的半導(dǎo)體芯片過(guò)程中使用,不能進(jìn)行大規(guī)模或大體量的生產(chǎn)與售賣(mài),并不能夠取代引線(xiàn)鍵合方式而成為現(xiàn)階段半導(dǎo)體內(nèi)部封裝連接方式。但倒裝芯片的半導(dǎo)體封裝內(nèi)部連接結(jié)構(gòu)形式,將作為高成本和高性能同步發(fā)展?fàn)顟B(tài)下的半導(dǎo)體封裝內(nèi)部連接方式,與引線(xiàn)鍵合連接方式長(zhǎng)期共存,該類(lèi)新型的半導(dǎo)體封裝技術(shù),將會(huì)對(duì)部分性能要求較高而在一定程度上忽視成本費(fèi)用的行業(yè),例如航空航天行業(yè)或軍用行業(yè)中的半導(dǎo)體封裝中得到進(jìn)一步發(fā)展與應(yīng)用。也就是說(shuō),引線(xiàn)鍵合的和倒裝芯片的半導(dǎo)體封裝內(nèi)部連接方式,在現(xiàn)階段都將繼續(xù)按照其自身發(fā)展的技術(shù)規(guī)律不斷進(jìn)步,也將在半導(dǎo)體封裝技術(shù)不斷提升和優(yōu)化背景下得到長(zhǎng)足穩(wěn)定的發(fā)展。此外,半導(dǎo)體封裝系統(tǒng)也是近年來(lái)半導(dǎo)體封裝技術(shù)發(fā)展的重要趨勢(shì),在一定程度上代表了未來(lái)較長(zhǎng)時(shí)間內(nèi)半導(dǎo)體封裝技術(shù)的發(fā)展方向。封裝中系統(tǒng)是在半導(dǎo)體封裝技術(shù)中利用多個(gè)不同結(jié)構(gòu)、形式相互獨(dú)立卻又緊密益相關(guān)的集成模塊,實(shí)現(xiàn)半導(dǎo)體,尤其是大規(guī)模集成電路的完整性和其他強(qiáng)大功能。該封裝系統(tǒng)具備較短的開(kāi)發(fā)周期技術(shù)優(yōu)勢(shì),也具備較強(qiáng)的開(kāi)發(fā)靈活性?xún)?yōu)勢(shì),封裝中系統(tǒng)技術(shù)的應(yīng)用,結(jié)合引線(xiàn)鍵合和倒裝芯片甚至是硅片鍵合和方向,在其技術(shù)發(fā)展上均有所體現(xiàn),其共同存在情況將進(jìn)一步優(yōu)化半導(dǎo)體封裝技術(shù)在未來(lái)的發(fā)展。
5 結(jié)論與展望
在電子信息化產(chǎn)業(yè)進(jìn)一步完善和市場(chǎng)發(fā)展過(guò)程中,半導(dǎo)體生產(chǎn)企業(yè)應(yīng)盡可能地提升其封裝工藝,通過(guò)半導(dǎo)體內(nèi)部封裝連接方式相互關(guān)系的總結(jié)與梳理以及半導(dǎo)體前端制造工藝對(duì)整個(gè)封裝技術(shù)應(yīng)用的影響關(guān)系梳理,充分感知半導(dǎo)體封裝技術(shù)的現(xiàn)階段應(yīng)用現(xiàn)狀及未來(lái)創(chuàng)新方向,為半導(dǎo)體封裝技術(shù)應(yīng)用水平的快速提升打下扎實(shí)基礎(chǔ)。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
459文章
52119瀏覽量
435627 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28547瀏覽量
231988 -
封裝
+關(guān)注
關(guān)注
128文章
8459瀏覽量
144720 -
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
573瀏覽量
68418 -
制造工藝
+關(guān)注
關(guān)注
2文章
198瀏覽量
20246
原文標(biāo)題:半導(dǎo)體封裝技術(shù)研究
文章出處:【微信號(hào):半導(dǎo)體封裝工程師之家,微信公眾號(hào):半導(dǎo)體封裝工程師之家】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
Sic mesfet工藝技術(shù)研究與器件研究
新型銅互連方法—電化學(xué)機(jī)械拋光技術(shù)研究進(jìn)展
申請(qǐng)半導(dǎo)體技術(shù)論壇版主
招聘半導(dǎo)體封裝工程師
集成電路封裝技術(shù)專(zhuān)題 通知
SiC功率器件的封裝技術(shù)研究
《炬豐科技-半導(dǎo)體工藝》用于半導(dǎo)體封裝基板的化學(xué)鍍 Ni-P/Pd/Au
國(guó)內(nèi)最近的三條半導(dǎo)體新聞首條先進(jìn)半導(dǎo)體封裝測(cè)試示范產(chǎn)線(xiàn)啟動(dòng)
中烏第三代半導(dǎo)體產(chǎn)業(yè)技術(shù)研究院落戶(hù)如皋
半導(dǎo)體封裝所通過(guò)江蘇省產(chǎn)業(yè)技術(shù)研究院2020年度績(jī)效核查
半導(dǎo)體封裝技術(shù)研究所獲產(chǎn)研院績(jī)效考核總院第一名
高功率半導(dǎo)體激光器過(guò)渡熱沉封裝技術(shù)研究
高功率半導(dǎo)體激光器過(guò)渡熱沉封裝技術(shù)研究
碳化硅功率半導(dǎo)體多芯片封裝技術(shù)研究
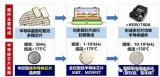





 半導(dǎo)體封裝技術(shù)研究
半導(dǎo)體封裝技術(shù)研究










評(píng)論